C 5941 : 1997
(1)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
まえがき
この規格は,工業標準化法に基づいて,日本工業標準調査会の審議を経て,通商産業大臣が改正した日
本工業規格である。これによってJIS C 5941-1989は改正され,この規格に置き換えられる。
今回の改正では,日本工業規格と国際規格との一致に留意したが,これについては解説にその詳細を記
述した。
この規格の一部が,技術的性質をもつ特許権,出願公開後の特許出願,実用新案権又は出願公開後の実
用新案登録出願に抵触する可能性があることに注意を喚起する。通商産業大臣及び日本工業標準調査会は,
このような技術的性質をもつ特許権,出願公開後の特許出願,実用新案権又は出願公開後の実用新案登録
出願にかかわる確認について,責任はもたない。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
C 5941 : 1997
光伝送用半導体レーザ測定方法
Measuring methods of laser diodes
for fiber optic transmission
序文 規格を適用するに当たっては,その規格が引用している規格も同時に参照しなければならない。
また,同類の規格があれば,これとの比較検討が必要なことも多い。
この規格は,1992年に発行されたIEC 747-5 (Semiconductors devices. Discrete devices and integrated circuits
−Part 5 : Optoelectronic devices), 及び1994年に発行されたIEC 747-5 Amendment 1を元に,技術的内容を
変更することなく作成した日本工業規格である。
1. 適用範囲 この規格は,光源として使用する光伝送用半導体レーザ(電子回路内蔵型を除く。ただし,
必要に応じモニタ用フォトダイオードを含む。以下,半導体レーザという。)の測定方法について規定する。
備考1. この規格の引用規格を,次に示す。
JIS C 1102 指示電気計器
JIS C 5001 電子部品通則
JIS C 5940 光伝送用半導体レーザ通則
2. この規格の対応国際規格を,次に示す。
IEC 747-5 : 1992 Semiconductors devices. Discrete devices and integrated circuits −Part 5 :
Optoelectronic devices
IEC 747-5 Amendment 1 : 1994
2. 用語の定義 この規格で用いる主な用語の定義は,JIS C 5940の規定による。
3. 測定の状態
3.1
標準状態 測定は,規定がない限り,JIS C 5001の4.1(標準状態)に規定の標準状態(温度15〜35℃,
相対湿度25〜85%,気圧860〜1 060hPa)のもとで行う。ただし,この標準状態での測定値の判定に疑義
が生じた場合,又は特に要求された場合は,3.3による。
また,基準状態への換算を必要とする場合は,3.2による。
なお,標準状態で測定することが困難な場合は,判定に疑義が生じない限り,標準状態以外の状態で測
定を行ってもよい。
3.2
基準状態 基準状態は,JIS C 5001の4.2(基準状態)に規定の基準状態(温度25℃,相対湿度45%,
気圧860〜1 060hPa)とする。ただし,温度だけをもって基準状態としてもよい。
2
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
3.3
判定状態 判定状態は,JIS C 5001の4.3(判定状態)に規定の判定状態I,温度2級及び相対湿度2
級(温度25±2℃,相対湿度45〜55%,気圧860〜1 060hPa)とする。
4. 測定用機器及び装置
4.1
測定用電源 直流電源はリプル含有率3%以下,交流電源は高調波含有率5%以下のものとする。た
だし,商用周波数の場合は,高調波含有率10%以下とする。
なお,特に交流出力を測定する試験では,直流電源のリプル含有率,交流電源の高調波含有率及び交流
の流れる直流電源回路の交流インピーダンスは,測定に影響を与えないように小さい値とする。
また,サージの侵入に対する十分な防護措置が施されていなければならない。
4.2
計器及び測定器 規定がない限り,計器はJIS C 1102に規定する0.5級のもの,測定器はこれと同
等以上の確度をもつものとし,これらの入力インピーダンスは測定系への影響を無視できる値とする。
備考 標準品として0.5級以上の計器又はこれに相当するような確度をもつ測定器がない場合は,4.2
の規定は適用しない。
4.3
光パワーメータ 測定に使用する光パワーメータは,該当する波長で校正し,かつ,受光面感度分
布が十分に平たんなものとする。
4.4
光スペクトラムアナライザ 測定に使用する光スペクトラムアナライザは,該当する波長で,十分
なダイナミックレンジ(十分低い迷光)と,横(波長)軸,縦(レベル)軸の確度,及び発振スペクトル
を分離するのに十分な分解能をもつものとする。
5. 測定方法
5.1
順電流 (If)
5.1.1
目的 規定された状態での,半導体レーザの順電流を測定することを目的とする。
5.1.2
測定回路 半導体レーザの順電流の測定は図1によって次の方法で行う。
5.1.3
測定方法 半導体レーザに規定の光出力Poを発生させ,そのときの順電流Ifを測定する。
5.1.4
測定上の注意 半導体レーザにおいて相当程度の電力消費があり,それに伴う接合部温度上昇が測
定値に大きな影響を与える場合には,次のいずれかの方法によって行い,その方法を明記する。
(1) 直流を用い,温度安定に達した後測定する。ただし,温度安定に達しない場合は,規定の電圧を印加
し始めた後,定められた時間に測定する。
(2) パルスを用いるか,又は接合部温度上昇が無視できるような短い時間で測定する。
パルスを用いるときは,パルス幅及びデューティサイクルを明記する。
5.1.5
個別規格に規定すべき項目
(1) 動作温度Top
(2) 光出力Po

3
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図1 順電流及び順電圧測定
5.2
順電圧 (Vf)
5.2.1
目的 規定された状態での,半導体レーザの順電圧を測定することを目的とする。
5.2.2
測定回路 半導体レーザの順電圧の測定は,図1によって次の方法で行う。
5.2.3
測定方法 半導体レーザに規定の順電流Ifを流し,そのときの順電圧Vfを測定する。
5.2.4
測定上の注意 半導体レーザにおいて相当程度の電力消費があり,それに伴う接合部温度上昇が測
定値に大きな影響を与える場合には,次のいずれかの方法によって行い,その方法を明記する。
(1) 直流を用い,温度安定に達した後,測定する。ただし,温度安定に達しない場合は,規定の電流を流
し始めた後,定められた時間に測定する。
(2) パルスを用いるか又は接合部温度上昇が無視できるような短い時間で測定する。
パルスを用いるときは,パルス幅及びデューティサイクルを明記する。
5.2.5
個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
5.3
逆電圧 (Vr)
5.3.1
目的 規定された状態での,半導体レーザの逆電圧を測定することを目的とする。
5.3.2
測定回路 半導体レーザの逆電圧の測定は図2によって次の方法で行う。
5.3.3
測定方法 半導体レーザに規定の逆電流Irを流し,そのときの逆電圧Vrを測定する。
5.3.4
測定上の注意 半導体レーザにおいて相当程度の電力消費があり,それに伴う接合部温度上昇が測
定値に大きな影響を与える場合には,次のいずれかの方法によって行い,その方法を明記する。
(1) 直流を用い,温度安定に達した後,測定する。ただし,温度安定に達しない場合は,規定の電流を流
し始めた後,定められた時間に測定する。
(2) パルスを用いるか又は接合部温度上昇が無視できるような短い時間で測定する。
パルスを用いるときは,パルス幅及びデューティサイクルを明記する。
5.3.5
個別規格に規定すべき項目
(1) 動作温度Top
(2) 逆電流Ir

4
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図2 逆電圧測定
5.4
光出力 (Po)
5.4.1
目的 規定された状態での,半導体レーザの光出力を測定することを目的とする。
5.4.2
測定回路 半導体レーザの光出力の測定は図3又は図4によって次の方法で行う。
5.4.3
測定方法 半導体レーザに規定の順電流Ifを流し,光出力Poを測定する。光出力は1端面からの
出力とする。
5.4.4
測定上の注意 光パワーメータの受光面は,放射される全光量を十分に受けられる大きさでなけれ
ばならない。また,光パワーメータの受光部から半導体レーザへの戻り光量を十分小さく抑えるようにし
なければならない。半導体レーザの出力光を受光部で直接受ける代わりに積分球を用いてもよい。積分球
を用いる場合には,測定デバイスとアパーチャとは,積分球の表面に比べて十分小さくなければならない。
また,積分球の内側の表面と遮へい板は,一定の拡散反射率(最小0.8)をもつ塗料でコーティングされて
いなければならない。
5.4.5
個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If
図3 半導体レーザの光出力測定
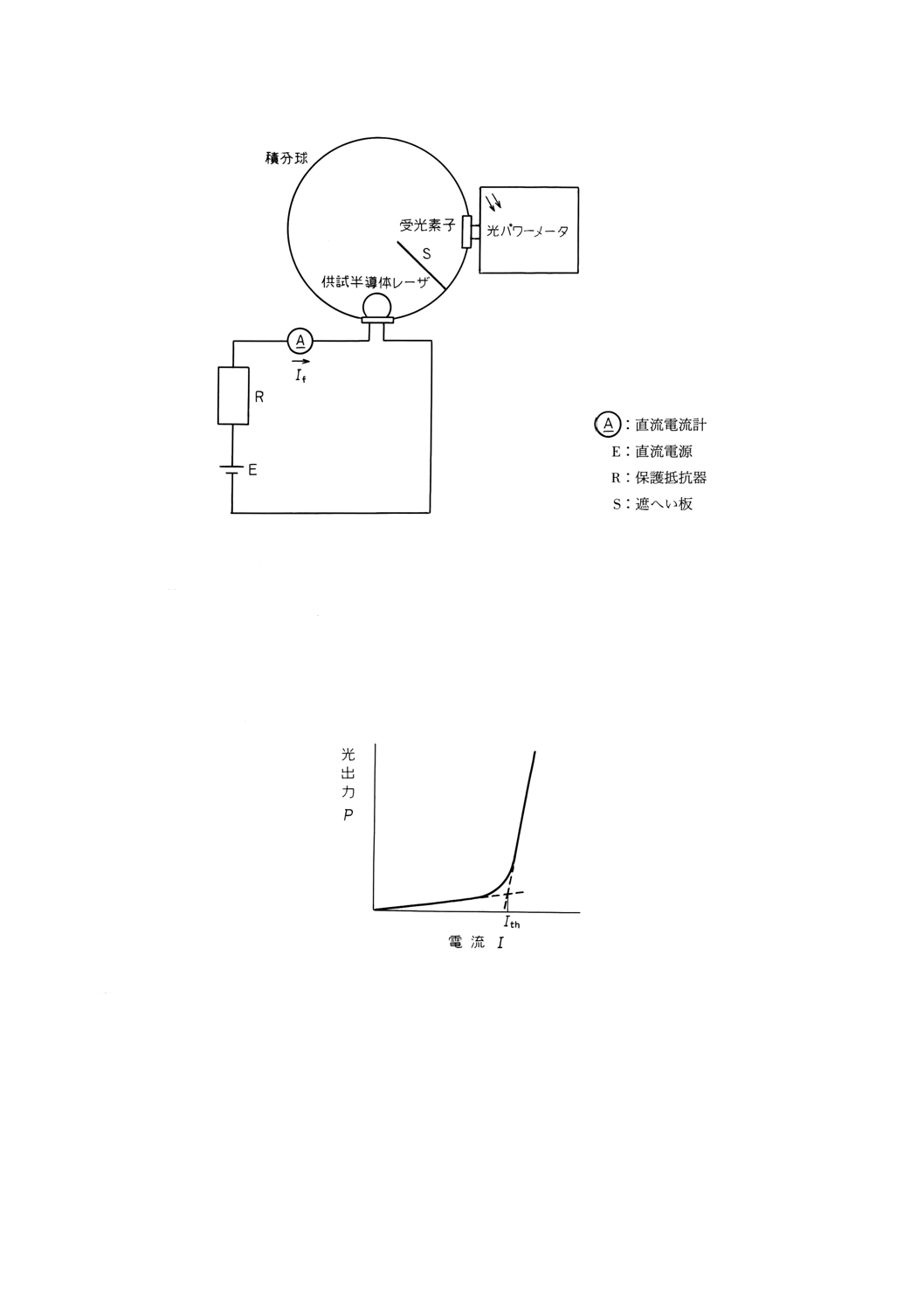
5
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図4 積分球を用いた光出力測定
5.5
しきい値電流 (Ith)
5.5.1
目的 規定された状態での,半導体レーザのしきい値電流を測定することを目的とする。
5.5.2
測定回路 半導体レーザのしきい値電流の測定は図3によって次の方法で行う。
5.5.3
測定方法 半導体レーザに流す順電流Ifを変化させながら,Ifと光出力PoをX−Yレコーダ,オシ
ロスコープなどで記録し,次の(1)〜(3)の方法のうち,いずれかを用いて,しきい値電流を算出する。
(1) 方法1 If-Po曲線の記録から図5に示すように特性上の2本の直線部を延長してその交点の電流を求
め,しきい値電流Ithとする。
図5 I-Po曲線(方法1)
(2) 方法2 しきい値近傍でIf-Po特性の変化が緩やかで(1)の方法の適用が困難な場合は,図6に示すよう
にレーザ発振出力に相当する部分の直線を延長し,X軸との交点の電流を求め,しきい値電流Ithとす
る。
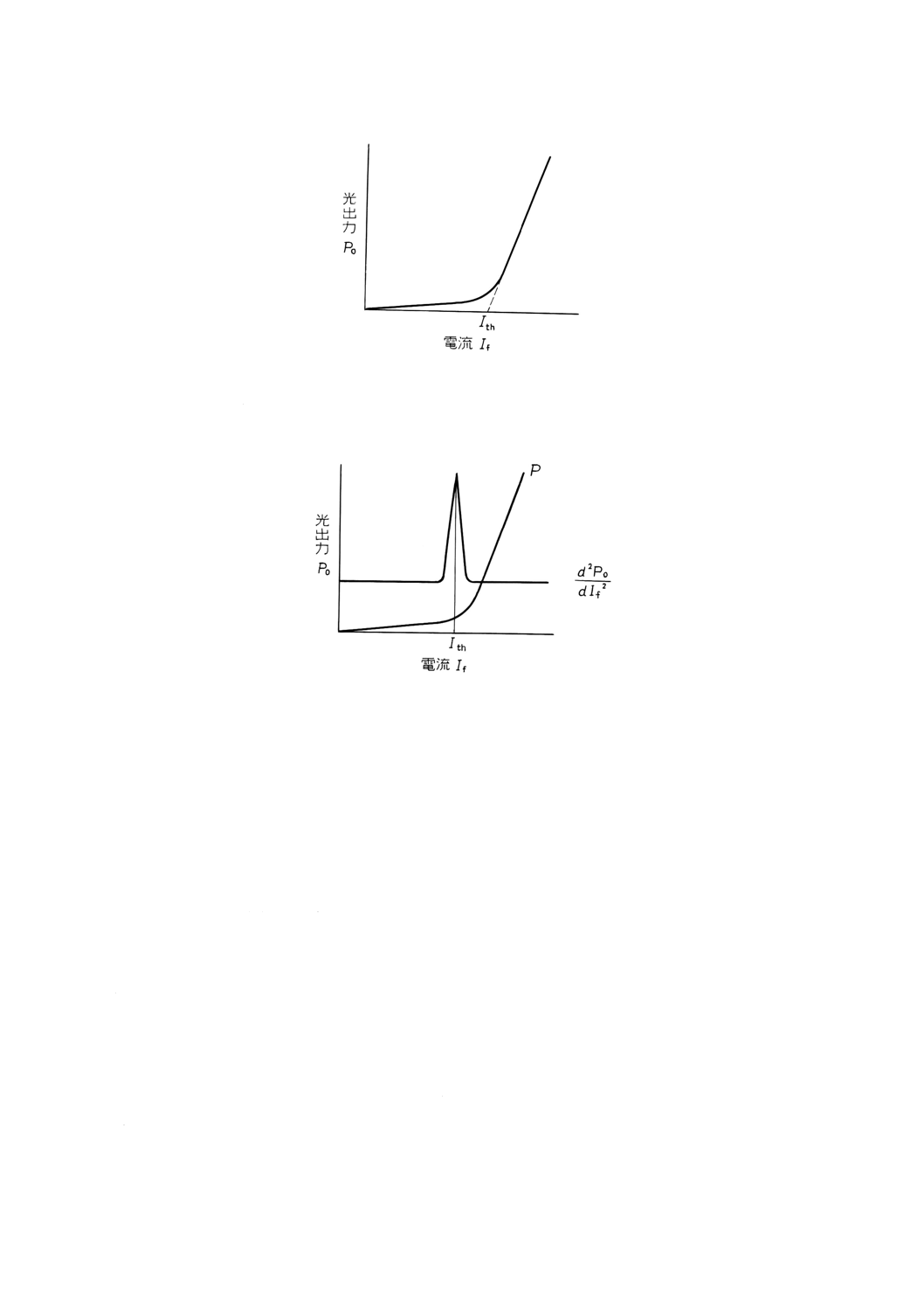
6
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図6 If-Po曲線(方法2)
(3) 方法3 If-Po曲線の2次微分を求め,図7に示すように2次微分のピークに相当する電流で最小のも
のを,しきい値電流Ithとする。
図7 If-Po曲線(方法3)
5.5.4
測定上の注意 測定に当たっては,測定系からの戻り光量を十分小さく抑えるように注意しなけれ
ばならない。また,しきい値電流の算出に用いた方法を明記すること。
5.5.5
個別規格に規定すべき項目
(1) 動作温度Top
5.6
しきい値光出力 (Pth)
5.6.1
目的 規定された状態での,半導体レーザのしきい値光出力を測定することを目的とする。
5.6.2
測定回路 半導体レーザのしきい値光出力の測定は図3によって次の方法で行う。
5.6.3
測定方法 半導体レーザに,しきい値電流Ithに等しい順電流Ifを流し,しきい値光出力Pthを測定
する。
5.6.4
測定上の注意 光出力の測定は,5.4に規定の方法を用いる。
5.6.5
個別規格に規定すべき項目
(1) 動作温度Top
(2) しきい値電流Ith
5.7
スロープ効率(ηd)
5.7.1
目的 規定された状態での,半導体レーザのスロープ効率を測定することを目的とする。
5.7.2
測定回路 半導体レーザのスロープ効率の測定は図3によって次の方法で行う。

7
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
5.7.3
測定方法 半導体レーザに流す順電流Ifを変化させながら,IfとPoをX-Yレコーダ,オシロスコ
ープなどで記録し,式(1)によって算出する。
5.7.4
測定上の注意 測定に当たっては,測定系からの戻り光量を十分小さく抑えるように注意しなけれ
ばならない。
th
f
th
o
d
I
I
P
P
−
−
=
η
············································································ (1)
ここに,
ηd: スロープ効率 (W/A)
Ith: しきい値電流 (A)
If: 規定の順電流(又は規定の光出力を得る順電流) (A)
Pth: Ithを流したときの光出力 (W)
Po: Ifを流したときの光出力(又は規定の光出力) (W)
備考 “しきい値電流”の代わりに,“しきい値電流よりも高く,かつ,動作電流よりも十分低い電流”
及び“Ithを流したときの光出力”の代わりに,“しきい値電流よりも高く,かつ,動作電流より
も十分低い電流での光出力”としてもよい。
5.7.5
個別規格に規定すべき項目
(1) 動作温度Top
5.8
縦モード間隔及び縦モード数
5.8.1
目的 規定された状態での,半導体レーザの縦モード間隔,縦モード数を測定することを目的とす
る。
5.8.2
測定回路 半導体レーザの縦モード間隔,縦モード数の測定は図8によって次の方法で行う。
5.8.3
測定方法 半導体レーザ素子の端子間に規定の順電流If又は規定の光出力を得る順電流Ifを流し,
光スペクトラムアナライザを用い得られたスペクトル(図9参照)から,モードの波長間隔(縦モード間
隔)を求める。また,ピークに対し規定の値のレベルよりも大きいピークの数(縦モード数)を数える。
5.8.4
個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
図8 光スペクトラムアナライザによる光スペクトラムの測定

8
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図9 縦モード間隔及び縦モード数の測定
5.9
ピーク発振波長(λp)
5.9.1
目的 規定された状態での,半導体レーザのピーク発振波長を測定することを目的とする。
5.9.2
測定回路 半導体レーザのピーク発振波長の測定は図8によって次の方法で行う。
5.9.3
測定方法 半導体レーザを規定の光出力の状態で駆動し,光スペクトラムアナライザを用いスペク
トルを測定し図10のようにスペクトルがピークの波長を測定する。
5.9.4
個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
図10 ピーク発振波長の測定
5.10 中心波長 (λc),スペクトル幅 (∆λw),スペクトル半値幅 (∆λ)
5.10.1 目的 規定された状態での,半導体レーザの中心波長,スペクトル幅,スペクトル半値幅を測定す
ることを目的とする。
5.10.2 測定回路 半導体レーザの中心波長,スペクトル幅,スペクトル半値幅の測定は図8によって次の
方法で行う。
5.10.3 測定方法 半導体レーザを規定の光出力の状態で駆動し,光スペクトラムアナライザを用い中心波
長λc,スペクトル幅∆λw,スペクトル半値幅∆λを測定する。包絡線法,N-dB法,RMS法による測定は図
11,図12, 図13に示される方法によって行われる。
RMS法による中心波長,スペクトル幅及びスペクトル半値幅は式(2)及び式(3)によって算出する。

9
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
n
n
n
c
A
A
Σ
×
Σ
=
λ
λ
··········································································· (2)
(
)
n
c
n
n
w
A
A
K
2
Σ
−
×
Σ
×
=
λ
λ
λ
Δ
························································ (3)
ここで,Kは定数で目的に応じて選択 (1, 2, 2.35, 3) し明示する必要がある(2.35を選択した場合はスペ
クトル形状をガウス分布とみなしたときのスペクトル半値幅に相当する。)。
5.10.4 測定上の注意 測定では,測定系,光ファイバ端面などからの戻り光量を十分小さく抑える。
5.10.5 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
図11 スペクトル幅,スペクトル半値幅及び中心発振波長の測定(包絡線法による。)
図12 スペクトル幅,スペクトル半値幅及び中心発振波長の測定(N-dB法による。)

10
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図13 スペクトル幅及び中心発振波長の測定(RMS法による。)
5.11 変調時スペクトル
5.11.1 目的 規定された状態での,半導体レーザの変調時スペクトルを測定することを目的とする。
5.11.2 測定回路 半導体レーザの変調時スペクトルの測定は図14によって次の方法で行う。
5.11.3 測定方法 半導体レーザを規定の直流バイアス電源とパルス発生器(繰返しパルス)によって駆動,
変調し,その放出された光を光スペクトラムアナライザに入力する。
5.11.4 測定上の注意 測定では,測定系,光ファイバ端面などからの戻り光量を十分小さく抑える。変調
周波数が比較的低く光スペクトラムアナライザの応答帯域との間で干渉を起こすおそれがある場合には光
スペクトラムアナライザの外部同期入力端子などによって同期させて測定する。
5.11.5 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
(3) 変調周波数
図14 変調時スペクトル測定
5.12 サイドモード抑圧比 (SMSR)
5.12.1 目的 規定された状態での,半導体レーザのサイドモード抑圧比を測定することを目的とする。
5.12.2 測定回路 半導体レーザのサイドモード抑圧比の測定は図8によって次の方法で行う。

11
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
5.12.3 測定方法 半導体レーザに規定の順電流If,又は規定の光出力を得る順電流Ifを流し,光スペクト
ラムアナライザを用い発振スペクトラムを測定し,図15のように対数表示画面上で最もパワーが大きいモ
ード(メインモード)のレベルPmainと2番目に大きいモード(サイドモード)のレベルPsideから式(4)に
よって算出する。
SMSR(dB)=10 log10
side
main
P
P
························································· (4)
5.12.4 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
図15 SMSRの測定
5.13 スペクトル線幅 (∆λL)
5.13.1 目的 規定された状態での,半導体レーザのスペクトル線幅を測定することを目的とする。
5.13.2 測定回路 半導体レーザのスペクトル線幅の測定は図16によって次の方法で行う。
5.13.3 測定方法 半導体レーザに規定の順電流If, 又は規定の光出力を得る順電流Ifを流し,図16のよう
な遅延自己ホモダイン又はヘテロダイン法(光周波数シフタを用いる方法)によって電気的なスペクトラ
ムアナライザ上の波形を観測する。求める線幅∆λLは図17のようにスペクトラムアナライザ上で観測され
る波形の規定のレベル低下した点での半幅(ホモダインの場合は得られる波形が片側部分だけであるので
その幅)に等しい。
5.13.4 測定上の注意 受光器及び回路は被測定レーザの線幅に対応する周波数広がりに対し,十分広い帯
域と平たん性をもっていること,得られる波形に対し十分なSN比が確保された状態で測定されること,
光アイソレータを使用するなどによってレーザ素子に対する戻り光が少ないこと,遅延用ファイバの長さ
は被測定レーザの可干渉距離に対して十分長いこと,接続にはシングルモードファイバを用いることが必
要である。また,検出されるレベルは分岐後に合成される二つの光の偏光方向の一致の程度に応じて高い
レベルが得られるので,分岐されたどちらかの光の偏光方向を調節できることが望ましい。
半導体レーザのスペクトル線幅が狭く,スペクトラムアナライザの低域での性能が問題になる場合は,
音響光学素子などによる光周波数シフタを用いてビート信号の中心周波数を数十〜数百MHzに設定する
とよい。
5.13.5 個別規格に規定すべき項目
(1) 動作温度Top
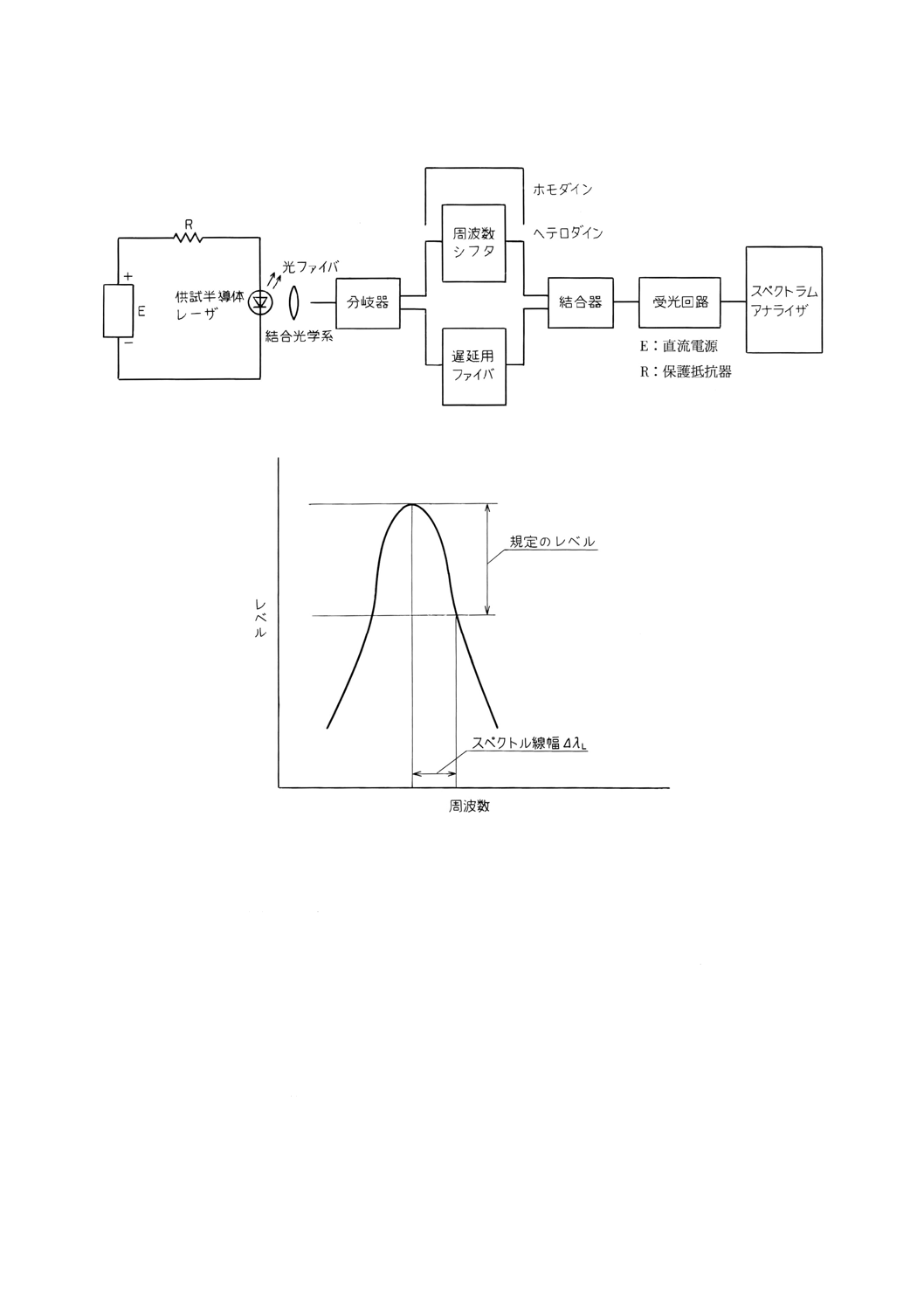
12
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(2) 順電流If又は光出力Po
図16 スペクトル線幅の測定
図17 スペクトル線幅の測定
5.14 近視野像幅
5.14.1 目的 規定された状態での,半導体レーザの近視野像幅を測定することを目的とする。
5.14.2 測定回路 半導体レーザの近視野像幅の測定は図18によって次の方法で行う。
5.14.3 測定方法 図18に示す構成で,半導体レーザに規定の光出力を得る順電流If,又は規定の光出力
を得る順電流Ifを流し,受光素子に規定の直流バイアス電圧Vbを与える。半導体レーザの端面発光部分の
像を十分拡大できるレンズを用いて半導体レーザの近視野像を十分大きく拡大する。このときの像拡大率
をMとする。結像面上を,発振領域の中心を通ってpn接合面に垂直な方向及び平行な方向に受光素子を
それぞれ走査し,出力電圧Voutを記録することによって,光パワー分布を求める。ピーク値の50%になる
出力電圧を示す2点間の距離(半値全幅)を垂直方向,平行方向のそれぞれで測定し,それらをWʼ⊥,Wʼ//
とする。Wʼ⊥/M, Wʼ///Mを計算してそれぞれ垂直方向,平行方向の近視野像幅W⊥,W//を求める。
垂直及び平行方向の測定については,どちらか一方の測定を終了した後,半導体レーザを90°回転させ
ることによって他方の測定ができる。受光素子については,受光面の幅は拡大された近視野像幅より十分

13
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
小さく,また,出力電圧Voutが受光素子への入射光パワーに比例するように負荷抵抗RLを調整しておく。
なお,上記のような方法のほかに結像面上における2次元の光強度分布を観測画面上に表示できる装置
を用い,pn接合面に垂直な方向及び平行な方向に,ピーク値の50%になる距離及び像の拡大率Mよりそ
れぞれ垂直方向,平行方向の近視野像幅W⊥/M, W///Mを計算してそれぞれ垂直方向,平行方向の近視野像
幅W⊥, W//を求めてもよい。
5.14.4 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
図18 近視野像幅の測定
5.15 ビーム広がり角
5.15.1 目的 規定された状態での,半導体レーザのビーム広がり角を測定することを目的とする。
5.15.2 測定回路 半導体レーザのビーム広がり角の測定は図19によって次の方法で行う。
5.15.3 測定方法 図19に示す構成で,半導体レーザに規定の光出力を得る順電流If,又は規定の光出力
を得る順電流Ifを流し,受光素子に規定の直流バイアス電圧Vbを与える。半導体レーザの発振領域の中心
を通って円弧上にpn接合面に垂直な方向及び平行な方向に受光素子を走査し,出力電圧Voutを記録するこ
とによって,光パワー分布すなわち遠視野像を求める。ピーク値の50%になる出力電圧を示す2点間の角
度(半値全角)を垂直方向,平行方向のそれぞれで測定し,ビーム広がり角 (θ⊥,θ//) を求める。
なお,受光素子を走査する代わりに半導体レーザを回転させてもよい。垂直及び平行方向の測定は,ど
ちらか一方の測定をした後,半導体レーザを90°回転させることによって他方の測定ができる。
5.15.4 測定上の注意 受光素子の受光面の幅及び受光面と半導体レーザとの距離は十分な分解能が確保
できるようにする。
5.15.5 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po

14
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図19 ビーム広がり角の測定
5.16 偏光比 (P1)
5.16.1 目的 規定された状態での,半導体レーザの偏光比を測定することを目的とする。
5.16.2 測定回路 半導体レーザの偏光比の測定は図20によって次の方法で行う。
5.16.3 測定方法 半導体レーザに規定の順電流If又は規定の光出力を得る順電流Ifを流し,放出された光
をレンズによって平行光にする。これを偏光プリズムに入射し,出力光を光パワーメータで測定する。偏
光プリズムを回転し最大値Pmaxと最小値Pminから式(5)を用いて,偏光比を求める。
P1=10log10 (Pmax/Pmin)·································································· (5)
5.16.4 測定上の注意 偏光保存性の十分高いレンズ,消光比の十分高い偏光プリズムを用いること。
5.16.5 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
(3) 開口 (N.A)
図20 偏光比の測定
5.17 上昇時間 (tr),下降時間 (tf),ターンオン時間 (ton),ターンオフ時間 (toff),ターンオン遅延時間 (td (on) ),
ターンオフ遅延時間 (td (off) )
5.17.1 目的 規定された状態での,半導体レーザの上昇時間,下降時間,ターンオン時間,ターンオフ時
間,ターンオン遅延時間及びターンオフ遅延時間を測定することを目的とする。
5.17.2 測定回路 半導体レーザの上昇時間,下降時間,ターンオン時間,ターンオフ時間,ターンオン遅
延時間及びターンオフ遅延時間の測定は図21,図22によって次の方法で行う。

15
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
5.17.3 測定方法 半導体レーザに規定の順電流If又は規定の光出力を得る順電流Ifを流し,規定の振幅,
パルス幅及び繰返し周波数の矩形電流パルスを重畳する。半導体レーザから放出された光を受光素子に入
力し,電気信号に変換する。この電気信号をオシロスコープなどで測定し,上昇時間,下降時間,ターン
オン時間,ターンオフ時間,ターンオン遅延時間及びターンオフ遅延時間を求める。
なお,駆動パルス波形,レーザ駆動回路,受光素子周辺回路,配置などが測定結果に影響する場合があ
るので,必要に応じ,これらを明示することが望ましい。
5.17.4 測定上の注意 矩形電流パルス発生器及び光パルス測定系の上昇時間並びに下降時間は,半導体レ
ーザの上昇時間及び下降時間よりも十分小さくする。また,半導体レーザから出た光パルスが反射して半
導体レーザに戻って測定に影響するのを防ぐため,半導体レーザの戻り光量を極力小さくする。
緩和振動が存在する場合には緩和振動後の定常値を基準として測定する。
5.17.5 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
図21 上昇時間,下降時間,ターンオン時間,ターンオフ時間,
ターンオン遅延時間及びターンオフ遅延時間の測定
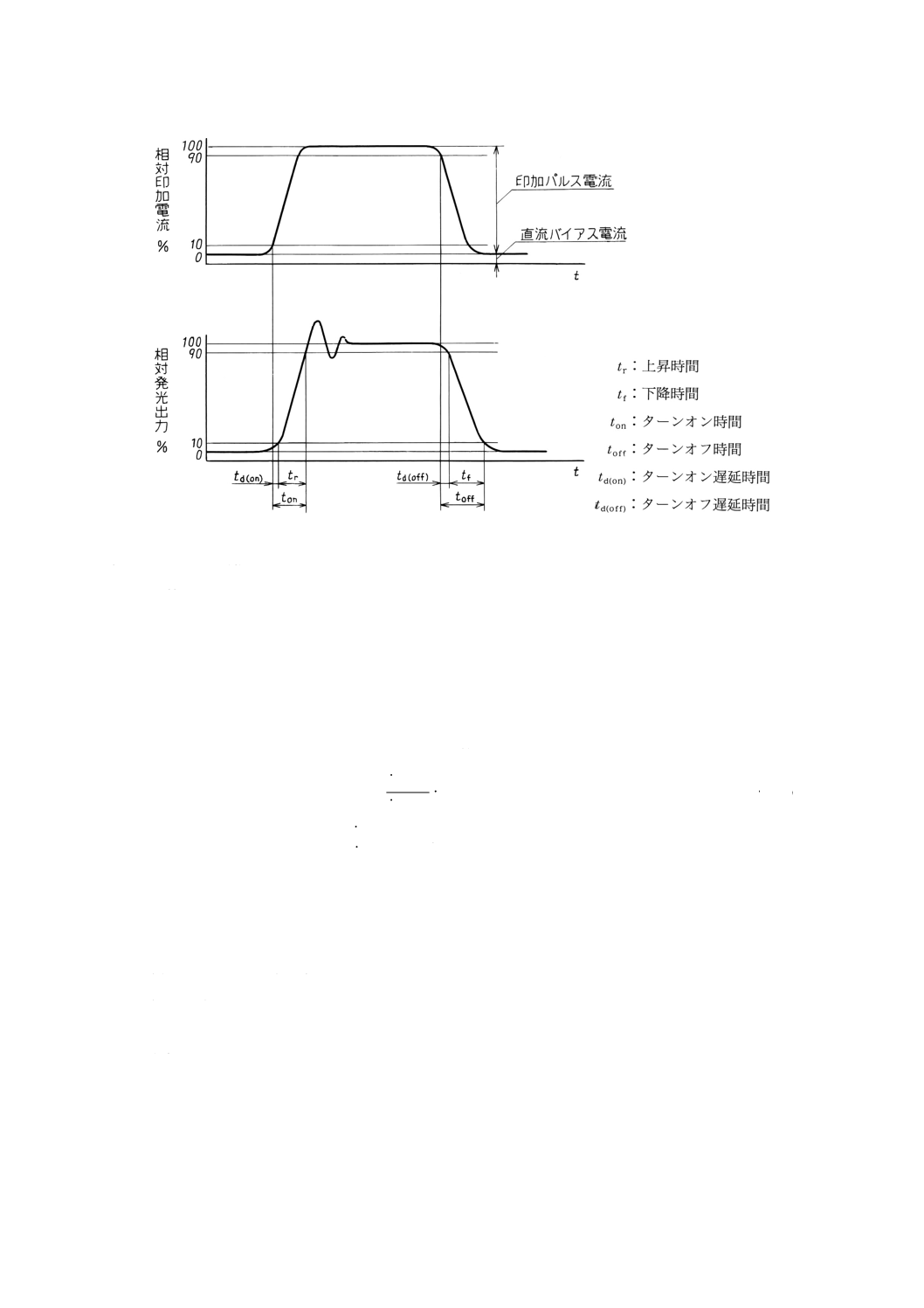
16
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図22 応答時間
5.18 遮断周波数 (fc)
5.18.1 目的 規定された状態での,半導体レーザの遮断周波数を測定することを目的とする。
5.18.2 測定回路 半導体レーザの遮断周波数の測定は図23によって次の方法で行う。
5.18.3 測定方法 半導体レーザのレーザ素子端子間に規定の順電流If又は規定の光出力Poを得る順電流
Ifを流し,さらに,小信号交流電流を重畳する。半導体レーザから出力された光を,受光素子に入射して
電気信号に変換し,その交流成分を取り出して選択レベルメータ又はスペクトラムアナライザによって変
調光に対応した交流電流を測定する。遮断周波数fcは,変調光出力が基準とする低周波f0 (f0≦fc/100) 重畳
時よりも3dB低下する周波数として,式(6)によって算出する。
)
(
)
(
log
10
3
0
10
f
i
f
i
dB
p
c
p
=
−
································································· (6)
ここに,
ip (f0) : 基準周波数f0のときの交流電流
ip (fc) : 遮断周波数fcのときの交流電流
5.18.4 測定上の注意 受光素子については半導体レーザよりも十分高い遮断周波数をもつものを使用し,
ケーブルなどを含めた受光系の周波数特性を校正する。また,レーザ駆動回路又は受光素子周辺回路の特
性が,測定結果に影響する場合があるので,必要に応じ,測定回路などを明示することが望ましい。さら
に,交流信号源出力の周波数変動は十分小さいものを用いる。
5.18.5 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po

17
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図23 遮断周波数測定
5.19 相対雑音強度 (RIN)
5.19.1 目的 規定された状態での,半導体レーザの相対雑音強度を測定することを目的とする。
5.19.2 測定回路 半導体レーザの相対雑音強度の測定は図24によって次の方法で行う。
5.19.3 測定方法 半導体レーザに規定の順電流If, 又は規定の光出力を得る順電流Ifを流し,規定のノイ
ズ中心周波数fn, ノイズ帯域∆fnでの電力Ntを測定器(パワーメータなど)で測定するとともに,このとき
受光素子に流れる直流逆電流Irを同時に測定する。
次に,測定系の雑音を算出するために,半導体レーザをランダムな雑音を発生すると考えられる十分広
いスペクトル半値幅をもつ非干渉性光源(例えば,平面発光形ダイオードなど)に置き換え,測定した受
光素子の逆電流Irと同じ値が得られるように光源の出力を調整する。この状態で測定器によって電力Nd
を測定し,式(7)に従い相対雑音強度RINを計算し,これを半導体レーザの雑音とする。
)
(
)
(
2
r
n
L
d
t
I
f
G
R
N
N
RIN
−
=
Δ
······························································ (7)
ここに,
RL: 負荷抵抗
G: 増幅器の利得
∆fn: フィルタの帯域幅
5.19.4 測定上の注意
増幅器には,必要な帯域で十分平たんな周波数特性をもつものを使用する。また,測定系の雑音は,可
能な限り低雑音とし,測定系から半導体レーザへの戻り光量を極力小さくする。
なお,測定系の雑音又は反射光などが測定結果に影響する場合があるので,必要に応じ測定条件又は測
定回路を明示することが望ましい。

18
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図24 相対雑音強度 (RIN) の測定
5.20 高調波歪 (Dn)
5.20.1 目的 規定された状態での,半導体レーザの高調波歪を測定することを目的とする。
5.20.2 測定回路 半導体レーザの高調波歪の測定は図25によって次の方法で行う。
5.20.3 測定方法 半導体レーザに規定の順電流If,又は規定の光出力を得る順電流Ifを流し,規定の振幅
の交流電流isを重畳する。半導体レーザから放出された光を受光素子に入射し,電気信号に変換する。こ
の電気信号の基本波出力P1及びn次高調波出力Pnをスペクトラムアナライザで測定し,式(8)からn次高
調波歪Dnを求める。
−
=
1
10
log
10
)
(
P
P
dB
D
n
n
······························································· (8)
5.20.4 測定上の注意 受光素子については,半導体レーザの歪よりも十分小さい歪の素子を用いる。また,
受光素子などから半導体レーザへの戻り光量は極力小さくする。さらに,受光素子及びスペクトラムアナ
ライザは,測定する高調波の周波数よりも十分広い帯域幅をもつものとする。スペクトラムアナライザの
代わりに,選択レベルメータなどを用いてもよい。
5.20.5 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
(3) 変調周波数

19
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図25 高調波ひずみ測定
5.21 合成第二次歪 (CSO) (又は複合二次歪),合成第三次歪 (CTB) (又は複合三次歪)
5.21.1 目的 規定された状態での,半導体レーザの合成第二次歪,合成第三次歪を測定することを目的と
する。
5.21.2 測定回路 半導体レーザの合成第二次歪,合成第三次歪の測定は図26によって次の方法で行う。
5.21.3 測定方法 半導体レーザに規定の順電流If,又は規定の光出力を得る順電流Ifを流す。光信号は,
光ファイバに結合させるための光学系,光ファイバからの反射を防止するための光アイソレータを介した
後,長尺の光ファイバや必要があれば光減衰器によって所望の減衰をさせ,受光素子に入射させ再び電気
信号に変換する。
この状態において,それぞれの周波数がf1〜fnのn個の発信器I1〜Inを用いてnチャネルの正弦波信号を
順電流Ifに重畳する。
この電気信号を,測定したい一つのチャネルCHiの周波数fi近傍においてそのチャネルの帯域内の信号
電力をスペクトラムアナライザで測定する(図27参照)。
基準となるチャネルの電力P1,測定するチャネルの帯域内に現れる二次の相互変調歪のうち最大の電力
P2を測定し,式(9)から合成第二次歪CSOを求める。
=
1
2
10
log
10
)
(
P
P
dBc
CSO
····························································· (9)
多チャネルを等間隔に配置した場合には三次の相互変調歪の現れる周波数はチャネル自身の周波数とお
おむね重なるため,合成第三次歪CTBは基準となるチャネルの電力P1測定するチャネルの発信器Iiを遮
断した際にその周波数にあらわれる三次の相互変調歪の電力P3を測定し,式(10)から求める。
=
1
3
10
log
10
)
(
P
P
dBc
CTB
··························································· (10)

20
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
5.21.4 測定上の注意 受光素子については半導体レーザの歪よりも十分小さい歪の素子を用いる。また,
受光素子や結合光学系などから半導体レーザへの戻り光量は極力小さくし,半導体レーザ,受光素子及び
スペクトラムアナライザは,変調するチャンネルの存在する周波数範囲において平たんな変換特性及び応
答特性をもつようにする。さらに,おのおのの周波数において変調光出力が等しくなるよう発振器I1,…,
Inの出力を調整する。また,チャネル数は10以上が望ましい。
5.21.5 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
(3) 半導体レーザと受光素子との間の光減衰退量及びその方法
(4) ファイバ長又はファイバ総分散
(5) 入力負荷抵抗
(6) 変調度
(7) チャンネル数及びチャンネル配置
(8) フィルタのバンド幅
図26 合成第二次歪及び合成第三次歪の測定

21
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図27 合成第二次歪及び合成第三次歪の測定(スペクトラムアナライザ表示)
5.22 トラッキングエラー (Er)
5.22.1 目的 規定された状態での,半導体レーザのトラッキングエラーを測定することを目的とする。
5.22.2 測定回路 半導体レーザのトラッキングエラーの測定は図28によって次の方法で行う。
5.22.3 測定方法 図28に示すように半導体レーザの光モニタ端子より半導体レーザの光出力のモニタ信
号を得,かつその信号によって順電流Ifに負帰還をかけててAPC(Automatic Power Control:自動出力制御)
を行う。この状態で,ケース温度を指定された範囲内で変化させ,トラッキングエラーErとして式(11)に
よって算出する。
t
r
P
P
P
E
min
max−
=
又は
=
min
max
10
log
10
P
P
Er
····························· (11)
ここに, Pmax: 指定されたケース又はサブマウント温度範囲内での光出力最大
値
Pmin: 指定されたケース又はサブマウント温度範囲内での光出力最小
値
Pt: 特定の温度での光出力
5.22.4 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po

22
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図28 トラッキングエラーの測定
5.23 信号対雑音強度比 (C/N)
5.23.1 目的 規定された状態での,半導体レーザの信号対雑音強度比を測定することを目的とする。
5.23.2 測定回路 半導体レーザの信号対雑音強度比の測定は図29によって次の方法で行う。
5.23.3 測定方法 半導体レーザに規定の順電流If,又は規定の光出力を得る順電流Ifを流し,規定の周波
数 (f1〜fn) で規定の振幅の交流電流 (I1〜In) を重畳する。半導体レーザから放出された光を受光素子に入
射し,電気信号に変換する(図30)。この電気信号の基本波出力P及び雑音強度Nを測定し,式(12)に従
い信号対雑音強度比 (C/N) を計算する。
)
(
/
3
2
1
K
K
K
N
P
N
C
+
+
+
−
=
(dBc) ·············································· (12)
ここに,
K1: 帯域変換係数
B
Bs
log
10
K2: 実効値変換係数 (1.05dB)
K3: スペクトラムアナライザのログアンプの補正係数(通常1.45dB)
Bs: 信号帯域(NTSCでは4MHz)
B: 雑音帯域 (12×RBW)
RBW: スペクトラムアナライザの分解能帯域幅
5.23.4 測定上の注意 受光素子については半導体レーザの雑音よりも十分低い雑音の素子を用いる。また,
受光素子や結合光学系などから半導体レーザへの戻り光量は極力小さくし,半導体レーザ,受光素子及び
スペクトラムアナライザは,変調するチャンネルの存在する周波数範囲において平たんな変換特性及び応
答特性をもつようにする。さらに,各々の周波数において変調光出力が等しくなるよう交流信号源 (I1,…,
In) の出力を調整する。
5.23.5 個別規格に規定すべき項目
(1) 動作温度Top
(2) 順電流If又は光出力Po
(3) 負荷抵抗値 (R1, R2)
(4) 変調度
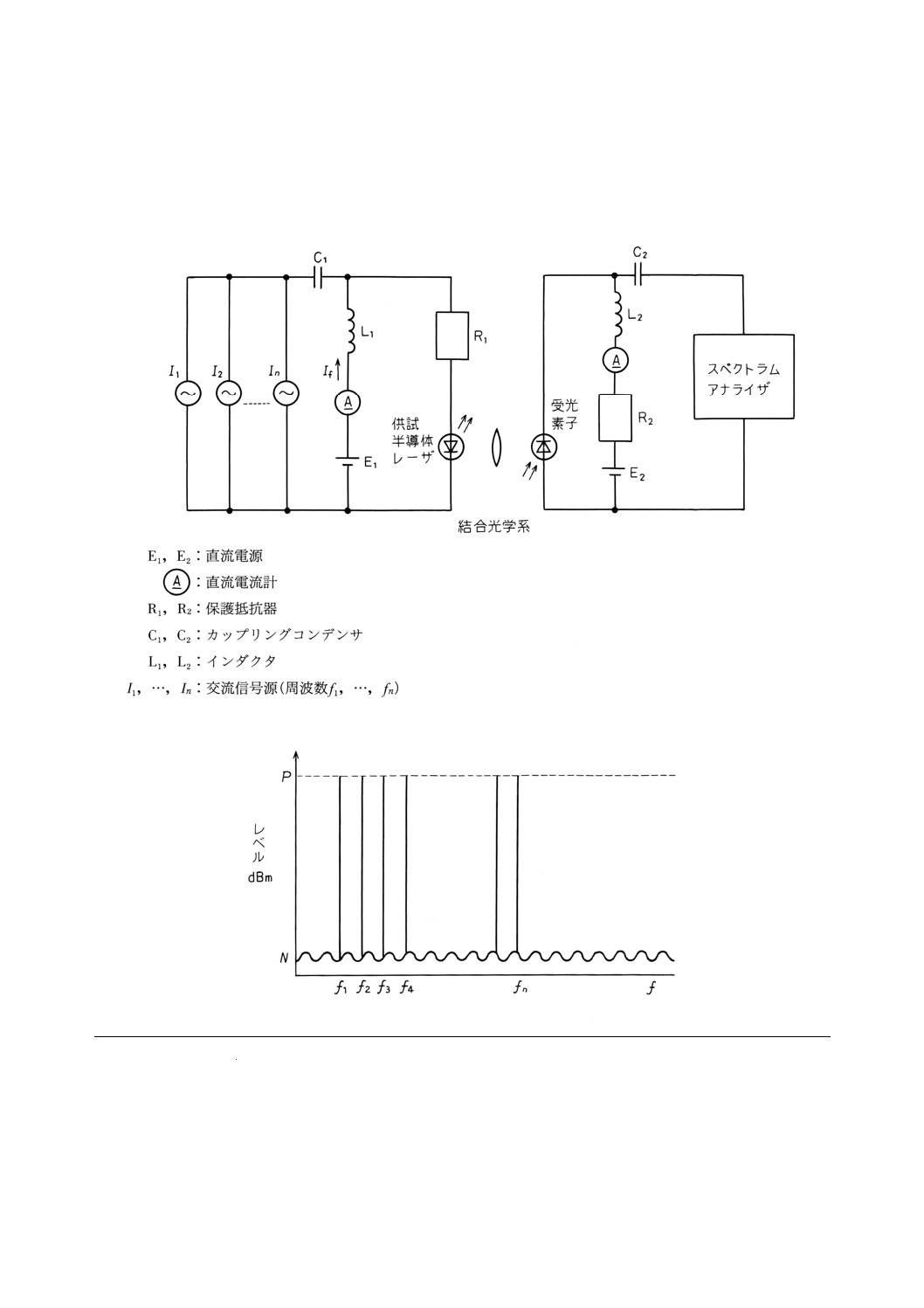
23
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(5) チャンネル数及び変調周波数
(6) スペクトラムアナライザの分解能帯域幅
(7) 信号帯域
(8) 半導体レーザと受光素子との間の光減衰量及びその方法
図29 C/Nの測定(測定回路)
図30 C/Nの測定(スペクトラムアナライザ表示)
関連規格 IEC 747-1 : 1983 Semiconductors devices. Discrete devices and integrated circuits−Part 1 : General
IEC 747-1 Amendment 1 : 1991
24
C 5941 : 1997
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
光能動部品標準化委員会 構成表
氏名
所属
(委員長)
福 田 光 男
日本電信電話株式会社
井 沢 浩
三菱電機株式会社
北相模 博 夫
富士通株式会社
北 原 知 之
株式会社日立製作所
城 野 順 吉
アンリツ株式会社
堀 川 英 明
沖電気工業株式会社
本 田 和 生
ソニー株式会社
御神村 泰 樹
住友電気工業株式会社
宮 島 博 文
浜松ホトニクス株式会社
本 舘 淳 哉
株式会社東芝
竹 川 浩
シャープ株式会社
加 山 英 男
財団法人日本規格協会
兼 谷 明 男
通商産業省
増 田 岳 夫
財団法人光産業技術振興協会
(事務局)
山 田 康 之
財団法人光産業技術振興協会