C 5630-30:2020 (IEC 62047-30:2017)
(1)
目 次
ページ
序文 ··································································································································· 1
1 適用範囲························································································································· 1
2 引用規格························································································································· 1
3 用語及び定義 ··················································································································· 1
4 MEMS圧電薄膜の試験装置 ································································································ 2
4.1 一般 ···························································································································· 2
4.2 機能ブロック及び構成部品 ······························································································ 3
5 試験薄膜の測定 ················································································································ 4
5.1 一般 ···························································································································· 4
5.2 測定原理 ······················································································································ 4
5.3 正圧電定数の測定手順 ···································································································· 4
5.4 逆圧電定数の測定手順 ···································································································· 5
6 試験報告························································································································· 5
附属書A(参考)MEMS圧電薄膜の測定方法の例 ······································································ 7
参考文献 ···························································································································· 13
C 5630-30:2020 (IEC 62047-30:2017)
(2)
まえがき
この規格は,産業標準化法第12条第1項の規定に基づき,一般財団法人マイクロマシンセンター(MMC)
及び一般財団法人日本規格協会(JSA)から,産業標準原案を添えて日本産業規格を制定すべきとの申出
があり,日本産業標準調査会の審議を経て,経済産業大臣が制定した日本産業規格である。
この規格は,著作権法で保護対象となっている著作物である。
この規格の一部が,特許権,出願公開後の特許出願又は実用新案権に抵触する可能性があることに注意
を喚起する。経済産業大臣及び日本産業標準調査会は,このような特許権,出願公開後の特許出願及び実
用新案権に関わる確認について,責任はもたない。
JIS C 5630の規格群には,次に示す部編成がある。
JIS C 5630-1 第1部:マイクロマシン及びMEMSに関する用語
JIS C 5630-2 第2部:薄膜材料の引張強さ試験方法
JIS C 5630-3 第3部:薄膜材料の標準試験片
JIS C 5630-6 第6部:薄膜材料の軸荷重疲労試験方法
JIS C 5630-12 第12部:MEMS構造体の共振振動を用いた薄膜材料の曲げ荷重疲労試験方法
JIS C 5630-13 第13部:MEMS構造体のための曲げ及びせん断試験による接合強度試験方法
JIS C 5630-18 第18部:薄膜曲げ試験方法
JIS C 5630-19 第19部:電子コンパス
JIS C 5630-20 第20部:小型ジャイロ
JIS C 5630-26 第26部:マイクロトレンチ構造及びマイクロニードル構造の寸法,形状表示及び計測
法
JIS C 5630-28 第28部:MEMSエレクトレット振動発電デバイスの性能試験方法
JIS C 5630-30 第30部:MEMS圧電薄膜の電気機械的変換特性の測定方法
日本産業規格 JIS
C 5630-30:2020
(IEC 62047-30:2017)
マイクロマシン及びMEMS−
第30部:MEMS圧電薄膜の電気機械的変換特性の
測定方法
Semiconductor devices-Micro-electromechanical devices-
Part 30: Measurement methods of
electro-mechanical conversion characteristics of MEMS piezoelectric thin film
序文
この規格は,2017年に第1版として発行されたIEC 62047-30を基に,技術的内容及び構成を変更する
ことなく作成した日本産業規格である。
なお,この規格で点線の下線を施してある参考事項は,対応国際規格にはない事項である。
1
適用範囲
この規格は,MEMS圧電薄膜デバイスにおけるマイクロアクチュエータ及びマイクロセンサに使われる
薄膜材料の電気機械的変換特性の測定方法及び報告様式について規定する。この規格は,MEMSプロセス
によって作成された圧電薄膜に適用する。
注記 この規格の対応国際規格及びその対応の程度を表す記号を,次に示す。
IEC 62047-30:2017,Semiconductor devices−Micro-electromechanical devices−Part 30:
Measurement methods of electro-mechanical conversion characteristics of MEMS piezoelectric
thin film(IDT)
なお,対応の程度を表す記号“IDT”は,ISO/IEC Guide 21-1に基づき,“一致している”こ
とを示す。
2
引用規格
この規格には,引用規格はない。
3
用語及び定義
この規格で用いる主な用語及び定義は,次による。
3.1
ユニモルフはり(梁)(unimorph beam)
圧電性をもたない基板及び圧電薄膜で構成する組合せはり(梁)。
3.2
正圧電定数(direct transverse piezoelectric coefficient)
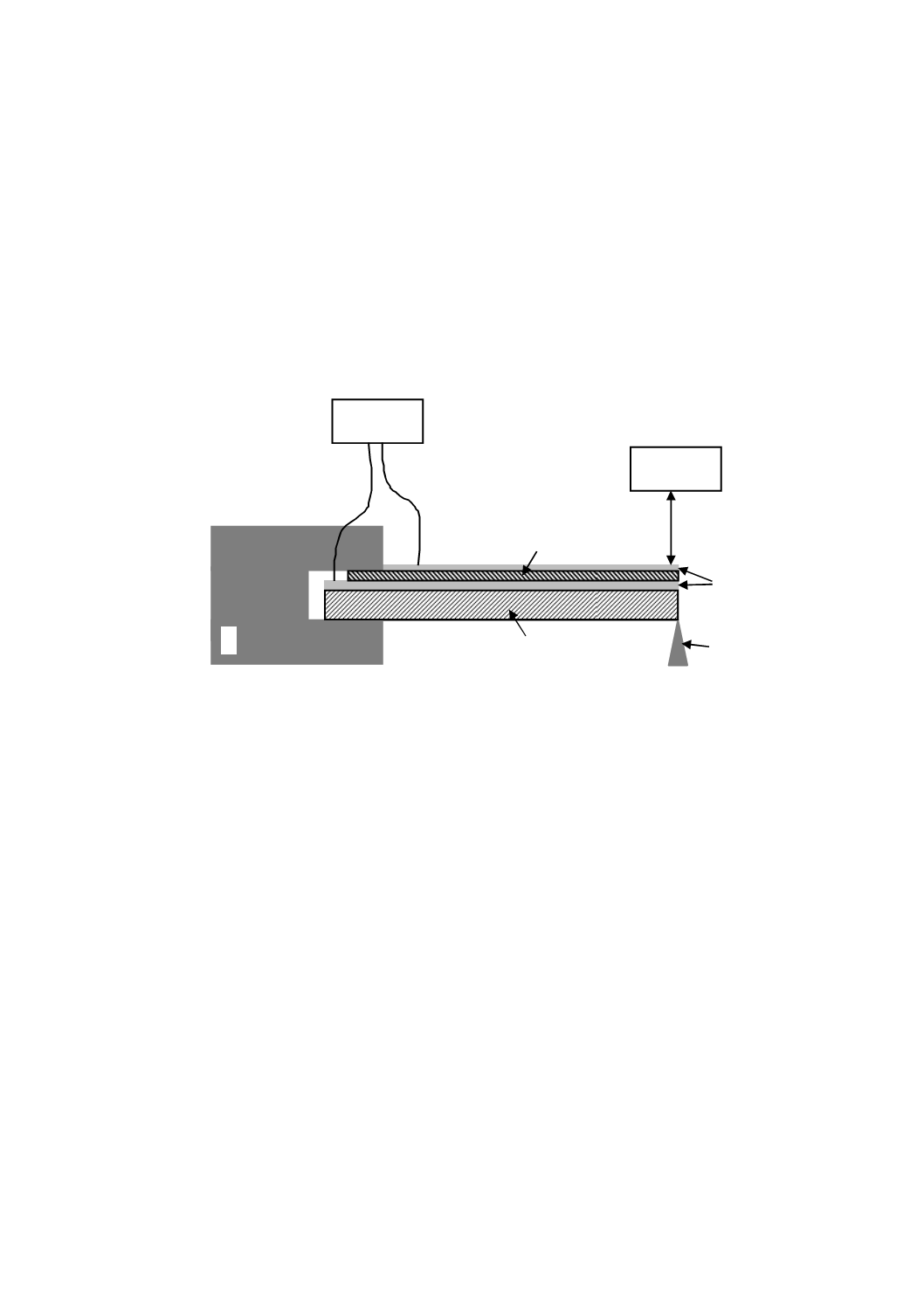
2
C 5630-30:2020 (IEC 62047-30:2017)
曲げ又は応力によって発生する電荷又は電圧から算出された圧電薄膜の圧電定数。
3.3
逆圧電定数(converse transverse piezoelectric coefficient)
電界又は電圧によって発生する曲げ又は応力から算出された圧電薄膜の圧電定数。
4
MEMS圧電薄膜の試験装置
4.1
一般
この圧電特性の測定方法は,ユニモルフはりを用いて実施する。図1に試験片を含むMEMS圧電薄膜の
試験装置の構成を示す。表1に試験装置で使用する特性,シンボル及び項目名を示す。
1
試験薄膜
2
電極(試験薄膜の表面及び底面に取り付けた電極)
3
基板
4
クランプ
5
リニアアクチュエータ(逆圧電測定用には使用しない。)
6
変位メータ
7
正圧電測定用の電気的測定装置(すなわち,電圧計,電荷計,電流計,オシロスコープ又はロックインアンプ),
及び逆圧電測定用の電源(電圧制御発生器及び増幅器)
図1−MEMS圧電薄膜の正圧電定数及び逆圧電定数の試験装置
5
4
7
6
3
2
1

3
C 5630-30:2020 (IEC 62047-30:2017)
表1−試験装置で使用する特性,シンボル及び項目名
特性の種類
シンボル
単位
項目名
カンチレバー試料の寸法
l
m
カンチレバー長
w
m
カンチレバー幅
hs
m
基板カンチレバー厚
hp
m
圧電薄膜厚
電気−機械的変換特性
e31,f
C/m2
圧電定数
ed31,f
C/m2
正圧電定数
ec31,f
N/Vm
逆圧電定数
ec31,f(Vin,0)
N/Vm
入力電圧Vinが0 Vにおける逆圧電定数
ec31,f(Vin,min)
N/Vm
入力電圧Vinが最小における最小逆圧電定数
ec31,f(Vin,max)
N/Vm
入力電圧Vinが最大における最大逆圧電定数
d31
m/V
逆圧電定数(d-form)
電気的特性
C
F
圧電薄膜の容量
Vout
V
出力電圧
Vin
V
入力ピークツーピーク電圧
tan δ
−
誘電損失
機械的特性
s11E, s12E
m2/N
圧電薄膜の伸縮
Din
m
入力先端変位
Dout
m
出力先端変位
Es
N/m2
基板カンチレバーのヤング率
νs
−
基板カンチレバーのポアソン比
Ep
N/m2
圧電薄膜のヤング率
yc
m
底面からユニモルフカンチレバーの中立面までの位置
4.2
機能ブロック及び構成部品
4.2.1
一般
図1に,MEMS圧電薄膜の正圧電定数及び逆圧電定数を測定するための試験片を含む試験装置の基本構
成を示す。機能ブロック及び構成部品の詳細を4.2.2〜4.2.6に記載する。
4.2.2
クランプ
クランプは,カンチレバーを構成するユニモルフはりの片端を固定するための固定具である。
注記 固定条件は,カンチレバーの共振状態での機械的Q値(以下,Q値という。)を計測すること
によって確かめられる。
4.2.3
リニアアクチュエータ
リニアアクチュエータは,三角波によって駆動されたカンチレバーの先端を変位させ,正圧電特性の測
定に利用される。
4.2.4
変位メータ
変位メータは,カンチレバーの先端変位を計測する計器である。
4.2.5
電気的特性測定装置
正圧電効果は,試験薄膜の電極間に発生する電気的出力を計測する。これに必要な電気的特性測定装置
は,電圧計,電荷計,電流計,オシロスコープ又はロックインアンプで構成され,リニアアクチュエータ
の変位に同期して生じる電極間の電圧,電荷又は電流を計測する。
4.2.6
電源
逆圧電効果の測定は,電圧制御発生器によって生成され,電力増幅器によって増幅された電気的入力信
4
C 5630-30:2020 (IEC 62047-30:2017)
号を上部電極と下部電極との間に供給することによってなされる。
5
試験薄膜の測定
5.1
一般
MEMS圧電薄膜上部表面は,上部電極で覆われており,正圧電定数の測定時は出力電圧の測定に,又は
逆圧電定数の測定時は入力電圧の印加電極として利用される。
ユニモルフはりの基板材料の厚さは,試験中の薄膜の厚さと比べて十分に厚くする必要があり,代表値
としては少なくても試験薄膜の100倍の厚さとし,ユニモルフはりの半分の厚さの位置の応力中立面を,
基板厚さの中間面に近づけるようにしなければならない。応力中立平面の理論的考察をA.5に示す[この
近似にはストーニー(Stoney)の式が使われている。]。
一般的に電極の厚さは,試験薄膜の厚さよりも十分薄くすることが望ましい。
強誘電体薄膜の場合は,強誘電体ドメイン配向方向をそろえて,圧電特性を最大化するためにポーリン
グ(分極)処理が不可避である。
5.2
測定原理
一般的に圧電薄膜の正圧電定数を,次のように定義する(参考文献[1]〜[3]を参照)。
E
12
E
11
31
f,
31
s
s
d
e
+
=
··········································································· (1)
正圧電効果による圧電定数ed31,fは,式(2)で算出する。
(
)
in
out
s
s
f,
31
d
1
3
4
D
V
v
wh
lC
e
−
=
······························································· (2)
逆圧電効果の圧電定数ec31,fは,式(3)で算出する。
(
)
in
out
s
2
2
s
s
f,
31
c
1
3
V
D
v
l
h
E
e
−
=
································································ (3)
逆圧電効果は,材料固有の圧電特性に従って入力電圧に強く依存する。したがって,三つの逆圧電定数
のec31,f(Vin,min),ec31,f(Vin,max) 及びec31,f(Vin,0) は,逆圧電効果の測定結果によって定義しなければならない。
ec31,f(Vin,min) は,入力電圧最小時におけるec31,fの値であり,一方ec31,f(Vin,max) は,入力電圧最大時における
ec31,fの値である。ec31,f(Vin,min) を計測するための入力電圧Vinは,ec31,f(Vin,max) を計測するための入力電圧Vin
の5倍未満とすることが望ましい。
ec31,f(Vin,0) は,入力電圧Vin=0におけるec31,fの値である。その値は,ec31,f及びVin間の外挿曲線から得る
ことができる。その外挿曲線の式は,測定者によって決めることができるが,試験報告書に記載すること
が望ましい。
注記1 共振周波数及びQ値は,上部電極と下部電極との間に正弦波電圧を印加した場合の,ユニモ
ルフカンチレバーの変位の周波数応答を計測することによって決定される。
注記2 比誘電率及び誘電損失は,一般的に周波数1 kHzの条件でLCRメータ又はインピーダンスア
ナライザーを利用して測定される。
5.3
正圧電定数の測定手順
正圧電定数の測定手順は,次による。
a) 周囲温度及び相対湿度を測定する。
b) カンチレバーを構成する試験薄膜ユニモルフはりの片端を固定する。
c) リニアアクチュエータをカンチレバーの先端に取り付けて,そのカンチレバーの先端を三角波で振動
5
C 5630-30:2020 (IEC 62047-30:2017)
させる。
d) カンチレバーの先端の変位を測定する。
e) 試験薄膜の出力電圧を測定する。
5.4
逆圧電定数の測定手順
逆圧電定数の測定手順は,次による。
a) 周囲温度及び相対湿度を測定する。
b) カンチレバーを構成する試験薄膜ユニモルフはりの片端を固定する。
c) カンチレバーを振動させるためにユニポーラの正弦波電圧を試験薄膜に印加する。ポーリング処理を
必要とする場合は,印加する電圧はポーリング処理と同方向にそろえる。
d) 試験薄膜の入力電圧を測定する。
e) カンチレバーの先端の変位を測定する。
f)
入力電圧は3回を超えて掃引する。最終掃引時のデータを用いてec31,fを決定する。
6
試験報告
試験報告には,少なくとも次の項目を記載しなければならない。
a) 必須記載事項
1) ユニモルフはりの全ての寸法
− 長さ
− 幅
− 厚さ
2) カンチレバーの長さ
3) 試験薄膜の仕様
− 構成
− 厚さ
4) 厚さ薄膜の成膜工程
5) 基板材料及びその特性
− 材料
− 厚さ
− 単結晶の場合は結晶方位
− ヤング率
− ポワソン比
6) 試験薄膜の電気的特性
− 容量
− 誘電損失
7) 試験環境
− 温度
− 相対湿度
8) 正圧電定数の試験条件
− 入力先端変位
− リニアアクチュエータに印加される波形
6
C 5630-30:2020 (IEC 62047-30:2017)
− リニアアクチュエータに印加される周波数
9) 逆圧電定数の試験条件
− 入力電圧
− 試験薄膜に印加される波形
− 試験薄膜に印加される周波数
10) ポーリング処理条件
− 電圧
− ポーリング方向
− 波形
− 周波数
− ポーリング時間
− ポーリング処理から測定までの時間
11) 試験項目
− 正圧電定数ed31,f
− 入力電圧最小時の逆圧電定数ec31,f(Vin,min)
− 入力電圧最大時の逆圧電定数ec31,f(Vin,max)
b) 選択記載事項
1) ポーリング処理条件(必須項目とは逆方向のポーリング処理)
− 電圧
− ポーリング方向
− 波形
− 周波数
− ポーリング時間
− ポーリング処理から測定までの時間
2) 逆圧電定数の試験条件
− 入力電圧
− 試験圧電薄膜に印加される波形
− 試験圧電薄膜に印加される周波数
3) 試験時間(必須項目とは逆方向のポーリング処理)
− 正圧電定数ed31,f
− 入力電圧最小時の逆圧電定数ec31,f(Vin,min)
− 入力電圧最大時の逆圧電定数ec31,f(Vin,max)
4) 0 Vにおける外挿逆圧電定数
− ec31,f (0)
− 外挿曲線の式
5) カンチレバーの共振仕様
− 共振周波数
− Q値
MEMS圧電薄膜の測定方法の一例を,附属書Aに記載する。
7
C 5630-30:2020 (IEC 62047-30:2017)
附属書A
(参考)
MEMS圧電薄膜の測定方法の例
A.1 一般
A.2〜A.5にMEMS圧電薄膜の測定方法の例を示す。サンプルの準備手順,ポーリング処理条件,圧電
定数算出用の材料特性,測定手順及び測定結果の要約である。
A.2 サンプルの準備手順
次の記載は,サンプルの準備手順を段階的に示している(図1参照)。
a) 高周波マグネトロンスパッタリング装置で結晶方位(100),厚さ625 μmのSi単結晶上にユニモルフは
り(梁)を成膜したPZT圧電薄膜をサンプルとする。
b) Si基板上に,最初にチタン接着層付き白金薄膜を成膜する。
c) PZT圧電薄膜の上に上部白金電極を成膜する。
d) PZT圧電薄膜の厚さ,チタン層付き下部白金電極及び上部白金電極の厚さは,それぞれ3 μm,0.2 μm
及び0.05 μmとする。
e) サンプルは,結晶方位 <110> に添ってダイシングソーによって幅約2 mm及び長さ約20 mmのはり
(梁)形状に加工する。
f)
クランプによってユニモルフはりの片端を固定する。
g) 金ワイヤーを銀ペーストによって電極に接続する。
A.3 測定手順
A.3.1 正圧電定数の測定方法
次の記載は,正圧電定数の測定手順の例を段階的に示している。
a) 図1に示すように,試験サンプルをクランプで固定して,カンチレバーの先端をリニアアクチュエー
タに固定した状態にする。
b) 電極にボンディングされている金ワイヤーを電圧計,オシロスコープ,FFT又はロックインアンプに
接続する。
c) ポーリング処理が必要であれば,測定の前に実施する。ポーリング処理条件を示した表A.1を用意す
る。
d) カンチレバーの寸法及び圧電定数の算出に必要な値を示した表A.2を用意する。
e) カンチレバーのヤング率及びポアソン比は,結晶方位 <110> のシリコンの参照値を使って算出する。
f)
入力先端変位は,ドップラーレーザ振動計によって測定する。
g) 入力変位は,周波数5 Hzで1 μm〜23.5 μmの間で変化させる。
h) 表A.3は,先端変位,出力電圧及び算出された正圧電定数ed31,fの対応を示している。
i)
図A.1は,先端変位に対する正圧電定数ed31,fの算出値の関係を示している。
j)
この試験の測定例によって導かれる正圧電定数ed31,fの算出値は,表A.3及び図A.1のとおり,−6.4 C/m2
となる。

8
C 5630-30:2020 (IEC 62047-30:2017)
表A.1−ポーリング処理条件
入力信号
条件
ピークツーピーク電圧
20 V
波形
負のユニポーラ正弦波電圧
周波数
1 kHz
表A.2−正圧電定数算出用の材料特性
特性の種類
材料特性
圧電薄膜材料
PZT(Zr/Ti=52/48)
基板カンチレバー材料
面方位 (100) のシリコン
長さ方向に沿った結晶方位
<110>
基板カンチレバーのポアソン比
0.064
カンチレバーの長さ
17.45 mm
カンチレバーの幅
2.00 mm
カンチレバーの厚さ
625 μm
薄膜の厚さ
3.00 μm
薄膜の容量
0.056 27 μF
誘電損失
0.020 7
表A.3−出力電圧に対する正圧電定数の算出値
先端変位
(μm)
出力電圧
(V)
正圧電定数ed31,f
(C/m2)
1.16
6.5
6.46
4.71
26.3
6.41
7.9
44.1
6.40
11.94
66.7
6.41
15.88
88.6
6.40
19.54
109.2
6.41
23.55
131.0
6.37

9
C 5630-30:2020 (IEC 62047-30:2017)
図A.1−先端変位に対する正圧電定数の算出値
A.3.2 逆圧電定数の測定手順
次の記載は,逆圧電定数の測定手順の例を段階的に示している。
a) 図1に示すように,試験サンプルをクランプで固定して,カンチレバーの取付け端を固定した状態に
する。
b) 電極にボンディングされている金ワイヤーを電力増幅器の端子に接続する。
c) カンチレバーの寸法及び逆圧電定数の算出に必要な値を示した表A.4を用意する。
d) カンチレバーのヤング率及びポアソン比は,結晶方位 <110> シリコンの参照値を使って算出する。
e) ポーリング処理が必要であれば,測定の前に実施する。
f)
電力増幅器から上部電極へ負のユニポーラ正弦波電圧を印加する。
g) 入力電圧は,5 V〜30 Vの間で変化させる。
h) 入力電圧周波数は,400 Hz,及びカンチレバーの共振周波数は,2.2 kHzに設定する。
i)
出力先端変位は,ドップラー振動計によって測定する。
j)
先端変位は,入力電圧を最初に5 Vから30 Vへ増加させ,次に30 Vから5 Vへ減少させ,最後に再
度5 Vから30 Vへ増加させて,測定する。入力電圧及び先端変位の測定は,合計3回行う。
k) 表A.5は,入力電圧とカンチレバーの先端変位に対応した逆圧電定数ec31,fの算出値との関係を示して
いる。
l)
図A.2のプロットは,入力電圧のピークツーピーク電圧に対する圧電薄膜の逆圧電定数ec31,fの算出値
の関係を示している。
m) 図A.2の測定値及び外挿曲線は,ec31,f(Vin,0) 及びec31,f(Vin,max) の算出値が,それぞれ10.0 N/Vm及び15.0
N/Vmとなることを示している。
25
20
15
10
5
0
0
1.0
2.0
3.0
4.0
5.0
6.0
7.0
8.0
9.0
10.0
e
d3
1
,f
(
C
/m
2
)
先端変位 (μm)

10
C 5630-30:2020 (IEC 62047-30:2017)
表A.4−逆圧電定数算出用の材料特性
特性の種類
材料特性
圧電薄膜材料
PZT(Zr/Ti=52/48)
カンチレバー基板材料
面方位 (100) のシリコン
長さ方向に沿った結晶方位
<110>
カンチレバー基板のヤング率
1.69×1011 Pa
カンチレバー基板のポアソン比
0.064
カンチレバーの長さ
17.45 mm
カンチレバーの幅
2.00 mm
カンチレバーの厚さ
625 μm
薄膜の厚さ
3.00 μm
表A.5−カンチレバーの先端変位に対する逆圧電定数の算出値
1回目
(電圧上昇)
2回目
(電圧下降)
3回目
(電圧上昇)
入力電圧
(V)
先端変位
(μm)
逆圧電定数
(N/Vm)
先端変位
(μm)
逆圧電定数
(N/Vm)
先端変位
(μm)
逆圧電定数
(N/Vm)
5
0.74
11.5
0.76
11.8
0.76
11.8
10
1.59
12.4
1.65
12.8
1.62
12.6
15
2.58
13.4
2.64
13.6
2.59
13.5
20
3.66
14.2
3.68
14.3
3.67
14.2
25
4.74
14.8
4.75
14.9
4.72
14.8
30
5.78
15.0
5.78
15.0
5.76
15.0
図A.2−入力電圧に対する逆圧電定数の算出値
A.4 試験報告
次の表A.6は,圧電薄膜の測定条件及び電気機械的特性の結果の一例を示している。次の測定項目は,
必須項目である。
y = -0.003 1x2+ 0.237 2x + 10.647
0.0
2.0
4.0
6.0
8.0
10.0
12.0
14.0
16.0
0
5
10
15
20
25
30
35
|e
c 3
1
,f
|
[
N
/V
m
]
入力電圧[V]
1回目電圧上昇
2回目電圧下降
3回目電圧上昇
外挿曲線
入力電圧(V)
|
e
c
3
1
,f
|(
N
/V
m
)

11
C 5630-30:2020 (IEC 62047-30:2017)
表A.6−圧電薄膜の測定条件及び電気機械的特性結果の一例
項目
特性の種類
材料特性
1)
ユニモルフはり(梁)
長さ(取付け端を含む長さ)
22.5 mm
幅
2 mm
厚さ
0.628 mm
2)
カンチレバーの長さ
(取付け端を含まない長さ)
17.45 mm
3)
圧電薄膜
組成
Pb(Zr0.52Ti0.48)O3
厚さ
3 μm
4)
成膜工程
−
スパッタリング
5)
基板材料
材料
(100)Si
厚さ
0.625 mm
長さ方向に沿った結晶方位(単結晶の場合)
<110>
ヤング率(Es)
169 GPa
ポアソン比(νs)
0.064
6)
電気的特性
容量(C)
56.27 nF
誘電損失(tanδ)
0.020 7
7)
試験環境
温度
20 ℃
湿度
40 %
8)
正圧電定数の試験条件
入力先端変位
≒23.55 μm
入力波形
圧縮三角波形
周波数
5 Hz
9)
逆圧電定数の試験条件
入力波形
上部電極への負のユニポーラ
正弦波電圧
入力電圧
≒−30 V
周波数
400 Hz
10)
ポーリング処理条件
電圧
20 V
方向
上部:負
下部:接地
波形
ユニポーラ正弦波電圧
周波数
100 Hz
ポーリング時間
1 min
ポーリング処理から測定までの時間
3 min
11)
試験項目
ed31,f
−6.4 C/m2
ec31,f(Vin,min)
−11.8 N/Vm(5 V印加時)
ec31,f(Vin,max)
−15 N/Vm(30 V印加時)
次の表A.7の項目は選択項目である。

12
C 5630-30:2020 (IEC 62047-30:2017)
表A.7−圧電薄膜の測定条件及び電気機械的特性の選択項目の一例
項目
特性の種類
材料特性
1)
ポーリング処理条件(逆方向)
電圧
20 V
方向
上部:正
下部:接地
波形
ユニポーラ正弦波電圧
周波数
100 Hz
ポーリング時間
1 min
ポーリング処理から測定までの時間
3 min
2)
逆圧電定数の試験条件
入力波形
上部電極への正のユニポーラ
正弦波電圧
入力電圧
≒30 V
周波数
400 Hz
3)
試験項目
ed31,f
−6.4 C/m2
ec31,f(Vin,min)
−11.8 N/Vm(5 V印加時)
ec31,f(Vin,max)
−15.0 N/Vm(30 V印加時)
4)
0 Vにおける外挿ec31,f
ec31,f(Vin,0)
−10.6 N/Vm
波形
負のユニポーラ測定波形から
の外挿
式
y=−0.003 1x2+0.24x+10.6
5)
ユニモルフカンチレバーの共振仕様
共振周波数
2.2 kHz
Q値
120
A.5 中立面の数式
正圧電定数ed31,f及び逆圧電定数ec31,fは,5.2の式(2)及び式(3)から導かれる。これらの式は,基板厚さの
半分であるユニモルフの中立面の理論式である。重複領域の中立面の理論式は,式(A.1)のように示される。
(
)
(
)
s
s
p
p
2
s
s
2
p
s
p
p
c
2
2
h
E
h
E
h
E
h
h
h
E
y
+
+
+
=
························································ (A.1)
基板厚さhsが圧電薄膜の厚さhpよりも十分に大きいときは,ycはhsの半分とほとんど同じ値となる。シ
リコン基板厚がPZT(Ep≒70 GPa)の100倍厚い場合には,hs/2とycとの差が2 %と小さくなり,シリコ
ン基板厚が圧電薄膜の厚さと比べて100倍超えの場合,式(2)及び式(3)が有効である。
13
C 5630-30:2020 (IEC 62047-30:2017)
参考文献
[1] IEC 60483:1976,Guide to dynamic measurements of piezoelectric ceramics with high electromechanical
coupling
[2] EN 50324-2,Piezoelectric properties of ceramic materials and components−Method of measurement−Low
power
[3] Dubois, M., and Muralt, P., Sensors and Actuators, A77, pp.106-112 (1999)
[4] Y. Tsujiura, S. Kawabe, F. Kurokawa, H. Hida, and I. Kanno: Jpn. J. Appl. Phys. 54 10NA04 (2015)
[5] Chun, D.-M., Sato, M., and Kanno, I., Journal of Applied Physics, Volume 113, Issue 4, pp. 044111-044111-9
(2013)
[6] Kanno, I., Kotera, H., and Wasa, K., Sensors and Actuators, A107, pp. 68-74 (2003)
[7] McSkimin, H. J., Bond, W. L., Buehler, E., and Teal, G. K., Measurement of the Elastic Constants of Silicon
Single Crystals and Their Thermal Coefficients, Phys. Rev. 83, 1080 (1951)