C 5945:2005
(1)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
まえがき
この規格は,工業標準化法に基づいて,日本工業標準調査会の審議を経て,経済産業大臣が改正した日
本工業規格である。
これによって,JIS C 5945:1996は改正され,この規格に置き換えられる。
改正に当たっては,日本工業規格と国際規格との対比,国際規格に一致した日本工業規格の作成及び日
本工業規格を基礎にした国際規格原案の提案を容易にするために,IEC 62007-2:1996,Semiconductor
optoelectronic devices for fibre optic system applications - Part 2 : Measuring methodsを基礎として用いた。
この規格の一部が,技術的性質をもつ特許権,出願公開後の特許出願,実用新案権,又は出願公開後の
実用新案登録出願に抵触する可能性があることに注意を喚起する。主務大臣及び日本工業標準調査会は,
このような技術的性質をもつ特許権,出願公開後の特許出願,実用新案権,又は出願公開後の実用新案登
録出願にかかわる確認について,責任はもたない。
JIS C 5945には,次に示す附属書がある。
附属書1(参考)JISと対応する国際規格との対比表

2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
C 5945:2005
光伝送用半導体レーザモジュール測定方法
Measuring methods of laser diode modules for fiber optic transmission
序文 この規格は,1996年に第1版として発行されたIEC 62007-2:1996,Semiconductor optoelectronic devices
for fibre optic system applications - Part 2 : Measuring methodsを翻訳し,技術的内容を変更して作成した日本
工業規格である。
なお,この規格で側線又は点線の下線を施してある箇所は,原国際規格を変更している事項である。変
更の一覧表をその説明を付けて,附属書1(参考)に示す。
1. 適用範囲 この規格は,光源として使用する光伝送用半導体レーザモジュール(光ファイバピグテイ
ル又は光ファイバ接続用のレセプタクルをもち,必要に応じモニタ用フォトダイオード,電子冷却素子,
温度センサ,光アイソレータなどの簡単な素子を含むもの。以下半導体レーザモジュールという。)の測定
方法について規定する。
備考 この規格の対応国際規格を,次に示す。
なお,対応の程度を表す記号は,ISO/IEC Guide 21に基づき,IDT(一致している),MOD
(修正している),NEQ(同等でない)とする。
IEC 62007-2:1996,Semiconductor optoelectronic devices for fibre optic system applications - Part 2 :
Measuring methods (MOD)
2. 引用規格 次に掲げる規格は,この規格に引用されることによって,この規格の規定の一部を構成す
る。これらの引用規格のうちで,発効年を付記してあるものは,記載の年の版だけがこの規格の規定を構
成するものであって,その後の改正版・追補版には適用しない。発効年を付記していない引用規格は,そ
の最新版(追補を含む。)を適用する。
JIS C 0617
電気用図記号
JIS C 1102-1
直動式指示電気計器 第一部:定義及び共通する要求事項
JIS C 5944:2002
光伝送用半導体レーザモジュール通則
JIS Z 8202-0:2000
量及び単位 − 第0部:一般原則
JIS Z 8202-1:2000
量及び単位 − 第1部:空間及び時間
JIS Z 8202-2:2000
量及び単位 − 第2部:周期現象及び関連現象
JIS Z 8202-3:2000
量及び単位 − 第3部:力学
JIS Z 8202-4:2000
量及び単位 − 第4部:熱
JIS Z 8202-5:2000
量及び単位 − 第5部:電気及び磁気
JIS Z 8202-6:2000
量及び単位 − 第6部:光及び関連する電磁放射
JIS Z 8203
国際単位系(SI)及びその使い方

2
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
3. 用語の定義 この規格で用いる主な用語の定義はJIS C 5944:2005による。
4. 測定の状態
4.1
標準状態 測定は,規定がない限り,温度15℃〜35℃,相対湿度25〜85%,気圧860〜1060hPaの
下で行う。なお,標準状態で測定することが困難な場合には,判定に疑義が生じない限り,標準状態以外
の状態で測定を行ってもよい。
4.2
基準状態 基準状態は,温度25℃,相対湿度45%,気圧860〜1060hPaとする。ただし,温度だけ
をもって基準状態としてもよい。
4.3
判定状態 判定状態は,温度25±2℃,相対湿度45〜55%,気圧860〜1060hPaとする。
5. 測定機器,装置,図記号及び単位
5.1
測定用電源 直流電源はリプル含有率3%以下,交流電源は高調波含有率5%以下のものとする。た
だし,商用周波数の場合は,高調波含有率10%以下とする。なお,特に交流出力を測定する試験では,直
流電源のリプル含有率,交流電源の高調波含有率及び交流の流れる直流電源回路の交流インピーダンスは,
測定に影響を与えないように小さい値とする。また,サージの侵入に対する十分な防護措置が施されてい
なければならない。
5.2
計器及び測定器 規定がない限り,計器はJIS C 1102-1に規定する0.5級のもの,測定器はこれと同
等以上の精度をもつものとし,これらの入力インピーダンスは測定系への影響を無視できる値とする。
備考 標準品として0.5級以上の計器又はこれに相当するような精度をもつ測定器がない場合は,4.2
の規定は適用しない。
5.3
光パワーメータ 測定に使用するパワーメータは,該当する波長で校正し,かつ,受光面感度分布
が十分に平たんなものとする。
5.4
光スペクトラムアナライザ 測定に使用する光スペクトラムアナライザは,該当する波長で,十分
なダイナミックレンジ(十分低い迷光)と,横(波長)軸,縦(レベル)軸の確度,及び発振スペクトル
を分離するのに十分な分解能をもつものとする。
5.5
図記号 この規格で用いる図記号は,JIS C 0617(電気用図記号)による。
5.6
単位 この規格で用いる単位は,以下のJISによる。
JIS Z 8202-0:2000
量及び単位 − 第0部:一般原則
JIS Z 8202-1:2000
量及び単位 − 第1部:空間及び時間
JIS Z 8202-2:2000
量及び単位 − 第2部:周期現象及び関連現象
JIS Z 8202-3:2000
量及び単位 − 第3部:力学
JIS Z 8202-4:2000
量及び単位 − 第4部:熱
JIS Z 8202-5:2000
量及び単位 − 第5部:電気及び磁気
JIS Z 8202-6:2000
量及び単位 − 第6部:光及び関連する電磁放射
JIS Z 8203
国際単位系(SI)及びその使い方
6. 測定方法
6.1
順電流(If)
6.1.1
目的 規定された状態での,半導体レーザモジュールの順電流を測定することを目的とする。
6.1.2
測定回路 順電流Ifの測定は,図1に示す回路によって次の方法で行う。

3
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.1.3
測定方法 半導体レーザモジュールに規定の光ファイバ端出力Pfを発生させ,そのときの順電流
Ifを測定する。ただし,この測定は,1kHz以下の交流電源を用いてオシロスコープの画面上に電流-電
圧波形を描かす方法によってもよい。
6.1.4
測定上の注意 半導体レーザモジュールで相当程度の電力消費があり,それに伴う接合部温度上昇
が測定値に大きな影響を与える場合には,次のいずれかの方法によって行い,その方法を明記する。
1) 直流を用い,温度安定に達した後,測定する。ただし,温度安定に達しない場合は,規定の電流を
流し始めた後,定められた時間に測定する。
2) パルスを用いるか,又は接合部温度上昇が無視できるような短い時間で測定する。パルスを用いる
ときは,パルス幅及びデューティサイクルを明記する。
6.1.5
個別仕様書に規定すべき項目
1) 動作温度Top
2) 光ファイバ端出力Pf
3) 順電圧Vf及びパルス幅及びデューティサイクル
6.2
順電圧(Vf)
6.2.1
目的 規定された状態での,半導体レーザモジュールの順電圧を測定することを目的とする。
6.2.2
測定回路 順電圧Vfの測定は,図1に示す回路によって,次の方法で行う。
6.2.3
測定方法 半導体レーザモジュールに規定の光ファイバ端出力Pfを発生させ,そのときの順電圧
Vfを測定する。ただし,その測定は,1kHz以下の交流電源を用いてオシロスコープの画面上に電流-電圧
波形を描かす方法によってもよい。
6.2.4
測定上の注意 半導体レーザモジュールで相当程度の電力消費があり,それに伴う接合部温度上昇
が測定値に大きな影響を与える場合には,次のいずれかの方法によって行い,その方法を明記する。
1) 直流を用い,温度安定に達した後測定する。ただし,温度安定に達しない場合には,規定の電圧を
印加し始めた後,定められた時間に測定する。
2) パルスを用いるか,又は接合部温度上昇が無視できるような短い時間で測定する。パルスを用いる
ときは,パルス幅及びデューティサイクルを明記する。
6.2.5
個別仕様書に規定すべき項目
1) 動作温度Top
2) 光ファイバ端出力Pf
3) 順電流If及びパルス幅及びデューティサイクル
図 1 順電流及び順電圧測定回路

4
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.3
逆電圧(Vr)
6.3.1
目的 規定された状態での,半導体レーザモジュールの逆電圧を測定することを目的とする。
6.3.2
測定回路 逆電圧Vrの測定は,図2に示す回路によって,次の方法で行う。
6.3.3
測定方法 半導体レーザモジュールのレーザ素子端子間に規定の逆電流Irを流し,その時の逆電圧
Vrを測定する。ただし,この測定は,1kHz以下の交流電源を用いてオシロスコープの画面上に電流-電圧
波形を描かす方法によってもよい。
6.3.4
測定上の注意 半導体レーザモジュールで相当程度の電力消費があり,それに伴う接合部温度上昇
が測定値に大きな影響を与える場合には,次のいずれかの方法によって行い,その方法を明記する。
1) 直流を用い,温度安定に達した後,測定する。ただし,温度安定に達しない場合は,規定の電流を
流し始めた後,定められた時間に測定する。
2) パルスを用いるか,又は接合部温度上昇が無視できるような短い時間で測定する。パルスを用いる
ときは,パルス幅及びデューティサイクルを明記する。
6.3.5
個別仕様書に規定すべき項目
1) 動作温度Top
2) 逆電流Ir
3) パルス幅及びデューティサイクル
図 2 逆電圧測定回路
6.4
光ファイバ端出力(Pf)
6.4.1
光ピグテイル形半導体レーザモジュールの場合
a) 目的 規定された状態での,光ピグテイル形半導体レーザモジュールの光ファイバ端出力を測定する
ことを目的とする。
b) 測定回路 光ピグテイル形半導体レーザモジュールの光ファイバ端出力測定は,図3に示す回路によ
って,次の方法で行う。
c) 測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流Ifを流し,光ファイバから出
る光ファイバ端出力Pfを光パワーメータで測定する。
d) 測定上の注意 光パワーメータの受光面は,光ファイバ端から放射される全光量を十分に受けられる
大きさでなければならない。また,光ファイバ端面や光パワーメータの受光部から半導体レーザへの
戻り光量を十分小さく抑えるよう注意する。
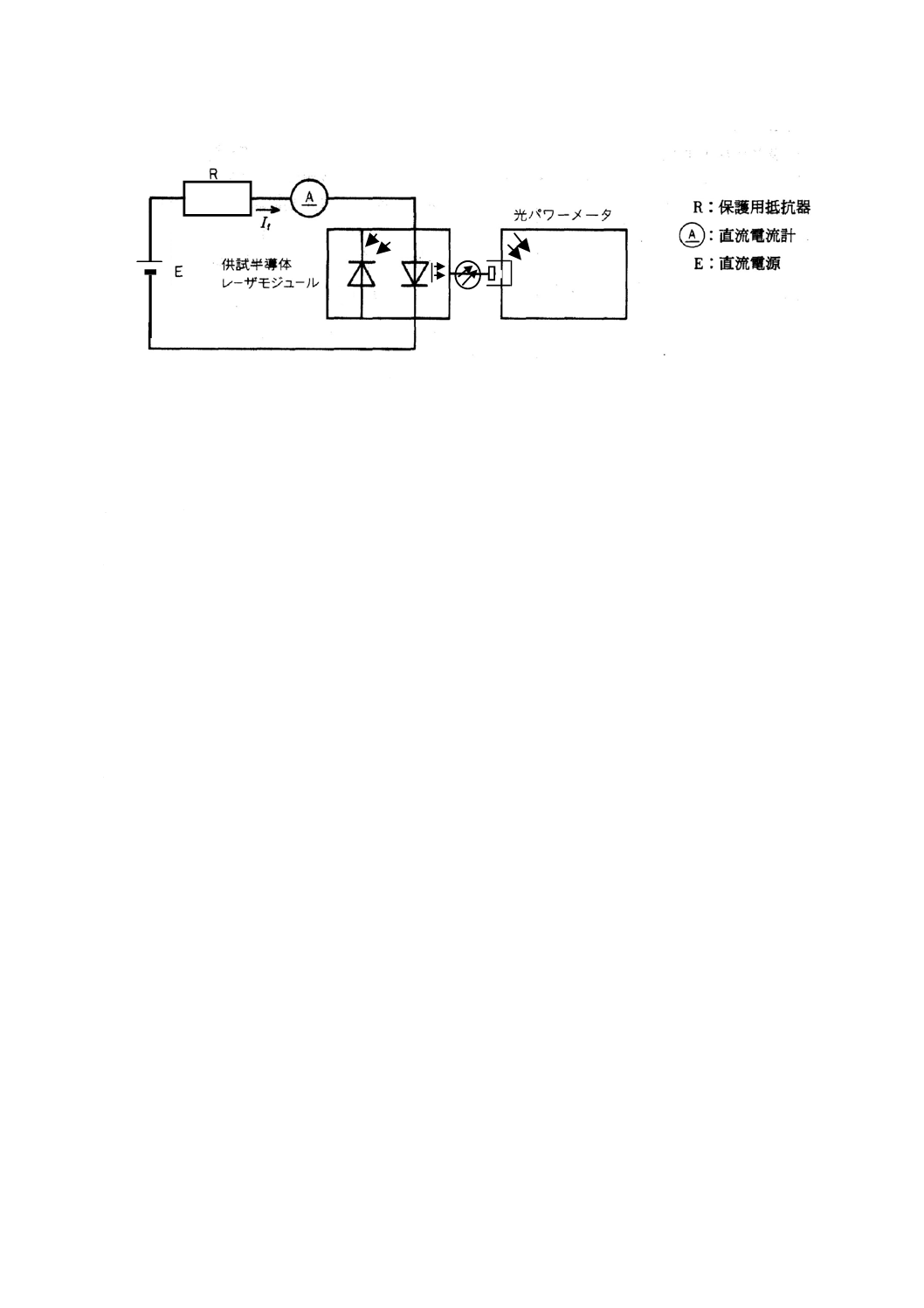
5
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
流流
図 3 半導体レーザモジュールの光ファイバ端出力測定回路
6.4.2
光レセプタクル形半導体レーザモジュールの場合
a) 目的 規定された状態での,光レセプタクル形半導体レーザモジュールのファイバ端出力を測定する
ことを目的とする。
b) 測定回路 光レセプタクル形半導体レーザモジュールの光ファイバ端出力測定は,図3に示す回路に
よって,次の方法で行う。
c) 測定方法 光レセプタクル形半導体レーザモジュールのレーザ素子端子間に規定の順電流Ifを流し,
レセプタクルと整合性がある光コネクタをもつ光ファイバを用いて,一端をレーザモジュールの光レ
セプタクルに,他端を光パワーが校正された光パワーメータに接続し,光ファイバ端出力Pfを光パワ
ーメータで測定する。
d) 測定上の注意 測定系からの戻り光量を十分小さく抑えるよう注意する(図4参照)。なお,光パワー
メータの受光面は,光ファイバ端から放射される全光量を十分に受けられる大きさでなければならな
い。また,光ファイバ端面や光パワーメータの受光部から半導体レーザへの戻り光量を十分小さく抑
えるよう注意する。
e) 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If
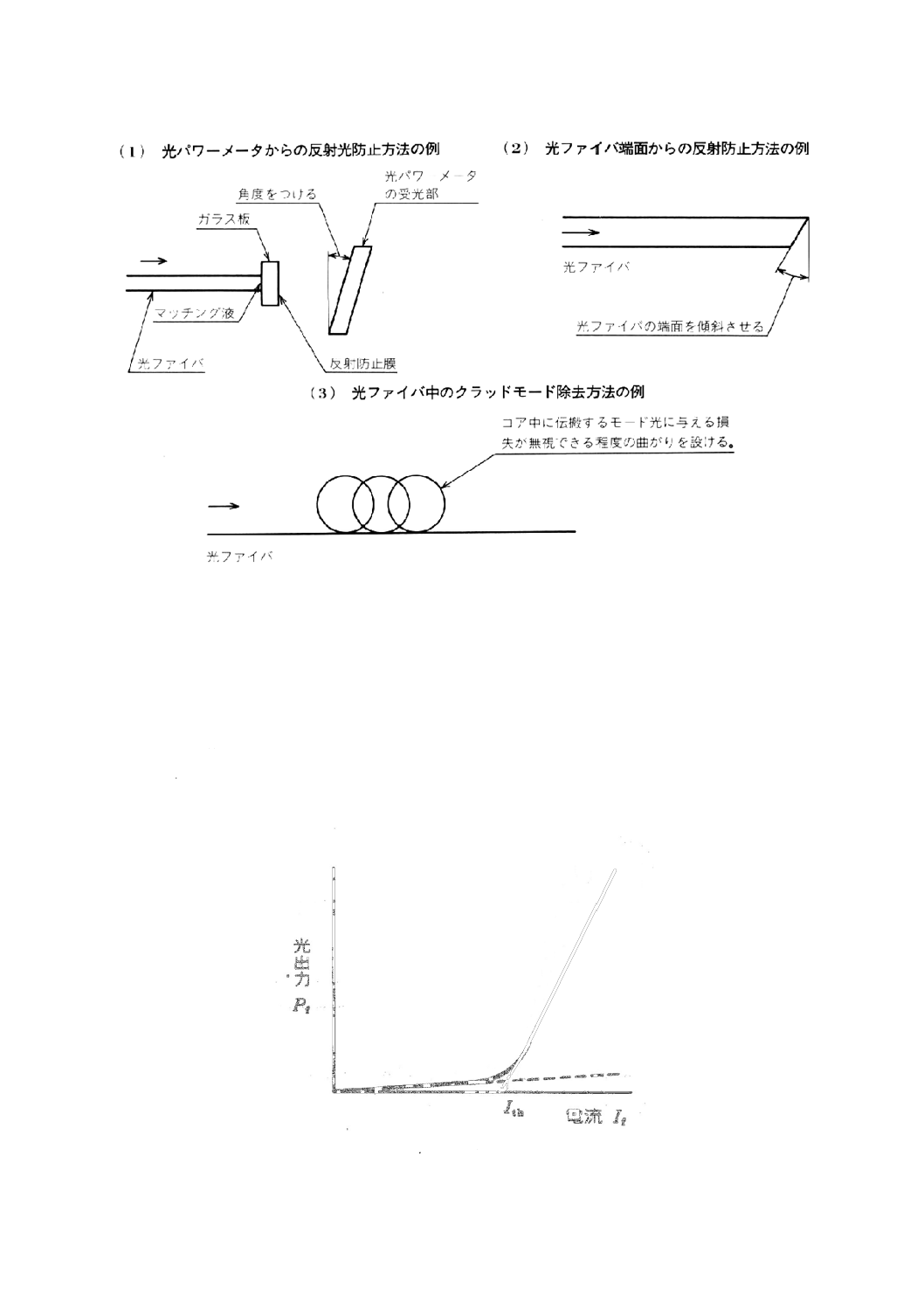
6
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図 4 測定系からの反射光防止方法の例
6.5
しきい値電流(Ith)
6.5.1 目的 規定された状態での,半導体レーザモジュールのしきい値電流を測定することを目的とする。
6.5.2
測定回路 しきい値電流Ithの測定は,図3に示す回路によって,次の方法で行う。
6.5.3
測定方法 半導体レーザモジュールに流す順方向電流Ifを変化させながら,Ifと光ファイバ端出力
PfをX−Yレコーダ,オシロスコープなどで記録し,次の方法1から方法3のうち,いずれかを用いて,
しきい値電流を算出する。
方法1 If - Pf曲線の記録から図5に示すように特性上の2本の直線部を延長してその交点の電流を求め,
しきい値電流Ithとする。
図 5 If - Pf曲線(方法1)

7
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
方法2 しきい値近傍でIf - Pf曲線の変化が緩やかで,(1)の方法の適用が困難な場合は,図6に示す
ようにレーザ発振光出力に相当する部分の直線を延長し,X軸との交点の電流を求め,しきい値電流
Ithとする。この時,直線を定義するために光出力Pf1,Pf2の2点を用いた場合は,その値を明記する。
図 6 If - Pf曲線(方法2)
方法3 If - Pf曲線の2次微分を求め,図7に示すように2次微分のピークに相当する電流で最小のも
のを,しきい値電流Ithとする。
図 7 If - Pf曲線(方法3)
6.5.4
測定上の注意 算出に用いた方法を明記することとする。また,測定に当たっては,測定系,光フ
ァイバ端面などからの戻り光量を十分小さく抑えるように注意する。また,順方向電流をディジタル的に
変化させて測定を行う場合は,十分な精度及び再現性が得られるように考慮しなければならない。
8
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.5.5
個別仕様書に規定すべき項目
1) 動作温度Top
2) しきい値電流の算出に用いた方法
6.6
しきい値光出力(Pth)
6.6.1
目的 規定された状態での,半導体レーザモジュールのしきい値光出力を測定することを目的とす
る。
6.6.2
測定回路 しきい値光出力の測定は,図3に示す回路によって次の方法で行う。
6.6.3
測定方法 しきい値光出力Pthの測定は,次の方法で行う。
半導体レーザモジュールに,しきい値電流Ithに等しい順方向電流Ifを流し,光ファイバ端出力Pfを測定
する。光出力の測定は,6.4に規定の方法を用いる。
6.6.4
個別仕様書に規定すべき項目
1) 動作温度Top
2) しきい値電流Ith
6.7
スロープ効率(ηd)
6.7.1 目的 規定された状態での,半導体レーザモジュールのスロープ効率を測定することを目的とする。
6.7.2
測定回路 スロープ効率ηdの測定は,図3に示す回路によって次の方法で行う。
6.7.3
測定方法 半導体レーザモジュールに流す順方向電流Ifを変化させながら, IfとPfをX−Yレコ
ーダ,オシロスコープなどで記録し,式(1)によって算出する。
th
f
th
f
d
I
I
P
P
−
−
=
η
(W/A)........................(1)
ここに,ηd :スロープ効率(W/A)
Ith :しきい値電流(A)
If :規定の順電流(又は規定の光ファイバ端出力を得る順電流)(A)
Pth : Ithを流したときの光ファイバ端出力(W)
Pf : Ifを流したときの光ファイバ端出力(又は規定ファイバ端出力)(W)
“しきい値電流”の代わりに,“しきい値電流よりも高く,かつ,動作電流よりも十分低い電流”及び“Ithを流したとき
の光ファイバ端出力”の代わりに,“しきい値電流よりも高く,かつ,動作電流よりも十分低い電流での光ファイバ端
出力”としてもよい。
6.7.4
測定上の注意 測定に当たっては,測定系,光ファイバ端面などからの戻り光量を十分小さく抑え
るように注意する。
6.7.5
個別仕様書に規定すべき項目
1) 動作温度Top
6.8
縦モード間隔及び縦モード数
6.8.1
目的 規定された状態での,半導体レーザモジュールの縦モード間隔及び縦モード数を測定するこ
とを目的とする。

9
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.8.2
測定回路 縦モード間隔及び縦モード数の測定は,図8及び図9に示す回路によって次の方法で行
う。
6.8.3
測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流If又は規定の光ファイバ
端出力を得る順電流Ifを流し,光スペクトラムアナライザを用い得られたスペクトルから,モードの波長
間隔(縦モード間隔)を求める。
また,ピークに対し規定の値のレベルよりも大きいピークの数(縦モード数)を数える。
6.8.4
個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If 又は光ファイバ端出力Pf
図 8 縦モード間隔及び縦モード数の測定
図 9 光スペクトラムアナライザによる光スペクトラムの測定回路
6.9
ピーク発振波長(λp)
6.9.1
目的 規定された状態での,半導体レーザモジュールのピーク発振波長を測定することを目的とす
る。
6.9.2
測定回路 ピーク発振波長λpの測定は,図9に示す回路及び図10によって,次の方法で行う。
6.9.3
測定方法 半導体レーザモジュールに規定の順電流If又は規定の光ファイバ端出力Pfを得る順電
流Ifを流し,光スペクトラムアナライザを用いてピーク波長λpを測定する。

10
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.9.4
個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
図 10 ピーク発振波長の測定
6.10 中心発振波長(λc),スペクトル幅(Δλw),スペクトル半値幅(Δλ)
6.10.1 目的 規定された状態での,半導体レーザモジュールの中心波長(λc),スペクトル幅(Δλw),
スペクトル半値幅(Δλ)を測定することを目的とする。
6.10.2 測定回路 中心波長λc ,スペクトル幅Δλw及びスペクトル半値幅Δλの測定は,図9に示す回
路,図11,図12及び図13によって,次の方法で行う。
6.10.3 測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流If又は規定の光ファイバ
端出力Pfを得る順電流Ifを流し,光スペクトラムアナライザを用い,中心波長λy ,スペクトル幅Δλy
及びスぺクトル半値幅Δλを測定する。
6.10.4 測定上の注意 測定では,測定系,光ファイバ端面などからの戻り光量を十分小さく抑えるよう注
意する。
図 11 スペクトル幅,スペクトル半値幅及び中心発振波長の測定(包絡線法による。)

11
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図 12 スペクトル幅,スペクトル半値幅及び中心発振波長の測定(N-dB法による。)
図 13 スペクトル幅,スペクトル半値幅及び中心発振波長の測定(RMS法による。)
RMS法による中心波長,スペクトル幅,スペクトル半値幅は,式(2)及び式(3)によって算出する。
n
n
n
c
A
A
∑
×
∑
=
λ
λ
........................(2)
(
)
n
2
c
n
n
w
A
A
K
∑
−
×
∑
×
=
λ
λ
λ
∆
.............(3)
ここで,Kは定数で目的に応じて選択(1, 2, 2.35, 3)し,明示する必要がある(2.35を選択した場合は
スペクトル形状をガウス分布とみなしたときのスペクトル半値幅に相当する)。
6.10.5 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf

12
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.11 変調時スペクトル測定
6.11.1 目的 規定された状態での,半導体レーザモジュールの変調時のスペクトルを測定することを目的
とする。
6.11.2 測定回路 変調時スペクトルの時間平均波長測定は,図14に示す回路及び図11,図12及び図13
によって,次の方法で行う。
6.11.3 測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流If又は規定の光ファイバ
端出力Pfを得る順電流Ifを流し,さらに,パルス発生器(繰返しパルス)によって変調し,放出された光
ファイバ端出力を光スペクトラムアナライザに入力し,中心波長λc ,スペクトル幅Δλw及びスぺクトル
半値幅Δλを測定する。RMS法による中心波長,スペクトル幅,スペクトル半値幅は,式(2)及び式(3)
によって算出する。
6.11.4 測定上の注意 測定では,測定系,光ファイバ端面などからの戻り光量を十分小さく抑えるよう注
意する。変調周波数が比較的低く光スペクトラムアナライザの応答帯域との間で干渉を起こすおそれがあ
る場合には,光スペクトラムアナライザの外部同期入力端子などによって同期させて測定する。
6.11.5 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
3) 変調周波数
図 14 変調時スペクトルの測定回路
6.12 波長チャープ(Δf)
6.12.1 目的 規定された状態での,半導体レーザモジュールの変調時のスペクトルの波長チャープを測定
することを目的とする。
6.12.2 測定回路 半導体レーザの変調時スペクトルの波長チャープ測定は,図15に示す回路によって,
次の方法で行う。

13
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.12.3 測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流If又は規定の光ファイバ
端出力Pfを得る順電流Ifを流し,さらに,パルス発生器(繰返しパルス)によって変調し,放出された光
ファイバ端出力を光干渉計に入力する。
光干渉計は光周波数の変化を光強度の変化に変換する働きをする。光干渉計のディレイラインの遅延時
間tdを制御し,光周波数弁別特性の傾き符号が異なる2点の光周波数での測定を行う。光干渉計の光出力
はフォトディテクタにより電気信号に変換し,サンプリングオシロスコープにて計測する。
光干渉計の特性を表す指標として光強度変化の一周期に対応する光周波数変化の幅をFSR(Free Space
Range)と呼ぶ。FSRは式(4)に示すように,光干渉計のディレイラインによる遅延時間tdの逆数に相当す
る。
測定する半導体レーザの波長に対して,光干渉計の正の弁別特性点での出力Pf+と負の弁別特性点での
出力Pf−はそれぞれ強度変調成分IM,光周波数変調成分FMと式(5)及び式(6)に示す関係にある。従
って式(7)によりIM,FMの値が求まる。波長チャープ(Chirp:動的なスペクトルの広がり)Δfは式(8)
により計算される。
d
1
t
FSR=
.....................(4)
FM
IM
P
+
=
+
f
...................(5)
FM
IM
P
−
=
−
f
..................(6)
(
)
(
)
2
,
2
f
f
f
−
+
−
+
−
=
+
=
P
P
FM
P
P
IM
f
.........(7)
∆f=FSR
2πarcsinFM
IM
(Hz)...........(8)
ここで,tdはディレイラインの遅延時間
6.12.4 測定上の注意 測定では,測定系,光ファイバ端面などからの戻り光量を十分小さく抑えるよう注
意する。また,FSRは測定しようとする動的なスペクトルの広がりΔfに対して少なくとも4倍の帯域が
望ましい。
6.12.5 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
3) 変調周波数
4) 光干渉計のFSR

14
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図 15 波長チャープ測定回路
6.13 サイドモード抑圧比(SMSR)
6.13.1 目的 規定された状態での,半導体レーザモジュールのサイドモード抑圧比を測定することを目的
とする。
6.13.2 測定回路 サイドモード抑圧比の測定は,図9及び図16によって,次の方法で行う。
6.13.3 測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流If又は規定の光ファイバ
端出力Pfを得る順電流Ifを流し,光スペクトラムアナライザを用い発振スペクトルを測定し,図16のよ
うに対数表示画面上で最もパワーが大きいモード(メインモード)のレベルPmainと2番目に大きいモード
(サイドモード)のレベルPsideから式(9)によって算出する。
=
side
main
10
log
10
P
P
SMSR
(dB) ..................(9)
6.13.4 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf

15
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図 16 SMSRの測定
6.14 スペクトル線幅(ΔλL)
6.14.1 目的 規定された状態での,半導体レーザモジュールのスペクトル線幅を測定することを目的とす
る。
6.14.2 測定回路 スペクトル線幅ΔλLの測定は,図17に示す回路によって次の方法で行う。
6.14.3 測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流If又は規定の光ファイバ
端出力Pfを得る順電流Ifを流し,遅延自己ホモダイン又はヘテロダイン法(音響光学素子など高周波数シ
フタを用いる方法)によって電気的なスペクトラムアナライザ上の波形を観測する。求める線幅ΔλLは
図18のようにスペクトラムアナライザ上で観測される波形の,規定のレベル低下した点での半幅(ホモダ
インの場合は得られる波形が当初から片側部分だけであるのでその幅)に等しい。
6.14.4 測定上の注意 受光器及び回路は被測定レーザモジュールの線幅に対応する周波数広がりに対し
十分広い帯域と平たん性をもっていて,得られる波形に対し十分なSN比が確保された状態で測定する。
レーザ素子に対する戻り光が少ない,及び遅延用ファイバの長さは被測定レーザモジュールの可干渉距離
に対して十分長いことが必要である。接続にはシングルモードファイバを用いる。
また,検出されるレベルは,分岐後に結合される二つの光の偏光方向の一致の程度の応じて,より高い
レベルが得られるので,分岐されたどちらかの光の偏光方向を調節できることが望ましい。
6.14.5 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf

16
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図 17 スペクトル線幅の測定回路
図 18 スペクトル線幅の測定
6.15 上昇時間(tr),下降時間(tf),ターンオン時間(ton),ターンオフ時間(toff),ターンオン遅延時間(td(on)),
ターンオフ遅延時間(td(off))
6.15.1 目的 規定された状態での,半導体レーザモジュールの上昇時間(tr),下降時間(tf),ターンオン
時間(ton),ターンオフ時間(toff),ターンオン遅延時間(td(on)),ターンオフ遅延時間(td(off))を測定することを目
的とする。
6.15.2 測定回路 半導体レーザモジュールの上昇時間(tr),下降時間(tf),ターンオン時間(ton),タ−ンオ
フ時間(toff),ターンオン遅延時間(td(on)),ターンオフ遅延時間(td(off))の測定は図19に示す回路によって行う。
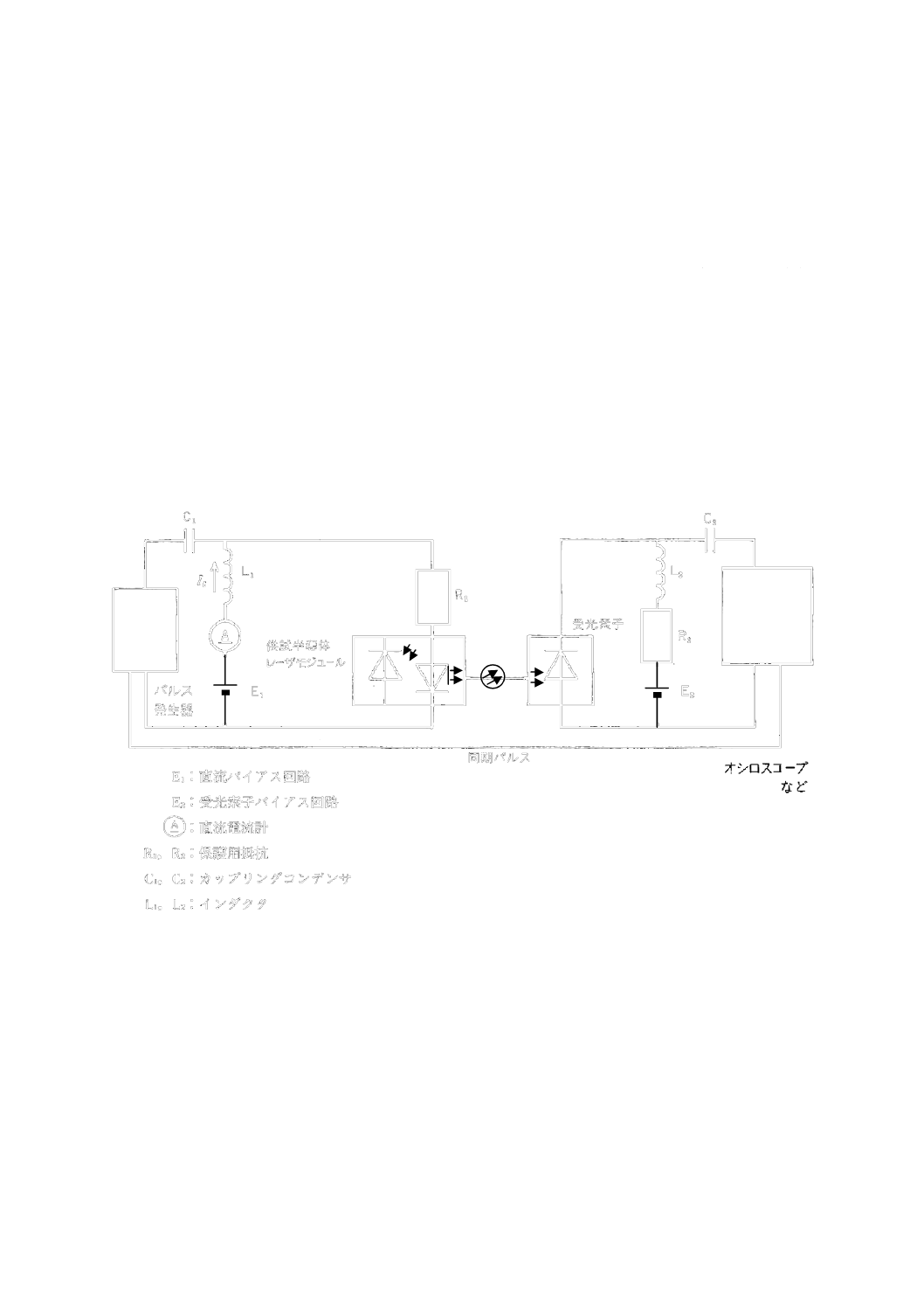
17
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.15.3 測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流If又は規定の光ファイバ
端出力Pfを得る順電流Ifを流し,規定の振幅,パルス幅及び繰返し周波数の方形電流パルスを重畳する。
半導体レーザモジュールから放出された光を受光素子に入力し,電気信号に変換する。この電気信号をオ
シロスコープなどで測定し,上昇時間(tr),下降時間(tf),ターンオン時間(ton),ターンオフ時間(toff),ター
ンオン遅延時間(td(on)),ターンオフ遅延時間(td(off))を求める。
6.15.4 測定上の注意 方形波電流パルス発生器及び光パルス測定系の上昇時間及び下降時間は,半導体レ
ーザモジュールの上昇時間及び下降時間よりも十分小さくする。
また,半導体レーザモジュールから出た光パルスが反射して半導体レーザモジュールに戻って測定に影
響するのを防ぐため,半導体レーザモジュールへの戻り光量を十分小さくするよう注意する。
なお,駆動パルス波形,レーザ駆動回路,受光素子周辺回路及び配置が測定結果に影響する場合がある
ので,必要に応じて,これらを明示することが望ましい。
6.15.5 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
図 19 上昇時間及び下降時間の測定回路
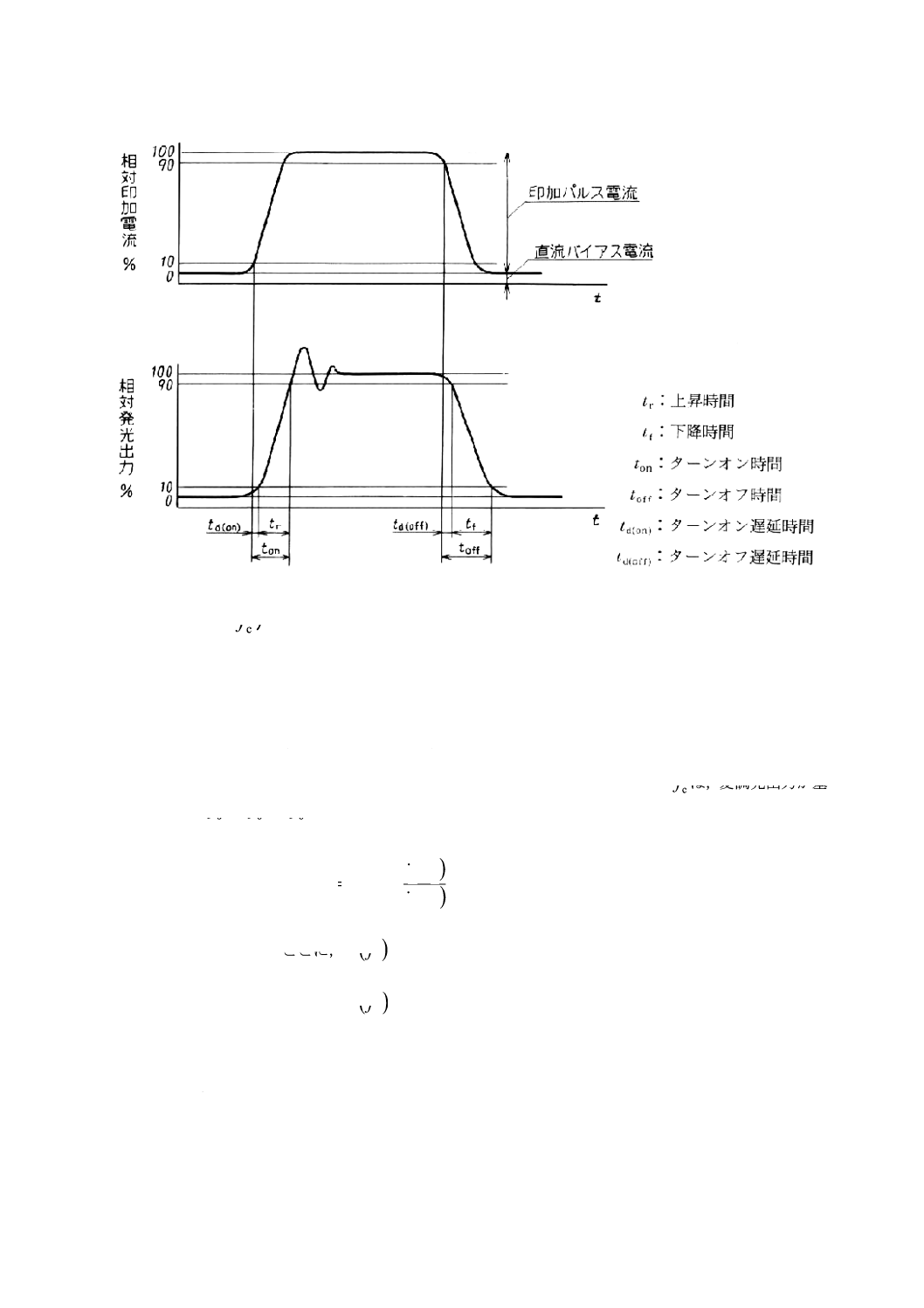
18
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図 20 応答時間
6.16 遮断周波数(
cf)
6.16.1 目的 規定された状態での,半導体レーザモジュールの遮断周波数を測定することを目的とする。
6.16.2 測定回路 遮断周波数fcの測定は,図21に示す回路によって,次の方法で行う。
6.16.3 測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流If又は規定の光ファイバ
端出力Pfを得る順電流Ifを流し,さらに,小信号交流電流を重畳する。半導体レーザモジュールから出力
された光を,受光素子に入射して電気信号に変換し,その交流成分を取り出して選択レベルメータ又はス
ペクトラムアナライザによって変調光に対応した交流電流を測定する。遮断周波数
cfは,変調光出力が基
準とする低周波f0( f0 ≦f0/100)重畳よりも3dB低下する周波数として,式(10)によって算出する。
()
()
0
p
c
p
10
log
10
3
f
i
f
i
dB=
−
....................(10)
ここに,()
c
pf
i
:遮断周波数fcのときの交流電流
()
0
pf
i
:基準周波数f0のときの交流電流
6.16.4 測定上の注意 受光素子については半導体レーザモジュールよりも十分高い遮断周波数をもつも
のを使用し,ケーブルなどを含めた受光系の周波数特性を校正する。
また,レーザ駆動回路又は受光素子周辺回路の特性が,測定結果に影響する場合があるので,必要に応
じ,測定回路などを明示することが望ましい。さらに,交流信号源出力の周波数変動は十分小さいものを
用いる。

19
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.16.5 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
図 21 遮断周波数測定回路
6.17 相対強度雑音(RIN)
6.17.1 目的 規定された状態での,半導体レーザモジュールの相対強度雑音を測定することを目的とする。
6.17.2 測定回路 相対強度雑音RIN(Relative Intensity Noise)の測定は,図22に示す回路によって,次の方
法で行う。
6.17.3 測定方法 半導体レーザモジュールのレーザ素子端子間に規定の順電流If又は規定の光ファイバ
端出力Pfを得る順電流Ifを流し,規定のノイズ中心周波数fn及びノイズ帯域 Δfw での電力Ntを測定器(パ
ワーメータなど)で測定するとともに,このとき受光素子に流れる直流逆電流Irを同時に測定する。
次に,測定系の雑音を算出するために,半導体レーザモジュールをランダムな雑音を発生すると考えら
れる十分広いスペクトル半値幅をもつ非干渉性光源(例えば,平面発光形ダイオードなど)に置き換え,
測定した受光素子の逆電流Irと同じ値が得られるように光源の出力を調整する。この状態で測定器によっ
て電力Ndを測定し,式(11)によって相対強度雑音RINを算出し,これを半導体レーザモジュールの雑音
とする。
(
)
(
)
2
r
n
L
d
t
I
f
G
R
N
N
RIN
−
=
∆
(dB/Hz)...........(11)
ここに,
L
R :負荷抵抗
G:増幅器の利得
nf
∆ :フィルタの帯域
6.17.4 測定上の注意 増幅器には,必要な帯域で十分平たんな周波数特性をもつものを使用する。
また,測定系の雑音は,可能な限り低雑音とし,測定系から半導体レーザへの戻り光量を十分小さく抑
えるように注意する。
なお,反射光又は測定系の雑音などが測定結果に影響する場合があるので,必要に応じ測定条件又は測
定回路を明示することが望ましい。
6.17.5 個別仕様書に規定すべき項目

20
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
図 22 相対強度雑音(RIN)の測定回路
6.18 高調波ひずみ
アナログ光伝送用半導体モジュールの高調波ひずみ測定には,CATVシステム(Cable Television System)
のような多チャンネルシステムで使われる複合2次ひずみ(CSO)及び 複合3次ひずみ(CTB)測定と,
2チャンネルの変調信号による2次相互変調ひずみ(IMD2), 3次相互変調ひずみ(IMD3)測定がある。
6.18.1 複合2次ひずみ(CSO),複合3次ひずみ(CTB)
a) 目的 規定された状態での,半導体レーザモジュールの複合2次ひずみ(CSO),複合3次ひずみ(CTB)
を測定することを目的とする。
b) 測定回路 複合2次ひずみ(CSO),複合3次ひずみ(CTB)の測定は,図23に示す回路によって,
次の方法で行う。
c) 測定方法 半導体レーザモジュールのレーザ素子端子間に電源P1により規定の順電流If又は規定の光
ファイバ端出力Pfを得る順電流Ifを流し,さらに規定の振幅の正弦波信号S1..SN(周波数f1..fN)を重
畳する。信号の数Nは,10以上が望ましい。正弦波信号S1..SNの振幅は半導体レーザの変調光のパワ
ーが同じ値Psになるように調整する。半導体レーザから放出された光を受光素子に入射し,電気信号
に変換する。この電気信号を着目する周波数の近傍のみを透過するバンドパスフィルタを通してスペ
クトラムアナライザにより記録する。各信号周波数f1..fNごとにアッテネータで変調する電気信号のパ
ワーを変化させながら,そのパワーと変調された光のパワーを切り替えスイッチSWで切り変えて測
定する。
図24に示すように,複合2次ひずみ(CSO)は周波数周波数2fi,fi±fj,複合3次ひずみ(CTB)
は3fi,2fi±fj, fi±fj±fkに発生する。
d) 測定上の注意 受光素子については,半導体レーザモジュールのひずみよりも十分小さいひずみの素

21
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
子を用いる。また,受光素子などから半導体レーザモジュールへの戻り光量は,十分小さく抑えるよ
う注意する。受光素子及びスペクトラムアナライザは,測定する高調波の周波数よりも十分広い帯域
幅をもつものとする。スペクトラムアナライザの代わりに,選択レベルメータなどを用いてもよい。
A
S1…SNのパワーモニタ用ライン(スイッチ切り替え)
E1
E2
供試半導体レーザ
S1…SN :正弦波信号源
E1: レーザバイアス用直流電源
E2: ディテクタ逆バイアス用直流電源
C1,C2 : 結合用コンデンサ
RL1 : インピーダンス整合用抵抗
RL2:負荷抵抗
信号用ディテクタ
図 23 複合2次ひずみ(CSO),複合3次ひずみ(CTB)ひずみ測定回路
パ
ワ
ー
図 24 複合2次ひずみ(CSO),複合3次ひずみ(CTB)ひずみ測定
6.18.2 2次相互変調ひずみ(IMD2) , 3次相互変調ひずみ(IMD3)
a) 目的 規定された状態での,半導体レーザモジュールの2次相互変調ひずみ(IMD2) , 3次相互変
調ひずみ(IMD3)を測定することを目的とする。
b) 測定回路 2次相互変調ひずみ(IMD2) , 3次相互変調ひずみ(IMD3)の測定は,図25に示す回路
22
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
によって,次の方法で行う。
c) 測定方法 半導体レーザモジュールのレーザ素子端子間に電源P1により規定の順電流If又は規定の光
ファイバ端出力Pfを得る順電流Ifを流し,さらに規定の振幅の正弦波信号S1,S2(周波数f1,f2)を重
畳する。正弦波信号S1..SNの振幅は半導体レーザの変調光のパワーPsが同じになるように調整する。
半導体レーザから放出された光を受光素子に入射し,電気信号に変換する。アッテネータで変調する
電気信号のパワーを変化させながら,そのパワーと,変調された光のパワーを切り替えスイッチSW
で切り変えてスペクトラムアナライザにより記録する。図26に示すように,2次相互変調ひずみ
(IMD2)は周波数周波数f1+f2,f2−f1に発生するIM2信号のパワーとPsの比,3次相互変調ひずみ
(IMD3)は2f1−f2,2f2−f1に発生するIM3信号とPsの比をdBで表わす。図27は変調パワーとPs,
IM2,IM3,IMD2,IMD3の関係を示すグラフである。
d) 測定上の注意 受光素子については,半導体レーザモジュールのひずみよりも十分小さいひずみの素
子を用いる。また,受光素子などから半導体レーザモジュールへの戻り光量は,十分小さく抑えるよ
う注意する。受光素子及びスペクトラムアナライザは,測定する高調波の周波数よりも十分広い帯域
幅をもつものとする。スペクトラムアナライザの代わりに,選択レベルメータなどを用いてもよい。
e) 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
3) 半導体レーザモジュールと受光素子との間の光減衰退量及びその方法
4) ファイバ長又はファイバ総分散
5) 入力負荷抵抗
6) 変調度
7) チャンネル数及びチャンネル配置
8) フィルタのバンド幅

23
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
A
S1,S2 :正弦波信号源
E1: レーザバイアス用直流電源
E2: ディテクタ逆バイアス用直流電源
C1,C2 : 結合用コンデンサ
RL1 : インピーダンス整合用抵抗
RL2:負荷抵抗
供試半導体レーザ
信号用ディテクタ
E1
E2
S1…SNのパワーモニタ用ライン(スイッチ切り替え)
図 25 2次相互変調ひずみ(IMD2),3次相互変調ひずみ(IMD3)の測定回路
パワー
図 26 2次相互変調ひずみ(IMD2),3次相互変調ひずみ(IMD3)の測定
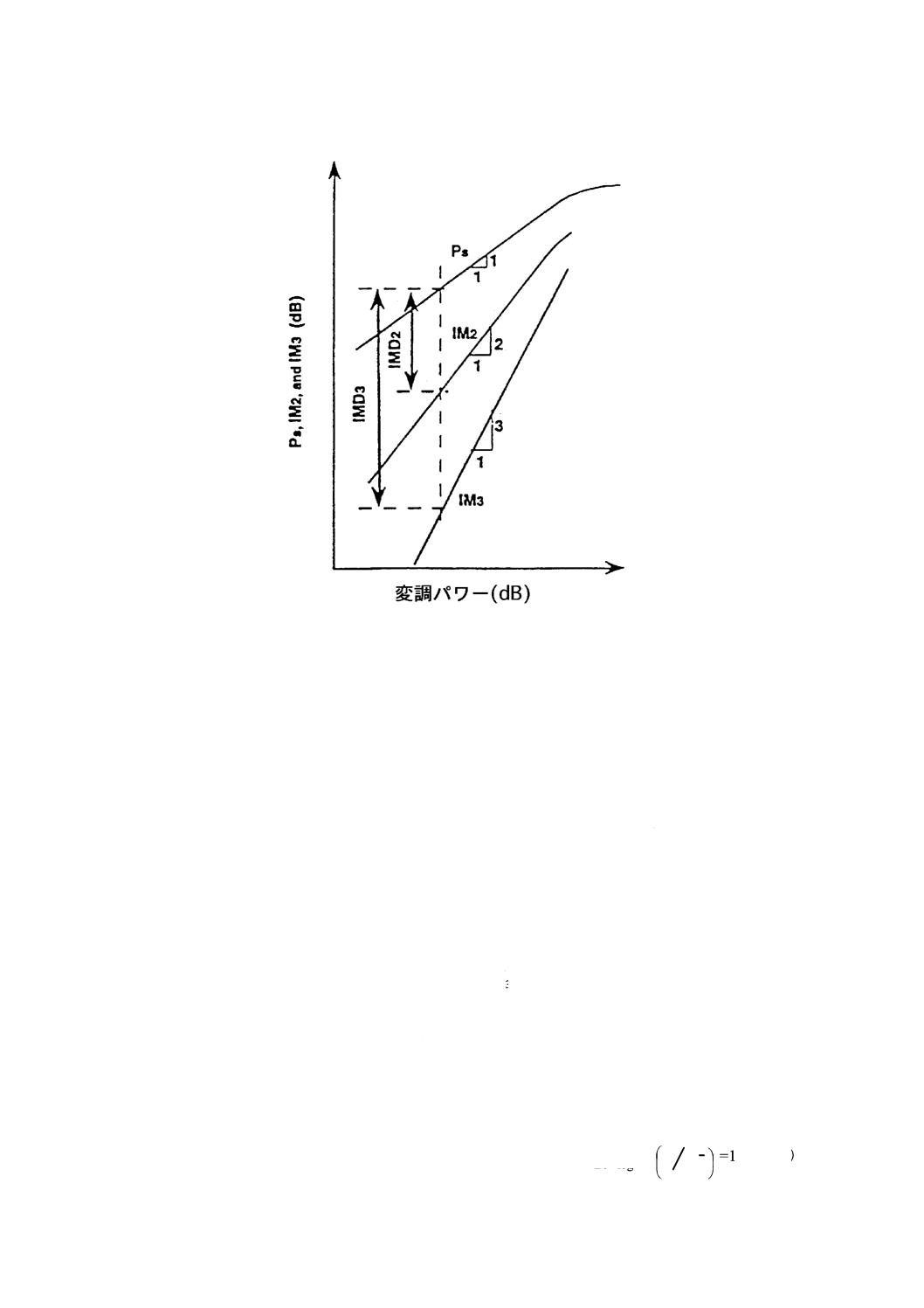
24
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図 27 2次相互変調ひずみ(IMD2),3次相互変調ひずみ(IMD3)の測定
6.19 信号対雑音強度比(CNR:Carrier to Nose ratio)
6.19.1 目的 規定された状態での,半導体レーザモジュールの信号対雑音強度比を測定することを目的と
する。
6.19.2 測定回路 信号対雑音強度比の測定は,図28に示す回路によって,次の方法で行う。
6.19.3 測定方法 半導体レーザモジュールのレーザ素子端子間に電源P1により規定の順電流If又は規定
の光ファイバ端出力Pfを得る順電流Ifを流し,さらに規定の振幅の正弦波信号S1..SN(周波数f1..fN)を重
畳する。正弦波信号S1..SNの振幅を同じ値になるように調整する。半導体レーザから放出された光を受光
素子に入射し,電気信号に変換する。スペクトラムアナライザにて特定の周波数の信号のパワーをキャリ
アレベルとして記録し,また,この電気信号をバンドパスフィルタを通した後の特定の帯域幅での雑音レ
ベルを記録する。スペクトルアナライザのダイナミックレンジが不足する場合は,バンドパスフィルタの
後に低ノイズ増幅器を挿入してもよい。式(12)によって信号対雑音強度比CNRを算出する。
CNR=C−N+K1+K2+K3
(
) ...........(12)
ここに,C :キャリア信号レベル (dBm)
N:雑音レベル (dBm)
K1:帯域幅変換係数 10log10(1チャンネルの帯域幅/B)
B:スペクトラムアナライザのResolution帯域幅の1.2倍
2
K:正弦波平均電圧計の実効電圧変換係数 20log
10
2
π
1
2
=1.05(dB)

25
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
K3:スペクトラムアナライザのログアンプ補正係数 1.45(dB)
6.19.4 測定上の注意 反射光又は測定系の雑音などが測定結果に影響する場合があるので,必要に応じ測
定条件又は測定回路を明示することが望ましい。
6.19.5 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
3) 負荷抵抗値(RL1,RL2)変調度m
4) 変調度
5) チャンネル数及び変調周波数
6) スペクトラムアナライザの分解能帯域幅
7) 信号帯域幅
8) 半導体レーザモジュールと受光素子との間の光減衰量及びその方法
A
S1…SNのパワーモニタ用ライン(スイッチ切り替え)
供試半導体レーザ
S1…SN :正弦波信号源
E1: レーザバイアス用直流電源
E2: ディテクタ逆バイアス用直流電源
C1,C2 : 結合用コンデンサ
RL1 : インピーダンス整合用抵抗
RL2:負荷抵抗
信号用ディテクタ
E1
E2
図 28 信号対雑音強度比の測定回路
6.20 変調度(m : Moduration index)
6.20.1 目的 規定された状態での,半導体レーザモジュールのアナログ変調時の変調度を測定することを
目的とする。変調度mの定義を式(13)及び図29に示す。
(
)(
)
av
min
max
min
max
i
i
i
i
i
i
m
=
+
−
=
........(13)
ここで,imax:最大信号電流
imin:最小信号電流

26
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
i :信号電流振幅
avi:平均信号電流振幅
図 29 変調度の定義
6.20.2 測定回路 変調度mの測定は図30に示す回路によって行う。
6.20.3 測定方法 半導体レーザモジュールのレーザ素子端子間に電源P1により規定の順電流If又は規定
の光ファイバ端出力Pfを得る順電流Ifを流し,さらに規定の振幅の正弦波信号S1(周波数f1)を重畳する。
半導体レーザから放出された光を受光素子に入射し,電気信号に変換する。受光素子は,直流電源P2によ
り逆バイアスをかける。平均受光電流は電流計によって測定する。受光素子は抵抗RL2により,測定装置
にインピーダンス整合する。信号電流の振幅は,スペクトラムアナライザ又はRFパワーメータにより測
定される変調周波数のうち特定の周波数の信号のパワーPから決定する。変調度は式(14)によって算出
する。
(
)
ph
2
1
L2
w
2
I
R
P
m=
.........(14)
ここで,
wP:受光電力 (W)
L2
R:負荷抵抗 (Ω)
ph
I:平均受光電流 (A)
6.20.4 測定上の注意 受光素子の反射光は-50dBm以下が望ましく,入力パワーレベルは受光素子の線形
入力範囲を越えてはならない。RFパワーPwはスペクトラムアナライザ又はRFパワーメータの最大入力を
越えてはならない。必要に応じ測定条件又は測定回路を明示することが望ましい。
6.20.5 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
3) 半導体レーザモジュールと受光素子との間の光減衰退量及びその方法
4) 変調周波数f

27
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
A
供試半導体レーザ
S1:正弦波信号源
E1: レーザバイアス用直流電源
E2: ディテクタ逆バイアス用直流電源
C1,C2 : 結合用コンデンサ
RL1 : インピーダンス整合用抵抗
RL2:負荷抵抗
信号用ディテクタ
E1
E2
図 30 変調度の測定回路
6.21 トラッキングエラー(Er)
6.21.1 目的 規定された状態での,半導体レーザモジュールのトラッキングエラーを測定することを目的
とする。
6.21.2 測定回路 トラッキングエラーErの測定は,図31に示す回路によって,次の方法で行う。
6.21.3 測定方法 図31に示すように半導体レーザモジュールの光モニタ端子から半導体レーザモジュー
ルの光出力のモニタ信号を得,かつ,その信号によって順電流Ifに負帰還をかけAPC(Automatic Power
Control ; 自動出力制御)を行う。この状態で指定されたケース温度Topを指定された範囲内で温度を変化
させ,トラッキングエラーEr1,Er2,Erをそれぞれ式(15), 式(16), 及び 式(17)によって算出する。
(%)
100
REF
min
REF
r1
×
−
=
P
P
P
E
.............(15)
(%)
100
REF
REF
max
r2
×
−
=
P
P
P
E
............(16)
=
REF
f
10
r
log
10
P
P
MAX
E
(dB) .............(17)
ここに,Pmax:指定されたケース又はサブマウント温度範囲以内での光ファイバ端出力最大値
Pmin :指定されたケース又はサブマウント温度範囲以内での光ファイバ端出力最小値
REF
P
:基準の動作温度(通常は25℃)での光ファイバ端出力

28
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
fP :規定された動作温度範囲内の特定の温度での光ファイバ端出力
6.21.4 測定上の注意 ケース温度を変化させる間に光パワーメータの感度が変化しないように注意する。
温度槽を用いるときは光パワーメータを温度槽の外に置くことが望ましい。また,式(15),式(16), 式(17)
いずれの方法によって測定したかを明記することが望ましい。
6.21.5 個別仕様書に規定すべき項目
1) 動作温度Top
2) 順電流If又は光ファイバ端出力Pf
3) 算出に用いた方法
図 31 トラッキングエラーの測定回路

29
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書1(参考)JISと対応する国際規格との対比表
JIS C 5945:2005 光伝送用半導体レーザモジュール測定方法
IEC62007-2:1999,Semiconductor optoelectronic devices for fibre optic system applications - Part
2 : Measuring methods
(Ⅰ)JISの規定
(Ⅱ)
国際規格番
号
(Ⅲ)国際規格の規定
(Ⅳ)JISと国際規格との技術的差異の項目
ごとの評価及びその内容
表示箇所:本体
表示方法:点線の下線
(Ⅴ)JISと国際規格との技術的差異の理由
及び今後の対策
項目番号
内容
項目
番号
内容
項目ごと
の評価
技術的差異の内容
1999年以降、伝送用光能動部品のIEC規格
がTC47(半導体デバイス)からTC86(光フ
ァイバシステム)への体系移行が行われた。
これに伴い規格体系がTC47の部品ごとの規
格体系からTC86の応用システムごとの規格
体系への再編が進められている。JISでは管
轄がTC47のときから部品ごとに分けて順
次、審議してきた経緯により、審議済みの規
格は、部品ごとの規格としてきている。なお、
IECでは複数の部品が一つの規格となって
おり、引き続き審議検討予定である。いまま
でJISで審議を行ってきた個々の部品を除
き、今後新規に検討を開始するJISについて
は、TC86の規格体系に合わせて整合を図っ
ていく予定である。
1.適用範囲
光伝送用半導体レーザ
モジュールの測定方法
について規定している。
IEC62007-2
1
IEC62007-2は光伝送用半
導体レーザモジュール以
外にも、光ファイバ増幅器
用半導体レーザモジュー
ルやLEDやPIN-FETモジ
ュールなどの光半導体モ
ジュール全般に広く適用
する測定方法としてまと
めてある。
MOD/削
除
IECでは複数の光能動部品に
対する規定となっているため、
光伝送用半導体レーザモジュ
ール以外の記載内容を削除し
た。
削除した製品は別のJISとして制定済み又は
制定予定である。
制定済み:
JIS C 5941(光伝送用半導体レーザ)、JIS C
5951(光伝送用発光ダイオード)、JIS C 991
(光伝送用フォトダイオード)
制定予定:
光ファイバ増幅器用半導体レーザモジュー
ル・pin-FETモジュール・光変調器モジュー
ル・デュプレクサモジュール

30
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2.引用規格
JIS C 0617
JIS C 1102-1
JIS C 5944
IEC62007-2
2
IEC規格には引用規格は
無いと記述されている。
MOD/追
加
IEC規格では,図記号や計器に
ついては触れていないが,JIS
では本規格の補充を行ってい
る。
JISでは本規格の補充を行っており,提案を
図る。
3.定義
本規格で用いる用語の
定義について規定して
いる。
−
−
−
(IECには規定なし)
MOD/追
加
用語の定義がJISC5944(光伝
送用半導体レーザモジュール
通則)に記載してあることを追
加。
JISでは本規格の補充を行っており,提案を
図る。
4.測定の状
態
測定状態(標準状態,基
準状態,判定状態)につ
いて規定している。
−
−
−
MOD/追
加
測定状態を追加。
本規格の対象であるレーザモジュールで通
常広く行われているため追加する。
(IEC60749 Chapter 1, Section 4の項を変更
して設定)。IECへ提案を図る。
5.測定用機
器,装置,図
記号及び単
位
測定に使用する電源や
その他の測定器及び参
照している図記号,単位
についての注意事項に
ついて記載している。
−
−
−
MOD/追
加
測定用機器の精度,装置及び図
記号の参照規格を追加。
本規格の対照であるレーザモジュールで一
般的に配慮されているため追加する。
(IEC60749 Chapter 7, Section 1.2.1の項を
変更して設定)。IECへ提案を図る。
6.測定方法
6.1順電流
IEC62007-2
3.1
順電流/光ファイバ端出
力測定
IDT
−
6.2順電圧
MOD/追
加
順電圧を追加
国内外で広く一般的に使用されており,商習
慣上必要。IECへ提案する。
6.3逆電圧
MOD/追
加
逆電圧を追加
6.4光ファイバ端出力
3.1
順電流/光ファイバ端出
力測定
IDT
−
6.5しきい値電流
3.4
しきい値電流測定
IDT
−
6.6しきい値光出力
MOD/追
加
しきい値光出力を追加
国内外で広く一般的に使用されており,商習
慣上必要。IECへ提案する。
6.7スロープ効率
3.16
微分量子効率測定
IDT
−
6.8縦モード間隔及び縦
モード数
MOD/追
加
縦モード間隔を追加
6.9ピーク発振波長
3.13
中心発振波長測定
MOD/追
加
ピーク発振波長を追加
6.10中心波長,スペクト
ル幅,スペクトル半値幅
IDT
−
6.11変調時スペクトル
MOD/追
加
変調時スペクトルを追加
国内外で広く一般的に使用されており,商習
慣上必要。IECへ提案する。

31
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
6.12 波長チャープ
MOD/追
加
波長チャープを追加。
6.13 サイドモード抑圧
比
MOD/追
加
サイドモード抑圧比を追加。
6.14スペクトル線幅
3.10
スペクトル線幅測定
IDT
−
6.15上昇時間,下降時
間,ターンオン時間,タ
ーンオフ時間,ターンオ
ン遅延時間,ターンオフ
遅延時間
3.6
立ち上がり,立ち下がり時
間測定
6.16遮断周波数
3.3
小信号変調帯域幅(遮断周
波数)測定
IDT
6.17相対強度雑音
3.5
相対強度雑音測定
IDT
−
6.18高調波ひずみ
6.18.1 複合2次,3次ひ
ずみ測定
3.14
複合2次,3次ひずみ測定
IDT
−
6.18.2 2次,3次相互変
調ひずみ測定
3.15
2次,3次相互変調ひずみ
測定
IDT
−
6.19信号対雑音強度比
3.7
信号対雑音強度比(CNR)
測定
MOD/削
除
パワーメータによるCNR測定
を削除。
−
スペクトラムアナライザによる方法が一般
的なため。
3.18
アナログ用信号対雑音強
度比(CNR)測定
IDT
6.20変調度
3.19
変調度測定
IDT
−
6.21トラッキングエラ
ー
トラッキングエラー測定
IDT
−
3.2
3.8
3.11
3.12
3.17
4.1
4.2
4.3
4.4
4.5
IEC規格では,光伝送用半
導体レーザモジュール以
外にも、LED、 pin-FET
モジュールなどの光能動
部品に適用する測定方法
も規定されている。
MOD/削
除
光伝送用半導体レーザモジュ
ール以外の記載内容を削除。
削除した部分は別のJISとして制定済み又は
制定予定である。
制定済み:
JIS C 5941(光伝送用半導体レーザ)、JIS C
5951(光伝送用発光ダイオード)、JIS C 5991
(光伝送用フォトダイオード)
制定予定:
光ファイバ増幅器用半導体レーザモジュー

32
C 5945:2005
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
4.6
4.7
4.8
4.9
4.10
4.11
ル・pin-FETモジュール・光変調器モジュー
ル・デュプレクサモジュール
JISと国際規格との対応の程度の全体評価:MOD
備考1. 項目ごとの評価欄の記号の意味は,次のとおりである。
― IDT……………… 技術的差異がない。
― MOD/削除……… 国際規格の規定項目又は規定内容を削除している。
― MOD/追加……… 国際規格にない規定項目又は規定内容を追加している。
― MOD/変更……… 国際規格の規定内容を変更している。
― MOD/選択……… 国際規格の規定内容と別の選択肢がある。
― NEQ…………… 技術的差異があり,かつ,それがはっきりと識別され説明されていない。
2.
JISと国際規格との対応の程度の全体評価欄の記号の意味は,次のとおりである。
― IDT……………… 国際規格と一致している。
― MOD…………… 国際規格を修正している。
― NEQ…………… 技術的内容及び構成において,国際規格と同等でない。