Z 4721 : 2000
(1)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
まえがき
この規格は,工業標準化法第12条第1項の規定に基づき,社団法人日本画像医療システム工業会 (JIRA)
/財団法人日本規格協会 (JSA) から工業標準原案を具して日本工業規格を制定すべきとの申し出があり,
日本工業標準調査会の審議を経て,通商産業大臣及び厚生大臣が制定した日本工業規格である。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
Z 4721 : 2000
医用X線イメージインテンシファイア
Medical X-ray image intensifiers
序文 この規格は,1.適用範囲の備考に示す対応国際規格を元に技術的内容を変更することなく作成した
日本工業規格であるが,対応国際規格には規定されていない種類及び解像度の項目を追加している。
1. 適用範囲 この規格は,JIS Z 4701に規定する医用X線装置の映像装置として使用するX線イメージ
インテンシファイアの特性及びその測定方法について規定する。ここに規定する以外の事項については,
JIS Z 4701の規定を適用する。
備考 この規格の対応国際規格を,次に示す。
IEC 61262-1 : 1994 Characteristics of electro-optical X-ray image intensifiers−Part 1 :
Determination of the entrance field size
IEC 61262-2 : 1994 Characteristics of electro-optical X-ray image intensifiers−Part 2 :
Determination of the conversion factor
IEC 61262-3 : 1994 Characteristics of electro-optical X-ray image intensifiers−Part 3 :
Determination of the luminance distribution and luminance non-uniformity
IEC 61262-4 : 1994 Characteristics of electro-optical X-ray image intensifiers−Part 4 :
Determination of the image distortion
IEC 61262-5 : 1994 Characteristics of electro-optical X-ray image intensifiers−Part 5 :
Determination of the detective quantum efficiency
IEC 61262-6 : 1994 Characteristics of electro-optical X-ray image intensifiers−Part 6 :
Determination of the contrast ratio and veiling glare index
IEC 61262-7 : 1995 Characteristics of electro-optical X-ray image intensifiers−Part 7 :
Determination of the modulation transfer function
2. 引用規格 次に掲げる規格は,この規格に引用されることによって,この規格の規定の1部を構成す
る。これらの引用規格は,その最新版を適用する。
JIS C 7614 照明の場における輝度測定方法
JIS H 4000 アルミニウム及びアルミニウム合金の板及び条
JIS T 0601-1 医用電気機器 第1部:安全に関する一般的要求事項
JIS Z 4005 医用放射線用語
JIS Z 4701 医用X線装置通則
JIS Z 4916 X線用解像力テストチャート
2
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
3. 定義 この規格で用いる主な用語の定義は,JIS Z 4005及びJIS Z 4701によるほか,次による。
a) X線イメージインテンシファイア X線パターンを増幅するために,エネルギーを更に加えることに
よって,対応する光学像に変換する器具(I. I. 又はXRIIと略し,ここではI. I. という。)。
備考1. この規格では,電子光学式真空管を組み込んだX線イメージインテンシファイアをいう。
2. この規格を適用するI. I. は,X線イメージインテンシファイア管,管容器及び/又はこれら
の電源部について構成する。
b) X線イメージインテンシファイア管 フォトカソードに光学的に接した入力面をもつ電子光学式真空
管。
この中で電子パターンが形成され,信号増倍のためのエネルギーを加えた後,出力面で光学像に変
換される(以下,I. I. 管という。)。
c) 可変視野形X線イメージインテンシファイア 線源,入射面位置及び入力面位置を一定にしたまま,
I. I. 管の電子光学的手段によって二つ以上の入射面視野寸法を得ることができるI. I. (以下,可変視
野形I. I. という。)。
d) X線イメージインテンシファイア管用管容器 I. I. 管を収容する容器(以下,管容器という。)。
管容器は,防電撃形とし,5.2に規定するX線遮へいを施す。
e) I. I. 管用電源部 I. I. 管の各電極へ電圧を供給する回路,及びI. I. 管に組み込む真空ポンプを動作さ
せる回路など(以下,電源部という。)。
f)
光学系 I. I. の出力像を伝送する装置。
g) 入射面 I. I. の中心軸に垂直であり,放射線源の方向に最も突き出している部分に接する面(図2参
照)。
h) 線源入射面間距離 X線管の焦点とI. I. の入射面間の距離(以下,SEDと略)。
備考 SEDは,SOURCE TO ENTRANCE PLANE DISTANCEの略。
i)
入射面視野寸法 規定の条件下で,X線パターンを写すことができる入射面の直径(7.2参照)。
j)
有効入射面視野寸法 指定されたSEDにおけるI. I. の入射面で測定される入射面視野寸法。
k) 入射面有効面積 入射面上でI. I. の中心軸の周りで有効入射面視野寸法を直径とする円の面積。
l)
公称入射面視野寸法 平行な電離放射ビームを用いたとき得られる入射面視野寸法。
m) 入力面 受像面を形成する層。
n) 入力面寸法 X線パターンを蛍光像に変換するために使用する入力面の有効直径。
o) 出力面 電子パターンが光学像に変換される層。
p) 出力像 出力面に描出される光学像。
q) 出力像寸法 入力面上の像が出力面上に結像されるとき,入力面寸法に対応する出力面上の寸法。
r) 入射野 I. I. に対して指定された条件のもとでX線パターンの伝達に使用される入射面内の領域。
s)
出力像の中心 出力像を囲っている最も小さい円の中心。
t)
入射野の中心 出力像の中心で像を形成している入射面内の点。
u) 中心軸 入射野の中心を通る入射面に垂直な線。
v) 中心拡大率 I. I. の特性として中心軸について対称な入射面上に置かれた小物体の実際の長さに対す
る出力像におけるその長さの比。
w) 変換係数 入射野の中心での空気カーマ率に対する出力像の中心での輝度の比。
x) 輝度分布 規定の条件下で,出力像の全域にわたる輝度の空間的変化(7.4参照)。
y) 輝度不均一度 規定された条件の下での出力像の中心と周辺近くの輝度の違い。出力像の中心輝度の
3
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
パーセントで表現する。
z) 蛍光像 蛍光面上の発光によって形成される像。
aa) 電子パターン 入力面及び出力面に像形成させる電子の密度の差。
ab) 陽極電圧 I. I. 管の陽極に加える電圧。通常,陽極と大地間の電位差。
ac) 集束電極電圧 I. I. 管の集束電極に加える電圧。通常,集束電極と大地間の電位差。
ad) 拡大率 入力面寸法に対する出力像寸法の比(図3参照)。
入力面寸法をd1,出力像寸法をd0とすると拡大率Mは,次の式で定義する。
1
0
d
d
M=
ae) 入力面位置 入力面の円形有効範囲の外周を含む平面と入射面との距離。
af) 像ひずみ I. I. の入射面上の実長とその出力面上の影像長さとの比の空間的変化。ag)とaj)との2種
類がある。
ag) 微分像ひずみ I. I. の入射面位置に近い平面上に任意に置いた試験器具についての像ひずみ。
ah) 径方向微分像ひずみ 入射面の任意の位置に径方向に置かれた単位長さの試験器具の像ひずみ。通常,
入射面内に置かれた試験器具の位置の関数である。
ai) 径方向局所的拡大率 入射面に置かれた小さな試験器具の径方向の実際の長さに対する出力像内の長
さの比。通常,入射面内に置かれた試験器具の位置の関数である。
備考 軸から離れた位置での径方向局所的拡大率は,一般に接線方向の局所的拡大率と等しくない。
径方向局所的拡大率は,径方向微分像ひずみを決定する際に使用される。
aj) 積分像ひずみ I. I. の入射面位置に近い平面上の中心軸に対称に置いた種々の長さの試験器具につい
ての像ひずみ。
ak) 積分拡大率 入射面内で,中心軸上に置かれた円形試験器具の,実際の直径に対する出力像内の直径
の比。
al) 公称像寸法 入射面内に置かれた小物体の長さと中心拡大率との積。
am) コントラスト比 規定の条件下で,I. I. の入射面の中央部に鉛円板があるときの出力像の中心輝度に
対する,I. I. の入射面に鉛円板がないときの出力像の中心輝度の比。通常は,10%面積コントラスト
比をいう。
an) 10%面積コントラスト比 コントラスト比を測定する際に,試験器具として入射面有効面積10%に相
当する鉛円板を用いたときのコントラスト比。
ao) 10mm直径コントラスト比 コントラスト比を測定する際に,試験器具として直径10mmの鉛円板を
用いたときのコントラスト比。
ap) ベーリンググレア指数 コントラスト比の逆数
aq) 解像度(図1参照) 入射面の前方に置いた試験器具のパターンのI. I. の光学的出力面の像を光学的
に拡大し,目視して測定したとき,分解して見える限界の線対を表したもの。試験器具には,線対の
パターンがX線に対して透過と非透過が同一幅で交互に形成されているものを用いる。

4
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図1 解像度の測定位置の定義(I. I. の光学的出力面の像)
ar) 中心解像度 I. I. の有効視野の中心部の解像度。
as) 周辺解像度 I. I. の有効視野の周辺部分の解像度。周辺の位置は,試験器具を通る同心円直径の入射
面視野寸法に対する比率を百分率 (%) で示す。通常は,90%の位置をいう。
at) 径方向解像度 周辺解像度で,I. I. 視野の任意の径方向の解像度。
au) 接線方向解像度 周辺解像度で,I. I. 視野の任意の接線方向の解像度。
av) 光学的出力面 I. I. の出力像を含む光学的な見掛け上の面。光学系の一次レンズの物体面として取り
扱われる面。
aw) 量子検出効率 放射線検出器の出力のSN比の二乗と放射線検出器の入力のSN比の二乗の比(以下,
DQEという。)。
備考 DQEは,DETECTIVE QUANTUM EFFICIENCYの略である。
ax) 入射口径 放射線ビームの断面を決定する口径。
ay) 実効口径 入射口径を通った放射線源によって放射されたI. I. の入射面上の領域。
備考 実効口径は,幾何学的拡大と線源の大きさに依存する。この領域の直径は,常に入射口径の直
径より大きい。
az) 単γ線光子パルス I. I. の入力面に,規定されたエネルギーのγ線が一つ入射したときに出力面で放射
される光量子の数。
ba) 量子吸収効率 放射線検出器に入射される全光量子数のうち放射線検出器の出力信号となりうる光量
子数の割合。
bb) MTF分析器 光学系,ソフトウェアを含み,変調伝達関数(以下,MTFという。)を測定できる装置。
bc) 最適フォーカス 与えられたスリットの方向に対してMTFが最大となるように電圧を調整されたI. I.
の状態。
bd) 低空間周波数での落込み現象 零空間周波数近傍でのMTFの値と零空間周波数でのMTFの値 (1.0)
との差(以下,LFDという。)。
備考 現在のI. I. には,零空間周波数近傍でMTF曲線が急激に落ち込むベーリンググレアが存在す
る。IECではLFDを決定する空間周波数として0.1mm−1を採用している。
4. 種類及び形名
4.1
種類 I. I. の種類は,次による。
a) 単一視野形I. I.
b) 可変視野形I. I.

5
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
4.2
形名 I. I. の形名は,公称入射面視野寸法によって区別するものとし,標準となる形名は,次によ
る。
a) 単一視野形I. I. 10形,15形,17形,23形,30形,31形,36形,40形
b) 可変視野形I. I. 10/5形,15/12形,17/12形,23/15形,23/17/12形,23/19/15/11形,30/23形,30/23/18
形,30/23/19/15形,31/23/15形,31/23/15/11形,36/23/17形,40/30/23形,40/30/23/19形,40/31/23/17
形,23/12Z形,31/15Z形
備考1. 形名の数値は,公称入射面視野寸法をセンチメートル (cm) 単位で表した無名数。
2. 形名の“/”は,公称入射面視野寸法の切換えを示す。
3. 形名の“/” “Z”は,二つの公称入射面視野寸法間の連続可変切換(ズーミング)を示す。
5. 性能
5.1
環境条件 I. I. は,表1に示す環境条件で,その性能及び安全性が維持できなければならない。
表1 環境条件
輸送及び保管環境条件
使用環境条件
周囲温度 ℃
−15〜45
10〜40
相対湿度 %
10〜100
30〜75
気圧 hPa
500〜1 060
700〜1 060
備考
こん(梱)包した状態で15
週間以内は,上記条件に耐え
なければならない。
15週間を超える長期の保管
には,上記条件を適用する。
備考 IEC 60601では,輸送及び保管環境条件の周囲温度が−40〜70℃で
あることが規定されており,この条件を満たさないときは,満たす
条件を表記することを義務づけている。このため,表1の条件だけ
を満たす場合は,この条件を表記しなければならない。
5.2
X線遮へい JIS Z 4701による。
6. 構造 構造は,次による。
a) I. I. 管が破損したとき,その破片が飛散しないような構造とする。
b) I. I. は,電気的・磁気的誘導の影響をできるだけ少なくする構造とする。
7. 特性の測定方法
7.1
測定方法一般 測定は,JIS Z 4701の試験の規定によって行い,I. I. は,確実に接地しておかなけれ
ばならない。
7.2
入射面視野寸法
7.2.1
入射面視野寸法測定用の試験器具
a) 試験器具は,I. I. の入射野を十分覆うことができ,目盛はX線を十分吸収する材料でなければならな
い。また,その最小目盛は2mmを超えてはならない。
b) 試験器具は,入射野における中心出しが容易にできるように,二つの直交する目盛がなければならな
い。
c) 試験器具は,入射面に接するように置かなければならない。
7.2.2
入射面視野寸法の測定(図2参照) 入射面視野寸法の測定は,次による。
a) I. I. の動作条件,例えば,陽極電圧,集束電極電圧及び出力像寸法を附属文書に規定する方法によっ

6
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
て調整する。可変視野形I. I. の場合,各入射野で測定する。
b) X線管装置の基準軸が,I. I. の入射面に垂直であり,かつ,線源(焦点)がI. I. の中心軸上にあるよ
うにX線管装置を配置する。SEDは1 000±10mmとする。公称入射面視野寸法を決定するためには,
1 000mmとは異なるSEDでの追加測定が必要である。通常,約500mmのSEDが推奨される。
c) I. I. の入射面上に試験器具を平行かつ密着した平面上(入射面より10mmを超えてはならない。)に置
かなければならない。また,試験器具の中心は中心軸上になければならない。
d) I. I. の出力面で光学的な手段で,この試験器具の最大像寸法を測定する。
7.2.3
入射面視野寸法の計算(図2参照) 有効入射面視野寸法は,測定によって直接決定できる。一方,
公称入射面視野寸法は,二つの異なるSEDのデータから,次の式で算出する。
(
)
(
)(
)
2
1
2
1
3
d
B
d
A
B
A
d
D
d
×
−
×
−
×
×
=
ここに,
d1=SEDがBのときの(φʼ/2に対応する)入射面視野寸法
d2=SEDがAのときの(φ/2に対応する)入射面視野寸法
d3=I. I. の公称入射面視野寸法
図2 入射面視野寸法の測定
7.2.4
入射面視野寸法の表示 有効入射面視野寸法は,ミリメートル (mm) 単位で示す。可変視野形I. I.
の場合は,各視野における有効入射面視野寸法を表記する。ただし,線源(焦点)と入射面までの距離が
7.2.2b)と異なる場合は,この距離を明記して入射面視野寸法を表示しなければならない。
備考1. 入力面の線源(焦点)側にX線ビームを妨害する部品が存在する管容器の場合には,その部
品の開口径を公称入射面視野寸法とする。
2. 可変視野形I. I. については,各入力面寸法に対する入射面視野寸法は,最大入力面寸法に対
応する出力像と同じ範囲に結像される入射面上の円形領域の直径とする。
7.3
変換係数(図3参照)

7
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
7.3.1
一般条件 測定は,I. I. の動作条件,例えば,陽極電圧,集束電極電圧及び出力像寸法を附属文書
に規定する方法によって調節する。輝度の測定は,JIS C 7614による。散乱線除去グリッド及び保護カバ
ーは取り除く。可変視野形I. I. の場合には,最も大きい入射野において測定しなければならない。他の入
射野での測定は任意で行う。
7.3.2
X線ビーム X線ビームは,次による。
a) X線管装置の基準軸が,I. I. の入射面に垂直であり,かつ,線源(焦点)がI. I. の中心軸上にあるよ
うにX線管装置を配置する。
b) SEDは,1 000±10mmとする。
c) X線ビームの総ろ過は,表2による。付加ろ過板が必要な場合には,線源(焦点)から330mm以内
に置く。
d) X線ビームの広がりは,線源(焦点)から1 000mmの距離において入射面有効面積を十分に覆わなけ
ればならないが,その領域は,入射野領域の10%を超えないようX線絞りを,X線管と付加ろ過板と
の間に挿入する。また,X線絞りとは別に,入射面に密着してX線遮へい板を置き,これを透過する
X線が,平均輝度を1%以上増加することがないようにする。
e) 入射面の中心における入射X線は,半価層7±0.2mmAlの線質とする。この線質は,表2に示す総ろ
過と管電圧との組合せによって得られる。ただし,ここに示した管電圧は,概略値である。
管電圧のリプル百分率は,10%以下とする。
表2 入射X線の線質を得る条件
半価層
線源と入射面間の総ろ過
管電圧
7±0.2mmAl
22±0.5mmAl
75kV
半価層を測定する基準材料及び付加ろ過板には,JIS H 4000に規定する合金番号1100のアルミニウム板
を使用する。
f)
空気カーマ率の測定及び輝度の測定には時間差があるので,X線管の出力を,例えば,フォトダイオ
ードを使った蛍光体などの放射線検出器などでモニタし,測定結果をこの精度に合うように補正しな
ければならない。モニタする場合は,次に注意する。
1) 放射線検出器は,±3%のX線変動を検出できなければならない。
2) 放射線検出器をX線ビーム内に置く場合,入射面から50cm以上,離さなければならない。また,
入射野内にあってはならない。さらに,付加フィルタが用いられている場合は,放射線検出器は付
加フィルタと入射面の間に置かれなければならない。
3) 放射線検出器は,測定が終了するまでは取り外すなど,その相対位置関係を崩してはならない。
g) 入射する線量については,次の注意が必要である。
1) 入射面での空気カーマ率は,測定に用いる検出器の線形動作が保証されなければならない。空気カ
ーマ率は,1μGy/sから100μGy/sが推奨される。
2) 入射野内の任意位置での空気カーマ率は,入射野内での空気カーマ率の最高値の70%以下になって
はならない。
7.3.3
照射線量率(空気カーマ率)の測定 照射線量率の測定は,次による。
a) 照射線量率測定器は,入射面視野寸法の40%以下の直径をもつ面積内の照射線量率の算術平均が測定
できなければならない。また,その面積内の空気カーマ率の感度公差は,3%以内でなければならない。
さらに,測定誤差は,±5%以内でなければならない。
b) 照射線量率は,照射線量測定器の中心をI. I. の入射面上に置き,かつ,I. I. の中心軸上に配置して測

8
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
定する。このとき,I. I. は除去しておく。
c) 照射線量率の測定値は,温度によって変化するため,測定は,通常の室温(すなわち,23±3℃)で行
う。また,測定値が気圧に依存する場合は,補正する。
7.3.4
変換係数の輝度の測定 輝度の測定は,次による。
a) I. I. の出力像の輝度は,明視条件下で人の標準視感度曲線に相当する分光感度をもつ計測器で測定す
る。
b) 測定面積は,入射面の中心部における直径25mmの円の面積に対応する出力面上の面積以上の大きさ
とする。ただし,測定面積の直径 (dx) は,出力像寸法の40%を超えてはならない。また,測定面の
中心は,出力像の中心と一致させ出力面に垂直な方向で測定する。
c) 出力面がランバートの法則に従っている場合には,開口角 (θ1) が60°以下の輝度測定装置Iを用い,
像中心の垂線との角度 (a) は0°で測定する。
d) 出力面がランバートの法則に従っていない場合(1)には,開口角 (θ2) が5℃の輝度測定装置IIを用い,
像中心の垂線との角度 (a) の関数として,出力面輝度の変化を明記することが望ましい。
注(1) ランバートの法則に従わない場合とは,開口角5°の輝度測定装置を使用し,像中心の垂線に関
して0〜30°の範囲で測定した輝度の値が,像中心の垂線の方向での測定値と25%以上異なる場
合をいう。
e) 出力像の発光スペクトルの相違によって変換係数の測定値に差が生じる。したがって,出力像の発光
スペクトルを変換係数とともに曲線又は数字の表で示す。
f)
測定器の精度は,±5%以内でなければならない。
図3 変換係数の測定
7.3.5
変換係数の計算 変換係数Gxは,次の式から求める。
Gx=L/K&
ここで,輝度Lはcd/m2であり,空気カーマ率K&はμGy/sである。また,結果の誤差は±15%を超えて
はいけない。
9
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
備考 1mR/sは空気カーマ率8.7μGy/sに相当する。
7.3.6
変換係数の表示 最大視野における変換係数をcd m−2/μGy s−1の単位で示す。可変視野形I. I. に
おける他の視野での変換係数の表示は任意とする。また,出力像の相対的な発光スペクトルを曲線又は表
で示す。
7.4
輝度分布及び輝度不均一度(図4参照)
7.4.1
一般条件 7.3.1を適用する。
7.4.2
X線ビーム 7.3.2を適用する。
a) X線管装置の基準軸に垂直な入射面視野の直径に沿って照射線量率を測定する。
7.4.3
X線ビーム不均一性の補正 X線ビームの不均一性は,次によって補正する。
a) 照射線量率測定器は,±2%の相対的変化が測定できなければならない。
b) 照射線量率測定器の有効面積は,入射面有効面積の1%,又は直径10mmの面積のどちらか大きい方
の値を超えてはならない。
c) X線ビームの不均一性の測定は,照射線量率測定器の検出面がI. I. の入射面上になければならない。
ただし,このときI. I. は除去しておく。
d) X線ビームの不均一性は,X線管装置の基準軸に垂直な入射面視野の直径に沿って測定する。
e) 不均一性が,2%を超える場合には,出力像の輝度値を補正する。最大照射線量率の20%を超える不均
一性があってはならない。
備考 X線ビームの不均一性は,光電的方法又はノンスクリーンフィルム上のX線像の濃度分布の解
析によって調べることが望ましい。
f)
測定期間を通じて照射線量率の時間的変動の平均値が,±2%を超えるときは,輝度値を適宜に補正す
る。
7.4.4
輝度の測定 輝度の測定は,次による。
a) 輝度測定装置の有効面積は,入射面に換算して7.4.3b)に対応する寸法を超えないものを用いる。
b) 輝度分布は,入射面有効面積の直径に対応する出力像の直径に沿って測定する。
c) 入射面視野寸法の10%に対応する長さ以下の間隔で測定する。
d) 輝度測定装置は,±2%の相対的変化が測定できなければならない。輝度測定装置の開口角は,出力像
の外周を測定するときに誤差のでない程度に十分小さくなければならない。
e) 輝度の測定値は,入射面上の対応する点のX線ビームの不均一性(7.4.3参照)によって補正する。
7.4.5
輝度不均一度の計算 輝度不均一度は,次の式で求める。
Ln=100%×1/4×Σ1|Lc−Li|Lc
ここに,Lcは出力像の中心における輝度,Liは出力像の中心を通り直交する2方向上で入射野の半径90%
の位置における4点の輝度を示す。

10
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図4 輝度分布の測定
7.4.6
輝度分布と輝度不均一度の表示
a) 輝度分布は,出力像の1本以上の直径に沿った長さの関数として,相対輝度を表す曲線か又は数値の
表として示す。測定値は,入射面有効面積の直径の90%を超える範囲にわたって示す。輝度の分布を
一つの径についてだけ示す場合は,出力像の中で最大の輝度変化を示す直径についての値を示す。
b) 輝度不均一度は,7.4.5で計算された値(パーセント)を表記する。
7.5
X線遮へい試験 JIS Z 4701による。
7.6
像ひずみ(図5,図6参照)
7.6.1
一般条件 7.3.1を適用する。
7.6.2
X線ビーム 7.3.2a)〜b)による。
7.6.3
像ひずみ測定用の試験器具 像ひずみ測定用試験器具は,次による(図5参照)
a) 試験器具は,入射面に平行に,かつ,できるだけ接近させて置く。入射面までの距離は,10mm以下
とする。
b) 径方向局所的拡大率の測定のため,試験器具に設けられた目盛は入射野の中心を通らなければならな
い。
c) 試験器具は,中心からの距離が測定でき,X線を吸収する目盛で作られていなければならない。
d) 入射野の中心の決定と径方向局所的拡大率を測定するために,水平方向,垂直方向に等距離の目盛を
使用しなければならない。
e) S字ひずみの影響を受けないように積分拡大率を測定するために,円形の目盛を使用する。
f)
目盛間の距離は,10mmか入射面視野寸法の10%のどちらか小さい方を用いる。
g) 試験器具は,I. I. の中心を通ってそれに対称に置く。試験器具の中心軸からのずれは,公称入射面視
野寸法の2%以下とする。
7.6.4
像ひずみの測定 像ひずみの測定は,次による。
a) 像ひずみ測定のための配置を図6に示す。
b) I. I. の出力面で光学的な手段を用いて試験器具の像寸法を測定する。像寸法は,目盛のついたマイク
ロメータを用いて測定するのがよい。結果の全体の精度は,積分像ひずみの場合で絶対値で2%,径
方向微分像ひずみの場合は,絶対値で3%以下でなければならない。
7.6.5
像ひずみの計算 像ひずみの計算は,次による。
a) 径方向微分像ひずみ (Vd)
c
c
d
d
a
a
a
V
−
=
ここに,
ad= hd/Ld

11
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
ac= hc/Lc
hd: 微分像ひずみ用試験器具の出力像寸法 (mm)
Ld: 微分像ひずみ用試験器具の長さ (mm)
hc: 中心用試験器具の出力像寸法 (mm)
Lc: 中心用試験器具の長さ (mm)
b) 積分像ひずみ (V1)
c
c
i
i
a
a
a
V
−
=
ここに,
ai= hi/Li
ac= hc/Lc
hi: 積分像ひずみ用試験器具の出力像寸法 (mm)
Li: 積分像ひずみ用試験器具の長さ (mm)
hc: 中心用試験器具の出力像寸法 (mm)
Lc: 中心用試験器具の長さ (mm)
図5 像ひずみ測定用試験器具の例
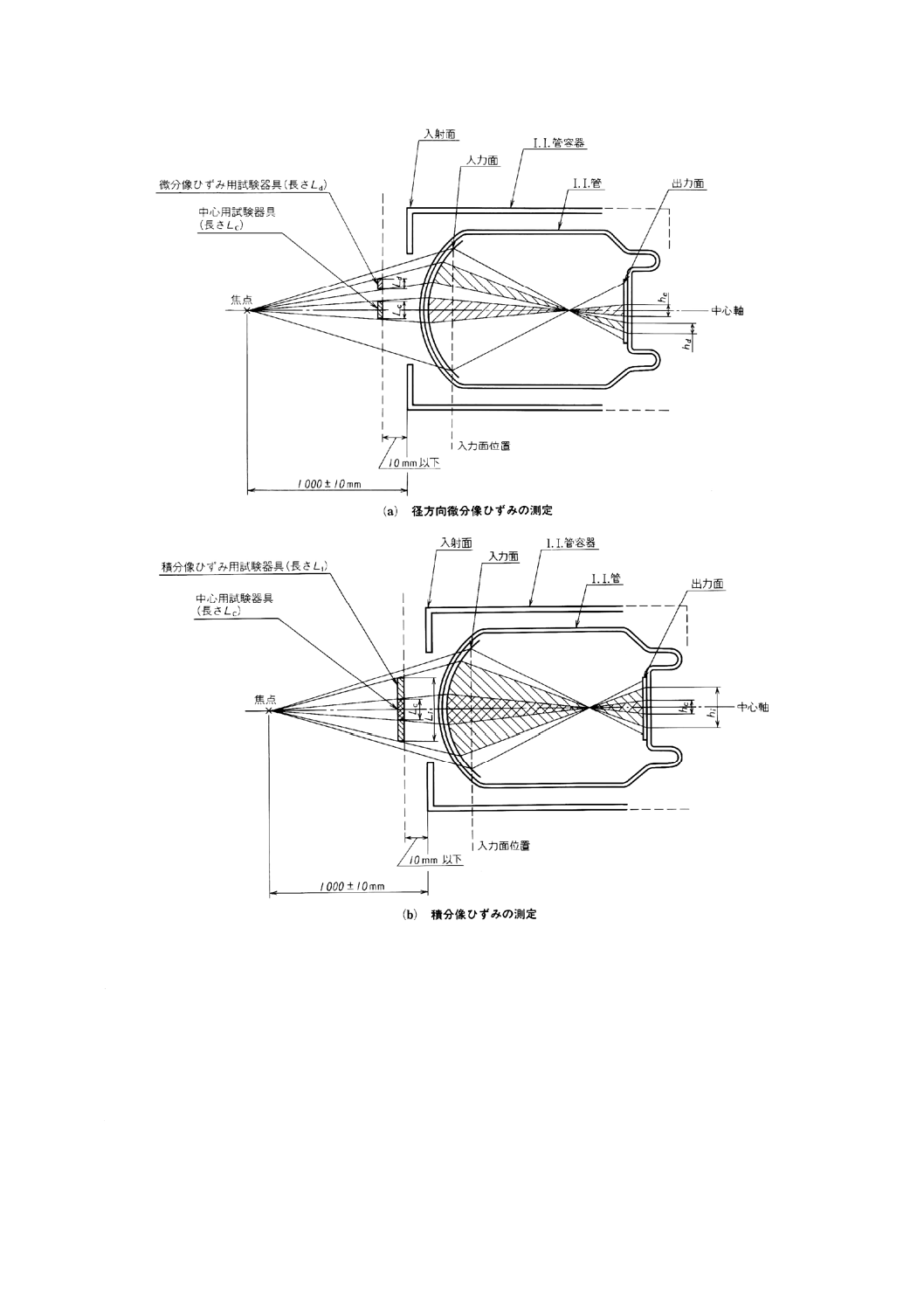
12
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図6 像ひずみの測定
7.6.6
像ひずみの表示 像ひずみは,次による。
a) 像ひずみは,グラフ又は数値表で表す。
b) 径方向微分像ひずみは,入射面全面にわたり一つ以上の直径に沿って,入射面視野寸法の90%を超え
るところまで測定した結果を表示する。可変視野形I. I. の場合は,最大視野の入射面視野寸法につい
て測定した結果を表示する。この値は,入射面における距離の関数(絶対値又は相対値のどちらでも
よい。)として表示する。
c) 積分像ひずみは,任意で示され,一つ以上の直径に沿って,入射面における距離(絶対値又は相対値
のどちらでもよい。)の関数として表示する。
13
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
7.7
コントラスト比及びベーリンググレア指数(図7参照)
7.7.1
一般条件 7.3.1を適用する。
7.7.2
X線ビーム X線ビームは,次による。
a) 7.3.2a),b),d),f)による。
b) 線質は,ピークX線管管電圧50±2kV,つまり,2.0±0.2mmのアルミニウムの半価層による線質でな
ければならない。これは全付加フィルタがアルミニウムで約3mmと等価である。
c) 7.3.2e)で決定される線質を用いてもよい。
7.7.3
コントラスト比測定用の試験器具 コントラスト比測定用試験器具は,次による。
a) 試験器具は,入射面に平行に,かつ,入射面の中心にできる限り接近させて置く。入射面までの距離
は,10mm以下とする。
b) 試験器具の種類 試験器具は円板で,次の1)及び2)の2種類とする。
1) 10%面積コントラスト比用試験器具(鉛板の厚さ3mm以上)
各入射面視野寸法に応じた試験器具を用いる。各入射面視野寸法によって決定された領域の10%
±0.5%の面積をもつような直径でなければならない。
2) 10mm直径コントラスト比用試験器具(鉛板の厚さ3mm以上)
試験器具の直径は10mm±0.5mmでなければならない。
7.7.4
コントラスト比の測定 コントラスト比の測定方法は,次による。
a) 輝度測定装置は,7.3.4の輝度測定装置 (θ≦60°) を用いる。公称像寸法の直径の3分の1の領域内を
測定する。
b) 輝度計の非線形性は,1%を超えてはならない。
c) 輝度計の暗電流による誤差は,最小輝度を測定する場合の1%を超えてはならない。
d) 試験器具は,中心軸上に設置し,中心軸から試験器具の中心が5mm以上離れてはいけない。
e) 出力像の輝度の測定は,出力像の中心で行わなければならない。10mm直径コントラスト比測定用試
験器具を用いた測定では,出力像の中心と輝度計の中心とのずれは0.1mm以内とし,10%面積コント
ラスト比測定用試験器具を用いた測定では,出力像の中心と輝度計の中心とのずれは,1.0mm以内と
しなければならない。
f)
コントラスト比測定用試験器具があるときの,I. I. の光学的出力面での出力像の中心輝度 (LD) を輝
度測定装置を用いて測定する。試験器具を外し,X線強度が±3%以内になったことを確認してから,
同じ部位で試験器具がないときの輝度 (LB) として同様に測定する。
7.7.5
コントラスト比及びベーリンググレア指数の計算 コントラスト比及びベーリンググレア指数の
計算方法は,次による。
CR=LB/LD
VGI=LD/LB
ここに,
CR: コントラスト比
VGI: ベーリンググレア指数
LB: 試験器具のないときの出力像の中心輝度 (cd/m2)
LD: 試験器具のあるときの出力像の中心輝度 (cd/m2)
7.7.6
コントラスト比及びベーリンググレア指数の表示 コントラスト比及びベーリンググレア指数の
表示方法は,次による。
例1. コントラスト比の表示

14
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
10%面積コントラスト比:25
10mm直径コントラスト比:17
(試験器具の直径と線質とを明記する)
例2. ベーリンググレア指数の表示
10%面積ベーリンググレア指数:0.04
10mm直径ベーリンググレア指数:0.06
(試験器具の直径と線質を明記すること)
図7 コントラスト比の測定
7.8
解像度(図8参照)
7.8.1
一般条件 7.3.1を適用する。
7.8.2
X線ビーム X線ビームは,次による。
a) 7.3.2a)〜b)による。
b) X線ビームの広がりは,線源(焦点)から1 000mmの距離において,入射面視野寸法に等しくなるよ
うに,X線絞りを,X線管装置に取り付ける。
c) X線管の焦点の呼びは,0.3以下とする。
d) 測定に用いる管電圧は,40〜50kVとして,X線管とI. I. の間には付加フィルタなしとする。管電流
は,0.3〜1.2mAとする。管電圧のリプル百分率は,10%以下とする。
なお,可変視野形I. I. で拡大視野の場合には,出力面輝度が同程度になるように,照射線量率を調
整する。
7.8.3
試験器具の位置 試験器具は,入射面に平行に置き,入射面までの距離は10mm以下とする。
7.8.4
試験器具の種類 JIS Z 4916に規定するX線用解像力チャートを用いる。ただし,これらのチャー
トでは,パターンのステップが粗すぎる場合には,板厚が鉛当量で50〜100μmPbの細かいパターンのチャ
ートを用いてもよい。
7.8.5 解像度の測定 I. I. の出力面での解像力チャートの像を,光学的に拡大して目視によって測定する。
このとき,解像していると判定するパターンが方向によって値の異なる場合には,低い方の値(2)とする。
注(2) 径方向解像度,接線方向解像度などを指す。
7.8.6
測定部位 中心解像度を1か所,周辺解像度を90°おきに4か所測定する。
7.8.7
解像度の表示 解像度の表示方法は,次による。
a) 解像度を表示する線対の単位,ミリメートル当たりの線対 (Lp/mm) で表す。
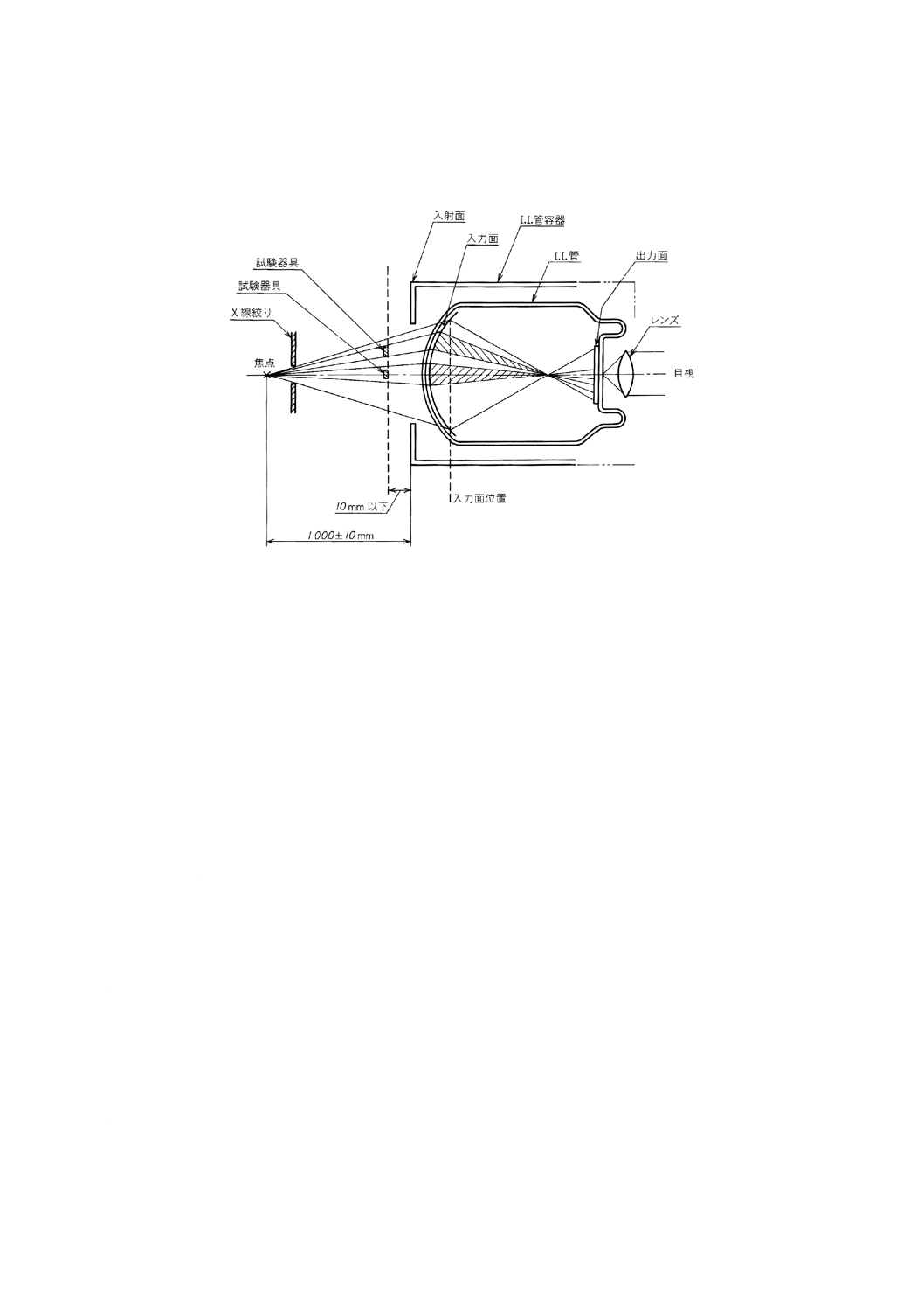
15
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
b) 目視測定値を数値として表示する。
例
中心解像度
4.0Lp/mm
周辺解像度 (90%)
3.2Lp/mm
図8 解像度の測定
7.9
量子検出効率 (DQE)
7.9.1
一般条件 7.3.1を適用する。
7.9.2
入射放射線源
a) 入射放射線源は,59.5keVのγ線を放出する放射線核種241Amとする。
b) 線源の出力は,241Amの崩壊とは異なる量子を含んでいてもよい。例えば,ネプツニウムのL-X線,
線源,その容器を構成するのに用いられる材料からの蛍光X線が挙げられる。
1) 59.5keV以外のエネルギーをもつ量子の放出比は,59.5keVの量子放出比の1%以下にしなければな
らない。0.5mmの銅フィルタを用いることで必要なスペクトル純度を得ることができるが,本フィ
ルタによって,59.5keVの光量子数は約半分に減る。
2) 付加フィルタは可能な限り線源に近づけて置かなければならない。
c) 7.9.3.2の幾何学的条件の元,入射口径の位置で毎秒50〜500個の59.5keVの光量子が必要であり,こ
のため,線源は約107Bqの放射能強度が必要である。
7.9.3
DQE測定用の試験器具
7.9.3.1
入射口径
a) I. I. 及び参照検出器に入射する放射線ビームの断面は,同じでなければならない。
b) 入力蛍光面の膜厚の変動を避けるため,入射口径の直径は4mmを超えてはならない。
c) 参照検出器に井戸形検出器を用いる場合は,入射口径はその底面積より小さく絞る必要があり,かつ,
入射ビームがその壁に衝突しないようにしなければならない。
d) 入射口径は,少なくとも3mm以上の厚さの鉛板で作られなければならない。
7.9.3.2
試験器具の幾何学的配置
a) γ線の入射角度が振れることによってI. I. の入力蛍光面でのγ線吸収量が変動したり,実効口径が見掛
け上大きくなることを防ぐため,図9に示す角度θは2°以下にしなければならない。ここにθは,次

16
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
の式によって求められる。
θ=tan−1 [(d0+d1) /2L]
ここに, d0: 線源の直径
d1: 入射口径の直径
L: 線源と入射口径との距離
b) 参照検出器とI. I. の測定時には,同じd0,d1,Lを用いなければならない。
c) 入射口径は,入射面にできるだけ近づけて置かなければならない。
図9 入射口径と実効口径
7.9.4
DQE測定用測定装置
7.9.4.1
光電子増倍管 (PMT) I. I. の発光及び参照検出器にシンチレータを使用して光子を検出する場
合は,次の事項に注意してPMTを使用する。
a) PMTの高圧電源は,PMTが線形応答する範囲に調整されていなければならない。また,PMTの応答
を安定させるためには,測定開始前,少なくとも30分間以上,PMTに電源供給したほうがよい。
b) PMTとI. I. は,周りの光が混入しないよう,また,その光を検出しないように遮光しなければならな
い。
c) 蛍光波高スペクトルを測定するため,I. I. 発光の少なくとも5%以上がPMTに達するようにすべきで
ある。通常,I. I. の出力窓に直接PMTを置くか,十分に大きい口径をもつ(F値2より明るいレンズ)
リレーレンズを用いるとよい。
d) リレーレンズを用いる場合は,PMTの光電陰極には感度の不均一性があるため,光学的な焦点をずら
してI. I. の出力像をPMTの光電陰極に結像させたほうがよい。
e) 入射口径に対応する出力像以外の領域で発光するバックグラウンド光を除去するために,PMTには適
当な遮光が必要であり,その口径は,実効口径に対応する出力像径の少なくとも2倍の領域内からの
発光を遮光しないようにする。
7.9.4.2
参照検出器 参照検出器は,入射面に入射する59.5keVの光量子束を測定するのに用いられる。
このエネルギーでの参照検出器の量子吸収効率は,十分に高い必要がある。測定誤差は,絶対値で少なく
とも±2%以下でなければならない。
7.9.5
DQEの測定(図10参照)
7.9.5.1
入射γ線のフルエンス率の測定
a) 7.9.3.2で示す位置関係に配置して参照検出器にγ線を入射させ,e)の精度が維持できるエネルギー範囲
での計数率Rtを計測する。Rtには線源からの計数率にバックグラウンドの計数率が含まれている。な
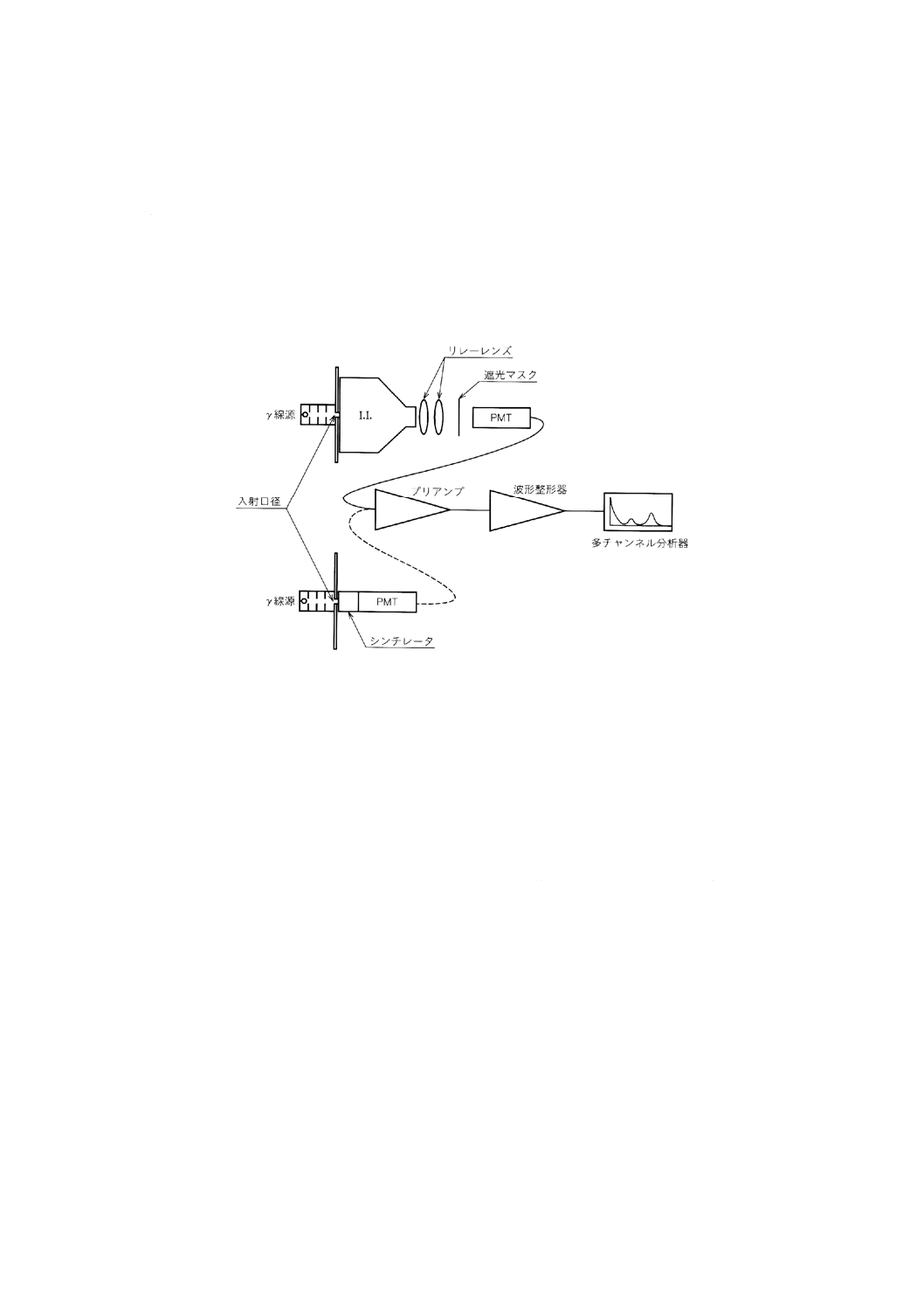
17
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
お,参照検出器からの信号のうち,10keV以下のエネルギーに相当する信号は,計数しない。
b) 放射線源を取り除き,バックグラウンドの計数率Rbを決定し,全体の計数率Rtから引き算する。
c) 全体の計数時間τ(3)は, (Rt−Rb) ×τが少なくとも100 000になるように決める。
注(3) τは,計数している時間を示し,計測している時間から測定系が信号を受け付けない時間分,短
くなる。
d) Rt−Rbを参照検出器の59.5keVの光量子に対する量子吸収効率で補正することで,線源の計数率Rsを
算出することができる。
e) Rsの測定は,±1%以下の誤差で行われなければならない。
図10 幾何学的配置
7.9.5.2
蛍光波高スペクトルの測定
a) I. I. に上記で計測した同じγ線を入射させ,単γ線光子パルスによるスペクトルを測定する。
b) データ収集時間τx(4)は,d)で得られるスペクトルに含まれる総カウント数が,少なくとも100 000とな
るように決める必要がある。
注(4) τxは,カウントしている時間を示し,計測している時間から測定系が信号を受け付けない時間
分,短い。
c) 放射線源を取り除き,τxの期間,バックグラウンドのスペクトルを測定する。
d) バックグラウンドのスペクトルをa)のスペクトルから引き算することで,各々の単γ線光子パルスレベ
ルEjに対する正味のカウント数Njのスペクトルを得る。
e) 0〜25keVのエネルギ間でスペクトルが最小値を示すところのエネルギでもって,それ以下の低エネル
ギを除去する(図11参照)。
なお,この低エネルギのしきい値におけるパルス数は,59.5keVの,すなわち光電ピークでのパルス数
の20%を超えてはならない。

18
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図11 蛍光波高スペクトル
7.9.6
DQEの計算
a) DQEは,次の式で計算される。
DQE=AQ×I
ここに,Iは,次の式で定義される蛍光効率である。
(
)
(
)
0
2
2
1
M
M
M
I
×
=
なお,Miは,蛍光波高スペクトルのi番目のモーメントであり,次の式で与えられる。
M1=Σj Nj× (Ej) i
ここで,Njは,Ejの強度をもつパルスの数である。
なお,ここでの計算におけるEjの最小値は7.9.5.2e)で決定したしきい値に相当するものでなければ
ならない。また,AQは,I. I. の量子吸収効率であり,次の式で示される。
(
)
s
x
0
Q
R
M
A
τ
=
ここに, M0: 上の式で定義
τx: 7.9.5.2b)で決められた時間
Rs: 7.9.5.1で定義
b) 算出は,絶対値で±2%の誤差で行われなければならない。
7.9.7
DQEの表示 DQEの計算結果をパーセントで表示する。
7.10 変調伝達関数 (MTF)
7.10.1 一般条件 7.3.1及び表3を適用する。
表3 MTF測定時の条件
項目
条件
電磁場の影響
非磁性材料使用によって,遮へいする。
外光
遮へいする。
測定装置の機械的安定性 10μm以下とする。
I. I. の集束電極電圧
中心が最適フォーカスになるように調整する。
I. I. の印加電圧リプル
0.1%以下にする。
7.10.2 X線ビーム

19
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
a) 7.3.2a),b),7.7.2b)による。
b) X線管の焦点の呼びは,0.6以下とする。もしこの条件に合わない(例えば,信号が低すぎることによ
るなど)ときは,実際に使用された焦点のMTFの補正を行い。実際に使用された焦点の呼びを結果
に表示する。
c) X線強度の相対的変動は,2%以内にする。
7.10.3 MTFの試験器具
a) 試験器具のスリットの幅は,0.5×fm−1以下とする。ここでfm−1は測定結果として表示できる最大空間
周波数であり,単位はmm−1である。
b) スリットの幅は,スリット全長にわたり,5%以上の変化をしてはならない。
c) スリットの長さは,同一化平面領域の範囲を超えないように,10mm程度とする。
d) 試験器具の材料は,例えば,タングステン,プラチナ,ウラニウムなど重金属元素を単層又は数層,
重ねて製作し,厚さは1.0mm以上とする。
7.10.4 MTFの測定 I. I. のMTFの測定方法は,表4の方法による(図12参照)。
表4 MTFの測定法の種類
空間フィルタ法
スリット像を1次元の空間フィルタで走査し,光電子増倍管 (PMT)
を用いて信号検出する。
LSF法
スリット像を1次元のサンプリングスリットとPMTを用いて走査する。又は
スリット像を,2次元カメラ(CCDカメラ)を用いて検出する。
a) MTF分析器を用いて出力面全体を分析できる光学系を少なくとも一つ,準備する。
b) MTF分析器に組み込まれている光検出器(PMT,CCDカメラ)は,線形応答する。
c) 試験器具は,入射面に平行にかつ中心軸上に設置し,かつ,入射面から10mm以内に置く。
d) 中心拡大率の測定誤差は,1%以下にする。
e) 測定は,次の二つの方法が考えられる。そのいずれかの方法を選択してもよい。
1) 空間フィルタ法
1.1)
空間フィルタは,スリット像の長軸方向に対して設置され,少なくともスリットの長軸方向に1回
転以上,回転する。
1.2)
空間フィルタを通過した光の強度は,光電子増倍管によって検出する。
1.3)
空間フィルタによる空間周波数fiで測定されたMTFは,次の式で表す。
()
min
max
min
max
i
M
INT
INT
INT
INT
f
MTF
+
−
=
ここでINTは光強度を示す。この測定は必要とされる空間周波数全体で繰り返す。
備考 異なった空間フィルタの代わりに調整できる空間周波数をもつフィルタによって数種類の空間
周波数でのMTFを決定することができる。
2) 線広がり関数法(以下,LSF法という。)
2.1)
少なくとも6けたの輝度レベルが測定できるダイナミックレンジをもつ。
備考1. このダイナミックレンジが得られない場合は,測定を複数回,実施し,暗電流信号の補正は
個々に分けて行う。
2. CCDカメラを用いる場合には,低雑音と広いダイナミックレンジをもつ冷却型センサを推奨
する。
2.2)
画素数は,1ライン当たり1 000程度もつ。

20
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2.3)
スリット像は,サンプリングスリットの長軸方向又はCCDカメラの画素配列方向に対して平行に
結像されるようにする。
2.4)
LSFの2次元のCCDカメラによって得られた画素値を列方向に足し合わせることによってLSFを
得る。又はサンプリングスリットをスリット像に対して垂直に走査し,サンプリングスリットを通
過した光をPMTによって検出することによってLSFを得る。
備考 低空間周波数成分におけるMTF測定の際のスリット幅は,高空間周波数成分の測定のときに
使用したスリット幅より広くする。このとき,スリット像の信号が強すぎるのでNDフィルタ
などを使用し,LSFのすそ野の部分を測定するときには,NDフィルタを外すことで広いダイ
ナミックレンジを昇ることができる。
2.5)
LSFをフーリエ変換し,測定された変調度伝達関数MTFMを計算する。
2.6)
測定に関する空間周波数の分解能∆fは,次の式で表現される。
1-
mm
1
X
N
f
×
=
∆
1-
min
mm
1
EFS
f
=
1-
max
mm
4
1
X
f
×
=
ここに,
N: 1ライン当たりの測定数(画素数)
X: 入射面換算したサンプリング間隔
fmin: 感知できる空間周波数の最小値
EFS: mm単位で表される入射面視野寸法
fmax: 有効な空間周波数(ナイキスト条件の半分)の最大値
備考 もし,fmaxでのMTFMが0.02を超えているなら,スリット像は誤ってサンプリングされている
ので光学系の倍率を上げる。
f)
空間周波数の大きさは,中心拡大率と光学系による拡大率とを用いてI. I. の入射面に換算させる。
g) 零空間周波数でのMTFは,1.00とする。
h) 結果として得られたMTFは,空間周波数全体にわたって0.02以上の精度で測定する。
図12 MTF測定器
7.10.5 補正 I. I. の変調伝達関数MTFxは,測定された変調伝達関数MTFMを試験器具の変調伝達関数
MTFT,リレーレンズ系とMTF分析器の変調伝達関数MTFA,焦点の変調伝達関数MTFsによって,補正
する。
a) MTFxは,次の式で計算する。
21
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
S
A
T
M
X
MTF
MTF
MTF
MTF
MTF
×
×
=
b) 試験器具のMTFTは,次の式で計算する。
()
(
)
f
d
f
d
f
MTF
×
×
×
×
=
π
π
sin
T
ここに,
f: 空間周波数
d: I. I. の入射面に換算したスリット幅
この近似は,スリット幅がスリット長に比べて十分小さいことを仮定している。
c) MTFsの補正の場合には,実効焦点のMTFはJIS Z 4704によって決定する。その他の場合は1.00とす
る。
d) 補正に用いたそれぞれのMTFの結果は,空間周波数全体で0.50以上である。
7.10.6 LFDの計算方法 LFDは,次の式から計算される。
LFD= [1.00−MTF (0.1mm−1)]
7.10.7 MTF及びLFDの表示
a) 変調度伝達関数の表示方法LFDを含んだMTF。これは,縦軸,横軸ともゼロを原点とした線形グラ
フで表現される。空間周波数は,mm−1(又はcm−1)で示され,I. I. の入射面に換算した数値で示す。
b) LFDの表示方法
LFDの数値
8. 表示 I. I. には,少なくとも次の事項を見やすい位置に表示しなければならない。ただし,e),f)は,
電源部に表示すればよい。
a) 形名又は名称
b) 製造業者名及び所在地
c) 製造番号
d) 据付年月又は製造年月若しくはこれらの略号
e) 定格電源の相数,電圧 (V) 及び周波数 (Hz) (電源部がある場合)
f)
消費電力 (W) (力率90%以上)又は皮相電力 (VA) (電源部がある場合)
g) その他必要な事項
9. 附属文書 附属文書には,少なくとも次の事項を記載しなければならない。
a) 形名又は名称
b) 構造及び構成[主要寸法 (mm),質量 (kg) など]
c) 入力面位置及び入力面寸法(図2参照) (mm)
d) 電源の相数,電圧 (V),周波数 (Hz) 及び消費電力 (W)(5)又は皮相電力 (VA) (電源部がある場合)
注(5) 力率90%以上の場合に限る。
e) 電源に備えるヒューズの種類及び定格(電源部がある場合)
f)
使用方法及び次の事項
1) 保守,管理に関する事項
1.1)
組み込んだ真空ポンプの作動条件(組込み真空ポンプがある場合)
1.2)
I. I. の交換時の注意事項
22
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
1.3)
その他必要事項
2) 過度の振動及び衝撃に関する注意事項
3) 運搬及び保管に関する事項
3.1)
許容できる輸送及び保管環境条件
3.2)
長期間不使用保管時の注意事項
3.3)
その他
g) 定格
1) 陽極電圧,集束電極電圧(kV又はV)
2) 公称入射面視野方法 (mm),有効入射面視野寸法 (mm)
3) 出力像寸法 (mm)
4) 変換係数 (cdm−2/μGys−1)
5) 輝度分布,輝度不均一度 (%)
6) 微分像ひずみ
7) コントラスト比又はベーリンググレア指数
8) 解像度(Lp/mm又はLp/cm)(7.8.7参照)
9) DQE
10) MTF
h) 取扱い上の注意事項
23
Z 4721 : 2000
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
JIS Z 4721 医用X線イメージエンテンシファイア 原案作成委員会 構成表
氏名
所属
委員長
平 松 慶 博
東邦大学医学部
委員
野辺地 篤 郎
聖路加国際病院
幾 瀬 純 一
東芝メディカル株式会社
宗 近 宏 次
昭和大学医学部
川 原 章
厚生省医薬安全局
尾 内 能 夫
財団法人癌研究会癌研究所
宮 崎 正 浩
通商産業省工業技術院標準部
山 村 修 蔵
財団法人日本規格協会
橋 本 進
財団法人日本規格協会
宮 崎 茂
社団法人日本放射線技術学会(東邦大学医学部附属大橋病院)
山 口 尚二郎
株式会社島津製作所
竹 中 栄 一
関東労災病院
多 田 信 平
東京慈恵医科大学
平 林 久 枝
社団法人日本放射線技術学会(東京女子医科大学病院)
荒 木 由季子
通商産業省機械情報産業局
三田村 正 義
ジーイー横河メディカルシステム株式会社
山 田 和 美
社団法人日本放射線技術学会(東京日立病院)
村 上 文 男
株式会社日立メディコ
矢 野 太
ジーイー田中メディカルシステム株式会社
荒 舘 博
株式会社東芝
谷 津 哲 夫
株式会社東芝
鴨 下 実
三田屋商事株式会社
伊 東 厚
社団法人日本画像医療システム工業会
(事務局)
椎 名 光 男
社団法人日本画像医療システム工業会
JIS Z 4721 医用X線イメージインテンシファイア 原案作成分科会 構成表
氏名
所属
(主査)
谷 津 哲 夫
株式会社東芝
佐 藤 直 高
株式会社東芝
斎 藤 啓 一
株式会社東芝
大久保 彰
株式会社日立メディコ
相 原 雄 一
フィリップスメディカルシステムズ株式会社
長谷川 亨
コニカ株式会社
松 永 功 介
株式会社ナック
三 橋 昇
シーメンス旭メディテック株式会社
山 田 稔
富士メディカルシステム株式会社
木 村 雄太郎
株式会社島津製作所
篠 原 文 章
社団法人日本放射線技術学会(日本医科大学附属第二病院)
寺 沢 操
社団法人日本放射線技術学会(財団法人癌研究会附属病院)
村 西 久 幸
社団法人日本放射線技術学会(神奈川県立厚木病院)
宗 像 保 男
通商産業省工業技術院標準部
橋 本 進
財団法人日本規格協会
(事務局)
椎 名 光 男
社団法人日本画像医療システム工業会