K 0143 : 2000 (ISO 14237 : 2000)
(1)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
まえがき
この規格は,工業標準化法第12条第1項の規定に基づき,財団法人大阪科学技術センター付属ニューマ
テリアルセンター (OSTEC) 及び財団法人日本規格協会 (JSA) から工業標準原案を具して日本工業規格
を制定すべきと申出があり,日本工業標準調査会の審議を経て,通商産業大臣が制定した日本工業規格で
ある。
JIS K 0143には,次に示す附属書がある。
附属書A(参考) シリコンウエハのキャリアー密度の決定
附属書B(参考) SIMSによって測定されたボロン同位体比
附属書C(規定) 装置仕様の評価の手順
附属書D(参考) NIST SRM 2137の深さ方向分布の測定手順
附属書E(参考) 共同実験の統計処理報告
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
K 0143 : 2000
(ISO 14237 : 2000)
表面化学分析−
二次イオン質量分析法−
シリコン中に均一に添加されたボロンの
原子濃度の定量方法
Surface chemical analysis−Secondary ion mass spectrometry
−Determination of boron atomic concentration in silicon using
uniformly doped materials
序文 この規格は,2000年に発行されたISO 14237, Surface chemical analysis−Secondary ion mass
spectrometry−Determination of boron atomic concentration in silicon using uniformly doped materialsを翻訳し,
技術的内容及び規格票の様式を変更することなく作成した日本工業規格である。
この規格は,シリコンウエハに均一に添加されたボロン原子濃度を二次イオン質量分析法(以下,SIMS
という。)によって決定するために作成された。
SIMSは,定量分析を行う場合に標準試料を必要とする。認証された標準試料は,限られたマトリックス
−不純物の組合せしか利用できず,また高価である。SIMSは,これらの標準試料を不可避的に消費して
しまう。したがって,各機関で用意が可能で,認証標準試料を用いて校正し得る二次標準試料が,日常の
分析には便利である。
この規格では,ボロンを注入して作製した認証標準試料で校正した二次標準試料を用いて,シリコン単結
晶中のボロンを定量分析する標準手順を述べる。
1. 適用範囲 この規格は,ボロンを注入して作製した認証標準試料で校正した均一添加試料を用いて,
単結晶シリコン中のボロンの原子濃度を決定するための二次イオン質量分析法を規定する。濃度範囲とし
て1×1016atoms/cm3から1×1020atoms/cm3の範囲の均一に添加されたボロンの濃度を決定する場合にこの
方法を用いる。
2. 引用規格 次に掲げる規格は,この規格に引用されることによって,この規格の一部を構成する。こ
れらの規格は,その最新版(追補を含む。)を適用する。
JIS Z 8402-2 測定方法及び測定結果の精確さ(真度及び精度)−第2部:標準測定方法の併行精度及
び再現精度を求めるための基本的方法
備考 ISO 5725-2 : 1994, Accuracy (trueness and precision) of measurement methods and results−Part 2 :
Basic method for the determination of repeatability and reproducibility of a standard

2
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
measurement methodがこの規格と一致している。
3. 原理 酸素イオンビーム又はセシウムイオンビームを試料表面に照射する。放出されたボロンとシリ
コンの二次イオンを質量分析し,検出する。
ボロンが均一に添加された二次標準試料は,イオン注入によって作製された一次標準試料で校正し,実
用標準試料として用いる。
4. 標準試料
4.1
一次標準試料
一次標準試料は,シリコンにボロンをイオン注入した認証標準試料(以下,CRMという。)であり,二
次標準試料のボロンの原子濃度を決定するために用いる。
参考 NIST標準試料SRM 2137(以下,NIST SRMという。)は,現時点でシリコン中のボロン定量の
ための唯一のCRMである。
4.2
二次標準試料
二次標準試料(以下,バルクRMという。)は,被測定試料のボロンの原子濃度を決定するために用い
る。少なくとも,一つの濃度レベルのボロンを添加した標準試料と一つのボロン無添加の標準試料を日常
の分析に使用する。装置の性能を確認するために他の二つの濃度レベルの異なるボロン添加試料を用いる
ことが望ましい(附属書C参照)。
4.2.1
二次標準試料は,単結晶シリコンウエハ又は100μm程度の膜厚のエピタキシャル層をもつエピタ
キシャルシリコンウエハであり,自然同位体比のボロンを均一に添加したものである。
4.2.2
1×1016atoms/cm3から1×1020atoms/cm3のボロン濃度をもつシリコンウエハが必要である。表1に
ある三つの異なる添加レベルの試料を用いることが望ましい。単一レベルの試料を用いて定表する場合は,
RM−B又はRM−Cを用いる。ボロン無添加の試料を用いてバックグラウンドを評価する。
ボロン濃度の均一性のよいウエハを用いる。濃度の変動は1cm当たり5%以下とする。
備考 正確なボロン原子濃度は,ウエハの電気抵抗からキャリアー密度として決定することができる。
電気抵抗の測定方法及び電気抵抗からキャリアー密度を導出する方法を附属書Aに示す。
表1 バルク標準試料(バルクRM)
試料名
ボロンの添加表レベル (atoms/cm3)
RM−A
低
1×1016−1×1017
RM−B
中間
5×1017−5×1018
RM−C
高
1×1019−1×1020
RM−BG なし
<1×1014
4.2.3
4.2.2において選んだバルクRMの10Bと11Bの同位体比は,次に示す方法の中の一つで決定する。
a) 同位体比を磁場型SIMSにより,BSi−分子イオンを検出することによって求める。
7.5.2に示す測定手順は,この目的のために用いる。
b) バルクRMは,一般的に受け入れられている自然同位体比,すなわち,10Bの存在率が19.9 at%で11B
が80.1 at%で,同位体比が4.025となっているものと仮定する。しかしながら,特定材料中のボロン
の同位体比は,自然同位体比から±5%偏移することがあり得る。
備考 SIMSは一般に装置の種類や検出イオン種によって偏移した同位体比を測定値として与える場
合がある。磁場型SIMS装置を用いる場合,10Bと11Bを検出するより10B28Si−と11B28Si−を検出

3
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
するほうが同位体分別効果は小さくなる(附属書B参照)。
5. 装置
二次イオン質量分析計は,酸素イオンビーム又はセシウムイオンビーム若しくはその両者をもつものを
用いる。
装置性能を確認する必要がある場合は,附属書Cに示した手順で実行する。C.5に示した測定結果の直
線性を得る手順は,装置担当者の作成した手順書(local documentを含む。以下同様。)で置き換えること
ができる。
6. 試料
試料は,鏡面研磨されたものを用いる。試料を適当な大きさに切断し,必要ならば,さらに脱脂,洗浄
を行う。
7. 手順
7.1
二次イオン質量分析計の調整
酸素イオンビームを用いる場合は,表2に示す条件で,また,セシウムイオンビームを用いる場合は,
表3に示す条件で行う。ここで示していない条件を用いる場合は,装置メーカーの手順書に従うか,装置
担当者の作成した手順書に従って調整を行う。
表2 酸素イオンビームを用いる場合の測定条件
要素
特性
一次イオン種
O2+
二次イオン極性
正
分析面積
>100μm2
一次イオンスキャン面積 分析面積の4倍又はそれ以上
第3 セシウムイオンビームを用いる場合の測定条件
要素
特性
一次イオン種
Cs+
二次イオン極性
負
分析面積
>100μm2
一次イオンスキャン面積 分析面積の4倍又はそれ以上
7.2
二次イオン質量分析計の設定条件の最適化
7.2.1
要求される装置因子を設定し,装置メーカーの手順書か装置担当者の作成した手順書に従ってイオ
ン光学系の調整を行う。
7.2.2
一次イオン電流の安定性及び質量分析計の安定性を装置メーカーの手順書か装置担当者の作成し
た手順書に従って確認する。
7.3
試料導入
SIMS装置に試料を導入する直前に,表面の付着物を圧縮空気等を利用して除去する。
分析室に試料を導入した後,装置メーカーの推奨する真空度に回復するか,装置担当者の作成した手順
書に示す真空度に回復するまで測定を開始してはならない。
備考 分析室の残留ガスが11B28Si−の検出のバックグラウンドとして10B28SiH−の二次イオン強度を増
加させるためセシウムイオンビームを用いる場合は,より良い真空度を得てから測定するよう
4
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
に注意する必要がある。
7.4
検出イオン
7.4.1
酸素イオンビームを用いる場合は,10B+と11B+の両方をボロンの二次イオン種として検出する。ま
た,セシウムイオンビームを用いる場合は,10B28Si−と11B28Si−の両方を検出し,ボロンイオン強度として
用いる。
7.4.2
装置メーカーの作業手順書か装置担当者の作成した手順書に従って,適当なイオン強度をもつシリ
コンの二次イオン種を検出し,シリコンイオン強度として用いる。
備考 装置が電流を検出するモードの場合は,電流計を用いて28Si+を検出することを推奨する。パル
スカウンティングの場合は,Si関連のイオン強度は1×105counts/s以下に設定する。BSi−を検
出する場合は,Si2−を検出することが望ましい。
7.5
校正
7.5.1
CRM試料の測定法
7.5.1.1
CRMのボロン(10Bと11Bのどちらか)の深さ方向分析は,附属書Dに示した手順に従って,バ
ルクRMと同一日に同一条件で測定を行う。CRMの平均積算強度比Aimpは,附属書D.7に示した手順に
従って計算する。
7.5.1.2
CRMの相対感度係数は次の式から得られる。
imp
imp
A
RSF
Φ
=
ここで,RSFimpは,CRMから求められる同位体相対感度係数,Φは,CRMのボロン(10Bと11Bのどち
らか)の注入量である。
7.5.2
バルクRMの測定手順
7.5.2.1
測定は,試料ホルダーの窓の中心の領域を用いて行う。バルクRM試料のボロンイオン強度が大
きい場合は,検出器が飽和しないように注意する。ボロンイオン強度が1×105counts/s以上の場合は,一
次イオン電流量を下げる。
7.5.2.2
すべてのバルクRMについてボロンとシリコンの深さ方向分析を行う。次に示すデータの取得は,
表面の汚染が除去され,二次イオン強度が安定な値に到達したところで開始し,イオン照射に伴う表面荒
れに起因する二次イオン強度の変化が現れる前に終了する。
7.5.2.3
ボロンとシリコンの二次イオン強度は,少なくともそれぞれ10サイクル以上測定する。同一測
定領域で少なくとも1サイクル当たりボロンの同位体を1秒以上測定する。この手順に従って,同一試料
の異なる三つの測定領域を繰返し測定する。その後,次の試料の測定に移る。
一つの測定領域におけるシリコンイオン強度の変動は装置メーカーが保証する範囲内であるか,装置担
当者の作成した手順書の許容範囲内であれば,一定であるとみなすことができる。この場合,必ずしもシ
リコン強度はサイクルごとに測定する必要はない。それぞれの測定領域の任意の1サイクルで測定してよ
い。
7.5.2.4
RM−BGのボロンの二次イオン強度は,測定のバックグラウンドとして用いる。
7.5.2.5
それぞれのバルクRMのボロン/シリコンイオン強度比は,一測定領域において各測定サイクル
ごとに決定する。その後,測定されたすべてのサイクルに対する平均値を次の式に従って計算する。得ら
れた平均値は三つの測定領域について,さらに平均化する。
5
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
sij
i
j
i
j
i
I
I
J
,
11,
11,=
∑∑
=
=
3
1
1
11,
11
1
3
1
j
n
i
j
iJ
n
J=
ここで,
11,j
iIと
sij
iI,は,測定位置jの測定サイクルiにおけるそれぞれのバルクRMの11Bイオン強度と
シリコンイオン強度である。J11は,それぞれのバルクRMの11Bの平均イオン強度比,nは,それぞれの
バルクRMの全測定サイクル数である。
10Bに関する平均イオン強度比J10の決定にも同様の手段を用いる。
7.5.2.6
マスディスクリミネーションを補正するため,バルクRMの一つを用いてボロンの同位体比を実
験的に求める。ボロン濃度の低い試料では,10B+と30Si3+の質量干渉があるので,同位体比が既知で1×
1017atoms/cm3以上のボロン濃度をもつバルクRM試料を用いることが望ましい。測定された同位体比を次
の式に従って求める。
10
10
11
11
BG
BG
J
J
J
J
−
−
=
α
ここで,αは,測定された11Bと10Bの同位体比,
11
BG
J
と
10
BG
J
は,RM−BG試料で得られた11Bと10Bの
平均バックグラウンド強度である。
測定された同位体比の補正係数δ(以下,マスディスクリミネーション補正係数という。)は,次の式で
決定する。
α
α
δ
0
=
ここで,α0は,4.2.3に従って求めた値である。
7.5.3
バルクRMの校正
7.5.1.2
で得られたRSFimpを校正用の相対感度係数として用い,それぞれのバルクRMの11Bの濃度を求
める。
CRMが10Bを注入したものであれば,7.5.2.6で得られたマスディスクリミネーション補正係数を用いる。
)
(
11
11
11
BG
k
imp
cal
k
J
J
RSF
C
−
=
δ
ここで,
cal
k
C11
は,それぞれのバルクRMの校正された11B濃度,
11
k
Jは,それぞれのバルクRMの平均
イオン強度比である。
CRMが11Bを注入したものであれば,マスディスクリミネーションの補正は必要ない。
)
(
11
11
11
BG
k
imp
cal
k
J
J
RSF
C
−
=
7.6
実試料の測定
7.6.1
測定手順
実試料の測定は,7.5.2に示したものと同一の条件で測定する。
ボロンとシリコンのイオン強度比は,同一測定位置でサイクルごとに測定し,次に,すべての測定サイ
クルの平均値を計算する。得られた平均値をさらに三つの測定領域について平均化する。
7.6.2
作業用相対感度係数の決定
6
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
7.6.2.1
実試料の測定のための作業用相対感度係数とマスディスクリミネーション補正係数を求めるた
めに前もって校正したバルクRMの一つを用いる。できるだけ実試料に近いボロンイオン強度をもつバル
クRMを選ぶことを推奨する。
備考 試料からのボロンの二次イオン強度が1×102counts/s以下の場合,RM−Aは用いないほうがよ
い。
7.6.2.2
選んだバルクRMとRM−BGを7.5.2に示した手順に従って,同一日に実試料と等しい測定条件
で測定する。ボロンの同位体とシリコンのイオン強度比を同一測定領域のサイクルごとに決定し,全測定
サイクルの平均値を計算する。得られた平均値を更に三つの測定領域について平均化する。
8. 結果の表現
8.1
計算方法
8.1.1
作業用相対感度係数を次の式に従って求める。
11
11
11
BG
m
cal
m
work
J
J
C
RSF
−
=
ここでRSFworkは,選んだバルクRMから得られた作業用相対感度係数である。また,
cal
m
C11
は,選んだ
バルクRMの校正された11B濃度,
11
m
Jは,その11Bの平均イオン強度比,
11
BG
J
は,RM−BGから得られ
た11Bのバックグラウンドイオン強度比である。
8.1.2
実試料測定におけるマスディスクリミネーション補正係数を,次の式に従って求める。
11
11
10
10
0
0
BG
m
BG
m
m
m
m
m
J
J
J
J
−
−
=
=
α
α
α
δ
ここで、α0mは,選んだバルクRMで測定した同位体比,
10
m
Jは,その10Bの平均イオン強度比,
10
BG
Jは
RM−BGから得られた10Bの平均バックグラウンドイオン強度比である。
8.1.3
実試料のボロン濃度を作業用相対感度係数を用いて,次の式に従って求める。
)
(
11
11
11
BG
t
work
J
J
RSF
C
−
=
m
BG
t
work
J
J
RSF
C
δ
)
(
10
10
10
−
=
10
11C
C
C
+
=
ここで,C11とC10は,それぞれ実試料の11Bと10Bの濃度,Cは,実試料中の全ボロン濃度である。
11
t
J
と
10
t
Jは,実試料の11Bと10Bのそれぞれ平均イオン強度比である。
8.2
精度
この規格の濃度範囲をカバーする四つのバルクRMを用いて,4か国12機関による共同実験を行った。
繰返し精度及び再現性をJIS Z 8402-2に従って計算した。
共同実験の統計処理報告を,附属書Eに示した。
再現精度のデータは,試料の均一性に起因する誤差も含んでいることに注意する必要がある。
9. 報告
次の情報を報告する。
a) 試料,装置,測定機関,測定日を特定するために必要なすべての情報。
b) この規格を参照して用いたCRMとバルクRM
c) この規格を参照した同位体比補正についての情報
7
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
d) 装置仕様の確認が必要なとき,この規格を参照した装置仕様と検量線の直線性評価法についての情報。
e) 結果及びこれらが表現されている式
f)
分析の際に認められた異常
g) この規格に記載されていない操作,又は結果に影響を与えうる付随的な操作。

8
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書A(参考) シリコンウエハのキャリアー密度の決定
A.0 序文
附属書Aは,二次標準試料(4.2参照)として用いられたシリコンウエハ中のボロン原子濃度を決定す
るための情報を与える。
A.1 シリコンバルク試料のキャリアー密度の決定
バルクのシリコン結晶中のキャリアー密度は,表A.1に示した方法で直接的に決定する。しかし,この
ような方法を適用する際は,ショットキー接合が形成されている場合に限られる。適用できるキャリアー
密度も4×1013から8×1016cm−3に限られる。
表A.1 バルクシリコンウエハのキャリアー密度の決定に関するASTM規格
F1392
水銀プローブを用いた電気容量・電圧測定によるシリコンウエハのキャリアー密度の決定に関する標準試
験方法
F1393
水銀プローブを用いたミラーフィードバックプロファイル法によるシリコンウエハのキャリアー密度の決
定に関する標準試験方法
したがって,一般的には,電気抵抗を測定し,電気抵抗全範囲にわたってキャリアー密度に変換する。
表A.2の中に示したF43とF84は,電気抵抗の測定方法に関する標準試験方法であり,一方,F723は,
電気抵抗をキャリアー密度に変換するための標準的な実行方法である。一般に,電気抵抗は,F43を参考
にしてF84により測定し,F723に従ってキャリアー密度に変換する。
表A.2 バルクシリコンウエハの電気抵抗の測定とキャリアー密度への変換に関するASTM規格
F43
半導体材料の電気抵抗に関する標準試験方法
F84
インライン4端針によるシリコンウエハの電気抵抗測定に関する標準試験方法
F723
ボロン添加及びりん添加シリコンウエハの電気抵抗と不純物密度の変換に関する標準実行方法
A.2 エピタキシャルシリコン層のキャリアー密度の決定
A.2.1 キャリアー密度の直接決定
シリコンのエピタキシャル層のキャリアー密度は,表A.3に示した規格で直接的に求める。しかし,こ
れらが適用できる範囲は,ショットキー接合を用いることや試料の準備の問題から4×1013cm−3から8×
1016cm−3の範囲に限定される。
表A.3 シリコンエピタキシャル層のキャリアー密度の決定に関するASTM規格
F1392
水銀プローブを用いた電気容量−電圧測定によるシリコンウエハのキャリアー密度の決定に関する標準試
験方法
F1393
水銀プローブを用いたミラーフィードバックプロファイル法によるシリコンウエハのキャリアー密度の決
定に関する標準試験方法
A.2.2 電気抵抗からの変換
シリコンエピタキシャル層の電気抵抗は,キャリアー密度に変換できる。エピタキシャル層の電気抵抗
は,一般に所定の伝導型のエピタキシャル層を異なる伝導型のシリコン基板上に成長させ,その厚みとシ
ート抵抗を測定し,シート抵抗にその厚みをかけることによって得られる。
シリコンエピタキシャル層のシート抵抗の標準試験方法を表A.4に示す。電気抵抗をエピタキシャル層
の厚みを使ってキャリアー密度に変換するためにF723を用いる。
表A.4 シリコンエピタキシャル層のシート抵抗の測定に関するASTM規格
F374 並列4端針を用いたシリコンエピタキシャル層,拡散層,イオン注入層のシート抵抗に関する標準試験方法

9
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
A.2.3 エピタキシャル層の厚み測定に関する標準
エピタキシャル層の厚みに関する標準試験方法を表A.5に示す。F95は,よい再現性が得られるが,エ
ピタキシャル層の不純物密度が高い(最高p型で2.8×1017cm−3,n型で7.8×1016cm−3)場合は適用できな
い。基板の不純物密度が高い(少なくともp型で3.2×1018cm−3,n型で1.3×1018cm−3)場合も同様に適用
できない。
F110は,斜め研磨とステンエッチングを用いた従来法である。この方法は,エピタキシャル層と基板が
1けた以上の電気抵抗の違いや伝導型が違っている場合に用いる。この場合は,たとえF95で測定できな
い高いキャリアー密度をもつエピタキシャル層でも測定可能である。しかし,25μm以上の厚さのエピタ
キシャル層については,干渉顕微鏡の光学系が対応できないため適用することが難しい。
これらの規格のどちらでも,エピタキシャル層と基板の遷移層の幅がエピタキシャル層の厚みの測定値
に影響を与える。厚みの決定におけるこのような遷移層の効果は,より厚い層(例えば100μm)を評価す
る場合より薄い層(例えば5μm)を評価する場合のほうが大きい。
表A.5 シリコンエピタキシャル層の厚み測定に関するASTM規格
F95
赤外分散分光器を用いた高濃度に不純物を添加した基板上の低濃度不純物添加したシリコンエピタキシャ
ル層の厚み測定に関する標準試験方法
Fl10
斜め研磨とステンエッチングによるエピタキシャル層又は拡散層の厚み測定に関する標準試験方法
A.2.4 エピタキシャル層の厚みを決定するその他の方法
表A.6に広がり抵抗測定を用いた電気抵抗分布の測定に関する標準試験方法と,測定試料の前処理に関
する標準実行方法を示す。F672を適用して,p−n接合の深さ又は異なる電気抵抗をもつ層間の界面,す
なわち,エピタキシャル層の厚みを決定できる。
この方法は,試料のキャリアー密度に関係なく,エピタキシャル層の厚みを決定するのに適用できる。
さらに,厚い(例えば100μm)エピタキシャル層の厚みを決定することができる。キャリアー密度が非常
に高くて電気容量−電圧測定のためのショットキー接合を形成するのが困難な場合は,この方法を適用す
るほうがよい。
表A.6 シリコンの広がり抵抗測定におけるASTM規格
F672 広がり抵抗端子を用いてシリコンウエハの表面に対して垂直方向の抵抗分布を測定するための標準試験方法
F674 広がり抵抗測定のためのシリコン前処理に関する標準実行方法
A.3 まとめ
A.3.1 バルクシリコン試料
電気抵抗は,F43を参考にしてF84によって測定し,F723によってキャリアー密度に変換する。キャリ
アー密度がショットキー接合を形成できる範囲内である場合は,F1392とF1393が適用できる。
A.3.2 エピタキシャルシリコン試料
キャリアー密度がショットキー接合を形成できる範囲である場合は,F1392又はF1393のいずれかを用
いることができる。キャリアー密度がこの範囲を超えている場合は,F374によってシート抵抗を測定し,
エピタキシャル層の厚みをF672で決定してエピタキシャル層の電気抵抗を決定した後,F723で電気抵抗
をキャリアー密度に変換するほうがよい。
10
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書B(参考) SIMSによって測定されたボロン同位体比
B.0
序文
SIMSによるボロン同位体比の測定に関して共同実験を行った。ボロン原子濃度が約1×1019atoms/cm3
のボロン添加シリコン試料を20機関で測定した。その結果を精密な同位体分析と比較した。
B.1
試験材
二つのボロン添加シリコンウエハをボロン濃度約1×1019atoms/cm3であるインゴットの隣接した場所か
ら切り出した。ウエハの一つは,7mm×7mmに切断し,試験に参加した機関にSIMS分析用に配布された。
もう一つのウエハは,次の論文に示された方法を用いて同位体分析に供した。
E. Nakamura, T. Ishikawa, J. L. Birck and C. J. Allegre : “Precise isotopic analysis of natural rock samples using a
boron-mannitol complex”, Chemical Geology (Isotope Geoscience Section) , 94 (1992) 193-204.
B.2
SIMS分析の手順
SIMS分析は,7.5.2に示した手順に従って行った。
B.3
同位体比分析結果
B.3.1 それぞれの機関における同位体比分析の結果を表B.1と図B.1に示す。
B.3.2 精密な同位体比分析の結果は次のとおりである。
α0=3.922 1±0.000 4 (2σ)
B.3.3 それぞれの機関で測定した同位体比の補正係数δも表B.1に示す。

11
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
表B.1 測定された同位体比 (α) と補正係数 (δ)
機関 検出モード
装置
α
δ
1
正イオン
磁場型
3.878
1.011
2
3.808
1.030
3
3.669
1.069
4
3.367
1.165
5
3.845
1.020
6
3.608
1.087
7
3.808
1.030
8
3.739
1.049
9
4.263
0.920
10
3.762
1.043
11
3.566
1.100
12
3.878
1.011
13
3.615
1.074
14
5.098
0.769
15
四重極型
4.155
0.944
6
3.566
1.100
11
3.950
0.993
16
3.762
1.043
17
4.236
0.926
18
3.566
1.100
1
負イオン
磁場型
3.785
1.036
2
3.902
1.005
3
3.751
1.046
19
3.808
1.030
11
3.831
1.024
20
四重極型
3.566
1.100
11
3.695
1.061
図B.1 測定された同位体比と補正係数
12
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書C(規定) 装置仕様の評価の手順
C.0 序文
三つのレベルのボロン添加バルクRM試料(以下,RM−A,RM−BとRM−Cという。)と無添加のRM
試料(以下,RM−BGという。)を用いて装置仕様を評価する。これらの試料は,この規格の本体表1に
示されている。バルクRMのボロン濃度は,附属書Aの手順を実行する能力をもつ測定担当者が,この規
格の附属書Aに示した手順で決定する。
C.1 バルクRMの測定手順
7.5.2に示した手順に従う。
C.2 質量分解能
C.2.1 RM−C試料の10Bと11Bのピーク間の谷の最小イオン強度が11Bの最高イオン強度の1%以下にな
るようにする。
C.2.2
29Si30Siと30Si30Siのピーク間の谷の最小イオン強度が29Si30Siの最高イオン強度の1%以下になるよ
うにする。
C.3 最低イオン強度
RM−A試料のボロンイオン(又はボロンのクラスターイオン)強度が少なくともRM−BGによって評
価されたバックグラウンド強度の3倍以上大きくなるようにする。
C.4 最低精度
C.4.1 RM−C試料のシリコンイオン(又はシリコンクラスターイオン)強度に対するボロンイオン(又
はボロンのクラスターイオン)強度比を試料表面の異なる三つの位置で測定し,平均イオン強度比と標準
偏差を求める。標準偏差は平均イオン強度の10%を超えないようにする。
C.4.2 RM−A試料のシリコンイオン(又はシリコンクラスターイオン)強度に対するボロンイオン(又
はボロンのクラスターイオン)強度比を試料表面の異なる三つの位置で測定し,平均イオン強度比と標準
偏差を求める。標準偏差は平均イオン強度の20%を超えないようにする。
備考 機関内の標準偏差は,次の式で定義される。
∑
n
i
AV
iX
X
n
1
2)
(
1
1
=
−
−
=
σ
ここで,σは,Xの標準偏差,nは,Xの総数,XAVは,Xの平均値である。
C.5 測定における直線性
C.5.1 相対感度係数の決定
それぞれのボロン濃度における相対感度係数は,次の式から求める。
11
11
0
0
1
BG
k
bulk
k
k
k
bulk
k
J
J
C
RSF
−
+
=
×
α
α
ここで,係数kは,試料RM−A,BとCを表す。また,α0kは,それぞれのバルクRMについて求めた
同位体比,
bulk
k
RSF
は,それらのバルクRMの相対感度係数,
bulk
k
C
は,電気抵抗から決定されたバルクRM
のボロン濃度である。また,
11
k
Jは,それぞれのバルクRMの11Bの平均イオン強度比,
11
BG
J
は,RM−BG
から得られる11Bの平均バックグラウンドイオン強度比である。
もしα0kが既知でないならば,自然同位体比(α0k=4.025)を用いる。
13
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
11
11
801
.0
BG
k
bulk
k
bulk
k
J
J
C
RSF
−
=
C.5.2 直線性の評価
三つのバルクRMの相対感度係数の平均値及び標準偏差を計算する。標準偏差は平均相対感度係数の
20%を超えないようにする。20%を超える場合は,測定条件を偏差が小さくなるように変更する必要があ
る。
14
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書D(参考) NIST SRM 2137の深さ方向分布の測定手順
D.1 二次イオン質量分析計の調整
一次イオンのスキャン面積を除いて,7.1に示した手順に従う。
一次イオンのスキャン面積は分析面積の10倍又はそれ以上にする。
D.2 二次イオン質量分析計の設定条件の最適化
7.2に示した手順に従う。
D.3 データ取得領域
深さ方向分析は少なくとも表面から0.4μm深さまで測定する(D.5参照)。
D.4 検出イオン
酸素イオンビームを用いる場合は,10B+をボロンの二次イオンとして検出する。セシウムイオンビーム
を用いる場合は,10B28Si−をボロンの二次イオンとして用いる。シリコンのイオン種はバルクRMのときに
用いたものと同一のものを用いる。
D.5 深さ方向分析の手順
ピーク深さにおけるボロン強度が高いため,検出器が飽和しないように注意しなければならない。注入
濃度分布のピーク位置におけるボロン強度が1×105counts/s以上ならば,一次イオン電流量を下げる。一
次イオン電流とスキャン面積は,表面から0.4μmの範囲で少なくとも50サイクルの測定が行えるように
(スパッタリング速度が8nm/サイクル以下になるように)決定する。ボロンとシリコンの二次イオン強度
を交互に測定し,1サイクル当たりのボロンの二次イオン測定時間を1秒以上確保する。測定は0.4μmの
深さに到達するまで続ける(図D.1に示される分布を参考にして仮のスパッタ深さを決定する。)か,又は
バックグラウンドが一定となるか,検出限界以下に到達した後,20サイクル以上測定したところまで続け
る。測定は試料表面の異なる三つの測定点で繰り返し行う。
D.6 深さの決定
サイクル(又は時間)測定により得られるイオン注入分布において,最大値の0.2倍となる2点の中点
を求める。この中点が0.167μmとなるように深さを校正する(図D.1参照)。
参考 上記の手順は深さ校正の仮の方法である。深さ方向の校正に関する規格が確立された段階で,
この方法は改訂される。深さ方向測定の共同実験では,この手順によって決定した値とクレー
タの深さ測定によって決定した値との差異は2.6%であった。これは,実験誤差の範囲内である。
D.7 積算強度の決定
ボロンのシリコンに対するイオン強度比を一つの測定点でサイクルごとに測定する。全測定点における
積算強度比を次の式に従って計算する。自然酸化膜や表面の汚染による表面領域における強度の異常は,
積算から除外する。得られた積算強度比はさらに3測定領域で平均化する。
∑∑
3
1
1
,
10,
3
1
=
=
⊿
−
=
j
n
i
Sij
i
BG
j
i
imp
z
I
I
I
A
ここで,Aimpは,NIST SRMの平均積算イオン強度比,nは,深さ方向分布の全測定サイクル数,
10,j
iIと
Sij
iI,は,NIST SRMの測定位置jにおける測定サイクルiのときのボロンイオン強度とシリコンイオン強度
である。IBGは,NIST SRMの平均バックグラウンドイオン強度で,∆zは深さ方向分析の間隔(全深さ/n)
である。
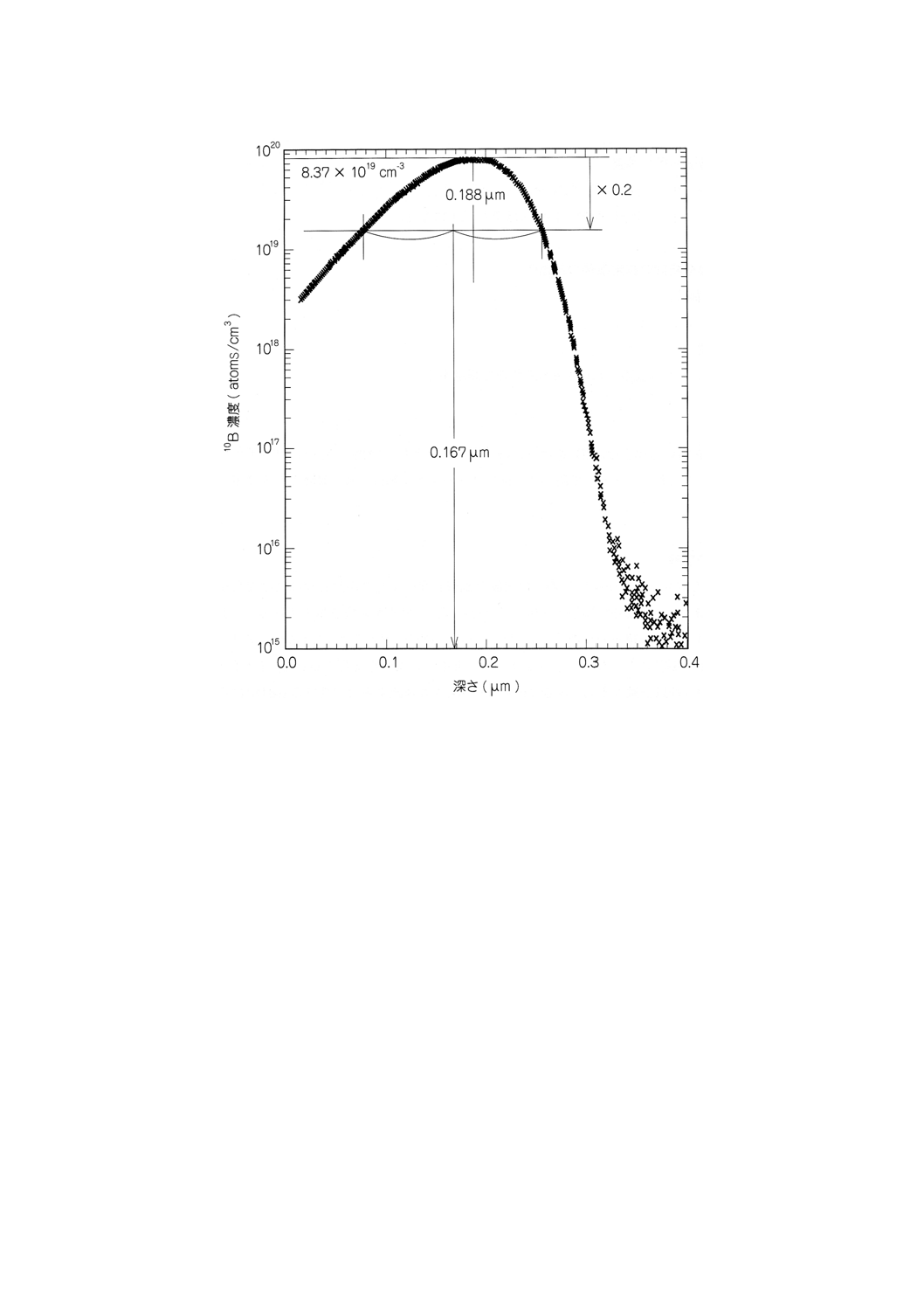
15
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図D.1 NIST SRMにおけるボロンの深さ方向分布
16
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書E(参考) 共同実験の統計処理報告
E.1
序文
この規格について,4か国12機関を含む機関間調査を行った。この規格の濃度範囲をカバーする四つの
バルク試料の測定を行い,繰返し精度及び再現精度をJIS Z 8402-2の原則に従って計算した。
E.2
試験計画
それぞれの参加機関が四つの試料について3回の独立した測定の結果を報告する。
E.3
試験材
それぞれ1×1016,8×1017,5×1018atoms/cm3のボロンを添加した三つのエピタキシャルシリコンウエハ
と1×1019atoms/cm3のボロンを添加したバルクのシリコンウエハを用意した。n型シリコンウエハもまた
バックグラウンドの確認のために用意した。SIMS用の試料を7mm×7mmのウエハの中心部から切り出し,
参加機関に配布した。NIST SRM 2137を一次標準試料として用いた。
E.4
SIMS分析の手順
四つのボロン添加試料中のボロンの濃度を7.5に示した手順によって決定した。
ボロンの同位体比は,全試料について附属書B (α0=3.922 1) に示した値を用いて補正した。
E.5
統計的処理
E.5.1 正当性の吟味
Cochran試験,Grubb試験とgraphical consistency法をJIS Z 8402-2に従ってデータ処理に独立に適用し
た。全試験でoutlierと判定された測定値は解析からはずした。
E.5.2 繰返し精度と再現性の計算
この試験を実施した研究機関の数は,正イオンの測定を行ったのが12機関,負イオンの測定を行ったの
が6機関であった。平均値,機関内ばらつき,機関間ばらつきを求めるためにそれぞれの機関から得られ
た結果をJIS Z 8402-2に従って取り扱った。相当する繰返し精度と再現性を計算した。
この後に与えられる情報の意味は次のとおりである。
2r
S:繰返し精度ばらつき
2L
S:機関間ばらつき
2R
S:再現性ばらつき
2
2
2
L
r
R
S
S
S
+
=
E.6
統計分析結果
E.6.1 正イオン検出における統計分析の結果を,表E.1に示す。これらのデータを図に示したのが,図
E.1である。

17
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
表E.1 正イオン検出測定におけるボロン濃度の繰返し精度と再現性
レベル
機関数
平均値
Sr
SR
1
11
9.15×1015
1.38×1015
2.68×1015
2
11
8.05×1017
1.73×1016
6.05×1016
3
10
1.08×1019
2.15×1017
6.14×1017
4
11
4.47×1018
7.36×1016
5.50×1017
図E.1 表E.1のデータの平均値に対するSrとSRのプロット
E.6.2 負イオン検出における統計分析結果を,表E.2に示す。これらのデータを図に示したのが,図E.2
である。
表E.2 負イオン検出測定におけるボロン濃度の繰返し精度と再現性
レベル
機関数
平均値
Sr
SR
1
5
1.40×1016
8.25×1015
9.87×1015
2
6
7.29×1017
4.09×1016
1.53×1017
3
5
1.06×1019
1.12×1017
1.11×1018
4
5
4.36×1018
1.83×1017
4.17×1017

18
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図E.2 表E.2のデータの平均値に対するSrとSRのプロット
19
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
JIS原案作成委員 構成表(平成10年4月1日)
氏名
所属
(委員長)
志 水 隆 一 大阪大学大学院工学研究科
吉 原 一 鉱 科学技術庁金属材料技術研究所精密励起
場ステーション
工 藤 正 博 成蹊大学工学部計測数理工学科
合 志 陽 一 東京大学大学院工学系研究科応用化学専
攻
福 田 安 生 静岡大学電子工学研究所
一 村 信 吾 電子技術総合研究所極限技術部
大 嶋 清 治 通商産業省工業技術院標準部材料規格課
大 坪 孝 至 財団法人日本適合性認定協会
大 場 正 幸 財団法人日本規格協会技術部
伊 藤 高 明 財団法人日本規格協会技術部
薄 木 智 亮 住友金属工業株式会社
大 堀 謙 一 株式会社堀場製作所
奥 村 豊 彦 日本電子株式会社
小 田 照 巳 ISO/TC 201/SC6セクレタリー(財団法人大
阪科学技術センター付属ニ
ューマテリアルセンター
内)
梶 原 和 夫 ソニー株式会社
河 合 健 一 三菱マテリアルシリコン株式会社
B. V. Crist
XPS International
源 内 規 夫 株式会社コベルコ科研
小 林 尚 アルバック・ファイ株式会社
篠 山 哲 明 株式会社島津製作所
鈴 木 茂 新日本製鐵株式会社
鈴 木 峰 晴 NTTアドバンステクノロジ株式会社
田 中 彰 博 アルバック・ファイ株式会社
田 沼 繁 夫 株式会社ジャパンエナジー分析センター
角 山 浩 三 川鉄テクノリサーチ株式会社
久 本 泰 秀 株式会社日立製作所
日野谷 重 晴 住友金属工業株式会社
廣 川 吉之助 アルバック・ファイ株式会社
古 川 洋一郎 電気化学工業株式会社
本 間 芳 和 日本電信電話株式会社
三 浦 薫 株式会社トクヤマ
村 山 順一郎 住友金属テクノロジー株式会社
吉 岡 芳 明 株式会社松下テクノリサーチ
(事務局)
菊 池 諄 一 財団法人大阪科学技術センター付属ニュ
ーマテリアルセンター
20
K 0143 : 2000 (ISO 14237 : 2000)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
小委員 構成表
氏名
所属
(主査)
角 山 浩 三 川鉄テクノリサーチ株式会社
(幹事)
本 間 芳 和 日本電信電話株式会社
吉 岡 芳 明 株式会社松下テクノリサーチ
岡 本 康 成 シャープ株式会社
奥 野 和 彦 株式会社東レリサーチセンター
小 田 照 巳 ISO/TC 201/SC6セクレタリー(財団法人
大阪科学技術センター付
属ニューマテリアルセン
ター内)
源 内 規 夫 株式会社コベルコ科研
東 條 二三代 株式会社松下テクノリサーチ
林 俊 一 新日本製鐵株式会社
山 本 公 川崎製鉄株式会社
* 津 田 信 博 信越半導体株式会社
* 丸 尾 哲 也 日本電信電話株式会社
* 米 沢 洋 樹 日本電信電話株式会社
(事務局)
菊 池 諄 一 財団法人大阪科学技術センター付属ニュ
ーマテリアルセンター
注* SIMS WGだけの委員