1
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
K 0131-1996
X線回折分析通則
General rules for X-ray diffractometric analysis
1. 適用範囲 この規格は,X線回折装置を用いて回折X線を測定し,これによって物質の同定・定量,
格子定数の精密測定,結晶化度の測定などを行う場合の一般的事項について規定する。
備考1. この規格の引用規格を,次に示す。
JIS K 0050 化学分析方法通則
JIS K 0119 蛍光X線分析方法通則
JIS K 0211 分析化学用語(基礎部門)
JIS K 0215 分析化学用語(分析機器部門)
JIS Z 9101 安全色及び安全標識
JIS Z 9104 安全標識−一般的事項
2. この規格の中で,{ }を付けて示してある単位は,従来単位によるものであって参考として
併記したものである。
2. 共通事項 共通事項は,JIS K 0050による。
3. 用語の定義 この規格で用いる主な用語の定義は,JIS K 0119,JIS K 0211及びJIS K 0215によるも
ののほかは,次による。
(1) 面内回転試料台 (specimen rotation stage) 試料を測定面に垂直な軸の周りに回転させることによっ
て,回折X線強度への粒径の影響を平均化する試料台。
(2) 繊維試料台 (fiber specimen stage) 繊維試料やフィルムなどの配向性を測定するための試料台。通常,
試料の長手方向に垂直な軸の周りに試料を回転させる機構をもつ。
(3) モノクロメータ (monochrometor) X線の波長選択を行うための分光器。
(4) 吸収効果(X線の) (absorption effect) 試料内でX線が吸収されて回折X線強度が減少すること。
(5) 選択配向 (preferred orientation) 結晶子の向きが特定の方向に偏り,特定の回折X線だけが強く観測
されること。優先配向ともいう。
(6) 標準物質(X線回折用の) (reference material) 格子定数などの特性値が精密に測定され,化学的に
安定でかつ高純度な物質で,X線の測定や分析の標準として用いられるもの。
(7) 格子定数 (lattice constants) 結晶の単位格子の大きさと形[りょう(稜)の長さとその間の角度]を
規定する定数。
(8) 質量吸収係数 (mass absorption coefficient) X線の吸収する度合を表す係数(吸収係数)を物質の密
度で割った量。
(9) リートベルト法 (Rietveld method) 粉末回折データを非線型最小二乗法で処理することによって格

2
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
子定数や構造パラメータの最も確からしい値を求める方法。最も確からしい値を求めることを精密化
という。
(10) ブラッグの式 (Bragg equation) X線回折が起こるための条件を与える式。
(11) 面指数 (Miller indices) 結晶の格子面を表す指数。ミラー指数ともいう。
(12) 干渉性散乱 (coherent scattering) X線が物質に入射したときに散乱されるX線で,入射X線と同じ
波長をもつ散乱。弾性散乱 (elastic scattering) ともいう。
(13) 非干渉性散乱 (incoherent scattering) X線が物質に入射したときに散乱されるX線で,入射X線より
長い波長をもつ散乱。非弾性散乱 (inelastic scattering) ともいう。
(14) 結晶子 (crystallite) 多結晶体中の単結晶微粒子。通常0.1μm以下で回折X線の幅を広げる効果が現
れる。
(15) 不均一ひずみ (inhomogeneous strain) 結晶粒子に加えられた又は残留している応力によって,格子が
不均一にひずむこと。
(16) 残留応力 (residual stress) 多結晶体が外力によって弾性的に変形されて応力が生じ,外力が除去され
た後も多結晶体内部に残存する応力。試料表面に対して平行な方向に引っ張られたような変形を示す
場合を引張応力 (tensile stress),圧縮が加えられたような変形を示す場合を圧縮応力 (compressive
stress) という。
(17) 動径分布 (radial distribution) 任意の原子を中心としたときの他の原子までの距離の分布。
(18) 集合組織 (texture) 多結晶体における結晶子の集合状態。
(19) ポーラネット (polar net) 球面上の緯線と経線を赤道面にステレオ投影したもの。
(20) ステレオ投影 (stereographic projection) 結晶の方位を表示するために結晶を球の中心に置き,結晶面
法線と球面との交点(これを極という。)を,平面に投影する方法。
(21) 極点図 (pole figure) 試料中のある方向に垂直な面に関して特定結晶面の極の位置や密度分布をス
テレオ投影したもの。
4. 装置
4.1
装置の構成 X線回折装置の基本構成の例を,図1に示す。
図1 X線回折装置の基本構成(例)
(1) X線発生部 X線発生部は,X線管球,高電圧電源及び制御部で構成する。
(1.1) X線管球 特性X線を発生し,測定に適する回折X線強度が得られる容量をもつもの。封入式管球
と開放式管球がある(1)。
注(1) これらとは別に,X線源としてシンクロトロン軌道放射光がある。
(1.2) 高電圧電源 X線管球に電圧及び電流を供給するもので,十分な容量をもつもの。
(1.3) 制御部 X線管球に印加する電圧及び電流の制御を行うもので,構成は次のとおりとする。
(a) 管電圧及び管電流の調節器
(b) 管電圧及び管電流の安定機構
(c) 安全機構
(2) ゴニオメータ部 回折X線の回折角を測るもので,十分な角度精度,再現精度をもつもの。ゴニオメ
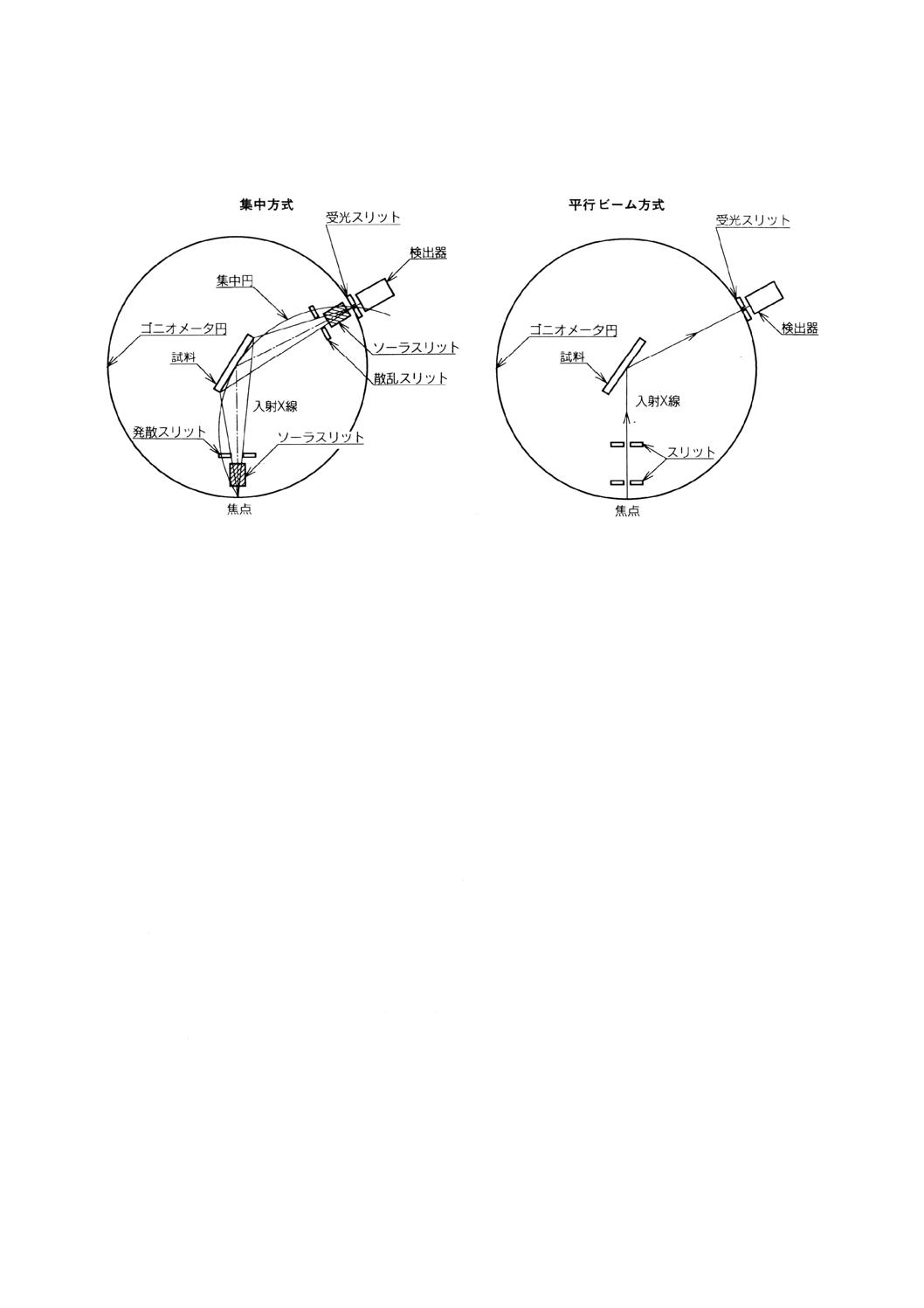
3
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
ータ部の光学系には,集中方式と平行ビーム方式とがある(図2)。
図2 集中方式と平行ビーム方式の光学系の一例
(2.1) 集中方式 発散スリット,試料保持部などで構成する。
(a) 発散スリット 発散X線が得られるもの。
(b) 試料保持部 試料の分析部位を集中円の円周上に保持する機能をもつもの。
(2.2) 平行ビーム方式 コリメータ又はスリット,試料保持部などで構成する。
(a) コリメータ 平行な細束X線が得られるもの。
(b) スリット 平行なX線が得られるもの。
(c) 試料保持部 試料の分析部位を入射X線上に保持する機能をもつもの。
(3) 計数・指示記録部 試料から発生した散乱X線を検出し,その中から分析に必要な回折X線を取り出
し,強度を計数する。構成は,次のとおりとする。
(a) 検出器 X線を検出し,その強度に比例したパルスを発生するもので,比例計数管,シンチレーシ
ョン計数管,半導体検出器,位置敏感形比例計数管などがある。
(b) 検出器用高電圧電源 検出器に印加する電圧を安定に供給するもの。
(c) 比例増幅器 検出器からのパルスを一定の増幅度で増幅できるもの。
(d) 波高分析器 パルスの波高の差を識別し,X線のエネルギーを選別する機能をもつもの。
(e) スケーラ パルスを計数するもので,十分な計数容量をもつもの。
(f) タイマ 定時法及び定計数法に用いるもので,高い繰返し精度をもつもの。
(g) 計数率計 X線強度を連続的にモニタできるもの(2)。
注(2) 計数率計は,備えないこともある。
(h) 表示器 記録計,プリンタ,陰極線管,ディスプレイなどを用いる。
(4) 制御・データ処理部 X線発生部,ゴニオメータ部及び計数部を制御して回折データを収集する。デ
ータに各種の補正を行い,物質の同定,定量分析,リートベルト法による結晶構造の精密化及びその
他の分析の機能を一つ以上もつものである。構成は,次のとおりとする。
(a) 制御機構
(b) データ処理部
4
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
4.2
附属装置 分析の範囲を広げるために各種の附属装置がある。必要に応じて使用する。
(1) 加熱・冷却装置
(2) 面内回転試料台
(3) 回転振動試料台
(4) 極点図測定装置
(5) 繊維試料台
(6) 残留応力測定装置
(7) 薄膜試料測定装置
(8) 微小領域測定装置
(9) モノクロメータ
(10) X線フィルタ(Kβフィルタ)
(11) 試料自動交換装置
4.3
付加機能 付加機能には,次のようなものがある。必要に応じて付加される。
(1) スムージング
(2) 吸収補正
(3) ローレンツ 偏光因子補正
(4) バックグラウンド補正
(5) ピークサーチ
(6) 積分強度,ピーク高さ,半値幅,積分幅などの算出
(7) ピーク分離
(8) 繰返し測定
(9) 回折角の系統誤差補正
(10) 数え落としの補正
(11) ゴニオメータの調整
(12) 計数部の調整
(13) スリット又はスリット幅の設定
5. 試料及びその調製方法
5.1
粉体試料
5.1.1
粉体試料の粒径調整 粒径の大きい試料は,必要に応じて乳鉢などを用い手動又は専用の機械によ
って粉砕して10μm以下の粒径になるようにする。ただし,粉砕によって生じる化学変化,構造変化,又
は汚染の可能性については注意を要する。
5.1.2
粉体試料の試料ホルダへの充てん 試料ホルダには,金属やガラスなどの板に穴又はくぼみを付け
たものを用いる(図3)。試料ホルダに,試料を均一に,かつ,試料面が平たんでホルダの面と一致するよ
うに充てんする(3)。
注(3) 試料粉末がうまく充てんできず測定時に脱落する可能性がある場合は,少量のグリース又はの
りを用いてもよい。

5
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図3 試料ホルダの例
5.1.3
配向性のある試料 試料ホルダに充てんする際に,選択配向を起こしやすい試料の場合は,次のよ
うにする。
(1) 非晶質物質(4)を希釈材として試料粉末に混合する。
注(4) シリカゲル粉末などが用いられる。
(2) 回転振動試料台を使用する。
5.1.4
少量試料 試料量が少なく通常の試料ホルダに充てんできない場合には,次のようにする。
(1) 無反射試料板又はガラス板上に固定する。
(2) ガラスキャピラリーに充てんする。
(3) 溶媒に分散させ,ろ過することによって,ろ紙上に固定する。
5.2
固体試料(薄膜,棒状,板状など) それぞれの試料ごとに適切な試料ホルダを用意し,必要なら
ばコンパウンド,グリースなどを用いて支持,固定する。
薄膜の場合には,基板ごと試料ホルダに張り付け(5),また,棒状,板状の試料は,必要に応じて切断し
適当な大きさにした上で試料ホルダに固定する(6)。
注(5) 回折に寄与する薄膜内部の結晶の数を確保するために,入射角を5°以下の小さな角度に固定で
きる薄膜測定用の光学系を用いることが望ましい。
(6) 固定に使用した接着剤などの回折X線の影響にも注意を払う必要がある。
5.3
たい積粉じん及び浮遊粉じん
5.3.1
たい積粉じん
(1) たい積粉じんは75μmのふるいを通して粒径をそろえる。必要な場合には,灰化処理を行う。ただし,
灰化処理によって生じる化学変化については注意を要する。
(2) 5.1に従って試料を作製する。
5.3.2
浮遊粉じん
(1) 試料をエアサンプラを用いてフィルタ上に吸引ろ過した後,フィルタ用試料ホルダに装着して測定に
供する。
なお,試料を捕集する場合,目的(7)に応じて分粒装置を用いる。
注(7) 石綿を除く吸入性粉じん(人の呼吸によって呼吸気道内に侵入,沈着する粒径範囲の粉じん)
を捕集する場合に分粒装置を用いる。
(2) 浮遊粉じん用標準試料の作製
(a) 発じん法 試料を発じん装置で発じんさせ,粗大粒子が沈降するまで数分間放置してからエアサン
プラを用いてフィルタ上に吸引ろ過して捕集する。
6
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(b) 懸濁液法 試料を分散液中(揮発性溶剤)に入れてかき混ぜた後,さらに超音波洗浄器を用いて均
に分散させる。この懸濁液から所定量をフィルタ上にろ過捕集する。試料面が上になるようにガラ
ス板に載せてデシケータ中で24時間以上放置して自然乾燥させる。
(c) 散布法 試料ホルダに円形に打ち抜いた両面テープをはり付け,その上に試料を脱脂綿などを用い
て均一に散布する。
6. 標準物質
6.1
回折角の精密測定用標準物質 標準物質は格子定数が精密に測定され,化学的に安定で,回折X線
プロファイルの対称性が高い物質を用いる。標準物質を選定するに当たり留意すべき点は,次のとおりで
ある。
(1) 未知試料の測定しようとする回折X線と重ならないこと(8)。
注(8) できるだけ近くにあることが望ましい。
(2) 未知試料の質量吸収係数とできるだけ近いこと。
(3) 高純度なものを選ぶこと(9)。
注(9) 例えば高純度けい素粉末(99.99%以上)が望ましい。
6.2
定量分析用標準物質
(1) 内標準物質 10.1(1)の内標準法において用いる標準物質(10)は,次の条件を満たすものを選ぶ。
(a) 被検成分の測定回折X線の近くに回折X線があり,重ならないこと。
(b) 選択配向を示さず,詰め替え測定した場合の回折X線強度の再現性がよいこと。
(c) 粉砕による回折X線強度の変化が少ないこと。
(d) 被検成分に質量吸収係数が近いこと。
(e) 強い回折X線を与えること。
(f) 試料と反応しないこと。
注(10) 内標準物質として,国際標準化機構標準物質委員会 (ISO/REMCO) で認知されている国際標準
物質データベース (COMAR) に登録されているα形三酸化二アルミニウム (NIST SRM 676)
がある。
(2) 被検成分用標準物質 10.の定量分析に用いる標準物質は,次の条件を満たすものを選ぶ。
(a) 被検成分と結晶相が同じであること。
(b) 結晶粒度や結晶性(不均一ひずみ)が同じであること。
7. 回折図形の測定 測定に際しては,以下の項目について,条件を設定する。
(1) X線発生部
(a) X線管球 測定目的や被検試料に適合した種類,焦点サイズのものを選択する。
(b) 管電圧,管電流 X線管球の管電圧,管電流は,使用するX線管球の負荷特性,対陰極元素の励起
電圧及び被検試料からの回折X線強度などを考慮して設定する。
(2) ゴニオメータ
(a) スリット及びコリメータ 測定目的に合った開口角又は直径のものを選択する。
(b) 走査条件 走査を必要とする場合は,走査速度と走査範囲を設定する。
(3) 計数・指示記録部 計数・指示記録部について,次の項目を設定する。
(a) 検出器の動作電圧
7
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(b) 波高分析器条件
(c) 計数率計の最大計数率と時定数
(4) 測定 試料ホルダに試料を取り付け,ゴニオメータの所定位置に置き,測定を開始する。
(5) データ処理 測定条件,試料名,測定データなどの記憶場所や必要な処理内容を指定する。
(6) その他 附属装置を使用するときはそれらの使用条件を設定する。
8. 同定
8.1
回折データの整理 すべての回折X線について面間隔 (d) と相対強度を求める。
(1) 回折X線から2θ値を求める(11)。
注(11) Kα1(KLIIIともいう。)とKα2(KLIIともいう。)が重なっている場合は,両者の波長の加重平
均を用いて2θを求める。
Kα1とKα2が分離している場合は,Kα1の波長を用いて2θ値を求める。
Kα2の除去が可能な場合は,Kα2を除去してから2θ値を求める。
(2) 2θの値から式(1)のブラッグの式を用いてd値を求める。
2dsinθ=λ ················································································· (1)
ここに,
d: 面間隔 (nm) {Å}
θ: ブラッグ角 (゚)
λ: 使用したX線の波長 (nm) {Å}
(3) X線強度はバックグラウンドを差し引いた回折X線のピーク高さを相対強度として求める。
8.2
データベースを検索する方法
8.2.1
マニュアル法による検索 マニュアル法による検索は,次のとおりとする。
(1) 粉末X線回折データベース (ICDD,PDF) (12)から以下の方法で該当するデータを検索する。
(a) 3強線を利用し,ハナワルト法の索引書から該当するデータを検索する(13)。
(b) 物質名が予想できる場合は,化合物名順の索引書又は鉱物名順の索引書から該当するデータを検索
する(14)。
注(12) International Centre for Diffraction Data, Powder Diffraction File.
(13) 元素情報を考慮する。
(14) 慣用名の場合は慣用名の索引書で化合物名を調べ,化合物名順の索引書から該当するデータを
検索する。
(2) 標準物質のデータと未知試料の全回折X線について一致状況を照合する。
8.2.2
コンピュータによる検索 粉末X線回折データベースをコンピュータで検索して結晶を同定する。
(1) 検索プログラムを用いて該当するデータを信頼度(15)の高い順に候補として選ぶ。
注(15) 信頼度はd値,強度比の一致度及び元素情報などから計算する。
(2) 未知試料の回折X線と検索したデータをモニタに表示し,目視による照合を行い,結晶相を同定する。
8.3
既知物質と比較する方法 被検試料の回折図形と予想される既知物質の回折図形を照合し,回折図
形全体の一致度から同定する。
9. リートベルト法
8
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
9.1
リートベルト法の概要 粉末X線回折図形の各回折角における観測強度 [yi (o)] と,仮定した結晶
構造モデルから式(2)によって計算した強度 [yi (c)] とが一致するように,結晶構造パラメータ(格子定数,
原子座標,温度因子など)とプロファイルパラメータ(ピークやバックグラウンドなどの形状関数)の両
方を同時に最小二乗法によって精密化する(16)方法である。
∑
k
ib
ik
k
k
k
k
k
i
c
y
Δ
G
L
P
m
F
s
c
y
)
(
)
(
)
(
)
(
2
+
=
θ
θ
······································ (2)
ここに,
i: ステップの番号
yi (c): i番目のステップの計算強度
k: i番目のステップの回折X線強度に寄与するピークの
番号
sk: k番目のピークに対する尺度因子
Fk: 構造因子
mk: 多重度
Pk: 選択配向関数
L (θk): ローレンツ (Lorentz) 因子
G (⊿θik): プロファイル関数
⊿θik: θi−θk
θi: i番目のステップの回折角
θk: ブラッグ角
yib (c): バックグラウンド関数
注(16) 精密化と同時に次のような粉末回折データの処理を行う。
(1) ピーク分離
(2) バックグラウンドの除去
(3) 格子定数の精密化
(4) 構造パラメータの精密化
(5) 選択配向の補正
(6) 混合比の定量
(7) 不純物ピークの識別
(8) ピークの指数付け
(9) 積分反射強度,半値幅,ピーク位置の決定
(10) 粉末回折図形のシミュレーション
9.2
試料の調製 選択配向を抑制するための注意を払いながら,5.によって試料を調製する。
9.3
準備する入力データ 入力データは次の項目を準備する。
(1) 試料名及びコメント
(2) 測定に用いたX線光学系
(3) X線波長,必要に応じてKα1,Kα2の強度比
(4) バックグラウンドパラメータ,ゼロ点シフト
(5) 反復計算のサイクル数
(6) フィッティング計算から除外する角度範囲
(7) 試料中に含まれる結晶相の数
(8) 各相の空間群,含まれる原子数(17)
(9) 各相に割り当てられるパラメータ(17)
(a) 尺度因子
9
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(b) 格子定数
(c) 各原子の元素名,座標,温度因子,占有率
(d) 用いたプロファイル関数の係数
(e) 選択配向パラメータ
注(17) 結晶相の数だけ準備する。
9.4
出力するデータ リートベルト法によって出力するデータは,次のとおりとする。
(1) 精密化後のパラメータ
(a) 相の存在比
(b) 格子定数
(c) 原子パラメータ(原子座標,温度因子)
(d) その他プロファイル関数の係数,選択配向パラメータ
(2) 実測値と計算値のフィットのよさを示す信頼度因子(R値)
(3) 回折図形の実測値,計算値及びそれらの差を比較したプロット図
10. 定量分析
10.1 定量法 計数・指示記録部又はディスプレイ上に表示された回折X線強度(18)(19)(20)を用い,次の方
法によって試料中の被検成分の濃度を算出する。いずれの場合も検量用標準物質と被検試料の測定は並行
して行わなければならない。
注(18) バックグラウンド除去後の積分強度又は面積強度を用いる。
(19) 複数の回折X線を用いることもある。
(20) 検量用標準物質が入手できないときは,計算によって強度比を求めることもある。
(1) 内標準法 希釈剤(21)と混合した濃度既知の検量用標準物質及び試料に,内標準物質を同一濃度になる
ように混合し,内標準物質に対する被検成分の強度比を測定し,強度比と濃度との関係線を作成して
検量線とする(22)(23)。この検量線を用いて,試料中の被検成分の濃度を求める(24)(図4参照)。
注(21) 希釈剤には,被検試料のマトリックスと質量吸収係数が近く,回折X線が重ならないようなも
のを選ぶ。
(22) 3点以上のプロットが必要である。
(23) 混合物中の検量用標準物質の濃度は,試料中の被検成分の濃度が内挿値となるように調製する。
(24) 検量線は,直線を示す範囲で使用することが望ましい。
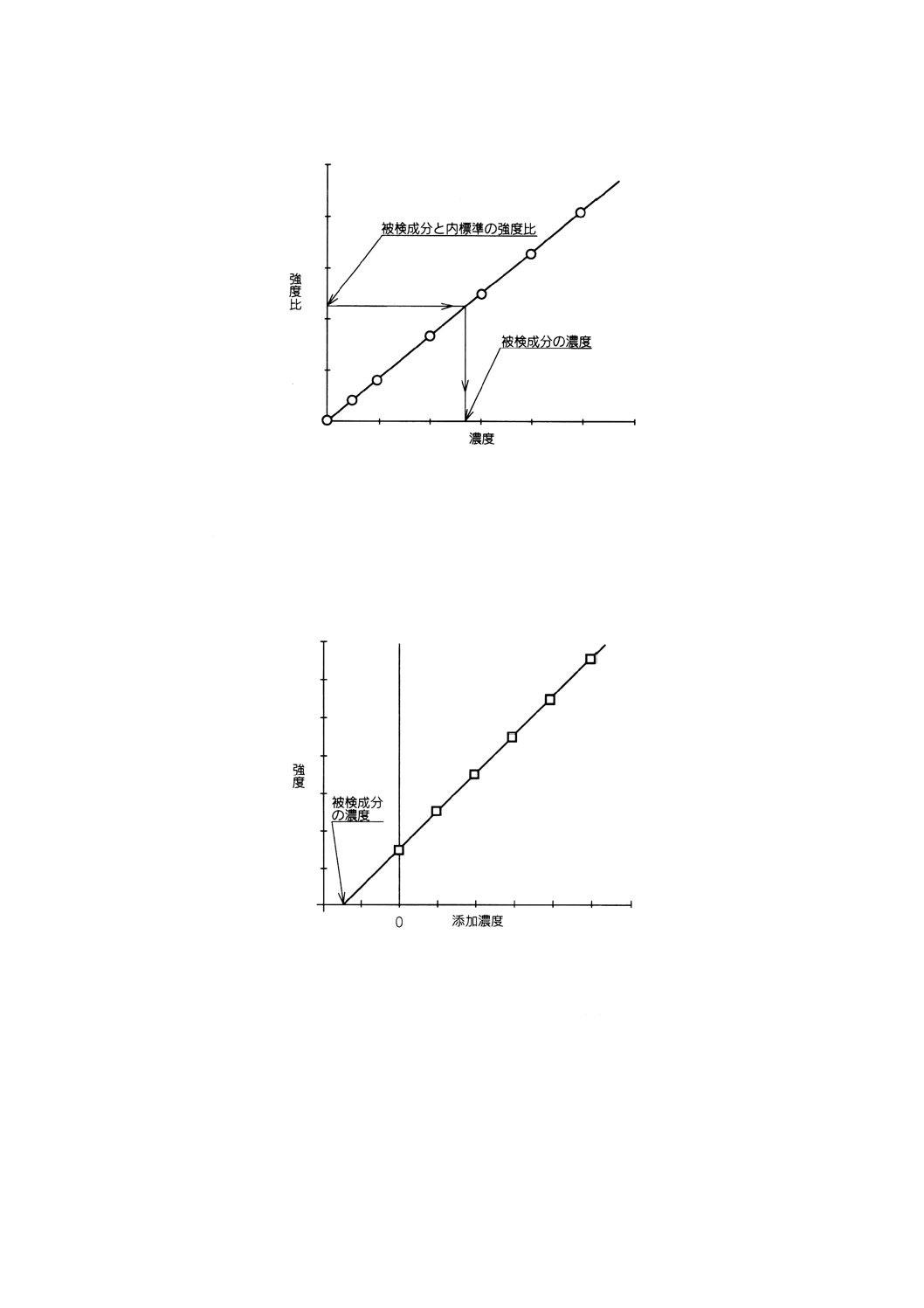
10
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図4 検量線(内標準法)
(2) 標準添加法 同一試料から複数の試料を分け取り,これを段階的に濃度が異なるように,検量用標準
物質を添加する。添加濃度と回折X線強度の関係線を作成して検量線とし,検量線の切片に相当する
濃度を求める(25)(図5参照)。
注(25) 検量線のプロットは3点以上必要である。
また,添加濃度の範囲は被検成分の濃度の3倍以上あることが望ましい。
備考 この方法は被検成分の濃度が低い場合にだけ適用できる。
図5 検量線(標準添加法)
(3) 回折吸収法 試料と標準物質の強度比に吸収補正を施す方法で,式(3)によって試料中の被検成分の濃
度を求める。
Cx= (Is/Ix) (μ*s/μ*x) ×100 ···························································· (3)
ここに,
Cx: 試料中の被検成分の濃度 (%)
Is: 試料の回折X線強度
Ix: 標準物質の回折X線強度
μ*s: 試料の質量吸収係数(26)
μ*x: 被検成分の質量吸収係数(26)
注(26) 試料と被検成分の質量吸収係数は,元素の質量吸収係数と化学組成から計算した値又は実測値
を用いる。
11
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(4) マトリックスフラッシング法 試料中に内標準物質を加え,被検成分と内標準物質の強度比に吸収補
正を施す方法で,式(4)によって試料中の被検成分の濃度を求める。
Cx=Ci (Ii/Ix) 1: 1 (Is/Ii) ·································································· (4)
ここに,
Cx: 試料中の被検成分の濃度 (%)
Ci: 内標準物質の添加濃度 (%)
Is: 試料の回折X線強度
Ix: 標準物質の回折X線強度
Ii: 内標準物質の回折X線強度
(Ii/Ix) 1 : 1: 内標準物質と標準物質の等重量混合物の強度比(27)
注(27) 参照強度比 [ (Ix/Ii) 1 : 1] と呼ばれる数値の逆数で,α形三酸化二アルミニウム (NIST SRM 676)
を内標準物質に用いるとICDDに記載されている値を用いることができる。
(5) リートベルト法による定量 9.のリートベルト法による計算で試料が二相以上の結晶からなる場合,
尺度因子は各成分のモル比であるので,被検成分の濃度を式(5)によって求める(28)。
100
×
Σ
=
i
i
i
i
x
x
x
x
x
V
M
Z
s
V
M
Z
s
C
·································································· (5)
ここに,
Cx: 試料中の被検成分の濃度 (%)
si, sx: i成分と被検成分 (x) の尺度因子
Zi, Zx: 単位格子中のi成分と被検成分 (x) の化学式量数
Mi, Mx: i成分と被検成分 (x) の化学式量
Vi, Vx: i成分と被検成分 (x) の単位格子の体積
注(28) 必要に応じて吸収補正を施す。
11. 格子定数の精密測定 測定した回折角について誤差の補正をして得られた面間隔dと面指数 (hkl) (29)
から格子定数a・b・c・α・β・γを求める(30)。
注(29) 面指数が既知でない場合には,あらかじめ指数付けを行っておく。
(30) 例えば立方晶では,式(6)によって求める。
2
2
2
2
2
a
l
k
h
1
+
+
=
d
····································································· (6)
(1) 測定 回折角の測定精度によって求める格子定数の精度が左右されるので,以下の点に留意する。
(a) 光学系 Kβフィルタやモノクロメータを使用し,スリットは狭いものを用いる。
(b) 測角範囲 被検試料によって,十分な強度をもつ回折X線が得られる範囲でなるべく高角領域を選
ぶ。
(c) 走査方法 ステップ走査が可能な場合にはこれを用い,ステップ幅は小さく測定時間は長くする。
計数率計を用いて記録する場合には,適切なゴニオメータの走査速度・計数率計の時定数・受光ス
リット幅を設定する。
(d) その他 測定中の温度は一定に保っておくことが望ましい。
(2) 誤差の補正 回折角測定には光学系から生じる系統誤差とその他のランダムな誤差とが含まれるので,
これを補正した値を使用する。
(a) 内標準法 格子定数測定用の標準物質(6.1参照)を被検試料に混ぜて測定し,被検試料の回折角を
補正する。
(b) 外標準法 被検試料に標準物質を混合できない場合には,標準物質と被検試料を別に同じ条件で測
定することによって誤差を補正する。
12
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
(3) 回折角の読取りと格子定数の計算
(a) Kα1とKα2による回折X線の分離 測定された回折図形にはKα1とKα2による回折X線が記録さ
れているので,これを分離する。
(b) 回折角の読取り 回折角は回折ピークの半値幅の中心,プロファイルフィッティングでは関数の頂
点のいずれかを使用する。
(c) 格子定数の計算 複数の回折角と面指数から最小二乗法や外挿法で計算する。
12. 結晶子の大きさと不均一ひずみの測定 結晶子が微細(31)な場合や結晶に不均一ひずみが存在する場
合など,回折X線の幅が広がることを利用し,次の方法によって結晶子の大きさや不均一ひずみを測定す
る。いずれの場合も標準物質(32)を用いて光学系による回折X線の幅の広がりを測定し,補正を行う必要
がある。
注(31) 通常,約0.1μm以下をいう。高精度の測定によって,0.2μmまで測定可能な場合もある。
(32) 被検試料と同じ物質で結晶子が十分に大きく,かつ,焼鈍したものを用いるのが望ましいが,
けい素,α形二酸化けい素(石英),α形三酸化二アルミニウムなどを焼鈍したものを用いても
よい。
(1) 測定
(a) 光学系 11.(1)(a)に準じる。
(b) 測角範囲 11.(1)(b)に準じる。
(c) 走査方法 11.(1)(c)に準じる。
(2) 回折図形の読取り 回折図形の読取りは,次による。
(a) Kα1,Kα2によるX線を分離し,Kα1だけの回折図形を描き,半値幅,積分幅及び回折角を求める。
(b) 実際に測定した回折X線の幅の広がりから光学系による回折X線の幅の広がりを差し引き,結晶子
の微細化又は不均一ひずみによる回折X線の幅の広がりを求める(33)。
注(33) 一般に,補正式やグラフを用い,βinstr/βmeasからβ/βmeasを求める。
ここに,
β: 結晶子の微細化又は不均一ひずみによる回折X線の幅の広
がり
βmeas: 実際に測定した回折X線の幅の広がり
βinstr: 光学系による回折X線の幅の広がり
(3) 結晶子の大きさを測定する方法 回折X線の幅が結晶子の大きさだけに依存する場合,式(7)又は式(8)
によって,その回折X線の面指数方向の結晶子の大きさを求める。
θ
λ
β
cos
D
K
=
············································································· (7)
又は,
θ
λ
cos
β
=K
D
············································································· (8)
ここに,
β: 回折X線の広がり (rad)
D: 結晶子の大きさ (nm) {Å}
θ: 回折X線のブラッグ角 (º)
λ: 測定X線の波長 (nm) {Å}
K: 定数(34)
注(34) βに半値幅(
21
β,図6参照)を用いる場合は0.94を,積分幅(βi,図7参照)を用いる場合は1.05
と設定することができる。

13
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図6 半値幅 (
21
β)
図7 積分幅 (βi)
ここに, IN: 回折X線強度の積分値
回折X線と同一面積で,回折X線強度と同一高さの長方形
Ip: 回折X線強度
(4) 不均一ひずみを測定する方法 結晶子が十分大きく回折X線の広がりが不均一ひずみだけによる場合,
式(9)又は式(10)によって不均一ひずみを求める。
β=2η・tanθ ··············································································· (9)
又は,
θ
β
η
tan
2
=
············································································· (10)
ここに,
η: 不均一ひずみ
(5) 結晶子の大きさと不均一ひずみの両方を測定する方法 結晶子の大きさと不均一ひずみの両方が回
折X線の幅の広がりに影響を与える場合,式(11)又は式(12)によって結晶子の大きさと不均一ひずみを
分離して求める。
θ
η
θ
λ
β
tan
2
cos
+
=D
····························································· (11)
又は,
λ
θ
η
λ
θ
β
sin
2
1
cos
+
=D
···························································· (12)
β・cosθ/λ対sinθ/λのグラフを描き1/D(切片)とη(こう配)を独立に求めることができる。
13. 結晶化度 回折図形を試料中の結晶質からの部分と非晶質からの部分に分離することによって,結晶
化度を求める(35)。
14
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
注(35) 非干渉性散乱の寄与は一般に小さいので無視するか,計算によって求めて全体の散乱強度から
差し引く。
(1) 標準物質を用いる方法 被検試料と同じ物質で100%結晶質,又は100%非晶質の試料が入手できる場
合はこれを標準物質として用い,それぞれの回折X線強度との差から式(13)又は式(14)によって結晶
化度を求める(36)。
s
c
x
c
c
I
I
X=
················································································ (13)
又は,
s
a
x
a
c
I
I
X
−
1
=
············································································ (14)
ここに,
Xc: 被検試料の結晶化度
Icx: 被検試料のある結晶質部分からの回折X線強度
Ics: 結晶質の標準物質の回折X線強度
Iax: 被検試料のある非晶質部分からの回折X線強度
Ias: 100%非晶質の標準物質の回折X線強度
注(36) 配向がある試料では式(13)〜(15)が成り立たないので,回転試料台などを用いて測定する。
(2) 絶対法(37) 結晶質部分からの回折X線強度を求め,全体の回折X線強度との比から式(15)によって結
晶化度を求める(36)。
Xc=K・Ic/It ·············································································· (15)
ここに, Xc: 被検試料の結晶化度
Ic: 結晶性部分からの回折X線強度
It: 全体の回折X線強度
K: 補正項(38)
注(37) W. Ruland, Acta Cryst., 14, 1180 (1961).
(38) 複数の2θ範囲でXcが一定になるようにKを決定するか,1とみなすことができる適当な条件を
選ぶ。
14. 極点図測定 極点図は,多結晶体を構成する結晶粒の優先配向,すなわち集合組織の解析に用いられ
る。結晶方位は,試料面を基準にした座標系(正極点図,例えば,圧延板では圧延方向RD,板幅方向TD
及び圧延面法線方向NDを座標軸にとる。)と結晶面を基準にした座標系(逆極点図,立方晶では<100>の
3方向を座標軸にとる。)で記述する。
(1) 正極点図 正極点図は,試料座標系を基準とするステレオ投影図上に特定の結晶面の極密度分布を表
示したものであり,測定方法,試料及びデータ処理は次による。
(1.1) 測定方法 正極点図の測定法には透過法と反射法があり,透過法はポーラネットの外周 (α=0°)
から内側に向かって測定し,反射法はポーラネットの中心 (α=90º) から外側に向かって測定する。
いずれの方法も測定不可能なα角に制限があるので,全範囲の正極点図(完全極点図)を得るため
には透過法と反射法を併用する必要がある。
(a) 透過法(図8参照) 平行X線束を試料に入射し,反対側から出てくる回折X線の全量を計測する。
このため,発散スリットはなるべく幅の狭いものを使用し,受光スリットは回折X線束の幅より大
きいものを使用する。

15
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図8 透過法による正極点図の測定
(b) 反射法(図9参照) 発散X線束を試料に入射し,試料表面側から出てくる回折X線の全量を計測
する。X線が試料からはみ出さないように発散スリット幅を決定する。αの低角側(極点図の外側)
に向かうにつれて回折X線の幅が広がるので,受光スリットは回折X線束よりも幅の広いものを使
用する。
図9 反射法による正極点図の測定
(1.2) 試料 透過法で測定するための試料は,回折X線の強度や試料の取扱いなどを考慮して適切な厚さ
の薄板にする。吸収補正を行うために,作製した試料について線吸収係数μと試料の厚さtの積μt
をあらかじめ求めておく。
備考 正確な極密度分布を決定するには,無配向試料を用いて強度補正を行う必要がある。
(1.3) データ処理 データ処理は,次の項目について行う。
(a) バックグラウンド補正
(b) 吸収補正
(c) ランダム試料の回折X線強度による極密度の計算
(d) (必要に応じ)透過法領域と反射法領域の結合
(e) 完全極点図の規格化処理
(f) 等高線図の作成
(2) 逆極点図 逆極点図は,結晶座標系を基準とするステレオ投影図上に試料の特定軸方向の密度分布を

16
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
表示したものである。投影図は,結晶の (001) 標準投影であり,例えば立方晶系の場合,結晶対称性
を考慮して,一つのステレオ三角形内に圧延面法線方向ND,圧延方向RDなどの軸密度分布を表示
する。
(2.1) 測定方法(図10参照) 特定軸方向に対して垂直に切断した面を試料面とし,試料面法線周りに試
料を回転させながら通常のθ−2θ走査によって反射の強度を測定する。これを無配向性試料の強度
で除して軸密度を計算する。
図10 逆極点図の測定原理
(2.2) データ処理 データ処理は,次の項目について行う。
(a) 積分強度の算出
(b) 各回折X線の軸密度の計算
(c) 等高線図の作成
15. 配向性の評価 多結晶体の回折X線強度比は結晶子の配向性を反映しているので,強度比を用いて配
向性の評価をすることができる。配向性の評価には,通常の試料保持部を用いる方法と繊維試料台を用い
る方法とがある。
(1) 通常の試料保持部を用いる方法 任意の2方向の結晶面による回折ピークの強度比と,配向していな
い場合の強度比又は理論強度比との比から,配向性を評価する。
(2) 繊維試料台を用いる方法 繊維試料台を用いて試料面法線方向で回転しながら,回折X線強度を測定
し,回折X線の半値幅の和の回転角に対する割合から式(16)によって配向度を求める(図11参照)。
100
360
360
×
Σ
゜
゜−
=
i
W
O
······························································ (16)
ここに,
O: 配向度 (%)
ΣWi: 半値幅の和 (º)
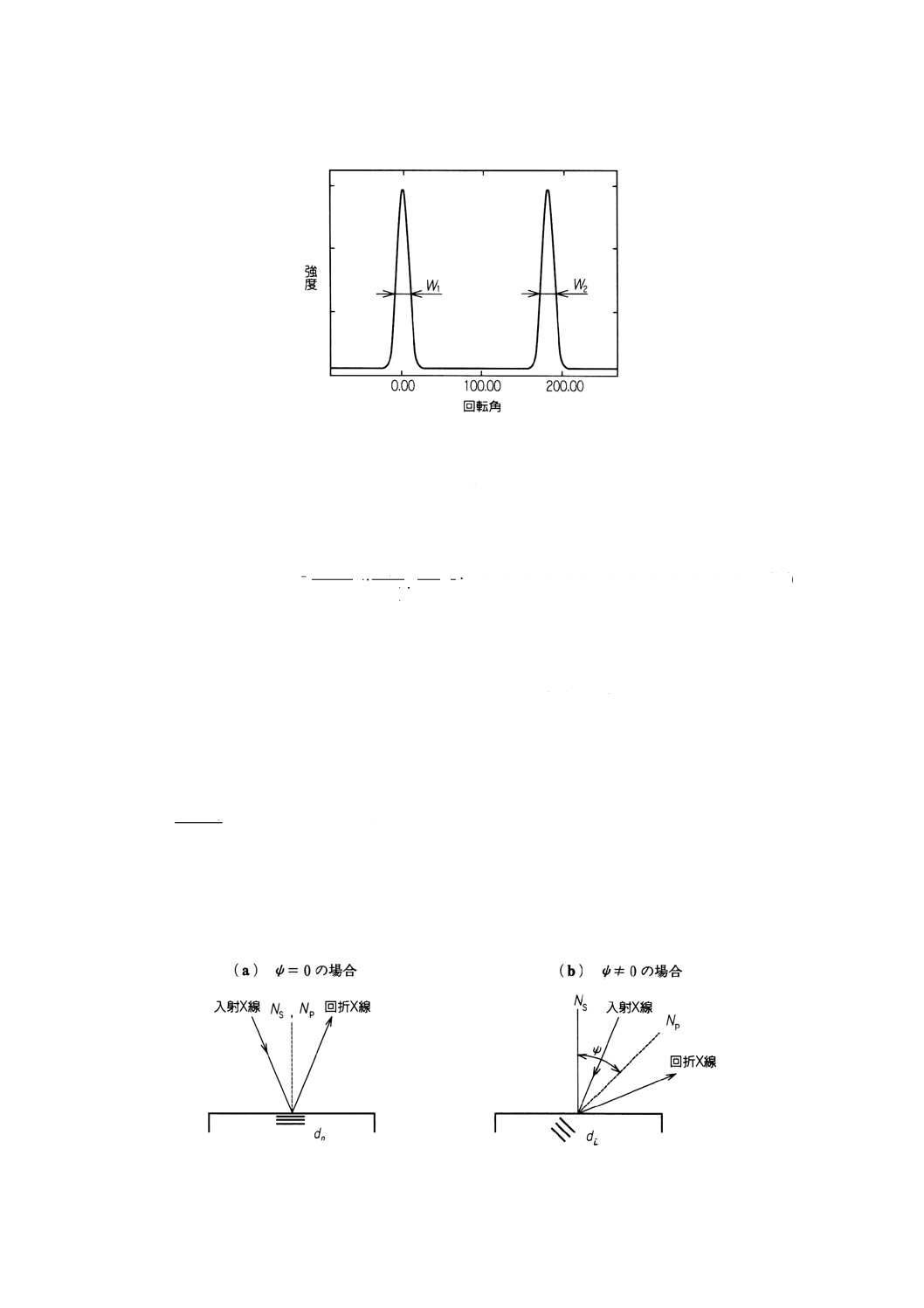
17
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図11 繊維試料台を用いて測定した図形の例
16. 残留応力測定 残留応力測定装置を用いて,試料面の法線Nsと特定の格子面(39)の法線Npのなす角ψ
(図12参照)の変化量に対し,その格子面の回折X線ピーク位置2θの変化量を測定する。この測定によ
って得られた2θ−sin2ψ図(図13参照)(40)の傾き⊿ (2θn−2θi) /⊿ (sin2ψ) を最小二乗法で求め,式(17)に
よって応力σ(引張応力を正とする)(41)を求める。
)
(sin
)
2
2(
)
1(2
cot
2
0
ψ
−
+ν
=
Δ
Δ
E
i
n
θ
θ
θ
σ
·························································· (17)
ここに,
E: ヤング率(41)
θ0: 応力がない場合の標準的な格子面のブラッグ角
ν: ポアソン比
2θn: ψ=0でのピークの回折角 (rad)
2θi: ψ>0でのピークの回折角 (rad)
残留応力測定の光学系(図14参照)(42)は,試料形状や測定方向などによる制限を軽減するため,試料
表面と光学面の立体的配置を考慮する。
注(39) 測定精度を上げるためには,回折角が大きく,強度が高いピークを用いることが望ましい。
(40)
n
n
i
d
d
d−
−sin2ψ図を用いる場合もある。ただし,dnはψ=0での格子面間隔,diはψ>0での格子
面間隔。
(41) 単位は,MPa {kgf・mm−2} を用いる。
(42) 並傾法と側傾法があり,試料の形状に応じて使い分ける。
図12 残留応力測定の概念図
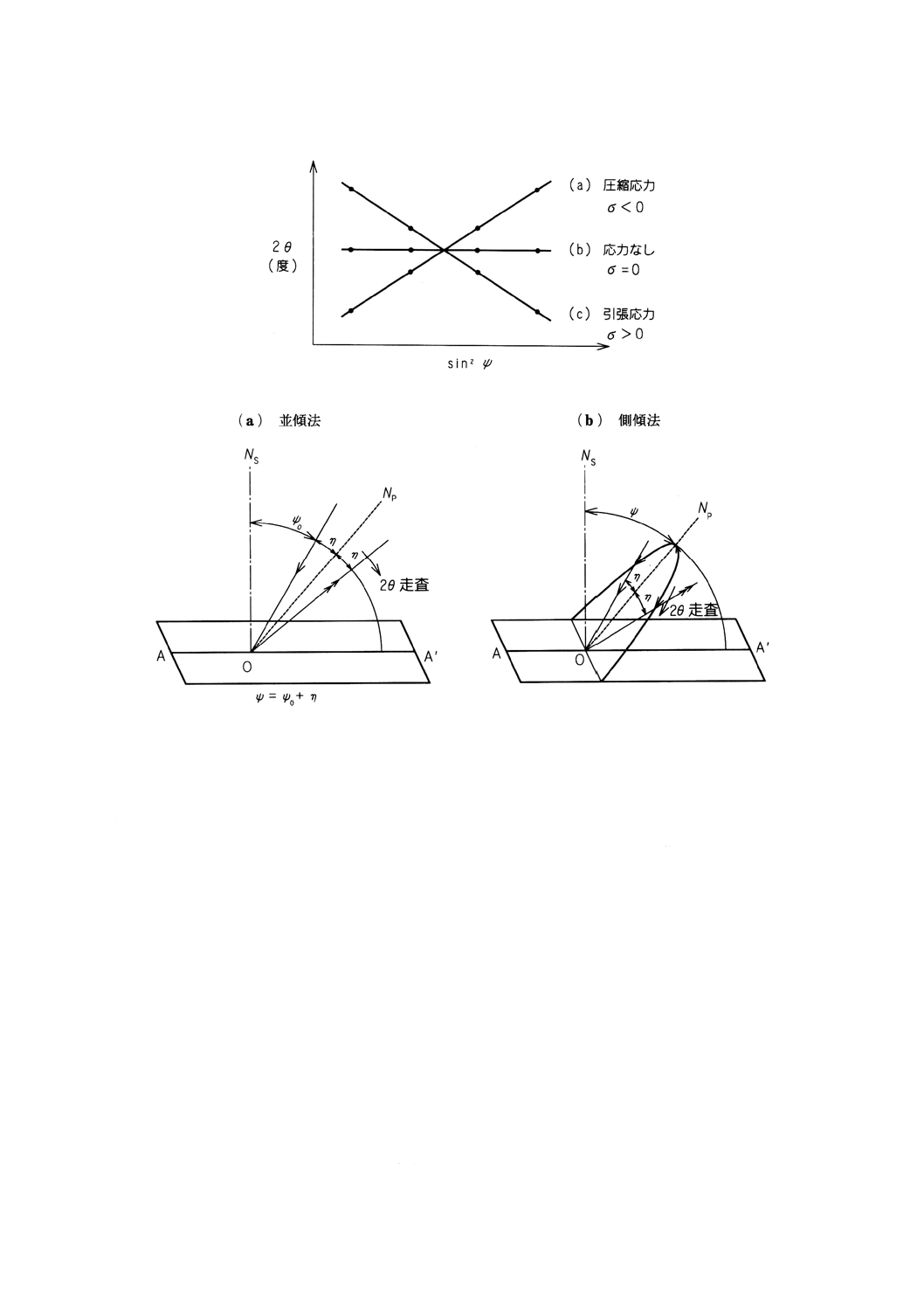
18
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図13 2θ−sin2ψ図
図14 残留応力測定の光学系
ここに,
O: 測定点
A−A': 応力測定方向
17. 動径分布測定 液体や非晶質物質の回折図形には,鋭いピークの代わりにハローが観測される。これ
を解析することによって,動径分布に関する情報を得ることができる。
(1) 動径分布測定の条件 通常のゴニオメータ法によって回折図形の測定を行う(43)。弱いハローを精度よ
く測定するために,次のような注意が必要である。
注(43) ゴニオメータの高角度側の測角範囲を広げたり,特性X線の波長が比較的短いMo,Ag,Rhな
どのX線管球が使用される場合が一般的である。
(a) モノクロメータやフィルタを使用して,試料からの蛍光X線や目的の波長以外の散乱X線を取り除
く。
(b) 大気による散乱X線を取り除く。
(c) 狭い発散スリットを使用し,低角度側で試料以外の部分に入射X線が照射されないようにする。
(d) ステップ走査を行い,かつ,十分に積算を行う。
(2) 動径分布測定データの解析 以下の手順で解析を行う。
(a) 回折図形によって1個の原子からの干渉性散乱強度を計算し,これを基に構造因子を計算する(44)。
注(44) 計算式は散乱に寄与する原子種の数に依存する。多元系にはあまり適用されない。
(b) 動径分布関数を構造因子のフーリエ変換によって得る。
19
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
18. 測定結果の整理 測定結果には,次の事項のうちから必要なものを記載する。
(1) 測定年月日
(2) 測定者
(3) 試料名
(4) 標準物質名
(5) 分析項目
(6) 装置の名称,形式
(7) 試料調製方法
(8) 測定方法とその条件
(a) X線管球の種類
(b) X線管球の作動条件
(c) X線の単色化の方法
(d) ゴニオメータの走査条件
(e) スリット,コリメータの条件
(f) 検出器の種類
(g) 試料の温度
(h) 附属装置の作動条件
(9) 解析方法とその条件
(10) その他必要な事項
19. 装置の点検
19.1 X線発生部
19.1.1 X線管球 X線管球の高電圧絶縁部分を点検し常に清浄に保つ。水冷部分のフィルタは定期的に清
掃する。開放型のX線管球については特に真空シール,冷却水シールの定期的な点検を行い,必要があれ
ば交換する。X線管球からの特性X線強度とそれ以外のX線強度を定期的に確認する。
19.1.2 高電圧電源 X線管球の管電圧と管電流の安定度について定期的に点検する。
19.2 ゴニオメータ
19.2.1 測角精度 標準物質を用いて測角精度を定期的に確認する。測角位置の誤差は,ゴニオメータの調
整を行い修正する。
19.2.2 角度分解能 標準物質を定期的に測定し,回折X線の半値幅からゴニオメータの角度分解能を確
認する。
19.3 計数・指示記録部
19.3.1 計数直線性 検出器を含めた計数部全体についての点検を行い,測定データの計数直線性を定期的
に確認する。
19.3.2 計数安定性 安定度が確認されているX線源などを用いて計数部の安定性を確認する。
19.3.3 波高分析器 定期的に波高分布曲線を測定し,検出器のエネルギー分解能を確認する。
19.4 X線被ばく(曝)防止機構 X線被ばく防止機構の動作テストを定期的に行い,常に被ばくに対す
る安全の確保に努める。
20
K 0131-1996
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
20. 安全管理 X線回折装置の取扱いに当たっては,労働安全衛生規則及び電離放射線障害防止規則を遵
守し,常に放射線障害の防止に留意しなければならない(45)。
注(45) 放射能標識は,JIS Z 9101及びJIS Z 9104による。
21. 個別規格で記載すべき事項 X線回折分析法を規定するに当たっては,少なくとも次の各項目を規定
しなければならない。
(1) 試料名
(2) 装置の構成及び条件
(3) 試料の調製方法
(4) 結果の整理及び表示
(5) その他必要事項
X線回折分析方法通則JIS新規原案作成委員会 構成表
氏名
所属
(委員長)
合 志 陽 一
東京大学工学部
○ 岡 林 哲 夫
工業技術院繊維化学規格課
池 谷 浩之輔
通商産業省計量行政室
◎ 中 村 利 廣
明治大学理工学部
○ 倉 橋 正 保
工業技術院物質工学工業技術研究所
○ 山 田 能 生
工業技術院資源環境技術総合研究所
○ 桜 井 健 次
科学技術庁金属材料技術研究所
加 山 英 男
財団法人日本規格協会
嶋 貫 孝
社団法人日本分析化学会
○ 高 山 透
社団法人日本鉄鋼協会(住友金属工業株式会社)
○ 伊 藤 醇 一
昭和電工株式会社
○ 森 田 勇
財団法人建材試験センター
○ 古 川 洋一郎
電気化学工業株式会社
○ 小佐野 康 子
三菱化学株式会社
○ 江 南 寛
株式会社島津製作所
*○ 小 島 建 治
日本電子株式会社
*○ 山 内 悦 雄
日本電子株式会社
○ 赤 井 孝 夫
日本フィリップス株式会社
○ 中 山 正 雄
理学電機株式会社
○ 伊 藤 尚 美
社団法人日本分析機器工業会(株式会社島津製作所)
○ 宮 川 清 孝
社団法人日本分析機器工業会
備考 ◎印は,小委員会委員長,○印は,小委員会委員を兼ねる。
*印は,平成6年10月に小島委員から山内委員に交代。