K 0055 : 2002
(1)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
まえがき
この規格は,工業標準化法第14条によって準用する第12条第1項の規定に基づき,財団法人化学物質
評価研究機構 (CERI) /財団法人日本規格協会 (JSA) から,工業標準原案を具して日本工業規格を改正す
べきとの申出があり,日本工業標準調査会の審議を経て,経済産業大臣が改正した日本工業規格である。
これによってJIS K 0055 : 1986は改正され,この規格に置き換えられる。
JIS K 0055には,次に示す附属書がある。
附属書(規定) 校正用ガス
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
K 0055 : 2002
ガス分析装置校正方法通則
General rules for calibration method of gas analyzer
1. 適用範囲 この規格は,ガスの定量分析を行うためのガス分析装置(以下,分析装置という。)の目盛
値又は出力値(以下,目盛値という。)を,校正用ガスを用いて校正する方法の通則について規定する。
2. 引用規格 次に掲げる規格は,この規格に引用されることによって,この規格の規定の一部を構成す
る。これらの引用規格は,その最新版(追補を含む。)を適用する。
JIS B 7957 大気中のオキシダント自動計測器
JIS K 0211 分析化学用語(基礎部門)
JIS K 0212 分析化学用語(光学部門)
JIS K 0213 分析化学用語(電気化学部門)
JIS Z 8103 計測用語
3. 定義 この規格で用いられる主な用語の定義は,JIS K 0211, JIS K 0212, JIS K 0213及びJIS Z 8103
によるほか,次による。
a) ガス分析装置 ガス試料採取部,分析計,指示記録計などからなる装置。
b) 校正用ガス 分析装置の校正に用いる標準ガスで,ゼロガス・スパンガス・中間点ガスの総称。
c) ゼロガス 分析装置の最小目盛値を校正するために用いる校正用ガス。
d) スパンガス 分析装置の所定の測定段階(レンジ)の,最大目盛付近の目盛値を校正するために用い
る校正用ガス。
e) 中間点ガス 分析装置の所定の測定段階(レンジ)内の,最小目盛と最大目盛の間の目盛値を校正す
るために用いる校正用ガス。
f)
希釈ガス 校正用ガスを調製する際に,目的成分ガスをある濃度に希釈するために用いるガスで,目
的成分ガスに経時変化を起こさせるような成分又は測定値に影響を与えるような成分を含まないもの。
g) 高純度物質 校正用成分ガスの原料物質で,高純度であるもの。
h) 指示誤差 分析装置の目盛を標準ガスによって校正したとき,標準ガスの表示濃度又は指示濃度と分
析装置の指示値との偏差。通常,指示誤差は分析装置の測定段階(レンジ)ごとの最大目盛値に対す
る偏差を百分率で表す。
4. 校正用ガス 校正用ガスは,次に示す方法によって調製されたものを用いる。
なお,使用する規格に校正用ガスが規定されている場合は,それに従う。
備考 校正用ガスの調製方法は附属書参照。
a) 容器詰め校正用ガス 容器詰め校正用ガスは,次による。
2
K 0055 : 2002
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
1) 計量法トレーサビリティ制度などにおいて供給されている実用標準ガス。
2) 高純度物質又は既知濃度のガスと希釈ガスとを質量比混合法,体積比混合法,質量体積比混合法及
び圧力比混合法によってガス容器(1)に調製,又は流量比混合法によってガス容器(1)に充てんし,濃
度値を確定し,その濃度の安定性が確認されたガス。
注(1) ここでいう容器とは,市販されている高圧ガス容器又はスプレー缶詰の標準ガス容器のほか,
校正用ガス調製に用いるガラス製,ステンレス製容器などを含む。
b) 校正用ガス調製装置による校正用ガス 容器詰め校正用ガスなどの既知濃度のガスを原料ガスとして,
連続的に希釈する装置(2),高純度物質から一定濃度を連続的に発生させる調製装置(3)又は成分ガスを
一定濃度で連続的に発生・希釈する装置(4)から得られたガスを用いる。
注(2) 流量比混合法による校正用ガス調製装置は,計量法の特定計量器検定検査規則第20条の規定に
基づく検査又は附属書4.1.2の流量比の校正方法で性能確認を行う。
(3) パーミエーションチューブ法又は蒸気圧法によって校正用ガスを発生させる装置を指す。
(4) オゾン,ホルムアルデヒドのようにオゾン発生装置,ホルムアルデヒド発生装置などを用いて,
定濃度で発生させた成分ガスをガス希釈装置などで濃度調製する校正用ガス調製装置を指す。
これらの装置で調製した校正用ガスは,ガス発生濃度を正確に求める実測でガス濃度を求め使
用する。
5. 校正
5.1
準備
5.1.1
校正用ガスの選定 校正用ガスの選定に当たっては,混合成分の種類・濃度・精度,校正用ガス調
製装置の性能などについて,分析装置の条件に適合するものを選ばなければならない。
備考 ゼロガスは,一般的には純度の確認された高純度窒素,高純度空気,零位調整標準ガスなどを
用いるが,測定対象ガスが極低濃度であるときには,これらの品質基準でも不十分の場合があ
る。このような場合,ゼロガス精製器などを用いて更に精製したものをゼロガスとして用いる。
5.1.2
分析装置の設置,配管及び接続 分析装置は,隣接区域からのコンタミネーション,振動,電源電
圧変動,温度変動などの影響のない環境に設置する。また,校正用ガスを分析装置に導入するための配管
接続は,できる限り短く,かつ,遊び空間ができないように,定められた導入口に接続する。
さらに,配管の材質には,吸着性,反応性及び透過性が小さいものか無視できるもの(例えば,ステン
レス鋼,四ふっ化エチレン樹脂など)を用いる。
なお,高圧ガス容器に充てんされた校正用ガスを使用する際には,圧力調整機構をもつ調整器(5)を使用
し,そのダイアフラムの材質は,吸着性,反応性の小さいものか,無視できるもの(金属製のものが望ま
しい。)を使用する。
注(5) 圧力調整を必要としない場合は,ニードル弁などでもよい。
備考 ガスクロマトグラフ質量分析装置などの高純度キャリヤーガスを用いるガス分析装置は,高圧
ガス容器を交換する際の大気の混入を防ぐため,大気遮断弁,配管内のバージ機能及び流路切
替えなどを十分考慮した配管とする必要がある。
5.2
ゼロ及びスパン調整(6) ゼロ及びスパン調整の実施周期は,分析装置の種類・用途に応じ,その性
能が維持できる期間を調べて,あらかじめ定めておかなければならない。通常,測定開始・終了時のほか,
必要に応じて8時間,24時間,1週間,1か月などを周期として,次によって行う。
a) 分析装置が定常状態に達したことを確認する。
3
K 0055 : 2002
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
b) ゼロガスを設定流量で導入し,指示が安定した後,ゼロ調整を行う(7)。
c) スパンガスを設定流量で導入し,指示が安定した後,スパン調整を行う(7)。
d) 必要に応じてb)及びc)の操作を交互に繰り返して行い,ゼロ,スパン,それぞれの指示が,指定の再
現性内で一致したことを確認する。
注(6) ここでいうゼロ及びスパン調整は,連続分析装置の方法であり,ガスクロマトグラフなどの間
欠式分析装置は,a)〜b)に準じて基線(ベースライン)の安定性及び指示値の再現性を確認す
る。
(7) ゼロ調整及びスパン調整は,ゼロドリフト及びスパンドリフトを考慮し,最小目盛値付近及び
最大目盛値付近に調整する。
なお,ゼロ及びスパン調整の代わりに,測定対象ガス濃度を挟む2段階の中間点ガスを用い
て校正点を調整してもよい。
5.3
定期校正
5.3.1
定期校正 定期校正の実施周期は,分析装置の種類・用途に応じ,その性能が維持できる期間を調
べて,あらかじめ定めておかなければならない。通常,1か月,3か月,6か月など,少なくとも1か年を
超えない期間を周期として行う。また,分析装置の設置時,修理後,校正用ガスの更新時などにも行う。
5.3.2
校正曲線の作成方法
a) 校正点の設定 分析装置の使用測定段階(レンジ)について,ゼロ点並びに最大目盛値のおおよそ20%,
40%,60%,80%及び100%に相当する点を校正点とする。
なお,校正点があらかじめ指定されている分析装置は,その指定された点又は目盛値とする。また,
分析装置の直線性が確認されているものは,ゼロ点及び試料ガスより高い濃度の2点,又は試料ガス
濃度より低い濃度及び高い濃度の2点を校正点としてもよい。
b) 校正曲線の作成 分析装置を,5.2の要領で,ゼロ及びスパン調整を行った後,a)で設定した各校正点
に相当する中間点ガスをゼロ及びスパン調整したときと同一条件で分析装置に導入し,各中間点濃度
に対する分析装置に指示値を読み取る。
これをそれぞれ2回以上繰り返して行い,指定の再現性内で一致した指示値の平均をとる。
以上の結果から,校正用ガスの濃度と分析装置の指示値との関係を求め,これを校正曲線とする。
5.3.3
校正曲線の確認 定期校正では,既に作成されている校正曲線が5.3.2の方法によって校正した場
合に,その分析装置に定められた指示誤差内で一致するかどうかを調べ,一致するように分析装置の維持
管理を行う。
4
K 0055 : 2002
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書(規定) 校正用ガス
1. 適用範囲 この附属書は,規格本体4.に示す校正用ガスの調製方法について規定する。
2. 質量比混合法による調製
2.1
概要 質量比混合法とは,高圧ガス容器に原料純物質と希釈ガスを充てんし,それぞれの質量をひ
ょう量し,ガス濃度を求める方法をいう。
2.2
原料,器具及び装置 原料,器具及び装置は,次による。
a) 高純度物質 通常は純度99.5vol%(又はwt%)以上のものを用いる。
b) 希釈ガス 高純度物質及び校正用ガスを希釈するために用いる適正な品質であることが確認されてい
るもの。
c) 高圧ガス容器 充てんガスと使用する容器の内面は,充てんするガスとの反応及び吸着のないもの。
d) 充てん装置 配管が充てんガスとの反応及び吸着のない耐圧性ものであり,真空排気装置,圧力計及
び除害装置を備えているもの。
e) 超大型精密天びん 高圧ガス容器をひょう量できる大容量であり,かつ,1mgのけたまでひょう量で
きる高性能なもの。
2.3
調製操作 調製操作は,次による。
a) 高圧ガス容器内のガスを,内圧0.1〜1Paになるまで真空引きを行う。
b) 高圧ガス容器の質量m0を測定する。
c) 高圧ガス容器に,高純度物質を目標量充てんする。このときあらかじめ充てん圧を算出しておき,そ
れを目安にして充てんする。
d) 高純度物質を含む容器の質量m1を測定する。
e) 高圧ガス容器に,希釈ガスを必要量充てんする。
f)
高純度物質及び希釈ガスを含む容器の質量m2を測定する。
2.4
計算 濃度を次の式によって算出する。
b
m
a
m
a
m
C
B
A
A
/
/
/
+
=
ここに,
C: 校正用ガス体積濃度
a: 高純度物質1molの質量
b: 希釈ガス1molの質量
mA: 高純度物質の質量 (m1−m0)
mB: 希釈ガスの質量 (m2−m1)
備考 高圧ガス容器の質量は,湿度などの環境条件影響を受けやすいため,この誤差を小さくするた
めに充てん容器とほとんど同じ形状及び質量の容器(タラ容器)も充てん容器と交互に質量測
定を行い,タラ容器の質量との差で充てん量を求めていくとよい。
3. 固定容器による調製方法
3.1
概要 内容積既知のガラス製容器又はキャニスターなどに定量の希釈ガス及び高純度物質又は既知
濃度のガスを入れ,校正用ガスを調製する。
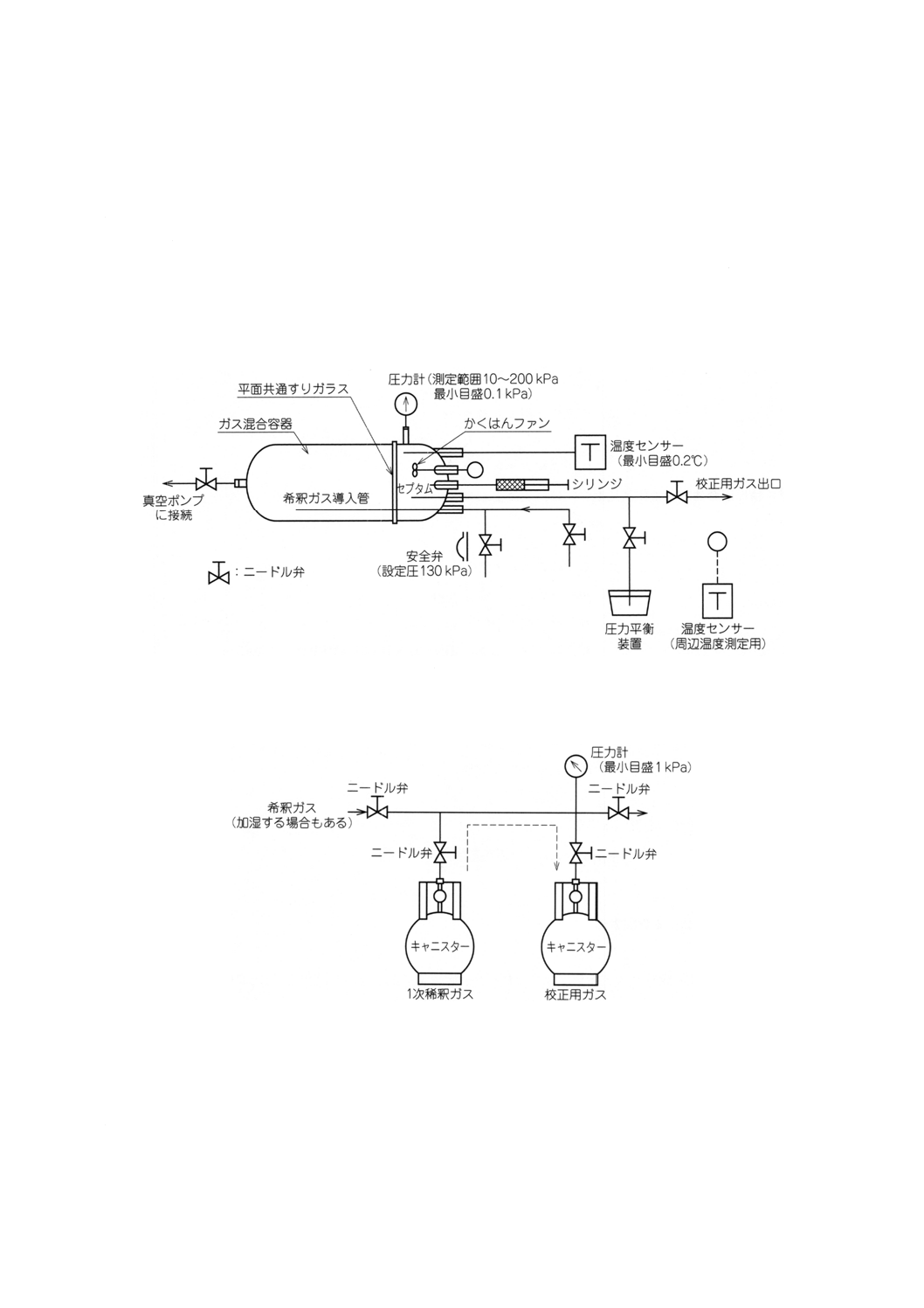
5
K 0055 : 2002
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
成分ガス量を質量で,かつ,希釈ガス量を容積で計量する方法を質量体積比混合法,又は成分ガス及び
希釈ガス量を容積で計量する方法を体積比混合法若しくは圧力で計量する方法を圧力比混合法という。
3.2
原料,器具及び装置 原料,器具及び装置は,次による。
a) 高純度物質 2.2a)による。
b) 希釈ガス 2.2b)による。
c) ガス混合容器 充てんガスと使用する容器の内面は,充てんするガスとの反応及び吸着のないもの。
附属書図1及び附属書図2に一例を示す。
附属書図1 校正ガス調製用混合容器(一例)
附属書図2 キャニスター:ステンレス製真空容器(一例)
3.3
調製操作
3.3.1
混合容器を用いる場合 混合容器を用いる場合は,次による。
a) 混合容器内を,内圧が10Pa以下になるまで真空ポンプで減圧する。
b) 混合容器内に希釈ガスを一定圧(例えば,110kPa)充てんし,そのときの充てん圧と容器内ガス温度
6
K 0055 : 2002
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
を測定する。
c) シリンダを用いて混合容器内に原料純物質又は既知濃度のガスを一定量入れる。そのときの充てん量
は,質量,容量又は容器内圧から算出する。
3.3.2
キャニスターを用いる場合 キャニスターを用いる場合は,次による。
a) キャニスター内を,内圧が10Pa以下になるまで真空ポンプで減圧する。
b) 希釈ガスを入れ圧力 (P1) を読む。
c) 既知濃度の1次希釈校正用ガスを入れ圧力 (P2) を読む。
d) さらに希釈ガスを入れ圧力 (P3) を読み,希釈率P3/ (P2−P1) を求める。
3.4
計算 計算は,次による。
a) 体積比混合法 体積比混合法は,次による。
6
X
A
X
10
×
V
V
V
C
+
=
ここに,
C: 校正用ガス濃度 (vol ppm)
VX: シリンジで注入した成分ガス容量 (ml)
VA: 希釈ガス量 (ml)
b) 質量体積比混合法 質量体積比混合法は,次による。
000
1
24.47×
×
×
Q
M
m
C=
ここに,
C: 校正用ガス濃度 (vol ppm)
m: 成分ガスの質量 (mg)
M: 成分ガスの分子量
Q: 容器内の総ガス量[25℃・101.32kPa換算ガス量 (L)]
c) 圧力比混合法 圧力比混合法は,次による。
1) 原料純物質で調製する場合
6
B
A10
×
P
P
C=
ここに,
C: 校正用ガス濃度 (vol ppm)
PA: 成分ガスの圧力
PB: 全圧
2) 3.3.2のキャニスターを用いる場合
希釈率
次希釈校正用ガス濃度
校正用ガス濃度=1
4. 校正ガス調製装置による調製方法
4.1
流量比混合法
4.1.1
概要 既知濃度の成分ガスと希釈ガスをそれぞれ一定流量で流しながら混合し,所定濃度の校正用
ガスを調製する。
なお,校正用ガス調製装置は,流量比の校正,装置の内部及び配管の漏れ試験,ガス吸着性の有無の確
認を行ってから用いる。
4.1.2
流量比の校正方法 校正用ガス調製装置の流量比簡易校正法を,次に示す。
a) 低濃度及び高濃度の標準ガスを用いて希釈率を校正する方法 高濃度の標準ガスを校正用ガス調製
装置で希釈したガスと,低濃度の標準ガスをそのまま,ガス分析装置に交互に導入し,希釈率を確認

7
K 0055 : 2002
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
する方法である。標準ガスは,例えばメタン又は一酸化炭素のような,低濃度でも安定であり,国家
標準にトレーサブルなものを使用する。校正用ガス調製装置の希釈精度を超える誤差(1)が見られた場
合は,希釈率の校正を行う。
注(1) 流量比混合法による校正用ガス調製装置は,特定計量器検査規則第20条の規定に基づく検査基
準値の以内又は次に示す希釈精度以内であること。
1) 校正用ガス調製装置で設定した希釈校正用ガス濃度(指示濃度)と国家計量標準とトレーサブルな
標準ガスによって値付けされた濃度(測定値)関係について,次の式によって算出した値(偏差)
が±5%以下でなければならない。
100
)
(
×
測定値
指示濃度−測定値
=
%
偏差
2) 濃度比5 : 1の範囲内での指示濃度−測定値関係が直線関係からずれる度合いは,濃度範囲に応じて
最大指示濃度の±3%以下でなければならない。
附属書図3 標準ガスで校正する方法(一例)
b) 校正済み校正用ガス調製装置と比較することによる方法 基準流量計(2)などによって校正された校正
ガス調製装置と比較し,希釈率を校正する。
注(2) 基準流量計は流量計が気体流量の特定計量器にトレーサブルなもの,石けん膜流量計などの精
度の確保されている流量測定方法で校正したものでなければならない。
附属書図4 基準用校正ガス調製装置で校正する方法(一例)
4.2
パーミエーションチューブ法

8
K 0055 : 2002
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
4.2.1
概要 パーミエーションチューブ法に用いるパーミエーションチューブは,一定品質のふっ素樹脂
管などに高純度の液化ガスや液体を封入したもので,これを恒温に保持すると,単位時間に管壁を浸透拡
散するガス量(浸透速度)が一定となる。したがって,そこに空気や窒素などの希釈ガスを定流量送れば,
微量濃度の校正用ガスが連続的に得られる。この調製方法は,質量計測によって求められた浸透速度と希
釈ガス流量など基礎的な物理量のデータからガス濃度を求める方法である。
調製できるガスの種類は,塩素,硫化水素,アンモニア,二酸化硫黄,二酸化窒素,ベンゼンなどの液
化ガスや液体である。
4.2.2
器具及び装置 器具及び装置は,次による。
a) 調製装置 附属書図5に調製装置の一例を示す。
附属書図5 パーミエーションチューブ校正用ガス調製装置(一例)
b) パーミエーションチューブ 十分な耐化学特性をもつ高分子化合物で,一般にポリテトラフロロエチ
レン (PTFE),ポリエチレン,ポリプロピレン及びテトラフロロエチレンとヘキサフロロプロピレンの
共重合体 (FEP) などに,高純度の液化ガスや液体が封入されたものを用いる。
4.2.3
操作 操作は,次による。
a) パーミエーションチューブを恒温に保った状態で空気や窒素などの希釈ガスを適当量流し,1〜2日放
置する。その後,適当な間隔でパーミエーションチューブを恒温槽から取り出してひょう量を繰り返
し,質量減少量とひょう量間隔時間を記録する。
b) 質量減少量とひょう量間隔時間から単位時間当たりの浸透速度 (μg/min) を求める。
c) 浸透速度が一定になった後,校正用ガスとして使用する。
4.2.4
濃度の計算 浸透速度と希釈ガスの流量から,次の式で求める。
(
)
V
M
t
P
C
×
×
×
273
/
273
22.4
r
+
=
ここに,
C: 校正用ガス濃度 (vol ppm)
Pr: 浸透速度 (μg/min)
M: 校正用成分ガスの分子量
V: 校正用ガス出口におけるガス流量(≒希釈ガス流量)(L/min)
t: 環境温度 (℃)
4.3
蒸気圧法
4.3.1
概要 液体純物質の飽和蒸気圧と温度との関係から,発生ガス濃度を求める方法である。
4.3.2
装置 装置の一例を附属書図6に示す。
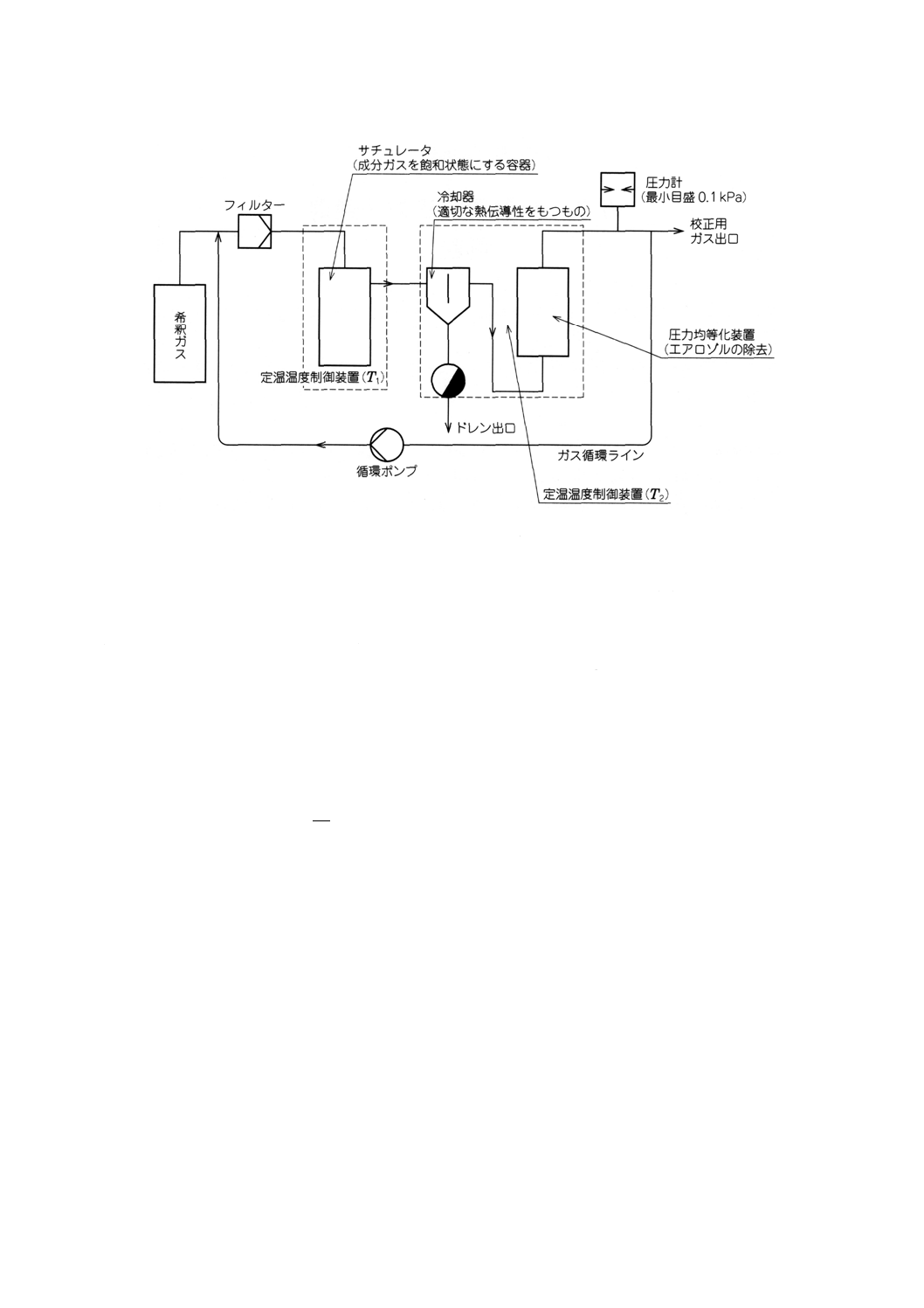
9
K 0055 : 2002
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書図6 蒸気圧法による校正用ガス調製装置(一例)
4.3.3
操作 操作は,次による。
a) 定温温度制御装置の温度 (T1) を設定し,次にその温度よりも5℃低い温度 (T2) を設定する。
b) サチュレータに液体純物質を入れ,希釈ガスを小流量(3)流す。
c) ガス濃度が安定したとき(4)の温度 (T2) 及び圧力計の圧力 (P) を記録する。
注(3) 校正用ガス出口におけるガス温度と冷却器の設定温度 (T2) が同じになるようにガス流量を調
節する。
(4) 1時間以上装置を稼動させ,発生ガスを一定間隔で分析装置に導入し,濃度の安定性を確認し
た後,校正用ガスとして用いる。
4.3.4
濃度の計算
6
X
10
×
P
P
C=
ここに,
C: 校正用ガス濃度 (vol ppm)
PX: T2の温度における校正用ガス成分の飽和蒸気圧
P: 全圧
4.3.5
成分ガス発生方式による方法 電気分解,化学分解又は合成,熱分解又は紫外線照射などの方式に
よるガス発生装置で校正用ガス成分物質を発生させ,この発生ガスを希釈ガスと混合して校正用ガスを調
製する。校正用ガス濃度は,それぞれ定められた方法(5)によって求める。
注(5) オゾン発生装置は,JIS B 7957の8.2.2の(1)参照。
10
K 0055 : 2002
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業標準調査会 標準部会 一般化学技術専門委員会 構成表
氏名
所属
(委員会長)
川 瀬 晃
セイコーインスツルメンツ株式会社科学機器事業部
(委員)
齋 藤 壽
社団法人日本分析機器工業会
角 田 欣 一
群馬大学工学部応用化学科
中 村 陽
旭化成株式会社研究開発本部基盤技術センター
中 村 進
独立行政法人産業技術総合研究所
中 村 洋
東京理科大学薬学部
西 川 輝 彦
石油連盟
西 本 右 子
神奈川大学理学部化学科
槇 宏
日本プラスチック工業連盟
松 本 潔
社団法人日本化学工業協会
松 本 保 輔
財団法人化学物質評価研究機構
森 嵜 功 一
社団法人日本試薬協会