K 0161:2010
(1)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
目 次
ページ
序文 ··································································································································· 1
1 適用範囲 ························································································································· 1
2 引用規格 ························································································································· 1
3 用語及び定義 ··················································································································· 1
4 記号及び略語 ··················································································································· 1
5 装置性能を示す主要な項目の記載方法 ·················································································· 2
5.1 分析手法 ······················································································································ 2
5.2 試料 ···························································································································· 2
5.3 構成及び配置 ················································································································ 2
5.4 電子線源 ······················································································································ 2
5.5 空間分解能及びビーム電流······························································································· 2
5.6 装置の信号強度特性及びエネルギー分解能 ·········································································· 5
5.7 装置のエネルギー軸 ······································································································· 5
5.8 装置の強度軸の直線性 ···································································································· 5
5.9 装置の応答関数 ············································································································· 5
5.10 装置のパラメータ ········································································································· 6
5.11 像ドリフト ·················································································································· 6
5.12 真空環境 ····················································································································· 6
5.13 主要項目の記載事例 ······································································································ 6
附属書JA(参考)主要項目の記載事例 ····················································································· 7
附属書JB(参考)JISと対応国際規格との対比表 ······································································· 9
K 0161:2010
(2)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
まえがき
この規格は,工業標準化法第12条第1項の規定に基づき,財団法人日本規格協会(JSA)から,工業標
準原案を具して日本工業規格を制定すべきとの申出があり,日本工業標準調査会の審議を経て,経済産業
大臣が制定した日本工業規格である。
この規格は,著作権法で保護対象となっている著作物である。
この規格の一部が,特許権,出願公開後の特許出願,実用新案権又は出願公開後の実用新案登録出願に
抵触する可能性があることに注意を喚起する。経済産業大臣及び日本工業標準調査会は,このような特許
権,出願公開後の特許出願,実用新案権及び出願公開後の実用新案登録出願にかかわる確認について,責
任はもたない。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格 JIS
K 0161:2010
表面化学分析−オージェ電子分光法−
装置性能を示す主要な項目の記載方法
Surface chemical analysis-Auger electron spectroscopy-
Description of selected instrumental performance parameters
序文
この規格は,2004年に第1版として発行されたISO 15471を基に,対応する部分については対応国際規
格を翻訳し,技術的内容を変更することなく作成した日本工業規格であるが,対応国際規格には規定され
ていない規定項目を日本工業規格として追加している。
なお,この規格で点線の下線を施してある箇所は,対応国際規格にはない事項である。変更の一覧表に
その説明を付けて,附属書JBに示す。
1
適用範囲
この規格は,オージェ電子分光器(以下,装置という。)の性能項目を記載する方法について規定する。
注記 この規格の対応国際規格及びその対応の程度を表す記号を,次に示す。
ISO 15471:2004,Surface chemical analysis−Auger electron spectroscopy−Description of selected
instrumental performance parameters(MOD)
なお,対応の程度を表す記号“MOD”は,ISO/IEC Guide 21-1に基づき,“修正している”
ことを示す。
2
引用規格
次に掲げる規格は,この規格に引用されることによって,この規格の規定の一部を構成する。この引用
規格は,その最新版(追補を含む。)を適用する。
JIS K 0147 表面化学分析−用語
注記 対応国際規格:ISO 18115,Surface chemical analysis−Vocabulary(IDT)
3
用語及び定義
この規格で用いる主な用語及び定義は,JIS K 0147による。
4
記号及び略語
この規格で用いる主な記号及び略語は,次による。
AES [Auger electron spectroscopy (also Auger electron spectrometer)]:オージェ電子分光法(又はオージェ
電子分光器)
FWHM (full width at half maximum):半値幅
2
K 0161:2010
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
rms (root mean square):二乗平均平方根
SAM [scanning Auger electron microscope (also scanning Auger electron microscopy)]:走査オージェ電子顕
微鏡(又は走査オージェ電子顕微鏡法)
SEM (scanning electron microscope):走査電子顕微鏡
FL (Fermi level):フェルミ準位
VL (vacuum level):真空準位
XPS [X-ray photoelectron spectroscopy (also X-ray photoelectron spectrometer)]:X線光電子分光法(又はX
線光電子分光器)
注記 歴史的に,XPS又はAES/XPS複合装置はFLを基準にしているのに対し,AESの運動エネルギ
ー軸はVLを基準としている。FLからVL基準へは,電子の運動エネルギーの値から装置の仕
事関数の値を引くことで変換できる。一般的なAES及びSAMのアプリケーションの場合,近
似的には,FL基準の運動エネルギーから4.5 eV引くことで十分である。
5
装置性能を示す主要な項目の記載方法
5.1
分析手法
試料から情報を得る方法に関する事項を記載しなければならない。また,検討している装置における,
オプションとしての他の分析手法に対する有効性も記載しなければならない。
5.2
試料
装置の性能に適した試料の寸法及び形状を記載しなければならない。例えば,角度分解測定,絶縁物測
定などの特別な分析モードにすることによって,試料の寸法及び形状が制限される場合は,その試料の寸
法及び形状を記載しなければならない。
5.3
構成及び配置
分析に重要な装置の構成部品(コンポーネント)について,設計上の幾何学的配置及びそれらの許容差
について記載しなければならない(例参照)。
例 角度30°±1°
5.4
電子線源
5.4.1
カソードタイプ
カソードのタイプを記載する。システムの記載例は,次による。
例 熱陰極形タングステン,六ホウ化ランタン(LaB6),冷陰極電界放出形タングステン(110),ショ
ットキー形
5.4.2
カソード寿命
5.5で規定する操作条件でのカソードの予想寿命値を記載する。通常,この値は保証寿命値であるが,そ
の代わりに平均寿命実績値でもよい。ただし,記載した寿命の定義を記載する。また,5.5で規定する加速
電圧でのエミッション電流を記載する。
5.5
空間分解能及びビーム電流
5.5.1
一般
空間分解能は,次の条件によって規定しなければならない。
a) 電子線の各加速電圧における特定条件での AES 空間分解能。
b) 空間分解能の測定は,5.5.2〜5.5.4 のいずれかの方法で測定しなければならない。
c) 加速電圧は,5 keV及び10 keVとする。それが不可能であれば,5 keV又は10 keVとする。さらに,

3
K 0161:2010
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
必要であれば他の適切な加速電圧も追加して,典型的な空間分解能を電流の関数として示さなければ
ならない。
注記 装置の空間分解能をガウス関数で表す場合は,FWHM は測定信号が最大値の12 %〜88 %の
変化に対応する距離に対応する。AESにおいては,試料表面から放出されるオージェ電子の
2次元分布は,ガウス分布形状の入射電子ビームによる発生領域に,後方散乱電子によって
励起された発生領域が重なった分布となる。このため,ステップ端を横切るオージェ電子信
号強度が20 %〜80 %まで変化する距離が空間分解能に対応すると定義するのが便利であり,
ガウス形分解能関数の71.5 %と同等である。この方法には物理的根拠がないが,広く使われ
ている。
5.5.2
手法1
試料が,装置のもつ空間分解能の30 %より小さい,孤立した特徴的な構造をしている場合に適用する方
法。その構造物からのオージェ電子信号強度による線分析から評価されるFWHMを空間分解能とする。
この場合,特徴付ける信号が,最大値の50 %〜100 %に上昇し,再度50 %に減少するまでの距離を空間分
解能とする(図1参照)。
図1−空間分解能の概念図
注記1 孤立した特徴的な構造物の幅が空間分解能の30 %より大きい場合は,評価される分解能は真
の空間分解能より大きくなる。
注記2 微細な試料を使うことで,装置の非点収差を調べることができる。
5.5.3
手法2
二つの物質が,同一面上で共通の直線に沿って接した試料に適用する方法。二つの物質のうちの一つを
特徴付けるオージェ電子を対象として,線分析を境界に垂直に行うことで空間分解能が得られる。オージ
ェ電子信号強度がプラトー部[平たん(坦)部]とエッジ外側部分との信号強度変化量の20 %〜80 %の変
化に対応する距離を,走査方向での空間分解能とする(図2参照)。
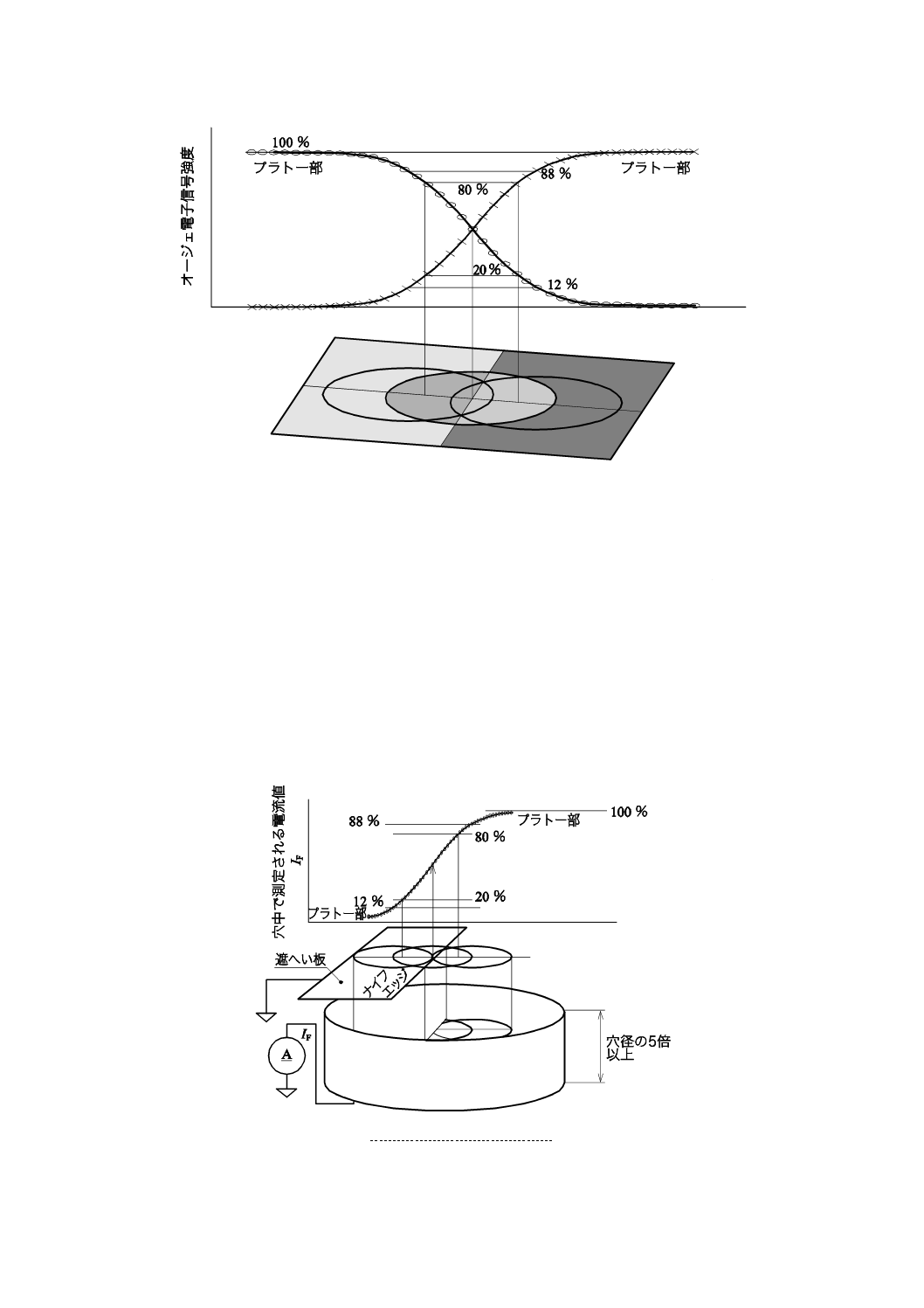
4
K 0161:2010
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図2−空間分解能の概念図
注記1 空間分解能がガウス形分解能関数で表されるならば,その距離は,分解能関数のFWHMの
71.5 %となる。
注記2 分解能の限界に近付くと非点収差が見られる場合がある。その場合には,複数の方位で空間
分解能を決定する必要があるときもある。
5.5.4
手法3
試料面で一つの物質がナイフエッジを形成している場合に適用する方法。穴径の5倍以上の深さをもつ
穴の上にエッジがあることが条件となる。オージェ電子励起用電子線を,エッジに垂直方向に走査するこ
とで空間分解能が得られる。プラトー部とエッジ外側部分との電流変化量の20 %〜80 %の変化に対応する
距離を,走査方向での空間分解能とする(図3参照)。
図3−空間分解能の概念図
5
K 0161:2010
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
注記1 空間分解能がガウス形分解能関数で表されるならば,その距離は,分解能関数のFWHMの
71.5 %となる。
注記2 分解能の限界に近付くと非点収差が見られる場合がある。その場合には,複数の方位で空間
分解能を決定する必要があるときもある。
5.6
装置の信号強度特性及びエネルギー分解能
5.6.1
一般
装置の信号強度特性は,(直接スペクトル測定モード)918 eVにおけるCu L3VVの強度(計数率)と950
eV におけるバックグラウンド強度(計数率)との差とする。パルスカウンティング測定系の場合,特性
は,ビーム電流nA当たりの計数率の差,又はその代わりに,最適なエネルギー分解能及び最適な感度そ
れぞれに対して決まる,ビームエネルギー及びビーム電流に対する計数率の差で特徴付けられる。装置が
異なるエネルギー分解能で動作可能であるなら,異なったエネルギー分解能それぞれでの特性,バックグ
ラウンド強度及びバックグラウンド上のピークのFWHMが,少なくとも一つのビームエネルギーに対し
て与えられなければならない。信号対ノイズ比は,918 eV及び950 eVで1秒間積算して得られた装置の
光電子信号強度特性と,5.6.2又は5.6.3による方法で得られたノイズとの比として定義しなければならな
い。ノイズの測定方法も記載しなければならない。
5.6.2
手法1
ノイズは,それぞれの測定(チャンネル)を積算時間1秒で,かつ,約0.2 eVのチャンネル間隔で970 eV
と994 eVとの間を,等エネルギー間隔で測定したバックグラウンド強度における,121点の独立したデー
タに対するrmsによる偏差で定義する。rmsによる偏差は,測定強度に対する直線による最小二乗近似か
らの測定強度の偏差によって計算する。
5.6.3
手法2
ノイズは,975 eVにおけるバックグラウンド強度について,それぞれ積算時間1秒で測定された121個
のデータの,それ自身の平均値に対するrmsによる偏差で定義する。
5.7
装置のエネルギー軸
エネルギー軸は,フェルミ準位を基準として定め,次の事項を規定しなければならない。
a) エネルギー軸の直線性
b) 装置の取扱説明書に記載されている手順によって,位置を調整した試料で測定した,Cu L3VVピーク
エネルギー値の標準偏差で表す繰返し性
c) Cu L3VVピーク位置における校正の正確さ
注記 中エネルギー分解能の装置のエネルギー軸校正法については,ISO 17973で規定している。
同様に,高エネルギー分解能の装置のエネルギー軸校正法については,ISO 17974で規定し
ている。
5.8
装置の強度軸の直線性
実用的な測定条件範囲における最大計数率,及び計数率の直線性として定義された制限値(例えば,±
2 %)における最大計数率を記載する。
5.9
装置の応答関数
装置の感度特性を記した測定条件に対して,装置の応答関数を与えることが望ましい。この応答が一定
に保たれる期間も記載しなければならない。
6
K 0161:2010
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
5.10 装置のパラメータ
5.10.1 装置の収差
電子線の入射位置の分散に伴うピーク位置のずれを記載する。入射電子線の照射位置を試料表面上でX
方向,Y方向及び Z方向に移動したときの,約918 eVのCu L3VVピーク位置のシフト量をeV/mm単位
で表す。
5.10.2 分析領域
分析領域を記載する。試料表面上で入射電子線を走査する領域又は分析器の分析領域のいずれかで決め
る。分析領域とは,Cu L3VV(約918 eV)及びCu M23VV(約62 eV)の両方のピークが,中心で測定した
強度の95 %以上を与える領域と定義する。
5.11 像ドリフト
画像化システムでは,像のドリフト速度を,所定の設置環境に対して定めなければならない。
5.12 真空環境
規定された温度で12時間ベーキングした後,24時間経過後のベースプレッシャー又は規定されたベー
スプレッシャーに到達する時間を記載する。また,規定された真空度で分析するために必要な試料導入時
間も記載しなければならない。
5.13 主要項目の記載事例
この規格で規定する記載事項の例を,附属書JAに示す。

7
K 0161:2010
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書JA
(参考)
主要項目の記載事例
この附属書は,この規格が規定する主要項目の記載例であって,規定の一部ではない。
JA.1 記載例
主要項目の記載例を,次に示す。
AES(AES ME-5AUGER)に関する主要項目表(JIS K 0161に準拠)
20XX年 月 日
○○○株式会社
1 分析手法
試料表面に電子線を照射することで,物質表面領域からのオージェ電子を検出し,組成・化学状態な
どに関する知見を得る手法。
2 試料
10×10×5 mm3 以下
3 構成及び配置
電子線源:試料台水平面に垂直方向から0°±1°
分析器:試料台水平面に垂直
イオン銃:試料台水平面に垂直方向から45°±5°
4 電子線源
4.1 カソードタイプ
ショットキー形
4.2 カソード寿命
10 000時間(経験値)
5 空間分解能及びビーム電流
15 μm @ 10 kV,10 μm @ 20 kV
炭素膜上の金粒子を手法1を用いて測定
6 分光器の信号強度特性及びエネルギー分解能
Cu L3VV
970−994 eVの範囲を0.2 eVステップで測定
50 000±5 000 カウント
7 分光器のエネルギー軸
直線性:ISO 17973を十分に満足
Cu L3VVの繰返し精度:±0.5 eV
Cu L3VVの校正の正確さ:±0.7 eV
8 分光器の強度軸の直線性

8
K 0161:2010
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
1 000 Kcpsで±1 %
9 分光器の応答関数
10 分光器のパラメータ
10.1 分光器の収差
0.3 eV/mm @ Cu L3VV,918 eV
10.2 分析領域
100×100 μm2走査領域 @ Cu L3VV(918 eV),Cu M23VV(62 eV)
11 像ドリフト
<5 nm/時間
温度安定度±1 ℃以下,音響ノイズ 50 dB以下
12 真空環境
150 ℃ 12時間ベーキング後,24時間冷却で1×10−8 Pa以下
参考文献 ISO 17973,Surface chemical analysis−Medium-resolution Auger electron spectrometers−Calibration
of energy scales for elemental analysis
ISO 17974,Surface chemical analysis−High-resolution Auger electron spectrometers−Calibration of
energy scales for elemental and chemical-state analysis

9
K 0161:2010
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書JB
(参考)
JISと対応国際規格との対比表
JIS K 0161:2010 表面化学分析−オージェ電子分光法−装置性能を示す主要な項目
の記載方法
ISO 15471:2004 Surface chemical analysis−Auger electron spectroscopy−
Description of selected instrumental performance parameters
(Ⅰ)JISの規定
(Ⅱ)
国際規格
番号
(Ⅲ)国際規格の規定
(Ⅳ)JISと国際規格との技術的差異の箇条
ごとの評価及びその内容
(Ⅴ)JISと国際規格との技術的差
異の理由及び今後の対策
箇条番号
及び題名
内容
箇条番号
内容
箇条ごと
の評価
技術的差異の内容
5.5.1
一般
5.5.1
a)
SEM
削除
AES装置に関する規定である
ためSEMに関する項目を削除
−
5.5.1
c)
本文をc)に
分解能の記載
5.5.1
本文に記載
一致
明りょう化のために項目を独
立した。
技術的差異はない。
5.5.2
図1
空間分解能の概念
図
追加
明りょう化のために図を追加。 技術的差異はない。
5.5.3
図2
空間分解能の概念
図
追加
明りょう化のための追加であ
るが,国際規格に技術的問題点
がある。
次回の国際会議に提案する。
5.5.4
図3
空間分解能の概念
図
追加
明りょう化のための追加であ
るが,国際規格に技術的問題点
がある。
次回の国際会議に提案する。
附属書JA
(参考)
−
追加
参考として記載事例を追加。
技術的差異はない。
JISと国際規格との対応の程度の全体評価:ISO 15471:2004,MOD
注記1 箇条ごとの評価欄の用語の意味は,次による。
− 一致……………… 技術的差異がない。
− 削除……………… 国際規格の規定項目又は規定内容を削除している。
− 追加……………… 国際規格にない規定項目又は規定内容を追加している。
注記2 JISと国際規格との対応の程度の全体評価欄の記号の意味は,次による。
− MOD…………… 国際規格を修正している。
2
K
0
1
6
1
:
2
0
1
0