H 7307:2010 (IEC 61788-7:2006)
(1)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
目 次
ページ
序文 ··································································································································· 1
1 適用範囲 ························································································································· 1
2 引用規格 ························································································································· 1
3 用語及び定義 ··················································································································· 2
4 要求事項 ························································································································· 2
5 装置······························································································································· 2
5.1 測定装置 ······················································································································ 2
5.2 Rs測定ジグ ··················································································································· 3
5.3 誘電体円柱 ··················································································································· 5
6 測定方法 ························································································································· 5
6.1 試料の準備 ··················································································································· 5
6.2 構成 ···························································································································· 6
6.3 基準レベルの測定 ·········································································································· 6
6.4 共振器の周波数応答の測定······························································································· 6
6.5 超電導体の表面抵抗及び標準サファイア円柱のε'及びtan δの決定 ·········································· 8
7 精度及び精確さ ················································································································ 9
7.1 表面抵抗 ······················································································································ 9
7.2 温度 ··························································································································· 10
7.3 試料及びホルダーの支持構造··························································································· 10
7.4 試料保護 ····················································································································· 10
8 試験報告 ························································································································ 11
8.1 試験試料の識別 ············································································································ 11
8.2 Rs値の報告 ·················································································································· 11
8.3 試験条件の報告 ············································································································ 11
附属書A(参考)箇条1から箇条8までの追加参考事項······························································ 12
H 7307:2010 (IEC 61788-7:2006)
(2)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
まえがき
この規格は,工業標準化法第14条によって準用する第12条第1項の規定に基づき,財団法人国際超電
導産業技術研究センター(ISTEC)及び財団法人日本規格協会(JSA)から,工業標準原案を具して日本工
業規格を改正すべきとの申出があり,日本工業標準調査会の審議を経て,経済産業大臣が改正した日本工
業規格である。
これによって,JIS H 7307:2005は改正され,この規格に置き換えられた。
この規格は,著作権法で保護対象となっている著作物である。
この規格の一部が,特許権,出願公開後の特許出願,実用新案権又は出願公開後の実用新案登録出願に
抵触する可能性があることに注意を喚起する。経済産業大臣及び日本工業標準調査会は,このような特許
権,出願公開後の特許出願,実用新案権及び出願公開後の実用新案登録出願にかかわる確認について,責
任はもたない。
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
日本工業規格
JIS
H 7307:2010
(IEC 61788-7:2006)
超電導−エレクトロニクス特性測定法−
超電導体のマイクロ波表面抵抗
Superconductivity-Part 7:Electronic characteristic measurements-
Surface resistance of superconductors at microwave frequencies
序文
この規格は,2006年に第2版として発行されたIEC 61788-7を基に,技術的内容及び構成を変更するこ
となく作成した日本工業規格である。
なお,この規格で点線の下線を施してある参考事項は,対応国際規格にはない事項である。
この規格に規定する方法は,低温超電導体を含めた他のバルク超電導体にも適用できる。
この規格に規定する測定方法は,VAMAS(Versailles Project on Advanced Materials and Standards)の超電
導体薄膜特性標準化準備研究の成果に基づいている。
1
適用範囲
この規格は,標準二共振器法によるマイクロ波帯における超電導体の表面抵抗測定について規定する。
測定の対象は,共振周波数における表面抵抗Rsの温度依存性である。
この方法における表面抵抗の可能な測定範囲は,次のとおりである。
− 周波数:8 GHz〜30 GHz
− 測定分解能:10 GHzで0.01 mΩ
測定した周波数における表面抵抗値及び比較のために周波数2乗則を用いて10 GHzに換算した表面抵
抗値を報告する。
注記 この規格の対応国際規格及びその対応の程度を表す記号を,次に示す。
IEC 61788-7:2006,Superconductivity−Part 7:Electronic characteristic measurements−Surface
resistance of superconductors at microwave frequencies(IDT)
なお,対応の程度を表す記号“IDT”は,ISO/IEC Guide 21-1に基づき,“一致している”こ
とを示す。
2
引用規格
次に掲げる規格は,この規格に引用されることによって,この規格の規定の一部を構成する。この引用
規格は,その最新版(追補を含む。)を適用する。
JIS H 7005 超電導関連用語
注記 対応国際規格:IEC 60050-815,International Electrotechnical Vocabulary−Part 815:
Superconductivity(MOD)
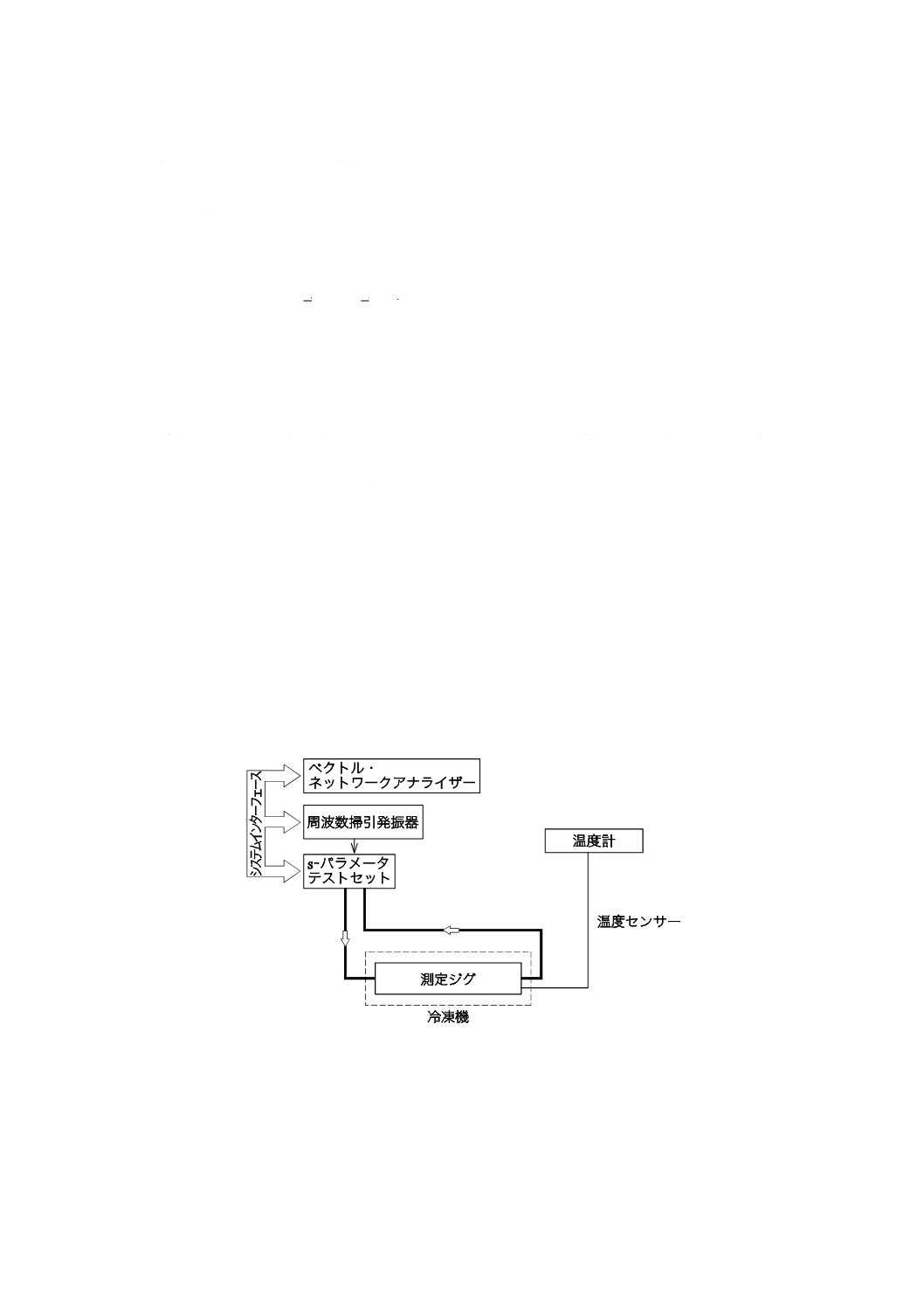
2
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
3
用語及び定義
この規格で用いる主な用語及び定義は,JIS H 7005によるほか,次による。
3.1
表面インピーダンス
一般に,超電導体を含む導体の表面インピーダンスZsは,導体表面における接線方向の電界Etと接線方
向の磁界Htとの比として定義される。
s
s
t
t
s
/
jX
R
H
E
Z
+
=
=
ここに,
Rs: 表面抵抗
Xs: 表面リアクタンス
4
要求事項
超電導薄膜の表面抵抗Rsは,2枚の超電導薄膜試料の間に誘電体円柱を置いて構成する誘電体共振器に
マイクロ波信号を印加し,各周波数における共振器の共振特性から測定する。周波数は共振周波数を中心
として掃引する。さらに,損失に対応するQ値を得るために減衰の周波数特性を記録する。
この方法の目標測定精度は,30 Kから80 Kまでの測定温度範囲において,20 %以下の変動係数(測定
された表面抵抗の標準偏差を平均値で割った値の100倍)である。
注記 Q値は,振動系の共振の鋭さを表す量。詳細は,JIS H 7002を参照するとよい。
5
装置
5.1
測定装置
マイクロ波測定に要求される装置の概略を,図1に示す。装置は,伝送特性測定のためのネットワーク
アナライザーシステム,測定ジグ及び測定温度を計測する温度計から構成されている。
周波数掃引発振器のような適切なマイクロ波源から,測定ジグ中に設置されている誘電体共振器に電力
を印加する。伝送特性はネットワークアナライザーのディスプレイに表示される。
図1−冷凍機を用いたRsの温度依存性測定装置の概略
測定ジグは,温度制御できる冷凍機の中に設置されている。
超電導薄膜Rs測定のためには,ベクトル・ネットワークアナライザーが推奨される。ベクトル・ネット
ワークアナライザーは,スカラー・ネットワークアナライザーよりもダイナミックレンジが広いため,高
い測定精度をもっている。
3
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
5.2
Rs測定ジグ
平滑表面基板上に形成した超電導薄膜のRs測定を行うための典型的な測定ジグ(密閉形の共振器)を,
図2に示す。上部の超電導薄膜はりん青銅でできているばねによって下方に押さえられる。測定精度を向
上するために,板ばねの使用を推奨する。この種のばねは,ばねと他の部品との摩擦を減らすことができ,
そのため誘電体円柱の熱膨張によって生じる超電導薄膜の動きをスムーズにすることができる。測定誤差
を最小限に抑えるために,サファイアが用いられ,サファイア円柱と銅リングを同軸に配置する。
セミリジット同軸線は,外径1.2 mmを推奨する。このセミリジット同軸線は,共振器の伝送特性を測
定するために,軸対称位置に共振器の両サイドから接続される(φ=0°と180°,ここでφはサファイ
ア円柱の中心軸周りの回転角。)。二つのセミリジット同軸線はそれぞれ端末に,小さなループをもつ。不
要のTMmn0モードを抑制するために,そのループの面は,超電導薄膜の面に平行に設置する。度重なる温
度履歴によって生じるかもしれない結合ループの溶接部分のクラックを注意深くチェックする。挿入損失
(IA)を調節するために,二つのケーブルは左右に移動可能にする。この調節で,必要とする誘電体共振
モードに不要な共振モードの励振を抑制することができる。これを行わないと,不要な共振モードとの結
合が,TEモード共振の高いQ値を小さくする。不要な結合を抑制するために,高Q共振器の設計に細心
の注意を払う必要がある。図2に示す密閉形以外に他の二つの異なるタイプの共振器を使うことができる
(A.4参照)。

4
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図2−Rs測定ジグ
セミリジット同軸線で作製された基準同軸線を用いて全透過電力レベル,すなわち基準レベルを測定す
る。この基準同軸線の長さは,測定ジグの2本の同軸線の長さの和に等しくする。

5
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
測定誤差を最小にするために,2枚の超電導膜はお互いに平行になるように設置する。2枚の超電導膜が
サファイア円柱の端部に,エアギャップがないように密接に接触することを保証するために,薄膜の表面
及び円柱の端部を注意深く清掃しなければならない。
5.3
誘電体円柱
同じ比誘電率ε'と誘電損tan δをもつ一対の誘電体円柱が必要なので,これらの一対の円柱は一本の誘電
体円柱から切り出すことが望ましい。それらの一対の誘電体円柱は,同じ直径で高さが異なる。一方がも
う一方の3倍の高さをもつ。
Rs測定を正確に行うために,tan δの小さい誘電体円柱を使用することが望ましい。推奨する誘電体円柱
は,77 Kで10−6以下のtan δをもつサファイア円柱である。サファイア円柱の仕上がり仕様を7.1に示す。
超電導膜のRs測定の誤差を最小限にするためにサファイア円柱の両端面は,平行になるように軸に垂直に
研磨しなければならない。
サファイア円柱の直径と高さとは,TE011及びTE013モードが他のTM,HE,EHモードと結合しないよ
うに,注意深く設計しなければならない。なぜならTEモードと他のモードとの結合は,無負荷Q値の低
下を引き起こすからである。他のモードとの結合を避けるように注意深く設計された一対のサファイア円
柱を,標準サファイア円柱と定義する。標準サファイア円柱の設計指針は,A.5に記載されている。表1
に共振周波数12 GHz,18 GHz及び22 GHzの標準サファイア円柱の代表的な寸法例を示す。より高い周波
数では無負荷Q値はより小さくなる。それは,測定を容易にし,誤差を小さくする。
表1−12 GHz,18 GHz及び22 GHz用一対の標準サファイア円柱の代表的な寸法
共振周波数
GHz
サファイア円柱
直径(d)
mm
高さ(h)
mm
12
短い円柱(TE011 共振器)
11.4
5.7
長い円柱(TE013 共振器)
11.4
17.1
18
短い円柱(TE011 共振器)
7.6
3.8
長い円柱(TE013 共振器)
7.6
11.4
22
短い円柱(TE011 共振器)
6.2
3.1
長い円柱(TE013 共振器)
6.2
9.3
6
測定方法
警告 この規格の使用に当たって,事前に適切な安全及び衛生上の対策を調査し構築すること,制限
規定の適用性を決定することは,利用者の責任である。
この種の測定では危険が伴う。超電導体を超電導状態に転移させるのに適切な冷凍機システ
ムを使用することは基本である。この冷凍機の冷却部に直接皮膚を接触させると,こぼした寒
剤に直接触れたときと同じように,すぐに凍傷を引き起こす。また,材料の高周波特性を測定
するために高周波発振器を使用することも基本である。もしその出力が高い場合,人体への直
接接触はすぐにやけど(火傷)を引き起こす。
6.1
試料の準備
誤差に関する考察によれば,膜の直径はサファイア円柱の3倍程度大きくとらなければならない。この
条件を満たす場合には,TE011及びTE013モード間の異なる放射損によるRs測定精度の低下は目標精度20 %
に対して無視できる。膜厚はそれぞれの温度に対してロンドン侵入長の3倍程度でなければならない。

6
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
もし,膜厚がロンドン侵入長の3倍より非常に薄い場合は,測定されたRsは実効的表面抵抗の意味をも
つ。表2に12 GHz,18 GHz及び22 GHzの標準サファイア円柱に対し,推奨される超電導膜の寸法を示
す。
表2−12 GHz,18 GHz及び22 GHz用超電導膜の寸法
標準サファイア円柱
超電導膜
共振周波数
GHz
直径(d)
mm
直径(d')
mm
厚さ
μm
12
11.4
>35
〜
〜0.5
18
7.6
>25
〜
〜0.5
22
6.2
>20
〜
〜0.5
密閉形共振器を使う場合,超電導膜の寸法は,2枚の超電導膜の間におかれる銅リングの寸法を考慮に
入れて設計する。銅リングの設計指針をA.6に示す。
6.2
構成
測定機器を図1のように構成する。高湿度はQ値の低下をもたらす可能性があるため,すべての測定用
機器,標準サファイア円柱及び超電導膜は,清浄かつ乾燥した環境で保管する。試料及び測定ジグは,温
度制御可能な冷凍機に取り付ける。試料室は,通常,真空に排気する。超電導膜及び標準サファイア円柱
の温度は,測温用ダイオード又は熱電対で測定する。上下の超電導膜及び標準サファイア円柱の温度は,
可能な限り等しくすることが必要である。このために共振器の部分をアルミホイルで覆うか,又はヘリウ
ムガスを試料室に封入することが効果的である。
6.3
基準レベルの測定
はじめに全透過電力レベル(基準レベル)の測定を行う。測定精度は信号強度に依存するため,周波数
掃引発振器の出力を10 mW以下に設定する。セミリジッド同軸線で作製された基準同軸線を入・出力コネ
クターに接続する。次に,測定を行う温度及び周波数領域における透過電力レベルを測定する。基準レベ
ルは,室温から最低測定温度までの冷却過程で数dB変化する可能性があるため,温度特性を考慮した基
準レベルの測定が不可欠である。
図3−T Kにおける挿入損失IA,共振周波数f0及び電力半値幅Δf
6.4
共振器の周波数応答の測定
表面抵抗Rsの温度依存性は,共振周波数f0並びにTE011及びTE013共振器の無負荷Q値(Qu)の測定を
7
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
通して行われる。これらの測定は,次による。
a) 測定ジグと入・出力コネクターの間を連結する(図1)。下側の超電導膜の中心付近に高さの小さい方
(TE011モード)の標準サファイア円柱を置き,標準サファイア円柱との間の距離を固定する。透過形
共振器が入出力ループと等しく疎結合するように,サファイア円柱とセミリジッド同軸線先端の各ル
ープとの間隔を等距離に調節する。標準サファイア円柱の上部端面に上部超電導膜を注意深く置く。
圧力をかけ過ぎて超電導膜の表面にきずを付けないように注意する。
b) 設計値f0とほぼ同じ周波数のところに,この共振器の共振周波数TE011モードがあることを確認する。
c) ディスプレイ上にTE011モードの共振ピークだけが現れるように周波数領域を狭める(図3)。標準サ
ファイア円柱とセミリジット同軸線との距離を変化させて共振ピークの挿入損失IAを基準レベルか
ら20 dB程度になるように調節する。共振周波数f0を測定する。
d) f0の温度依存性及び半値幅Δfを測定する。TE011共振器の負荷時のQ値,QLは式(1)で与えられる。
f
f
Q
∆
=
0
L
·················································································· (1)
e) 無負荷Q値,Quは,次に示すいずれかの方法によってQLから導き出される。無負荷Q値を導き出す
一つ目の方法は,測定された挿入損失IAから式(2)のように求められる。
t
L
u
1A
Q
Q
−
=
··············································································· (2)
ここに,
20
/]
dB
[
t
10IA
A
−
=
上記の無負荷Q値を測定するための技術は,共振器の入出力の結合度が等しいことを前提にしてい
る。
しかし,結合ループは作製が難しく,ループ面を水平に制御することも困難である。さらに,測定
中に標準サファイア円柱が移動する可能性もある。このような共振器の不完全な設置に起因する効果
は,温度によっても変化する。もし結合が強ければ(IAが約10 dB未満),このような結合における
非対称性(共振器の設置上の問題によって共振器の入力ループの結合が互いに等しくない状態)は,
結合係数を計算する上で大きな誤差を生む可能性がある。結合が十分弱い場合(IAが20 dB以上)に
は,結合における非対称性の影響は無視できる。
無負荷Qを得るもう一つの方法では,共振器の入出力側で,共振周波数における反射係数を測定す
る。この場合,無負荷Q値,Quは,式(3)〜式(5)で計算される。
)
1(
2
1
L
u
β
β+
+
=Q
Q
···································································· (3)
22
11
11
1
1
S
S
S
+
−
=
β
············································································ (4)
22
11
22
2
1
S
S
S
+
−
=
β
············································································ (5)
上記の式でS11及びS22は図4に示すようにSパラメータであり,デシベル単位ではなく,線形単位
で測定される。β1及びβ2は結合係数である。
このSパラメータを使う方法は二つの利点をもっている。まず,基準レベルの校正を行う必要はな
い。さらに共振器の入出力側の結合係数を測定しているので,結合の非対称性に起因した誤差を含ま
ない。しかし,この方法は二つの欠点をもっている。すなわち,一つは狭帯域の共振にしか適用でき
ないことである(ただし,超電導では狭帯域であるので適用できる。)。二つ目は,反射係数測定にお
けるネットワークアナライザーのダイナミックレンジによる制限を受けることである。

8
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
上記に規定する2種類の技術を組み合わせることは,優れたダブルチェックとなるため,推奨され
る。
f)
短いほうの円柱を使って測定されるf0及びQuを,f01及びQu1とする。冷凍機の温度をゆっくりと変化
させてf01及びQu1の温度依存性を測定する。
g) f01とQu1との温度特性測定の後,測定装置は室温まで加熱されなければならない。
h) 次に,室温で測定装置の中のTE011共振器をTE013共振器と入れ替え,超電導臨界温度以下まで装置の
温度を下げる。その後,TE011共振器の場合と同じようにして,TE013共振モードのf0及びQuの温度依
存性,すなわち,f03とQu3とを測定する。TE013共振器の標準サファイア円柱の高さがTE011共振器の
高さの正確に3倍であれば,TE013共振器のf03はTE011共振器のf01に一致する。もし注意深く設計す
れば,f01とf03との差は,一般的に非常に小さい(約0.25 %未満)。6.5の計算において,f0 = f01 = f03
として扱ってよい。
図4−反射Sパラメータ(S11又はS22)
6.5
超電導体の表面抵抗及び標準サファイア円柱のε'及びtan δの決定
式(6),式(7)及び式(8)からf01,Qu1,f03及びQu3の温度依存性を用いて超電導膜の表面抵抗Rs及び標準サ
ファイア円柱の比誘電率ε',誘電体損tan δの温度依存性を算出する。
−
+
+
−
×
=
3
u
1
u
3
0
0
2
s
1
1
1
2
)1
3(
3
π
30
Q
Q
W
W
ε'
λ
h
R
············································ (6)
(
)1
π
2
2
2
0
+
+
=
v
u
d
λ
ε'
·································································· (7)
−
−
+
=
1
u
3
u
1
3
)1
3(
1
tan
Q
Q
ε'
W
δ
····························································· (8)
ここに,
0
0
f
c
λ=
··················································································· (9)
)
(
)
(
)
(
)
(
)
(
)
(
)
(
)
(
2
0
2
1
2
1
2
0
2
1
2
1
u
J
u
J
u
J
v
K
v
K
v
K
v
K
u
J
W
−
−
×
=
·················································· (10)

9
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
−
=
1
2
π
2
0
0
2
0
2
h
λ
λ
d
v
······························································(11)
)
(
)
(
)
(
)
(
1
0
1
0
v
K
v
K
v
u
J
u
J
u
−
=
··································································· (12)
これらの式で,λ0は自由空間における共振波長,cは真空における光の速度(c=2.997 9×108 m/s),h0
は短いほうの標準サファイア円柱の高さである。u2の値は,v2の関数として超越方程式(12)から与えられ
る。
ここで,Jn (u)は第1種ベッセル関数で,Kn(v)は第2種変形ベッセル関数である。式の導出をA.3に記載
する。
一般的に誘電体円柱の寸法は温度変化するので熱膨張係数を考慮する必要がある。しかし,サファイア
円柱の熱膨張効果はRsの目標精度(20 %)に対して無視できる。
侵入長の温度依存性が膜厚より十分大きくない場合,測定されたRsは実効的表面抵抗を意味しているこ
とを注意しておく。
7
精度及び精確さ
7.1
表面抵抗
表面抵抗は,誘電体共振器法を用いて測定されたQ値から決定される。
表3に示すベクトル・ネットワークアナライザーを減衰の周波数依存性の測定に用いる。Q値の測定結
果の相対不確かさは,1 %以下でなければならない。
表3−ベクトル・ネットワークアナライザーの仕様
S21のダイナミックレンジ
60 dB以上
周波数分解能
1 Hz以下
減衰の不確かさ
0.1 dB以下
最大入力
10 dBm以下
誘電体共振器は,77 Kにおいて1×10−6以下のtan δと超電導体試料半径の1/3以下の半径をもつ2個の
誘電体円柱で構成されなければならない。誘電体円柱に最も望ましいのは表4に示す仕上がり仕様をもつ
サファイア円柱である。表4における用語の定義は図5に示す。
表4−サファイア円柱の仕上がり仕様
直径
±0.05 mm以下
高さ
±0.05 mm以下
平たん性
0.005 mm以下
表面粗さ
上,底表面:10 nm rms以下
円筒部表面:0.001 mm rms以下
垂直性
0.1°以内
円柱軸方向
c軸に対して0.3°以内で平行

10
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図5−表4における用語の定義
ここに記載した測定方法は,等しいtan δをもつ高さ比1:3の一対の標準サファイア円柱が作製できる
ことを仮定している。しかしながら,同じ原料結晶から切り出し,同じ手法で研磨した,同一とみなしう
る円柱においても,tan δのばらつきは2けた程度に及ぶことがある。今日,同一の一連の製造工程で作製
したサファイア円柱における最も少ないtan δのばらつきは4倍程度 [9] である。このサファイア円柱の
tan δのばらつきがここに記載したRs測定法において少なくとも10 %の付加的な不確かさをもたらしてい
る。これによって,この測定法の目標精度が20 %にとどまっている。もし,サファイア円柱の製造工程の
ばらつきが改善されるか,又は多くのサファイア円柱の中から特性のそろった一対のサファイア円柱を選
び出す手法が確立されれば,この誘電体共振器法によるRs測定の目標精度を改善することができる。
7.2
温度
測定時に測定ジグは測定温度まで冷却されるが,どのような冷却手段を用いてもよい。最も簡便な方法
は液体冷媒に測定ジグを浸せき(漬)することであろう。この手法は手早く,簡単であり,既知の安定し
た温度が得られる。しかし残念なことに,ほとんどの高温超電導材料は試料を冷媒から取り出すときに生
じる結露によって損傷される。さらに,共振器内に気体,液体混合物が存在することの影響による誤差及
び温度依存性を測定することの困難さがあるため,他の冷却手法を採用することが望ましい。これらの問
題は,真空容器ごと液体冷媒に浸せき(漬)することによって解決できる。真空容器に気体を再充てん(填)
すれば素早く冷却でき,かつ,均一な温度が得られる。ジグにヒータが備え付けられていれば,高温超電
導材料の温度依存性の測定が可能である。その他の有効な手法は,冷凍機の使用である。この場合,共振
器は真空下に置かれ,金属容器を通した伝熱によって冷却される。この場合,ジグ内に温度こう配が生じ
ないよう注意しなければならない。
クライオスタットはRs測定に必要な環境を備えたものを準備し,試料は測定の間安定で,かつ,等温状
態に保持されなければならない。試料の温度は測定ジグの温度と同一であるとみなされる。ジグの温度は
適切な温度センサを用いて±0.5 Kの精度で測定し,記録しなければならない。
良好な熱伝導体で作られた遮へい(蔽)で覆うことによって,試料温度とジグ温度との差を最小に抑え
なければならない。
7.3
試料及びホルダーの支持構造
支持構造は,試料に適したものとしなければならない。測定を通して2枚の超電導膜は平行に配置され,
機械的に安定である(特に,冷凍機中で広い温度範囲にわたって)ことが必す(須)である。
7.4 試料保護
膜表面に水蒸気が結露したり,引っかいたりしてしまうと,超電導特性を損なうことになる。試料を保
護するためには幾つかの方策がある。ポリテトラフルオロエチレン(PTFE)又はポリメチルメタクリレー
11
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
ト(PMMA)を塗布することは測定に影響を与えないため,保護のためにそれらを用いることが可能であ
る。塗布する材料は少なくとも数μm以下の厚さにしなければならない。
8
試験報告
8.1
試験試料の識別
a) 試料製造業者名
b) 等級及び/又は記号
c) ロット番号
d) 薄膜及びその形成に用いられた基板の化学組成
e) 薄膜の厚さ及び表面粗さ
f)
製造方法
8.2
Rs値の報告
Rs値は,関連したf01,f03,Qu1,Qu3,IA,(β1,β2),ε',tan δ及びそれらの温度依存性とともに報告され
なければならない。
8.3
試験条件の報告
次の試験条件を,報告しなければならない。
a) 測定周波数及び周波数分解能
b) 全透過電力レベル(基準レベル)
c) 測定温度及びその精度,2枚の超電導膜間の温度差
d) 試料の温度履歴
12
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
附属書A
(参考)
箇条1から箇条8までの追加参考事項
A.1 適用範囲
高温超電導膜(以下,HTS膜という。)は10 GHzにおいて,およそ0.1 mΩという極めて低い表面抵抗
Rsの値をもつ。この品質評価のために標準測定法の確立が求められている。マイクロ波・ミリ波領域にお
ける表面抵抗を測定する目的で,これまでに図A.1に示すような幾つかの共振器法が提案されてきた。これ
らの共振器構造は,次の6種類に分類される。
A.1.1 円筒空洞共振器法 [1]1)
図A.1 a)は,銅の円筒と2枚のHTS膜で構成されたTE011モードを用いた空洞を示したものである。
30 GHz以下のマイクロ波領域では,この方法によるRs測定の精度は十分ではない。これは銅円筒のRsの
値がHTS膜のRsよりもおよそ100倍大きいためである。一方,Rsの値はHTS膜の場合f 2に比例し,銅の
場合にはf 1/2に比例して増加するため,この方法はミリ波領域での測定に適する。
注1) 文献番号は,A.9を参照。
A.1.2 平行平板共振器法 [2]
図A.1 b)は,薄い低誘電損誘電体板を2枚の四角形のHTS膜で挟んだ平行平板共振器の構造を示したも
のであり,測定にはTMnm0モードが用いられる。この方法を用いれば,極めて小さいRsを測定できる可能
性がある。しかし,Rsの絶対的評価という観点からは,誘電体板の厚さとtan δの測定精度,放射損及び誘
電体板と超電導膜間の空げき(隙)効果の不確かさ,共振モードの励振の困難さなど,幾つかの問題があ
る。
A.1.3 マイクロストリップライン共振器法 [1],[3]
図A.1 c)は,実際のマイクロ波デバイスと同様にパターニングが施されたマイクロストリップライン共
振器の構造を示したものである。この共振器ではTEMnモードが用いられる。しかし,この方法はパターン
形成時の形状・特性変化の影響を排除できないため,HTS膜それ自体の特性評価には適さない。
A.1.4 誘電体共振器法 [4],[5]〜[7]
図A.1 d)にTE011モードを用いた誘電体共振器の構成を示した。この共振器は,誘電損失の小さいサファ
イア円柱を平行な2枚のHTS膜構造をもつ。TE0mpモードに対してはHTS膜に直交する電界成分が存在し
ないため,空げき(隙)の影響は無視できる。この方法におけるHTS膜のRsの導出は,単結晶サファイ
アのもつtan δが1×10−8より小さく無視できるという仮定に基づいている。しかし,50 K付近で10 GHz
におけるサファイアのtan δの測定値は格子欠陥の数に依存し10−6から10−8の値をとることが知られてい
る。したがって,この方法を用いる場合には,tan δ<1×10−8を満たす極めて損失の低いサファイアを準
備することが不可欠である。
A.1.5 イメージタイプ誘電体共振器法 [8]
図A.1 e)にTE01δモードを使ったイメージタイプ誘電体共振器の構造を示す。この構造においてはHTS
膜1枚で測定が可能である。しかしながら,Rs測定においてtan δの影響を無視することになるため,この
方法においても非常に低損失なサファイア円柱が必要となる。
加えて,測定した共振周波数,無負荷Q値からRs値を決定するため,複雑で面倒な数値計算が必要と
なる。
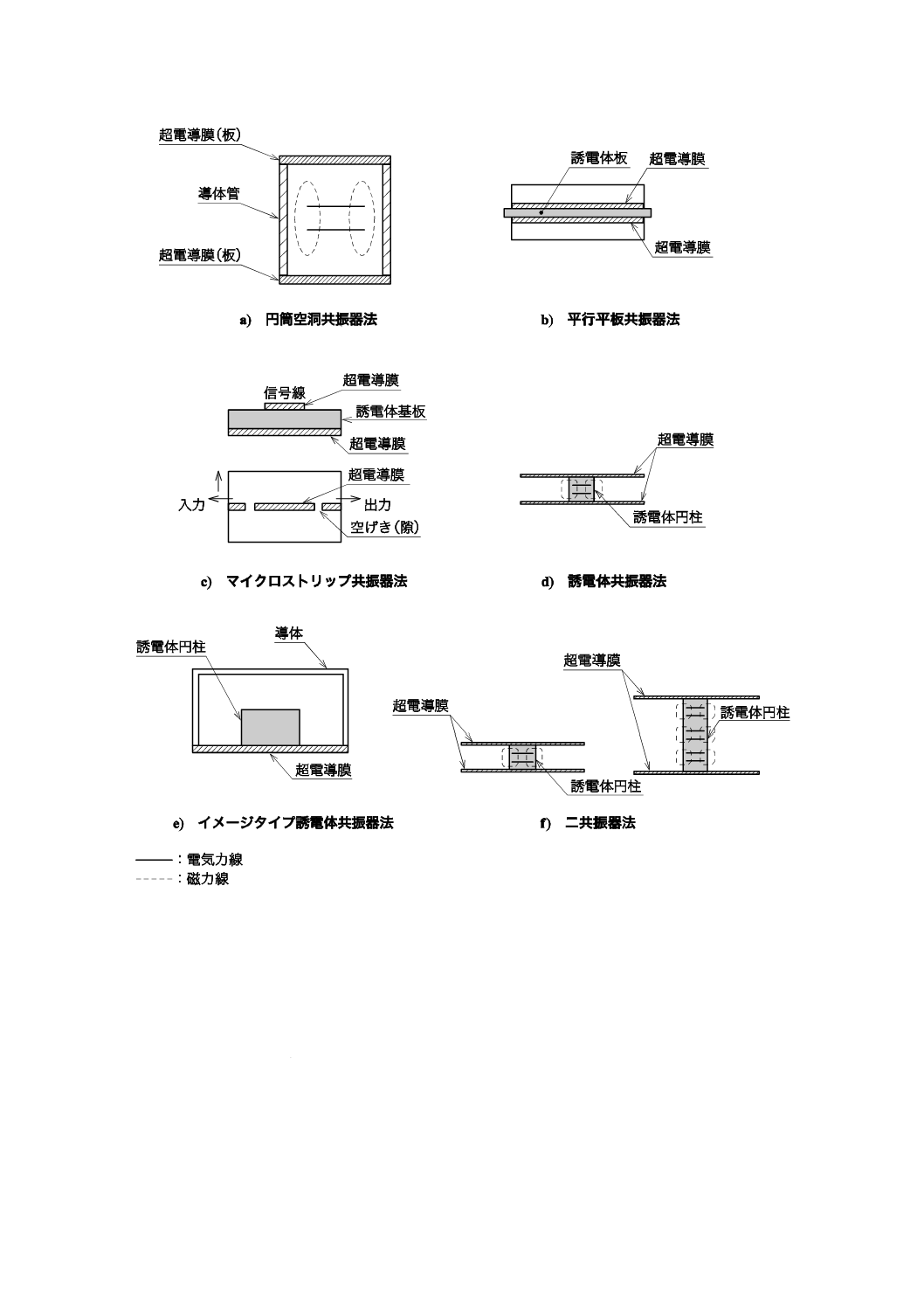
13
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図A.1−表面抵抗測定法の模式図
A.1.6 二共振器法[9],[10]
この方法では,同じtan δをもつ二つのサファイア円柱共振器を用いる。図A.1 f)に示したように,一方
はTE011モード共振器で,もう一方はTE013モード共振器である。誘電体共振器法と同様に,この方法にお
いては空げき(隙)の影響は除去することができる。これら共振器によって測定された共振周波数,無負
荷Q値から,サファイア円柱のtan δ,HTS膜のRs値はそれぞれ別個に決定できる。その方法はモードマ
ッチング法に基づいた厳密な解析によって導かれる簡単な数式を用いるものである。したがって,この方
法はRs測定に影響するtan δの不正確さを除去することができる。実際,12 GHzにおいてRs=0.1 mΩの
6個のイットリウム系HTS膜のRs測定結果は,この方法によって10 %の測定精度が実現できることを実
証した [10]。しかしながら,もし二つのサファイア円柱のtan δに違いがあれば(Δtan δという)。Δtan δ

14
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
によるRsの誤差を考慮に入れなければならない。この効果は,この手法を用いた同じHTS膜のラウンド
ロビンテストの結果から見積もることができる。
上記の六つの手法を比較すると,次に示す二つの利点から二共振器法をHTS膜の標準的なRs測定方法
として推奨する。
− Rsの絶対値測定が可能である。
− 数値処理が単純で簡単である。
A.2 要求事項
f 2則によって周波数とともに超電導膜のRsも増加するため,低いRsを高精度に決定するためには測定周
波数を上げることが望ましい。また,より高い測定周波数を使うことによって,共振器の大きさも小さく
することができる。しかしながら測定周波数が高くなるとマイクロ波測定システムのセットアップは難し
くなる。
30 K以下,又は80 K以上の温度においても,冷却方法を考慮する必要はあるが,この測定方法は十分
に適用可能である。
A.3 原理
図A.2にTE0mpモード共振器の構成を示す。TE0mpモードは誘電体と超電導試料間とに生じるすき(隙)
間の影響を小さくできる。図で直径d,高さhの円柱形誘電体の上下両端はそれぞれ測定対象の超電導薄
膜で短絡する。Rs値は共振周波数f0とTE0mp共振モードの無負荷Quの測定値から計算される。
なお,測定される2枚の超電導薄膜は同じRs値をもつことが要求される。これらが異なるRs値をもつ
場合,測定される値は,二つの薄膜のRs値の平均になる。
図A.2−誘電体円柱と2枚の超電導膜の構成
Rs値は,式(A.1)で与えられる。
−
=
δ
tan
1
u
s
Q
A
B
R
································································· (A.1)
ここで,各記号の定義式を式(A.2)〜式(A.7)に示す。
ε'
W
A
+
=1
············································································· (A.2)

15
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
,
,2,1
,
π
30
1
2
2
3
0
2
=
+
=
p
ε'
W
h
λ
p
B
················································· (A.3)
0
0
f
c
λ=
················································································ (A.4)
)
(
)
(
)
(
)
(
)
(
)
(
)
(
)
(
2
0
2
1
2
1
2
0
2
1
2
1
u
J
u
J
u
J
v
K
v
K
v
K
v
K
u
J
W
−
−
×
=
················································ (A.5)
1
−
2
π
=
0
2
0
2
2
h
pλ
λ
d
v
··························································· (A.6)
)
(
)
(
−
=
)
(
)
(
1
0
1
0
v
K
v
K
v
u
J
u
J
u
································································· (A.7)
式(A.1)及び式(A.2)中のε'及びtan δは,誘電体円柱の比誘電率及び誘電体損である。式(A.3)及び式(A.4)
中のλ0は自由空間における共振モードの波長であり,cは真空中の光の速度(c=2.997 9×108 m/s)である。
関数W/ε'は誘電体円柱内に蓄えられるエネルギーと外側に残るエネルギーとの比である。もし,すべての
電場が誘電体円柱中に集中するならばWは0となる。u 2はv 2の値を使って超越方程式(A.7)から導かれる。
式(A.7)でJn(u)は第1種ベッセル関数で,Kn(v)は第2種変形ベッセル関数である。vの任意の値に対し,m
番目のuの解はu0mとu1mの間に存在する。ただし,u0mとu1mは,J0(u0m)=0とJ1(u1m)=0を満たす。モー
ド同定が簡単な第1解(m=1)を図A.3中に曲線(1)で示す。また,m=1のTE0mp共振モードに対するW-v
関係の計算結果は図A.3中に曲線(2)で示す。
図A.3−計算によって求められたTE01pモードに対するu-vとW-vとの関係
ε'はv 2とu 2との値を用いて,式(A.8)で与えられる。
(
)1
+
π
=
2
2
0
2
v
+
u
d
′
λ
ε
······························································· (A.8)
二共振器法では,対となる二つの誘電体円柱が使われ,今後,これらを“標準誘電体円柱”と定義する。
これらの誘電体円柱は同じ直径をもつが,高さは異なり,一方は他方のp倍になっている。

16
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
なお,pは3が通常選ばれる。図A.4にその構成を示す。ここで,同じ2枚の超電導膜を用いる。混乱
を避けるため,短い標準誘電体円柱の高さをh0と表す。それぞれの誘電体円柱を用いた共振器は“TE011
共振器”と“TE013共振器”と呼ばれる。TE011モードに対するf0とQuとはTE011 共振器を用いて測定され,
TE01pモードに対してはTE01p共振器が用いられる。それぞれの共振器のf0とQuとは1とpとの添え字を用
いて区別する。すなわちTE011共振器ではf01,Qu1と,TE01p共振器ではf0p,Qupと表す。
図A.4−二共振器法におけるRs及びtanδ測定用標準誘電体円柱共振器の構成
tan δの値はQuの測定値から求められる。TE01p共振器の高さが正確にTE011共振器の高さのp倍であれ
ば,f0pはf01と一致する。一方,Q値に関しては,二つの誘電体円柱に蓄えられる電場エネルギーの大きさ
が異なるため,QupはQu1より大きくなる。同じ超電導薄膜を用いて二つの誘電体円柱が短絡されているこ
とから,式(A.1)により,式(A.9)が導かれる。
−
−
u1
up
1
1)
(
=
tan
Q
Q
p
p
A
δ
······················································· (A.9)
さらに,式(A.9)を式(A.1)のtan δに代入することで,超電導膜のRsを直接求めるための式(A.10)が導か
れる。
(
)
−
+
+
−
=
up
u1
3
0
0
2
s
1
1
1
2
1
π
30
Q
Q
W
W
ε'
λ
h
p
p
R
·······································(A.10)
A.4 測定ジグ(共振器)
不要モードへの結合はTEモード共振器の高Q値を低下させる。この不要な結合を抑制するため,高Q
値をもつ測定ジグの設計には特別な注意が必要である。提案されている3種類の測定ジグを図A.5に示す。
図A.5−三種類の誘電体測定ジグ(共振器)
17
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
a) 開放形測定ジグ 2枚の平行な超電導膜の間に低損失誘電体円柱を配置する。rf入出力部における磁
界結合のため,2本のセミリジット同軸線を測定ジグの両側に取り付ける。ここで,励振同軸線の垂
直方向の位置は,同軸線に沿って伝搬する放射損を避けるために細心の注意をもって決定されるべき
である。この放射損は共振モードのQ値を減少させるので,Rsの測定誤差の増加の原因となる。これ
を避けるには,同軸線をできるだけ下部超電導膜に近づけて配置することは有効である。
b) 空洞形測定ジグ a)に示す開放形測定ジグを導体(銅)空洞中に配置する。
c) 密閉形測定ジグ 超電導膜の間に導体(銅)円筒を置く。この構造では,同軸線に沿った放射損を銅
円筒により避けることができる。同軸線の垂直方向の位置は,磁場のz軸成分が最大となるz=h/2に
配置することを推奨する。
冷凍機内に置かれた測定ジグは,機械的及び熱的じょう乱から保護されるべきである。また,開放形測
定ジグの場合,アンテナのループ位置を調整するための三軸マニピュレーターを取り付けることが望まし
い。
アンテナのループ長は,測定感度を上げるため1/4波長以内にする。
A.5 標準サファイア円柱の寸法
図A.6と図A.7は,TE011共振器及びTE013共振器の設計に用いるサファイア円柱の比誘電率の一軸異方
正を考慮したモードチャート [11] を示す。ただし,εZはc軸方向におけるサファイア円柱の比誘電率,εr
はc軸に垂直な面内におけるサファイア円柱の比誘電率,dはサファイア円柱直径,hは円柱の高さ,λ0
は自由空間の共振波長である。図A.6と図A.7とから明らかなように,TE013共振モードはTE011共振モー
ドに比べて,TM及びHEモードの影響を受けやすい。TEモードと他のモードの結合は無負荷Qの劣化を
引き起こすことから,サファイア円柱の(d/h)は不要な結合を避けるように選ばなければならない。
図A.7に示されるようにTE013モード共振器の(d/h)2は,他のモードの影響を避けるために0.24〜0.46
に選ばれる。これに相当するTE011共振器の高さは1/3であるから,TE011共振器の(d/h)2=2.2〜4.1が導
かれ,図A.6から,この範囲ではTE011モードも他のモードと結合しないことが分かる。
TEモードの共振周波数は誘電体円柱の比誘電率と寸法の関数なので,その直径及び高さは目的のf0が得
られるように決定される。
図A.6におけるTE011モードの曲線から,各(d/h)2の値に対してεr(d/λ0)2の値を決定することができる。
例えば(d/h)2=4.0の場合,εr(d/λ0)2=1.92である。(d/h)2=4.0のサファイア円柱に対するTE011モードの
共振周波数は,サファイア円柱のdとεrとを指定することによって,式(A.11)から計算される。
=
c/
f
d
ε
=
d
ε
92
.1
)
(
)
/
(
2
0
r
2
0
r
×
λ
···············································(A.11)
A.6 密閉形測定ジグの寸法設計
密閉形測定ジグでは,銅円筒が超電導膜の間に置かれ,サファイア円柱は銅円筒の中央に置かれる[図
A.5 c)]。TMモードの共振周波数は,銅円筒内径Dの影響で変化する。したがってDは,他のモードとの
結合を避けるように決定されるべきである。図A.8と図A.9とは,密閉形TE011共振器[(d/h)2=4]とTE013
共振器[(d/h)2=0.44]との設計に用いるモードチャートを示す。ただし,横軸はS=D/dを示す [11]。TE011
及びTE013モードを同時に他の共振モードから避けることのできるSの範囲は,S=1.8〜2.8,3.8〜4.1,4.8
〜5.2である。ここでは,S=D/d=4の値が,取扱いの容易さから推奨される。
注記 TEモードの共振周波数は,D/dの影響を受けないので,d/hは開放形測定ジグの寸法設計[図
A.5 a)]が適用できる。
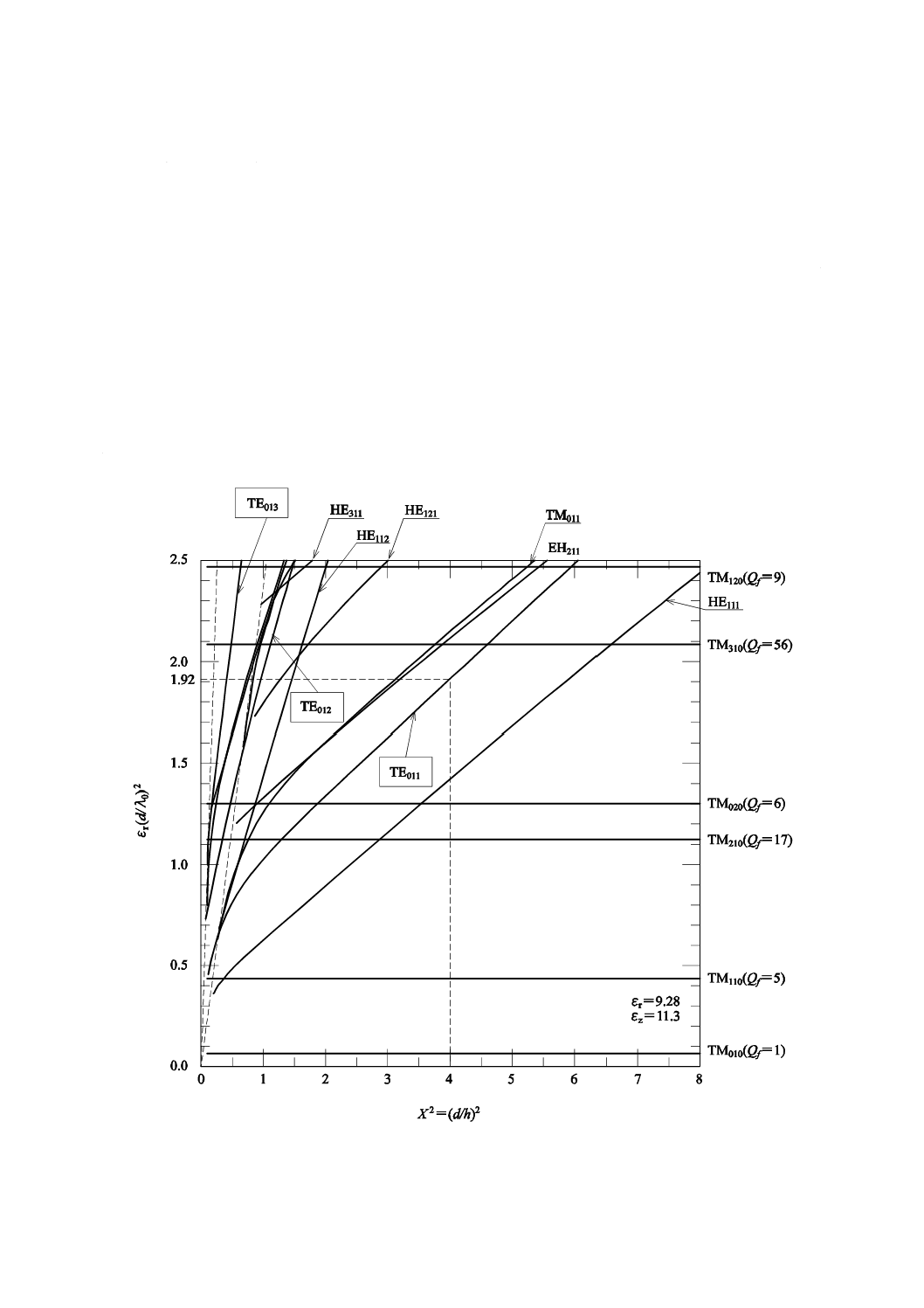
18
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
A.7 試験方法の精度及び精確さ
この測定法の誤差評価 [4],[10],感度,精確さ及び再現性は,Rsに関する誤差解析とラウンドロビン試
験によって評価できる。
A.8 サファイア円柱の選択
サファイア円柱のtan δを正確に測定することは難しい問題である。そこで,二つの標準円柱の選択を含
む二共振器法を基にした手法が薦められる。最初に高温超電導膜の組を固定し,一共振器法によって多数
のTE011サファイア円柱について共振特性を測定し円柱間で比較する。一番高いQ値をもつTE011サファイ
ア円柱を仮の標準と選択する。同じ作業を,高さが3倍のTE013サファイア円柱に対しても繰り返す。こ
れによって選択された二つの仮の標準サファイア円柱を用いて,前述した二共振器法によってtan δを求め
る。他の円柱の誘電特性(ε'及びtan δ)はこの仮の標準試料との直接の比較から校正できる。この校正に
よってtan δが求められたTE011サファイア円柱だけを用いて,測定対象の超電導膜のRsを求めることがで
きる。
図A.6−開放形TE011共振器設計用モードチャート[11]
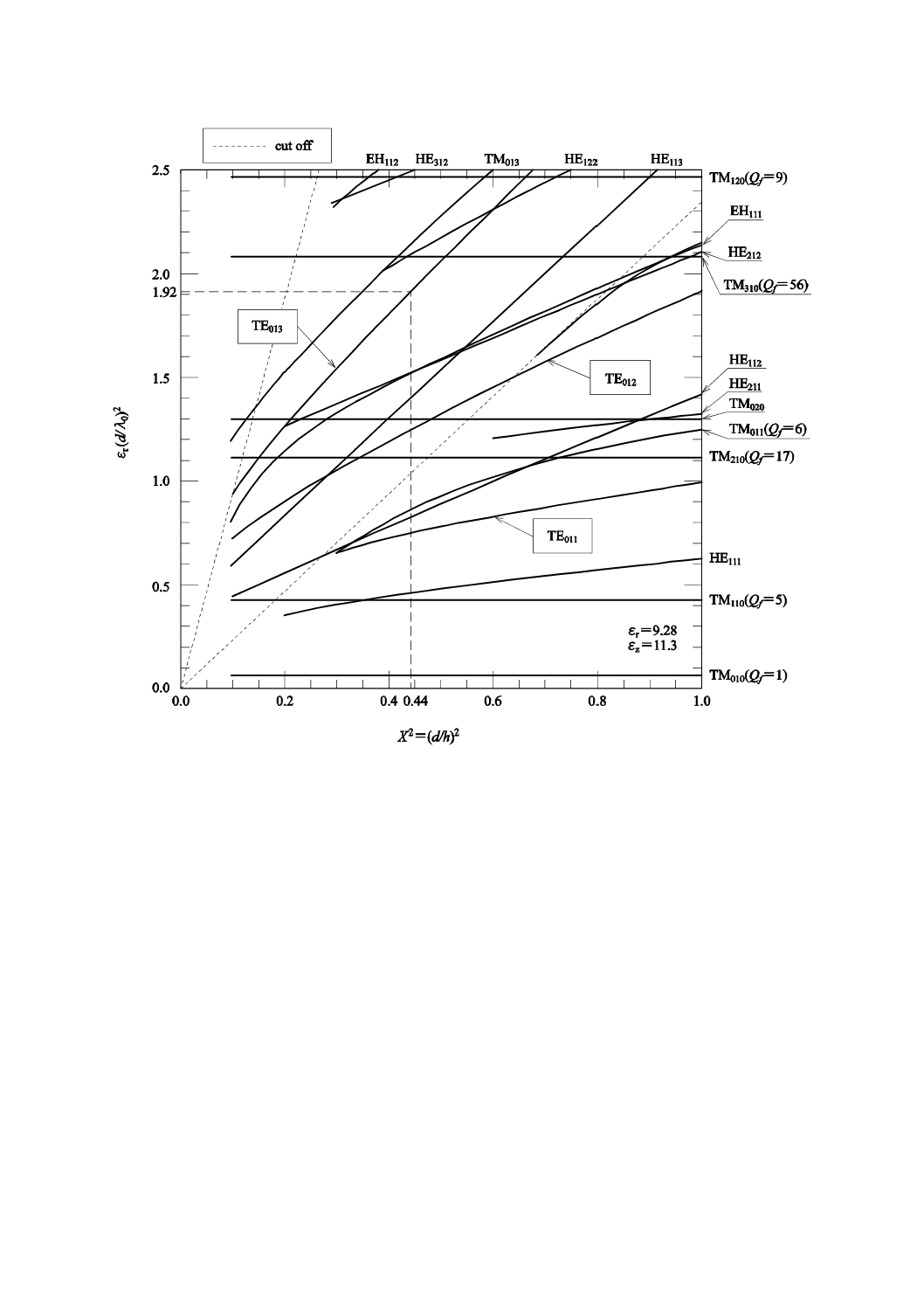
19
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図A.7−開放形 TE013 共振器設計用モードチャート[11]
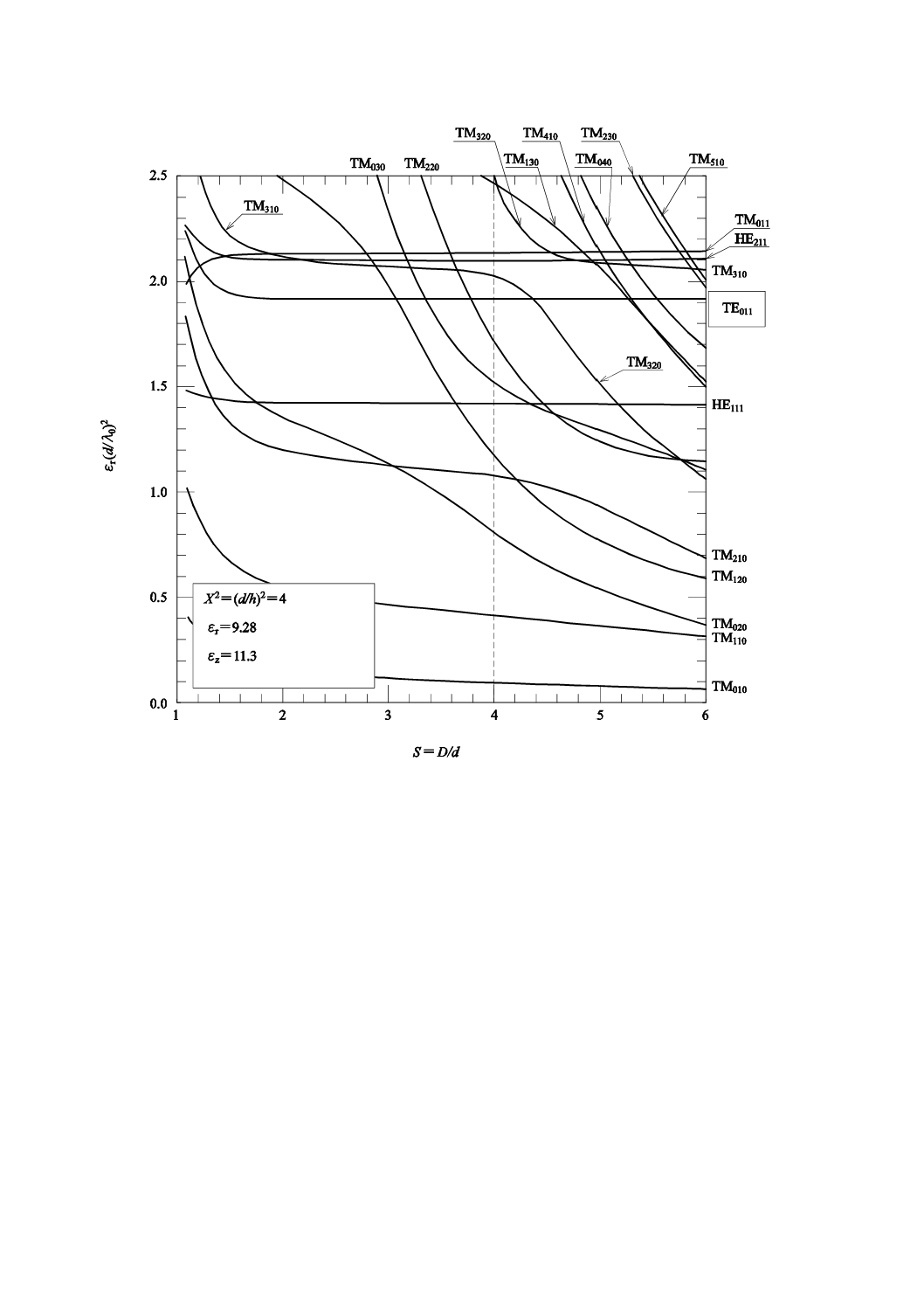
20
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図A.8−密閉形TE011共振器設計用モードチャート
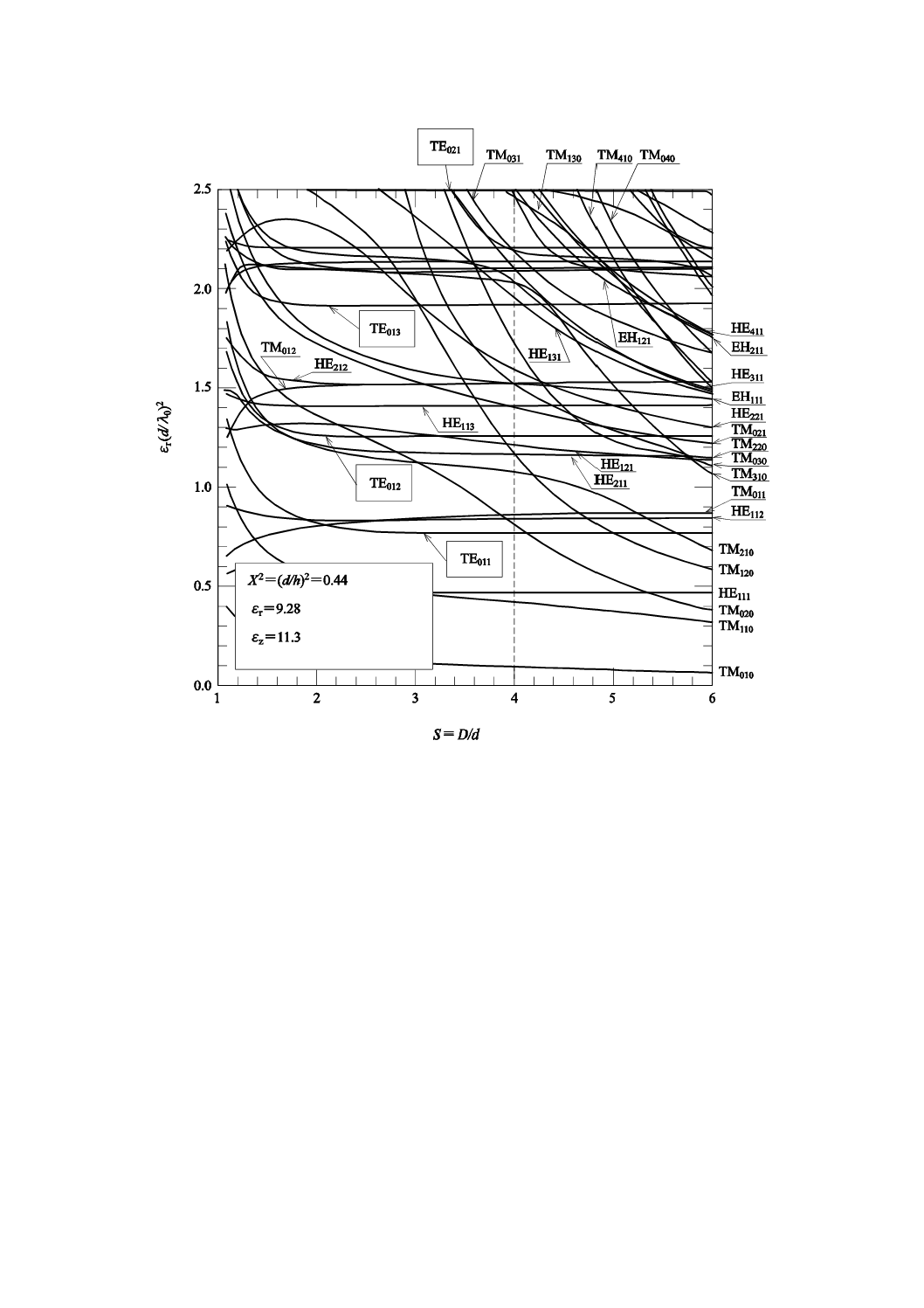
21
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
図A.9−密閉形TE013共振器設計用モードチャート
22
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
A.9 出典
[1] WILKER, C., SHEN, Z.-Y., PANG, P., FACE, DW., HOLSTEIN, WL., MATTHEWS, AL. and LAUBACHER,
D.B. 5 GHz high-temperature-superconductor resonators with high Q and low power dependence up to 90 K.
IEEE Trans. Microwave Theory Tech., 1991, 39, p.1462.
[2] TABER, RC. A parallel plate resonator technique for microwave loss measurements on superconductors. Rev.
Sci. Instrum., 1990, No. 61, p.2200〜2206.
[3] YOSHITAKE, T. and TSUGE, H. Effects of microstructures on microwave properties in Y-Ba-Cu-O microstrip
resonators. IEEE Trans. Appl. Supercond., 1995, 5, p.2571.
[4] MAZIERSKA, J. Dielectric resonator as a possible standard for characterization of high temperature
superconducting films for microwave applications. J. Supercond., 1997, 10, p.73.
[5] SHEN, Z.-Y., WILKER, C., PANG, P., HOLSTEIN, WL., FACE, DW. and KOUNTZ, DJ. High Tc
superconductor-sapphire microwave resonator with extremely high Q-values up to 90 K. IEEE Trans.
Microwave Theory Tech., 1992, 40, p.2424.
[6] KRUPKA, J., KLINGER, M., KUHN, M., BARANYAK, A., STILLER, M., HINKEN, J. and MODELSKI, J.
Surface resistance measurements of HTS films by means of sapphire dielectric resonators. IEEE Trans. Appl.
Supercond., 1993, 3, p.3043.
[7] TELLMANN, N., KLEIN, N., DAHNE, U., SCHOLEN, A., SCHULZ, H. and CHALOUPKA, H. High-Q
LaAlO3 dielectric resonators shielded by YBCO-films. IEEE Trans. Appl. Supercond., 1994, 4, p.143.
[8] KOBAYASHI, Y. and KAYANO, H. An improved dielectric resonator method for surface impedance
measurement of high-Tc superconductors, IEEE MTT-S Digest, 1992, No. IF2 T-3, p.1031.
[9] KOBAYASHI, Y., IMAI, T. and KAYANO, H. Microwave measurement of temperature and current
dependences of surface impedance for high-Tc superconductors. IEEE Trans.Microwave Theory Tech., 1991, 39,
p.1530.
[10] YOSHIKAWA, H., OKAJIMA, S. and KOBAYASHI, Y. Comparison between BMT ceramic one-resonator
method and sapphire two-resonator method to measure surface resistance of YBCO films. Proc. Asia-Pacific
Microwave Conf., 1998, 2, p.1083.
[11] HASHIMOTO, T and KOBAYASHI, Y. Two-Sapphire-Rod-Resonator method to measure the surface resistance
of High-Tc superconductor films. IEICE Trans. Electron., 2004, E87-C, No.5, p. 681.
23
H 7307:2010 (IEC 61788-7:2006)
2019年7月1日の法改正により名称が変わりました。まえがきを除き,本規格中の「日本工業規格」を「日本産業規格」に読み替えてください。
参考文献 [1] ZHANG, D., LIANG, G-C., SHIH, CF., LU, ZH. and JOHANSSON, ME. A 19-pole cellular
bandpass filters using 75-mm diameter high temperature superconducting thin films. IEEE
Microwave and Guided Wave Letters, 1995, 5, p.405.
[2] ONO, RH., BOOTH, JC., STORK, F. and WILKER, C. Developing standards for the emerging
technology of high temperature superconducting electronics. Adv. in Superconductivity X, Tokyo:
Springer, 1998, p.1407.
[3] KINDER, H., BERBERICH, P., UTZ, B. and PRUSSEIT, W. Double sided YBCO films on 4”
substrates by thermal reactive evaporation. IEEE Trans. Appl. Supercond., 1995, 5, p.1575.
[4] FACE, DW., WILKER, C., SHEN, Z-Y., PANG, P. and SMALL, R.J. Large area YBa2Cu3O7 films
for high power microwave applications. IEEE Trans. Appl. Supercond., 1995, 5, p.1581.
[5] KOBAYASHI, Y., IMAI, T. and KAYANO, H. Microwave measurement of temperature and current
dependences of surface impedance for high-Tc superconductors. IEEE Trans. Microwave Theory
Tech., 1991, 39, p.1530.
[6] WILKER, C., SHEN, Z.-Y., NGUYEN, VX., and BRENNER, MS. A sapphire resonator for
microwave characterization of superconducting thin films. IEEE Trans. Appl. Supercond., 1993, 3,
p.1457.
[7] MAZIERSKA, J. Dielectric resonator as a possible standard for characterization of high
temperature superconducting films for microwave applications. J. Supercond., 1997, 10, p.73.
[8] LLOPIS, O. and GRAFFEUIL, J. Microwave characterization of high Tc superconductors with a
dielectric resonator. J. Less-Common Met., 1990, 164, p.1248.
[9] MAZIERSKA, J. and WILKER, C. Accuracy issues in surface resistance measurements of high
temperature superconductors using dielectric resonators (corrected). IEEE Trans. Appl. Supercond.,
2001, 11, p.4140.